
文章介绍了利用XPS(X-ray Photoelectron Spectroscopy)和SIMS(Secondary Ion Mass Spectrometry)进行多层材料的结构和组成分析。实验方法有很多值得广大材料研究者借鉴之处。
方案详情

X-ray Photoelectron SpectroscopyandSecondary lon MassSpectrometry Location: Dunn (Physics) Building Dr. Ted Monchesky -(902) 494-3584Theodore.Monchesky@dal.ca Dr. Shuran Sheng -(902) 494-2321/494-3543Shuran.Sheng@dal.ca Institute forResearch in Materials The Dalhousie XPS/SIMS system XPS: VG Microtech MultiLab ESCA 2000 System. SIMS: Hiden EQS 300 System. Institute forResearch in Materials X-ray photoelectron spectroscopy (XPS) XPS is the most widely used surface analysis technique because of its relative simplicity inuse and data interpretation. The information XPS provides about surface layers or thin filmstructures is of value in many industrial applications. XPS measures the electronic states in a solid by irradiating a specimen with monochromaticx-ray radiation and analyzing the emitted photoelectrons. Key features of XPS Chemical Identification: of all elements except hydrogen and helium Surface sensitivity: measures outer 10 -60 A of a sample Detection limit: 0.1 atomic percent Quantification of the surface concentrations of elements present Determination of molecular environment and/or oxidation state Destructive depth profiling using argon etching Non-destructive depth profiling using angular dependence Information on surface electrical properties from charging studies System Specs Analyzer spatial resolution: 100 um Energy resolution:10 meV. X-ray sources (line widths): Mg Ka (0.7 eV) and Al Ka (0.85 eV) Institute forResearch in Materials The Analysis Chamber Showing the CLAM4 electron analyzer, X-ray gun, Ar+ gun, andthe mass spectrometer focused on the sample. Schematic diagram of the XPS apparatus, illustrating the depth profiling ofa multilayer sample. Institute forResearch in Materials Secondary Ion Mass Spectrometry (SIMS) SIMS is widely used for analysis of trace elements in solid materials. In SIMS the sample surface is bombarded by high energy ions, leading to the ejectionof both neutral and charged (+/-) species from the surface. The secondary ionsare extracted by electric fields and then energy and mass analyzed. Key Features of SIMS All elements detectable Isotopes can be distinguished High sensitivity System Specs and Features Detection limit: ppm Dynamic SIMS:“destructive”depth profiling Static SIMS:“non-destructive”surface analysis Quantification using standards and RSFs 5 keV Ar ion gun: resolution ~ 40 pm Institute forResearch in Materials Photograph of Hiden EQS 300 SIMS System. Institute forResearch in Materials multilayer sample Schematic diagram of the SIMS apparatus, illustrating the depthprofiling of a multilayer sample. Institute forResearch in Materials DALHOUSIEUniversity
确定






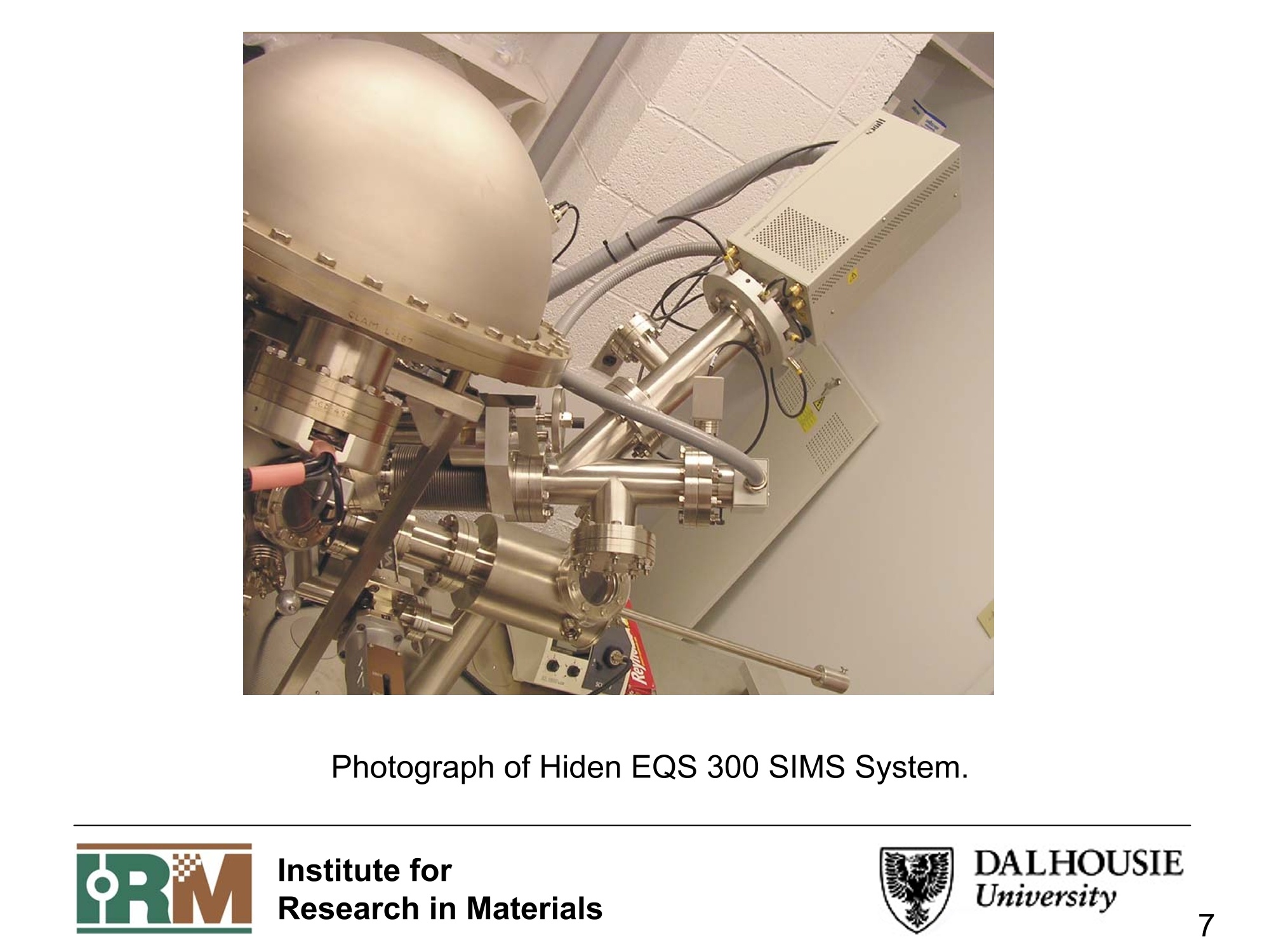
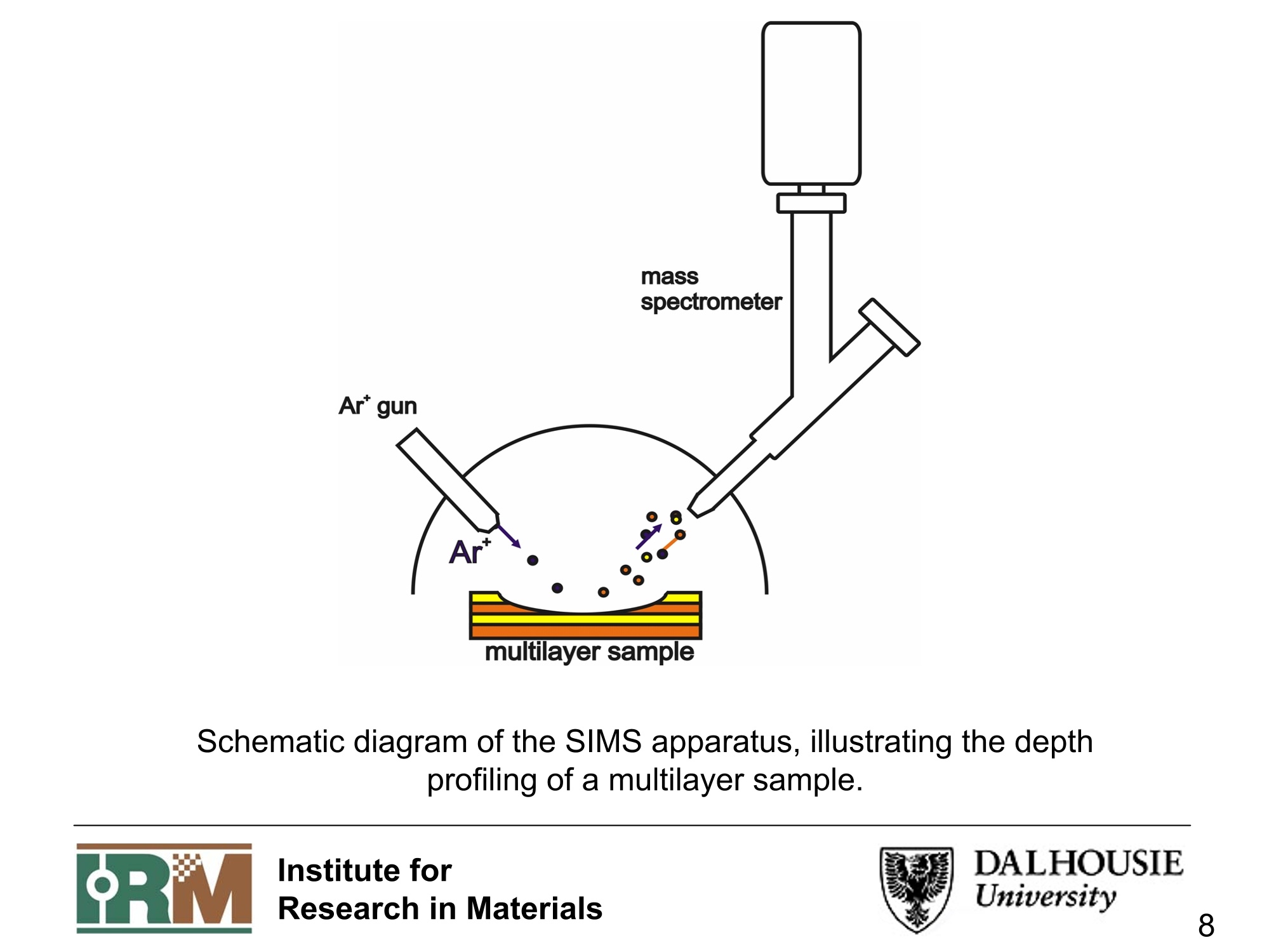
还剩6页未读,是否继续阅读?
北京英格海德分析技术有限公司为您提供《材料中表面表征检测方案(二次离子质谱)》,该方案主要用于其他中表面表征检测,参考标准--,《材料中表面表征检测方案(二次离子质谱)》用到的仪器有二次离子质谱探针
推荐专场
相关方案
更多