方案详情
文
使用MProbe-Vis系统可以轻松测量光刻胶厚度。实际上,任何光刻胶都可以快速可靠地测量:烧结或部分烧结,薄的或厚的。尽管如此,第一次测量可能会令人困惑——光致抗蚀剂的类型和处理条件多种多样。本应用说明试图通过烧结和两个部分烧结的光致抗蚀剂样品来阐明测量过程。使用500nm-1000nm波长范围进行光致抗蚀剂测量,以最小化吸收的影响。
方案详情

利用MProbe Vis系统进行光刻胶厚度测量摘要使用MProbe-Vis系统可以轻松测量光刻胶厚度。实际上,任何光刻胶都可以快速可靠地测量:烧结或部分烧结,薄的或厚的。尽管如此,第一次测量可能会令人困惑——光致抗蚀剂的类型和处理条件多种多样。本应用说明试图通过烧结和两个部分烧结的光致抗蚀剂样品来阐明测量过程。使用500nm-1000nm波长范围进行光致抗蚀剂测量,以最小化吸收的影响。操作步骤步骤1:测定光致抗蚀剂的光学常数。• 在材料库中已经定义了许多光致抗蚀剂。在这种情况下无需采取任何措施• 光致抗蚀剂规格表具有关于分散参数的信息。它们以柯西系数的形式列出——这是3个系数,可以确定材料在不同波长的光下的折射率(R.I.)。可以创建新的柯西材料,并为其指定特定光刻胶的柯西系数• 如果光致抗蚀剂的柯西系数不可用,则使用半光致抗阻剂的柯西系数作为起点。步骤2:创建薄膜堆栈薄膜堆栈代表物理样品的模型——它定义了基底和材料层。如果在硅晶片上沉积3000nm的光致抗蚀剂,则薄膜堆叠将是硅衬底/3000nm PR。此处PR将是步骤1中定义的光响应材料。步骤3:测量实际上,测量是一个两步走的过程:数据采集和数据分析。它们由TFCompanion软件透明地处理。在第一次测量过程中,可能会也可能不会得到完美的结果——需要调整胶片堆叠。如果光致抗蚀剂的厚度足够厚(>1um),可以从厚膜(基于FFT)算法开始。一旦确定了厚度,就可以使用曲线拟合(Marquardt Levenberg算法)对膜堆叠进行微调。在这一点上,方法略有不同,这取决于光刻胶的处理/条件(完全烧结、未烧结、部分烧结等)。如果光刻胶完全烧结且柯西系数正确,则无需采取任何措施。否则,需要调整光学常数。结论结果表明,在光学助剂与规格不同的情况下,需要特别小心未烧结的光致抗蚀剂。可以通过将模型与测量数据拟合来确定或确认正确的光学常数。或者,光学常数可以独立测量(使用光谱椭圆偏振法等)。一旦确定了光学常数,就可以使用FFT算法进行进一步的测量。在厚膜的情况下,FFT的厚度结果与用曲线拟合算法测量的厚度非常匹配。然而,当光致抗蚀剂具有明显的吸收时,可能存在小的下降(<0.1%)。FFT通常会给出略高的厚度值,因为它不使用吸收信息。消光系数在500-1000nm范围内非常小(<0.01),但它们影响厚膜中的光学测量。同时,FFT提供了快速、简便的测量方法,非常适合生产环境。创建光刻胶材料创建一种新材料来表示AZ1580光致抗蚀剂分散体。使用CauchyK材料类型。柯西近似仅使用3个系数来定义整个波长范围内的光学常数色散。这些系数取自AZ1500光致抗蚀剂规格表。给出了AZ1500系列未曝光光刻胶在更好条件下软烧结的柯西系数。单个光致抗蚀剂可能具有不同的溶剂浓度和烧结条件——这将需要调整柯西系数。柯西函数是柯西函数的扩展,它将色散关系应用于折射率(n)和消光系数(k)。k目前为0——我们将其保留下来,以备将来与明显存在吸收的欠烧结光刻胶一起使用。测量完全烧结的光刻胶硅晶片上的AZ1580光刻胶:完全软烧结。模型与实测数据的拟合显示出非常好的拟合。同一测量的厚膜(FFT)数据分析-与曲线拟合结果匹配(厚度差异<0.2 nm)。测量部分烧结的光刻胶硅晶片上的AZ1580光刻胶:部分烧结。模型与数据的拟合有显著的下降。这表明光学常数需要调整。测量光致抗蚀剂的厚度和n,k色散以改善对数据的拟合。厚度增加了约500nm(与原始结果相比),折射率下降。这与具有较低密度的欠烧结光刻胶一致。使用厚膜算法(FFT)在左侧给出了与曲线拟合厚度相匹配的结果。测得的厚度差为2nm。这主要是由于吸收的存在。测量轻度烧结的光刻胶硅晶片上的AZ1580光刻胶:轻微烧结。有明显的下降。看起来有残余吸收,但事实上,n、k和都需要调整。测量光致抗蚀剂的厚度和n,k以改善拟合。由此产生的厚度明显更高(几乎高出30%)。使用厚膜算法(FFT)来确定厚度与左侧的曲线拟合结果相匹配。由于高吸收,在厚度上存在3nm的差异。
确定





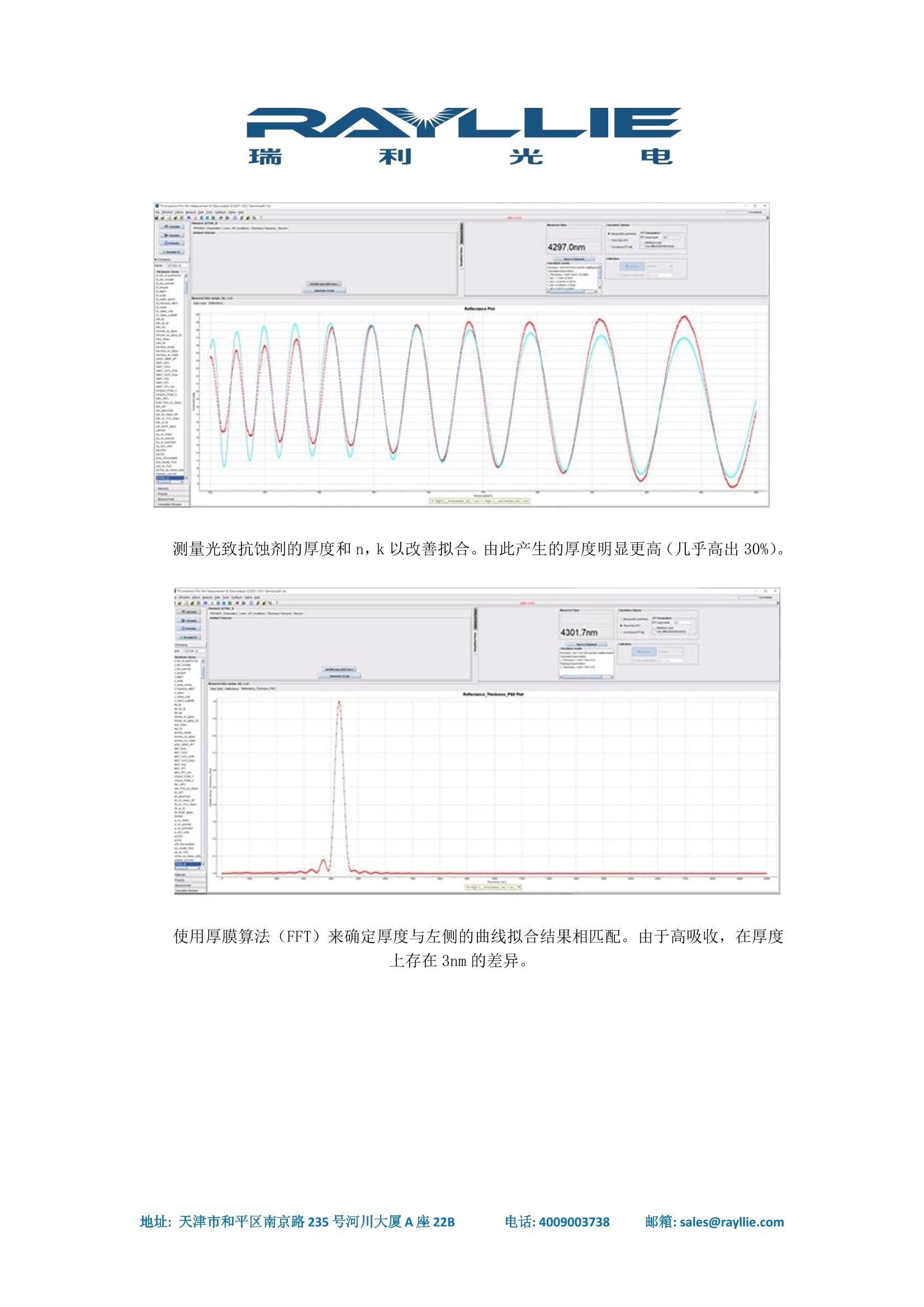
还剩4页未读,是否继续阅读?
天津瑞利光电科技有限公司为您提供《利用MProbe Vis系统进行光刻胶厚度测量》,该方案主要用于光电器件中光刻胶检测,参考标准--,《利用MProbe Vis系统进行光刻胶厚度测量》用到的仪器有薄膜厚度测量系统-MProbe Vis-天津瑞利-Semiconsoft
推荐专场
相关方案
更多
该厂商其他方案
更多
















