方案详情
文
本文介绍运用inspeXio SMX-225CT FPD HR Plus微焦点X射线CT系统观察BGA芯片内部结构。使用VG软件虚拟出三维立体图,可观察绑定线断线。通过CT截面可观察芯片破损、锡球变形、锡球破损及锡球气泡等缺陷。使用VG软件缺陷模块计算BGA锡球中的气泡率,呈现气泡分布立体效果图。
方案详情

采用岛津公司的inspeXio SMX-225CT FPD HR Plus微焦点X射线CT系统检测BGA芯片内部结构,通过CT无损观察BGA芯片内部破损和气泡。通过VG软件测量BGA锡球大小及气泡的直径,并通过孔隙率缺陷模块测量气泡率并量化分析。岛津SHIMADZUSSL-CA22-585Excellence in Science 岛津SHIMADZUExcellence in ScienceSMX-040 SMX-225CT FPD HR Plus 观察 BGA 芯片内部结构 SMX-040 摘要:本文介绍运用 inspeXio SMX-225CT FPD HR Plus 微焦点X射线 CT 系统观察 BGA 芯片内部结构。使用 VG 软件虚拟出三维立体图,可观察绑定线断线。通过 CT截面可观察芯片破损、锡球变形、锡球破损及锡球气泡等缺陷。使用 VG 软件缺陷模块计算 BGA 锡球中的气泡率,呈现气泡分布立体效果图。 关键词:微微焦点X射线 CT 系统 BGA 绑定线 孔隙率 气泡 技术特点: 小对 BGA芯片内部缺陷观察、解析。 BGA (Ball Grid Array)1,2中文名为球状引脚栅格阵列封装技术,是一种高密度表面装配封装技术。在封装底部,引脚都成球状并排列成一个类似于格子的图案,由此命名为 BGA。主板控制芯片组多采用此类封装技术,材料多为陶瓷。采用 BGA 技术封装的内存,,可以使内存在体积不变的情况下,内存容量提高两到三倍, BGA与 TSOP 相比,具有更小体积,更好的散热性能和电性能。BGA封装技术使每平方英寸的存储量有了很大提升, 实验部分 1.1仪器 :6 inspeXio SMX-225CT FPD HR PLUS 微焦点X射线 CT系统 1.2分析条件 X射线 CT 检查分析条件: 测试电压: 180 KV 测试电流:100 uANumber of Views2400图像尺寸:2048 pixels*2048 pixelsNumber of Averages:1扫描时间:30 minVoxel Spacing0.018 mm/voxelSD D:800mmExposure(ms)1000.00SR D:99.146mmAcquisition ModeFine 结果与讨论 2.1微焦点X射线 CT 对 BGA的观察 本次分析的是一种电脑主板上的 BGA芯片,图1是其外观图,样品尺寸 L28 mm X W28 mm XH2 mm, 使用X射线 CT 针对整个样品进行扫描。 采用 BGA 封装技术的内存产品在相同容量下,体积只有 TSOP 封装的三分之一;与传统 TSOP 封装方式相比,BGA封装方式有更加快速有效的散热途径。 BGA 在生产过程中会产生气泡或者绑定线断裂的情况,这需要通过岛津X射线CT检查装置检测这些缺陷。不但测试速度快,而且精度高。本文介绍运用 inspeXioSMX-225CT FPD HR PLUS 的微焦点X射线 CT 系统检测BGA的内部结构,观察内部缺陷及使用软件进行分析。 图1 BGA 外观图 图2示出了该 CT 成像数据的三维显示。当转换为三维显示时,可以观察出 BGA 芯片的内部缺陷,红圈指出的是绑定线断了。 图3是通过颜色渲染出来的三维显示图像,,可以更直观的观察内部断线。 图4是 BGA 芯片层截面图,可观察到芯片和绑定线连接部分破损,如红圈所示。 图5是 BGA 中锡球部分截面图,可观察到 BGA 锡球中的锡球变形、破损及气泡,从另一个截面展示芯片层破损状态。 图2 BGA 3D 图 图3 BGA 3D 颜色渲染图 图4 BGA芯片层截面图 图5 BGA锡球截面图 2.2 BGA 芯片数据分析 在 BGA 生产过程中, BGA 锡球大小不均及内部气泡过多过大容易影响产品的性能。利用 VG 软件对 BGA锡球尺寸进行测量,如图6所示;图7是对BGA中的锡球气泡进行测量;利用VG软件缺陷模块对图2分析气泡缺陷,计算出气泡分布效果图(图8)。并用不同颜色标注不同大小尺寸的气泡。 景生标屋 图6 BGA 锡球大小测量 图7 BGA气泡大小测量 图8 BGA气泡率分析图 结论 采用岛津公司的 inspeXio SMX-225CT FPD HR Plus 微焦点X射线 CT 系统检测 BGA 芯片内部结构,通过CT 无损观察 BGA 芯片内部破损和气泡。通过 VG 软件测量 BGA 锡球大小及气泡的直径,并通过孔隙率缺陷模块测量气泡率并量化分析。 岛津应用云 岛津企业管理(中国)有限公司-分析中心
确定

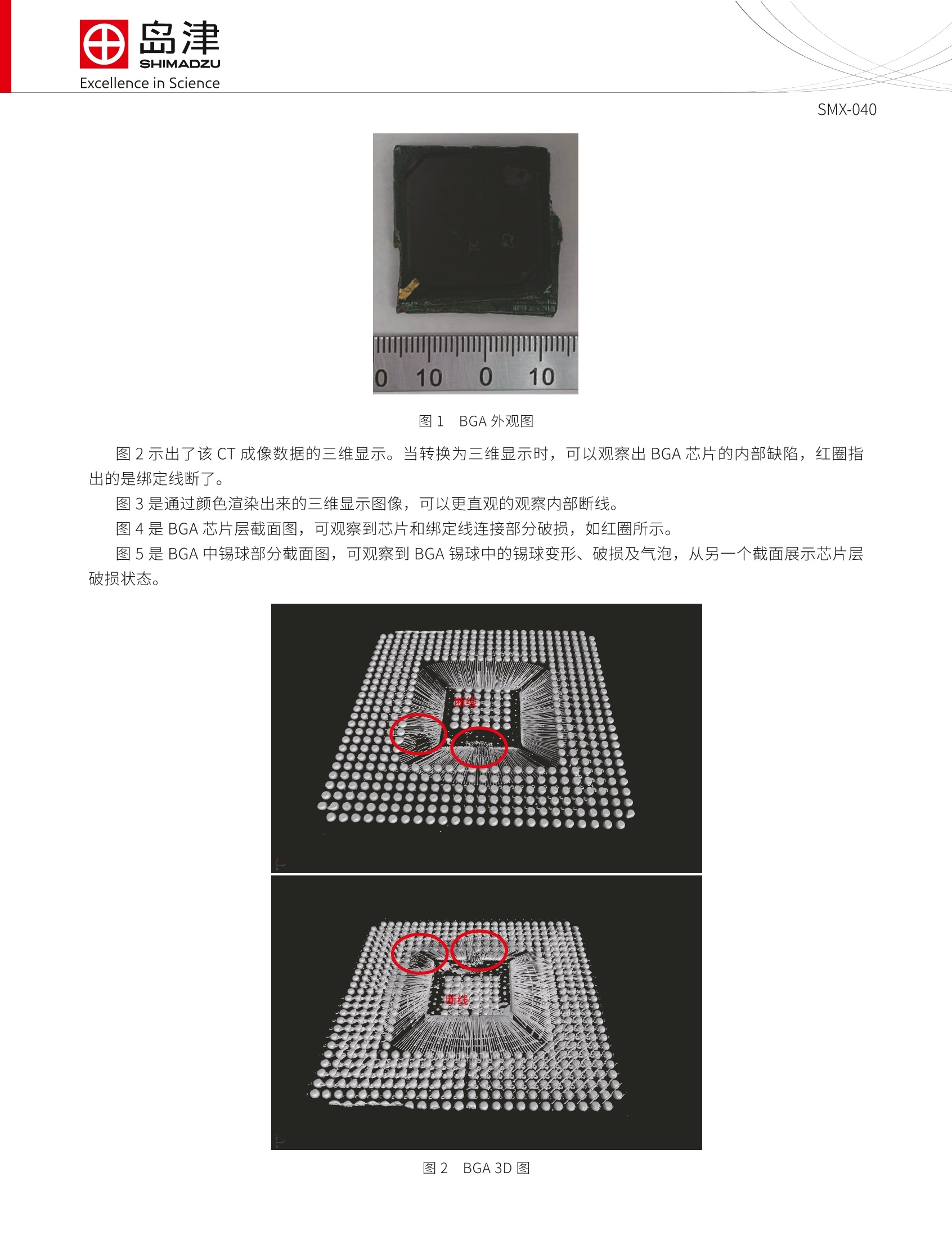
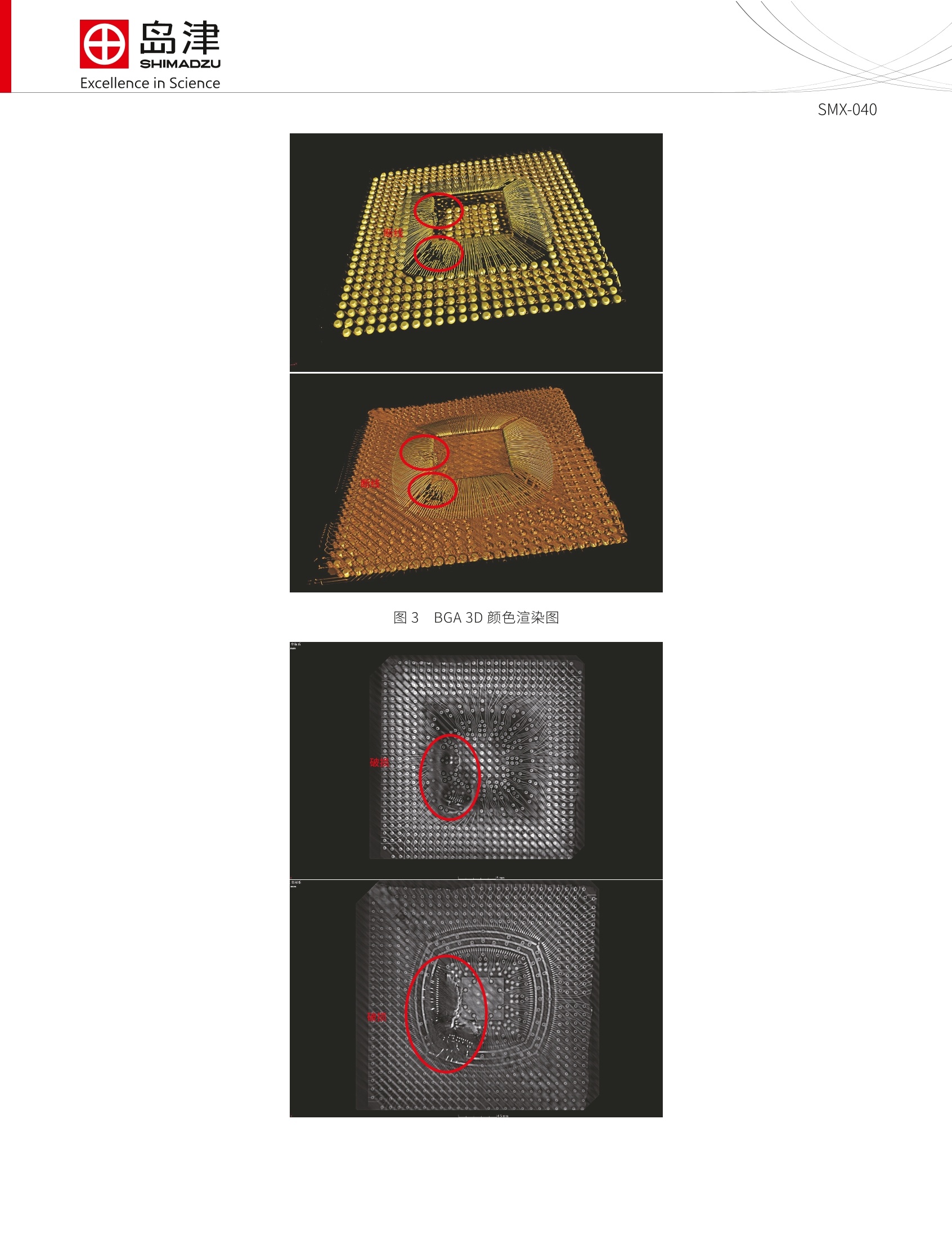
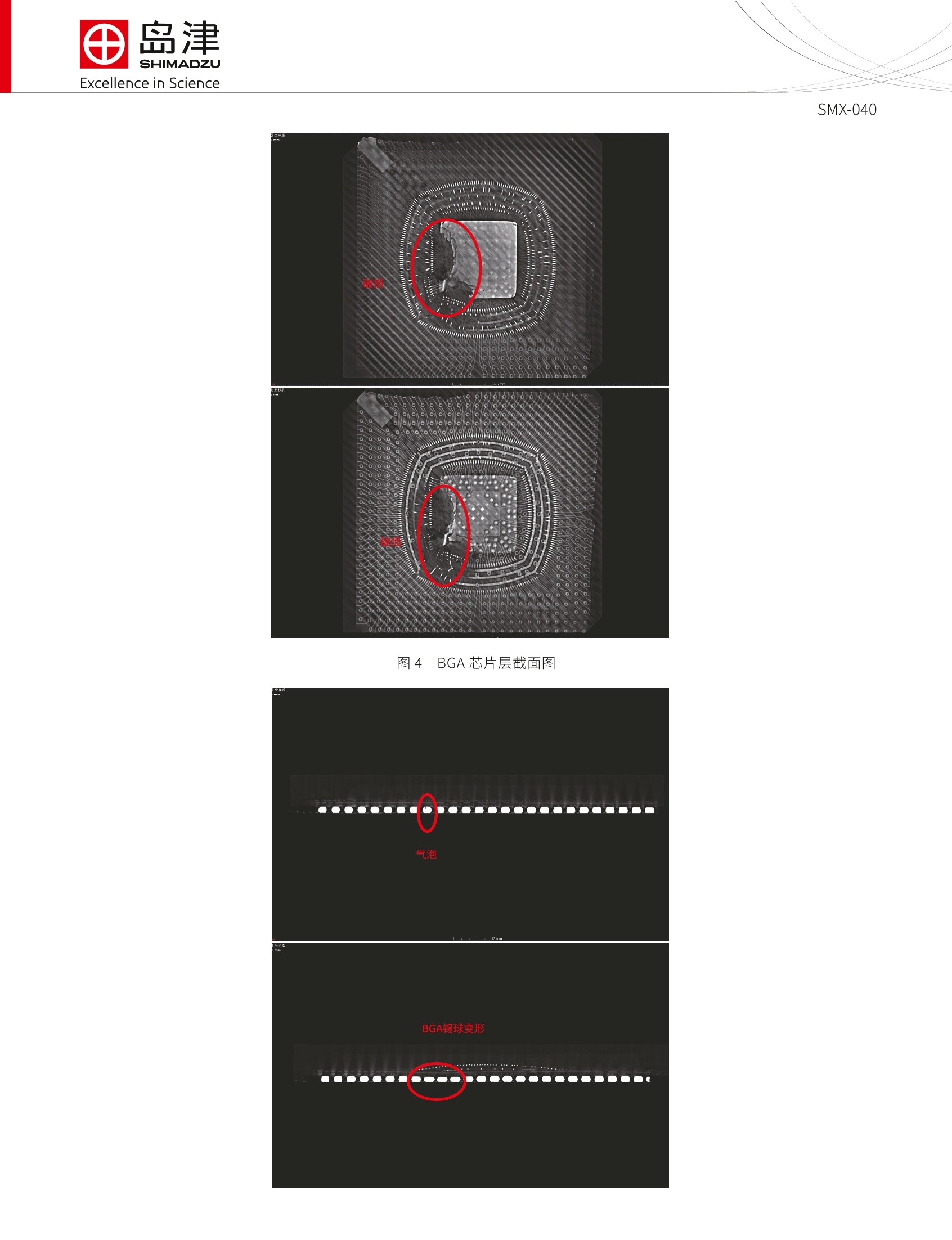
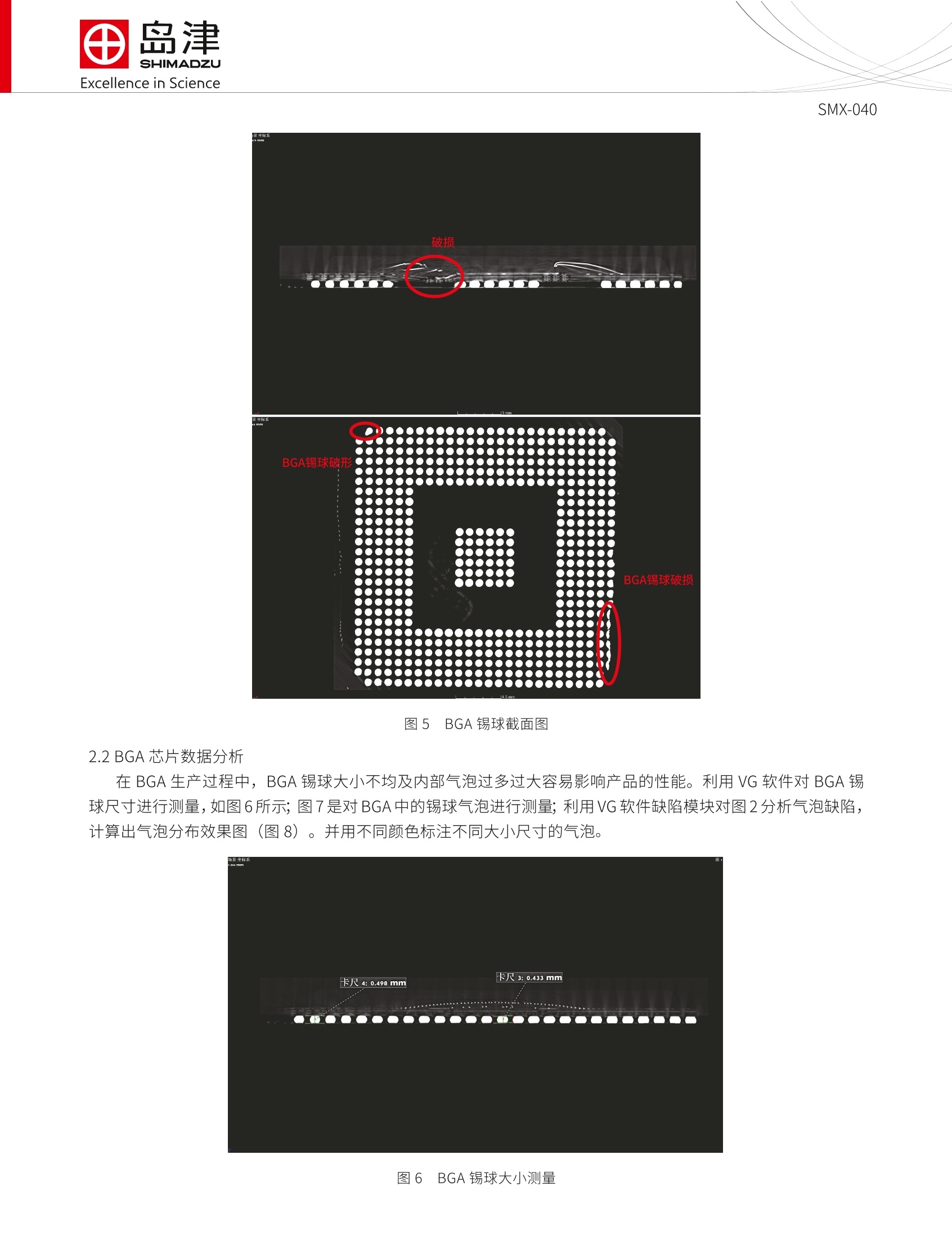
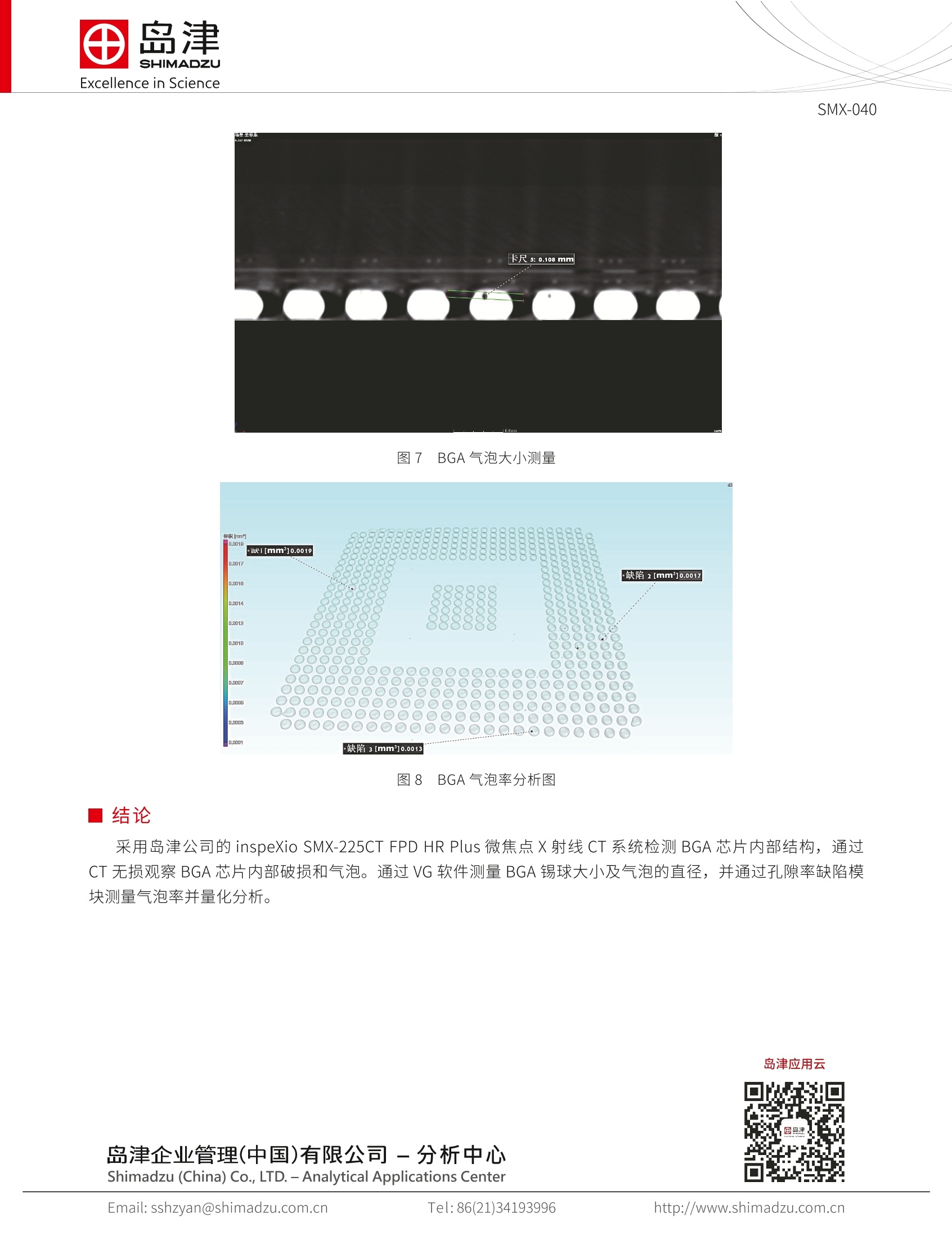
还剩4页未读,是否继续阅读?
岛津企业管理(中国)有限公司为您提供《SMX-225CT FPD HR Plus观察BGA芯片内部结构》,该方案主要用于其他中BGA芯片检测,参考标准--,《SMX-225CT FPD HR Plus观察BGA芯片内部结构》用到的仪器有岛津无损检测仪器—X射线微焦点工业用CT InspeXioSMX-225CT
推荐专场
相关方案
更多
该厂商其他方案
更多