推荐厂家
暂无
暂无



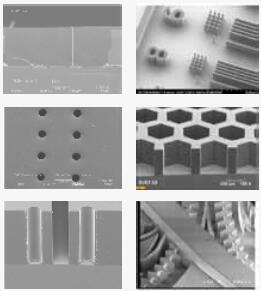
 400-860-5168转2459
400-860-5168转2459
 留言咨询
留言咨询

 400-860-5168转0250
400-860-5168转0250
 留言咨询
留言咨询

 400-860-5168转4967
400-860-5168转4967
 留言咨询
留言咨询



光刻加工工艺中为了图形转移,辐照必须作用在光刻胶上,通过改变光刻胶材料的性质,使得在完成光刻工艺后,光刻版图形被复制在圆片的表面。而加工前,如何选用光刻胶在很大程度上已经决定了光刻的精度。尽管正性胶的分辨力是最好的,但实际应用中由于加工类型、加工要求、加工成本的考虑,需要对光刻胶进行合理的选择。 划分光刻胶的一个基本的类别是它的极性。光刻胶在曝光之后,被浸入显影溶液中。在显影过程中,正性光刻胶曝过光的区域溶解得要快得多。理想情况下,未曝光的区域保持不变。负性光刻胶正好相反,在显影剂中未曝光的区域将溶解,而曝光的区域被保留。正性胶的分辨力往往是最好的,因此在IC制造中的应用更为普及,但MEMS系统中,由于加工要求相对较低,光刻胶需求量大,负性胶仍有应用市场。 光刻胶必须满足几个硬性指标要求:高灵敏度,高对比度,好的蚀刻阻抗性,高分辨力,易于处理,高纯度,长寿命周期,低溶解度,低成本和比较高的玻璃化转换温度(Tg)。主要的两个性能是灵敏度和分辨力。大多数光刻胶是无定向的聚合体。当温度高于玻璃化转换温度,聚合体中相当多的链条片以分子运动形式出现,因此呈粘性流动。当温度低于玻璃化转换温度,链条片段的分子运动停止,聚合体表现为玻璃而不是橡胶。当Tg低于室温,胶视为橡胶。当Tg高于室温,胶被视为玻璃。由于温度高于Tg时,聚合体流动容易,于是加热胶至它的玻璃转化温度一段时间进行退火处理,可达到更稳定的能量状态。在橡胶状态,溶剂可以容易从聚合体中去除,如软烘培胶工艺。但此时胶的工作环境需要格外关注,当软化胶温度大于Tg时,它容易除去溶剂,但也容易混入各种杂质。一般来说,结晶的聚合体不会用来作为胶,因为结晶片的构成阻止均一的各向同性的薄膜的形成。 感光胶的主要成分是树脂或基体材料、感光化合物以及可控制光刻胶机械性能并使其保持液体状态的溶剂。树脂在曝光过程中改变分子结构。感光化合物控制树脂定相的化学反应速度。溶剂使得胶能在圆片上旋转擦敷并形成薄瞙。没有感光化合物的光刻胶称为单成分胶或单成分系统,有一种感光剂的情形下,称为二成分系统。因为溶剂和其他添加物不与胶的感光反应发生直接关系,它们不计入胶的成分。 在曝光过程中,正性胶通过感光化学反应,切断树脂聚合体主链和从链之间的联系,达到削弱聚合体的目的,所以曝光后的光刻胶在随后显影处理中溶解度升高。曝光后的光刻胶溶解速度几乎是未曝光的光刻胶溶解速度的10倍。而负性胶,在感光反应过程中主链的随机十字链接更为紧密,并且从链下坠物增长,所以聚合体的溶解度降低。见正性胶在曝光区间显影,负性胶则相反。负性胶由于曝光区间得到保留,漫射形成的轮廓使显影后的图像为上宽下窄的图像,而正性胶相反,为下宽上窄的图像。微流控芯片刻蚀如何选择光刻胶呢?一般来说线宽的用正胶,线窄的用负胶! 相对而言,正性光刻胶比负性的精度要高,负胶显影后图形有涨缩,负性胶限制在2~3μm.,而正性胶的分辨力优于0.5μm 导致影响精度,正性胶则无这方面的影响。虽然使用更薄的胶层厚度可以改善负性胶的分辨率,但是薄负性胶会影响针孔。同种厚度的正负胶,在对于抗湿法和腐蚀性方面负胶更胜一筹,正胶难以企及。汶颢科技提供AZ、SU_8、及其他系类光刻胶的供应与技术参数。注意事项:①若腐蚀液为碱性,则不宜用正性光刻胶;②看光刻机型式,若是投影方式,用常规负胶时氮气环境可能会有些问题③负性胶价格成本低,正性胶较贵;④工艺方面:负性胶能很好地获得单根线,而正性胶可获得孤立的洞和槽;⑤健康方面:负性胶为有机溶液处理,不利于环境;正性胶属于水溶液,对健康、环境无害。
横向赛曼石墨炉原子吸收光谱法在紫外正型光刻胶中的应用摘 要:随着电子技术的飞速发展,对紫外正型光刻胶的质量提出了极高的要求。因为紫外正型光刻胶中钙、铬、铜、铁、钾、镁、钠、镍、铅、锌的存在将严重影响器件的成品率、可靠性和电化学性。因此建立准确、快速的分析方法有一定的意义。对于光刻胶中金属的检测方法,有电感耦合等离子体-质谱法(ICP-MS)、电感耦合等离子体发射光谱法(ICP-AES),但是这两种方法光刻胶都需要经过湿法消解或者干法灰化后才可以进样。湿法消解或者干法灰化容易引起易挥发元素的损失,同时存在容器污染,酸基体或者其他试剂的污染,本底较高等问题。本文提出了用石墨炉原子吸收法(GFAA)直接测定紫外正型光刻胶中十种金属元素的方法,本方法不经任何化学处理和富集,减少了中间过程,避免了样品被污染。详细描述了仪器最佳条件选择、控制空白,建立标准曲线、加标回收、测定检出限的方法。钙、铬、铜、铁、钾、镁、钠、镍、铅、锌的检出限分别为0.07ng/ml、0.03ng/ml、0.15ng/ml、0.15ng/ml、0.01ng/ml、0.03ng/ml、0.05ng/ml、0.36ng/ml、0.14ng/ml、0.02ng/ml。石墨炉原子吸收法(GFAA)需要选择合适的溶剂稀释光刻胶,考虑到试剂对光刻胶的溶解性,试剂本身空白值的大小等因素,我们最终选择丙二醇甲醚醋酸脂(PGMEA)做稀释剂,稀释样品后直接进样。关键字:紫外正型光刻胶、金属、石墨炉原子吸收绪 论:光刻胶(又称光致抗蚀剂)是指通过紫外光、准分子激光、电子束、离子束、X射线等光源的照射或辐射,其溶解度发生变化的耐蚀刻薄膜材料。主要用于集成电路和半导体分立器件的微细加工,同时在平板显示、LED、倒扣封装、磁头及精密传感器等制作过程中也有着广泛的应用。由于光刻胶具有光化学敏感性,可利用其进行光化学反应,将光刻胶涂覆在半导体、导体和绝缘体上,经曝光、显影后留下的部分对底层起保护作用,然后采用蚀刻剂进行蚀刻就可将所需要的微细图形从掩模版转移到待加工的衬底上。因此光刻胶是微细加工技术中的关键性化工材料。随着集成电路(IC)存储容量的逐渐增大,存储器电池的蓄电量需要尽能的增大,因此氧化膜变得更薄,而紫外正型光刻胶中的碱金属杂质(Na、[/size
电子信息产业的更新换代速度不断加快,新技术、新工艺不断涌现,对光刻胶的需求不论是品种还是数量都大大增多。日本是光刻胶生产和应用最多的国家。根据日本富士经济株式会社的统计1,2011年全球光刻胶市场规模为4,736.40亿日元。电脑、手机、显示器等日常电子产品中都需要用到十几种光刻胶,光刻胶是发展微电子信息产业及光电产业中关键基础工艺材料之一。http://www.whchip.com/upload/201610/1477892797460052.jpg 光刻胶发明后,首先被运用于军事、国防设备中高性能集成电路、光学、传感、通讯器材等的加工制作,因此发达国家以前一直将光刻胶作为战略物资加以控制。1994年巴黎统筹委员会(对社会主义国家实行禁运和贸易限制的国际组织)解散前,光刻胶都被列为禁运产品。目前尽管放松了管制,但最尖端的光刻胶产品依然是发达国家管制对象。 生产光刻胶的原料光引发剂、光增感剂、光致产酸剂和光刻胶树脂等专用化学品是体现光刻胶性能的最重要原料,和光刻胶一样长期以来被国外公司垄断。 我国对光刻胶及专用化学品的研究起步较晚,国家非常重视,从“六五计划”至今都一直将光刻胶列为国家高新技术计划、国家重大科技项目。尽管取得了一定成果,并有苏州瑞红电子化学品有限公司和北京科华微电子有限公司实现了部分品种半导体光刻胶的国产化,但技术水平仍与国际水平相差较大,作为原料的主要专用化学品仍然需要依赖进口。 目前中国需要的绝大部分光刻胶都依赖进口或由外资企业在中国设立的工厂提供。光刻胶作为印制电路板、LCD显示器、半导体的上游材料不能实现国产化,严重制约了我国微电子产业的发展。 光刻胶专用化学品化学结构特殊、保密性强、用量少、纯度要求高、生产工艺复杂、品质要求苛刻,生产、检测、评价设备投资大, 技术需要长期积累。至今光刻胶专用化学品仍主要被光刻胶生产大国日本、欧美的专业性公司所垄断。公司是国内少数从事光刻胶专用化学品研发、生产和销售的企 业之一,主营产品是光刻胶产业链的源头,是光刻胶的基础,属于国家鼓励、重点支持和优先发展的高新技术产品。公司光刻胶专用化学品的发展对于促进光刻胶的 国产化,提升我国微电子产业的自主配套能力具有重要意义。http://www.whchip.com/upload/201610/1477892838134263.jpg


