









天眼查显示,芯联集成电路制造股份有限公司“键合结构及其制备方法”专利公布,申请公布日为2024年7月23日,申请公布号为CN118380407A。
背景技术
晶圆级键合是半导体制造技术中重要的一个工艺步骤,共晶晶圆键合技术是使两表面间的键合能(Bonding Energy)达到一定强度和密封性,而使这两晶圆片结为一体。晶圆级键合主要的作用是机械保护和一定的气体氛围或真空度要求下的密封,为了保证机械强度和密封性,一般密封环占用了大量的芯片面积,尤其是考虑到键合的对准偏差,密封环还要增加面积,图1示意出现有技术中常见的一种密封环的结构,该密封环包括第一键合层100、第二键合层200和位于两侧的阻挡件300,考虑到键合的对准偏差,第二键合层200比第一键合层100单侧宽10um,密封环单侧宽度达到120μm,如图2中所示,密封环两侧宽度之和为240μm,而芯片宽度为1mm,由此两侧的密封环占据了芯片约25%的尺寸,密封环会导致单个晶圆上的芯片数目减小,不利于降低成本。
发明内容
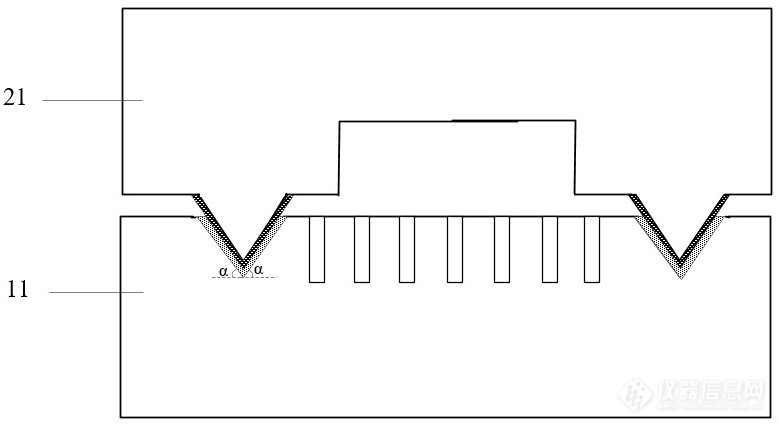
本发明提供一种键合结构及其制备方法,所述键合结构包括:第一晶圆和第二晶圆;所述第一晶圆具有环形凹槽,所述第二晶圆具有环形凸起部,所述环形凹槽具有V型纵截面,所述环形凸起部具有三角状纵截面,所述三角状纵截面的顶角角度与所述V型纵截面的夹角相等;所述环形凹槽的表面覆盖有第一键合层,所述环形凸起部的表面覆盖有第二键合层,所述环形凸起部部分嵌入所述环形凹槽内,使得所述第一键合层和所述第二键合层彼此相键合。本发明所形成的键合结构,键合层不必为了减小对准偏差而增加尺寸,从而密封环可采用更小尺寸的设计。
[来源:仪器信息网] 未经授权不得转载

2024.08.16

2024.08.19

2024.08.19

华海清科拟投不超16.98亿元建设上海集成电路装备研发制造基地
2024.08.19

2024.08.19

2024.08.19
版权与免责声明:
① 凡本网注明"来源:仪器信息网"的所有作品,版权均属于仪器信息网,未经本网授权不得转载、摘编或利用其它方式使用。已获本网授权的作品,应在授权范围内使用,并注明"来源:仪器信息网"。违者本网将追究相关法律责任。
② 本网凡注明"来源:xxx(非本网)"的作品,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,且不承担此类作品侵权行为的直接责任及连带责任。如其他媒体、网站或个人从本网下载使用,必须保留本网注明的"稿件来源",并自负版权等法律责任。
③ 如涉及作品内容、版权等问题,请在作品发表之日起两周内与本网联系,否则视为默认仪器信息网有权转载。
![]() 谢谢您的赞赏,您的鼓励是我前进的动力~
谢谢您的赞赏,您的鼓励是我前进的动力~
打赏失败了~
评论成功+4积分
评论成功,积分获取达到限制
![]() 投票成功~
投票成功~
投票失败了~