推荐厂家
暂无
暂无
 留言咨询
留言咨询
 留言咨询
留言咨询
 留言咨询
留言咨询
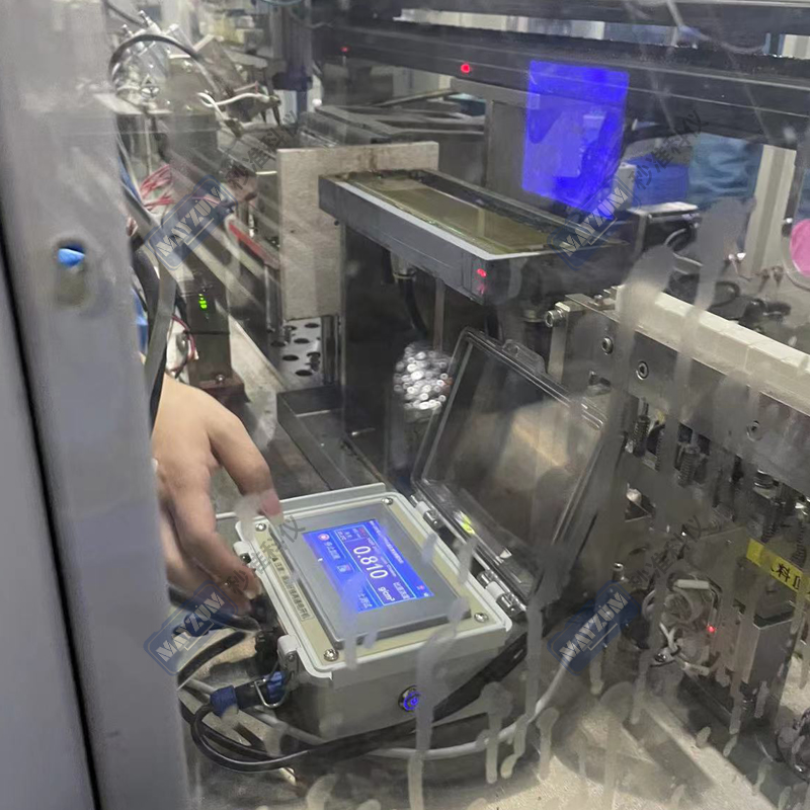
 400-860-5168转5892
400-860-5168转5892
 留言咨询
留言咨询

 400-860-5168转3623
400-860-5168转3623
 留言咨询
留言咨询

 400-860-5168转3623
400-860-5168转3623
 留言咨询
留言咨询






有客户问助焊剂一般是不是会含铅?我觉得助焊剂应该就是一些有机物,容剂、松香之类的,这些有机物中含有铅的可能性应该是微乎其微的。客户又说他用XRF扫助焊剂铅含量为5000多ppm,并且行业内也有有铅助焊剂和无铅助焊剂的分别。我也糊涂了,上网一查,发现原来是这样的:有铅助焊剂是指用于有铅焊锡的助焊剂,无铅助焊剂是指用于无铅焊锡的助焊剂。有铅助焊剂和无铅助焊剂的区别并不在于本身是否含有铅。有没有助焊剂方面的专业人士出来释疑?
各位,有没有什么好方法分离焊锡丝里的助焊剂和合金?分离后如何精确测试助焊剂的卤素含量?请大家踊跃发言。
摘要:本文从表面张力对软钎焊工艺的影响开始,深入探讨了表面活性剂的作用及其帮助焊接的工作原理,以及表面活性剂在助焊剂中的应用及要求,并分析了因为浸润不当而造成焊接不良的几种状况。关键词:表面张力 软钎焊 表面活性剂 助焊剂 浸润在软钎焊工艺中,影响焊接质量的原因是很多的,焊料不能充分浸润是影响焊点质量的一个重要原因,也是比较难以解决的一种状况。表面张力是影响焊料浸润的主要原因,在焊接过程中,助焊剂可以降低熔融焊料的表面张力,而表面活性剂作为助焊剂中的重要组成部分,它是如何工作的?它的原理是什么?常见的浸润不良是怎样引起的、表现为哪些焊接缺陷等?针对这些问题本文将展开全面的论述。


