推荐厂家
暂无
暂无

 400-860-5168转3241
400-860-5168转3241
 留言咨询
留言咨询
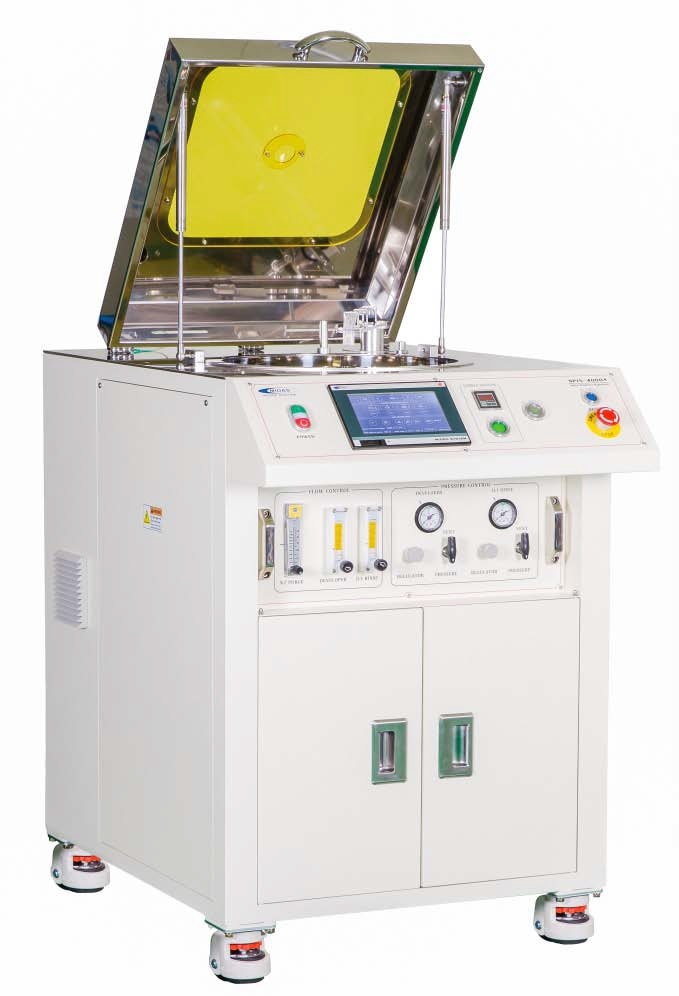
 400-860-5168转3281
400-860-5168转3281
 留言咨询
留言咨询

 400-860-5168转3726
400-860-5168转3726
 留言咨询
留言咨询



不是所有的匀胶机都叫旋涂仪的!It’s not only Spin Coater, it’s Spin Processor!——匀胶机顾名思义,一种可以“让胶液均匀涂敷的机器”。MYCRO的MSC-650S所有数据结果都可以通过电脑输出并予以保存。完成从单纯旋转机器到旋涂仪器的升级。匀胶机是一种常见用于材料薄膜制备工艺的实验室设备,它的原理相对比较简单,利用电机高速旋转时所产生的离心力使得试液或者胶液均匀地涂敷在基底材料的表面,顾名思义,一种可以“让胶液均匀涂敷的机器”。匀胶机有很多称谓,匀胶台,旋转涂膜机,旋转涂层机或者旋转涂敷机等等,它的英文是 Spin Coater(旋转涂膜的意思)。匀胶机既然是科研开发上制备薄膜材料必备的方法之一,使用者对于该设备最大的期待就在于其能够“均匀”地涂敷试液或者胶液。通常我们会用均一性和可重复性来衡量薄膜材料制备的好坏。国内外对于这种匀胶旋涂设备的发展呈现出很大的差距。中国国内最先开展匀胶机研制的单位是中科院微电子所,推出的KW-4A型号的匀胶机,具有低速起步和高速旋转两个单位。国外的高性能匀胶机最早则集中在美国和德国。后来随着半导体工业的发展,日韩等国家也开发出性价比较高的匀胶机器。日韩等国随着在半导体制程,LCD,TFT显示材料的研发制造等领域的发展占据先机,所开发的产品基本上集中于半导体湿制程系列工艺中的自动化控制系统,由于涉及到与其它工序的自动化集成的趋势,故产品价格高得也令人咂舌。目前美德诸多公司也放弃利润低下的单独功能的匀胶产品发展,全部集中于半导体整体工艺的解决方案提供。MYCRO美国产的匀胶设备MSC-650S系列,除了对于转速的精密控制以外(转速范围50~12000转/分,分辨率小于0.5转/分,可重复性小于±0.5转/分,由美国NIST工业标准认证,无需再校准,加速度可达80000RPM/S,最低则可达1RPM/S),加速时间可调范围1秒至99分59.9秒,最小增加度0.1秒。MYCRO的MSC-650S匀胶机还可以通过与电脑链接,以及随机附带的SPIN分析软件,对于每次实验结果进行分析调试,并挑选出最佳的制备过程。所有数据结果都可以通过电脑输出并予以保存。完成从单纯旋转机器到旋涂仪器的升级。
选购匀胶机(spin coater)的三要素 匀胶机有很多种称谓,(英文叫Spin Coater或者Spin Processor),又称甩胶机、匀胶台、旋转涂胶机、旋转涂膜机、旋转涂层机、旋转涂布机、旋转薄膜机、旋转涂覆仪、旋转涂膜仪、匀膜机,总的来说,他们原理都是一样的,既在高速旋转的基片上,滴注各类胶液,利用离心力使滴在基片上的胶液均匀地涂覆在基片上,厚度视不同胶液和基片间的粘滞系数而不同,也和旋转速度及时间有关。 针对目前匀胶机市场品牌众多,良莠不齐现象,笔者结合自己多年从事匀胶机技术服务的实际经验。帮助广大用户提高辨别能力,为用户提供了直观明确的选择标准。 从其原理来说,我们可以看出选购匀胶机需要注意的三个要素: 1、 旋转速度 转速的快慢和控制精度直接关系到旋涂层的厚度控制和膜层均匀性。如果标示的转速和电机的实际转速如果误差很大,对于要求精密涂覆的科研人员来说是无法获得准确的实验数据的。国产的某些匀胶机只能提供转速范围,并不能精确标定实时的转速。进口的匀胶机虽然大部分能标定转速,但是大部分转速精度没有国际标准认定。建议购买转速控制方面有国际认定标准的,比如:美国NIST标准等。 2、 真空吸附系统的构造 真空泵一定要无油的,压力标定准确,国内生产的无油真空泵实在不敢恭维。因为任何的油污都可能堵塞真空管道,如果真空吸附力降低,会导致基片吸附不住而产生“飞片”的情况,还会让滴胶液不慎进入真空管道系统造成完全堵塞。用过国产匀胶机的客户常常会关心怎么清洗的问题,这一点许多国外的匀胶机做得不错,他们有通过联动机制,如果真空吸附力不够的时候,不会开始旋转。 3、 材质的选择 对于半导体化工行业的应用来说,材质的选择尤为关键,大部分匀胶机采用的是不锈钢或者普通塑料材质,因为这种材质的成本很低,不锈钢的对于各类化工胶液的抗腐蚀性不太好,塑料对于较高温度和压力下易产生变形。如果这种变形引起托盘的位置失去水平的话,将会导致旋涂时,时高时低的颠簸状态。自然无法得到好的旋涂效果。例如美国Laurell的WS-400B,500B,650等型号都是采用天然聚丙烯(NPP)或者聚四氟乙烯(特氟隆, PTFE)材质。这两种材质具备绿色环保、节约资源、重量轻、强度大、抗冲击性能好、坚固耐用、花纹自然、光泽度好等优点。
针对于混凝土物料的复杂多样性,青岛迪凯设计的立轴混凝土搅拌机采用行星搅拌原理,自转与公转相结合,可以将搅拌物料快速分散,再通过强有力的搅拌作用力来实现物料的高匀质混合效果。立轴混凝土搅拌机可以根据搅拌物料的组分进行有效的计量配比,自动化程度高,大大减少了人工成本的支出。立轴混凝土搅拌机升级的搅拌工艺,完善的质量控制体系,在很大程度上推进了混凝土行业领域的高标准化进程,成为行业认可的“全能战士”。[img=,600,600]https://ng1.17img.cn/bbsfiles/images/2024/06/202406250942343383_910_5336215_3.jpg!w600x600.jpg[/img]





