









SK 海力士突破 HBM 堆叠层数限制,MR-MUF 和混合键合封装两手抓。
近日,SK 海力士封装研发副社长李康旭(Kangwook Lee)于 9 月 3 日出席“2024 年异构集成全球峰会”,发表了名为“面向人工智能时代的 HBM 和先进封装技术”的演讲。
HBM 是克服 “存储墙”(Memory Walls)的优化解决方案,通过 I/O 并行化能力,使 HBM 成为人工智能系统中用于训练和推断的最高规格动态随机存取存储器(DRAM)。
根据应用产品不同,使用的 HBM 数量也不同。随着 HBM 世代发展,在训练和推理人工智能服务器中搭载 HBM 的平均数量也会增加,如近期训练服务器需要 8 个 HBM3E、推理需要 4 - 5 个,长远估算可能分别需要 12 个和 8 个 HBM4/HBM4E 存储器。
李康旭表示,SK 海力士计划 2025 年推出 12 层 HBM4 产品,通过自家研发的封装技术,在 HBM 产品的能效和散热性能方面具有优秀的产品竞争力。
有趣的是,SK 海力士到 HBM3E 仍是以动态随机存取存储器基础裸片(Base Die),采用 2.5D 系统级封装,到 HBM4 考虑将动态随机存取存储器基础裸片改成逻辑基础裸片(Logic Base Die),使性能和能效获得提升。此外,到了 HBM5 架构可能出现改变,SK 海力士目前正在评估包括 2.5D 和 3D 系统级封装(SiP)在内的各种方案。
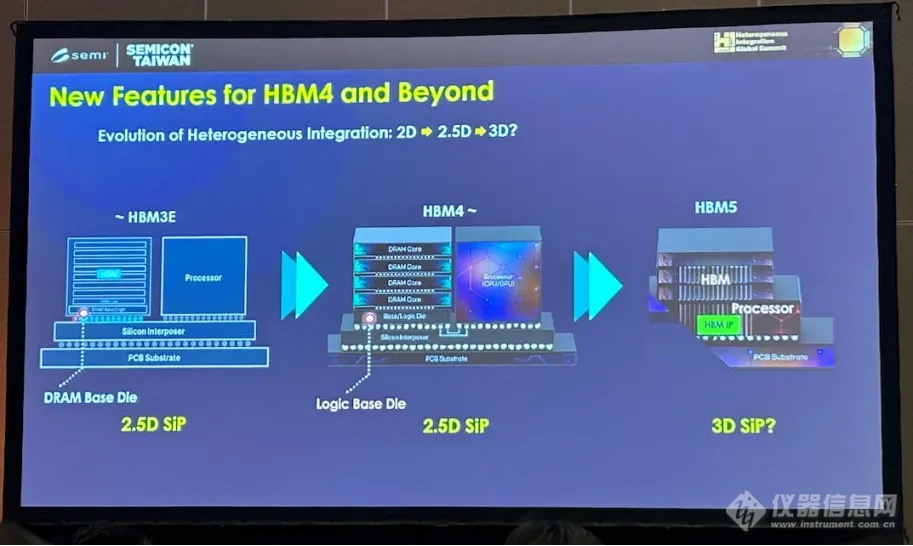
SK海力士技术朝两个方向进行:封装MR-MUF和混合键合(Hybrid Bonding)
MR-MUF技术由SK海力士多个团队共同开发,该技术能够同时对HBM产品中所有的垂直堆叠芯片进行加热和互联,比堆叠芯片后填充薄膜材料的TC-NCF技术更高效。此外,与TC-NCF技术相比,MR-MUF技术可将有效散热的热虚设凸块数量增加四倍。
MR-MUF技术另一个重要特性是采用了一种名为环氧树脂模塑料(EMC, Epoxy Molding Compound)的保护材料,用于填充芯片间的空隙。EMC是一种热固性聚合物,具有卓越的机械性、电气绝缘性及耐热性,能够满足对高环境可靠性和芯片翘曲控制的需求。由于应用了MR-MUF技术,HBM2E的散热性能比上一代HBM2提高了36%。
从开发HBM2E开始,MR-MUF技术及随后推出的先进MR-MUF技术的应用,使SK海力士能够生产出业界最高标准的HBM产品。时至2024年,SK海力士已成为首家量产HBM3E的公司,这是最新一代、拥有全球最高标准性能的HBM产品。在应用先进的MR-MUF技术后,与上一代8层HBM3相比,HBM3E在散热性能方面提高了10%,成为人工智能时代炙手可热的存储器产品。
SK 海力士的高带宽存储器(HBM)产品采用 MR-MUF 封装技术,具有低压、低温键合和批量热处理的优势,在生产效率和可靠性方面优于热压膜非导电胶(TC-NCF)制程。此外,具有高热导特性的填充空隙材料(Gap-Fill 材料)和高密度金属凸块(在垂直堆叠 HBM 动态随机存取存储器时起连接电路作用的微小鼓包型材料)的形成,在散热方面比 TC-NCF 制程有 36% 的性能优势。
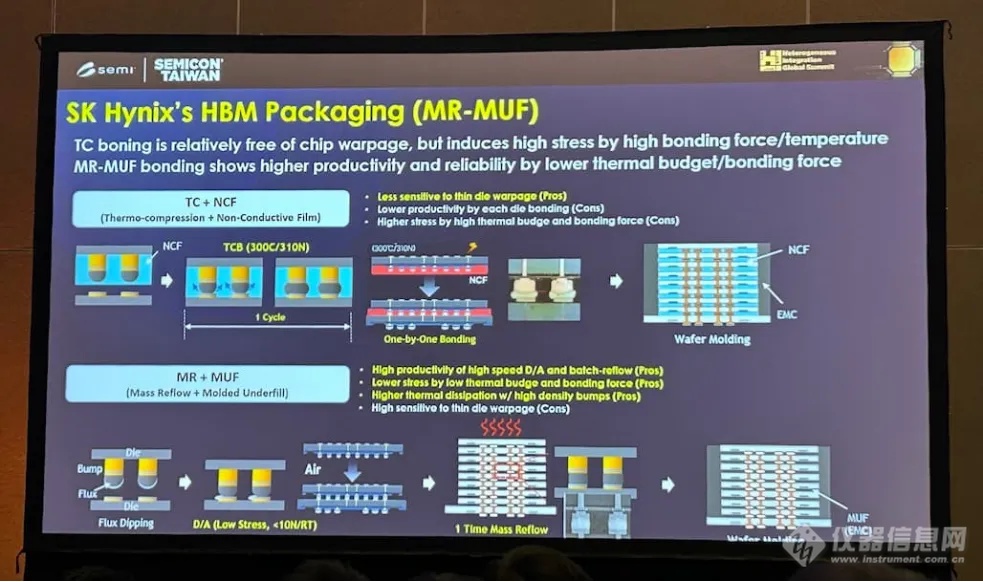
由于堆叠将面临高度限制,目前 SK 海力士不断寻找新方法,在有限高度下装入更多堆叠层数。李康旭指出,公司 8 层 HBM3/HBM3E 使用 MR-MUF 技术;12 层 HBM3/HBM3E 采用先进 MR-MUF 技术;明年下半年准备出货的 12 层 HBM4 同样采用先进 MR-MUF 技术;至于 16 层 HBM4/HBM4E 将同步采用先进 MR-MUF 和混合键合(Hybrid Bonding)两种技术,未来堆叠 20 层以上产品(如 HBM5)则将转向混合键合技术发展。
混合键合是一种先进的集成电路封装技术,主要用于实现不同芯片之间的高密度、高性能互联。这种技术的关键特征是通过直接铜对铜的连接方式取代传统的凸点或焊球(bump)互连,从而能够在极小的空间内实现超精细间距的堆叠和封装,达到三维集成的目的。
在混合键合工艺中,两个或多个芯片的金属层(通常是铜层)被精密对准并直接压合在一起,形成直接电学接触。为了保证良好的连接效果,需要在芯片表面进行特殊的处理,例如沉积一层薄且均匀的介电材料(如SiO2或SiCN),并在其上制备出微米甚至纳米级别的铜垫和通孔(TSV)。这些铜垫和通孔将芯片内部的电路与外部相连,使得数据传输速度更快、功耗更低,同时极大地提升了芯片的集成度。
李康旭指出,SK 海力士正在研发 16 层产品的相关技术,最近确认对 16 层产品可应用先进 MR-MUF 技术的可能性。此外,该公司也强调,从 HBM4E 开始会更强调 “定制化 HBM”,以满足各种客户需求,如提升芯片效率。
[来源:半导体产业纵横]
 5亿!大基金入股EDA厂商
5亿!大基金入股EDA厂商
盛美上海新品发布!推出Ultra C bev-p面板级边缘刻蚀设备
2024.09.04

2024.09.07

2024.08.16

2024年Q2全球芯片市场规模攀升至1500亿美元,中国同比增长21.6%
2024.08.15

半导体行业回暖!57家公司上半年净利润135亿同比大增200%
2024.08.14

2024.08.14
版权与免责声明:
① 凡本网注明"来源:仪器信息网"的所有作品,版权均属于仪器信息网,未经本网授权不得转载、摘编或利用其它方式使用。已获本网授权的作品,应在授权范围内使用,并注明"来源:仪器信息网"。违者本网将追究相关法律责任。
② 本网凡注明"来源:xxx(非本网)"的作品,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,且不承担此类作品侵权行为的直接责任及连带责任。如其他媒体、网站或个人从本网下载使用,必须保留本网注明的"稿件来源",并自负版权等法律责任。
③ 如涉及作品内容、版权等问题,请在作品发表之日起两周内与本网联系,否则视为默认仪器信息网有权转载。
![]() 谢谢您的赞赏,您的鼓励是我前进的动力~
谢谢您的赞赏,您的鼓励是我前进的动力~
打赏失败了~
评论成功+4积分
评论成功,积分获取达到限制
![]() 投票成功~
投票成功~
投票失败了~