







半导体&电子测试测量,投稿:kangpc@instrument.com.cn


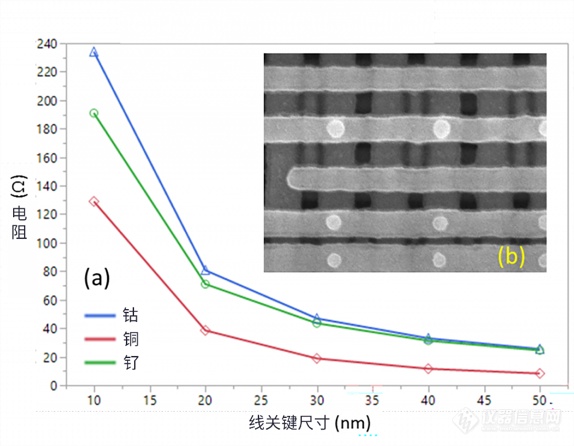
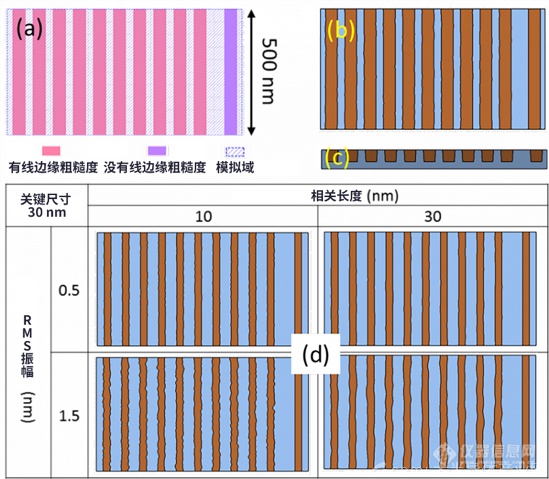

3. 在所有线关键尺寸和线边缘粗糙度条件下,应选择特定的金属来获得最低的绝对电阻值。
由于线边缘粗糙度对较小金属线关键尺寸下的电阻有较大影响,线边缘粗糙度控制在先进节点将变得越来越重要。在工艺建模分割实验中,我们通过改变金属线关键尺寸和金属线材料研究了线边缘粗糙度对金属线电阻的影响。在EUV(极紫外)光刻中,由于大多数EUV设备测试成本高且能量密度低,关键尺寸均匀性和线边缘粗糙度可能会比较麻烦。在这种情况下,可能需要对光刻显影进行改进,以尽量降低线边缘粗糙度。这些修改可以进行虚拟测试,以降低显影成本。新的EUV光刻胶方法(例如泛林集团的干膜光刻胶技术)也可能有助于在较低的EUV曝光量下降低线边缘粗糙度。在先进节点上,需要合适的金属线材料选择、关键尺寸优化和光刻胶显影改进来减小线边缘粗糙度,进而减少由于电子表面散射引起的线电阻升高。未来的节点上可能还需要额外的线边缘粗糙度改进工艺(光刻后)来减少线边缘粗糙度引起的电阻。
[来源:大半导体产业网]

重磅!拜登签署对华投资限制令,锁定半导体、量子信息和人工智能领域
2023.08.11

院士领衔,共谋发展!2023宽禁带半导体先进技术创新与应用发展高峰论坛成功召开
2023.08.11

2024.07.22

2024.07.19

2024.07.19

突破瓶颈!Nature Electronics揭示高性能MEMS器件的创新设计!
2024.07.18
版权与免责声明:
① 凡本网注明"来源:仪器信息网"的所有作品,版权均属于仪器信息网,未经本网授权不得转载、摘编或利用其它方式使用。已获本网授权的作品,应在授权范围内使用,并注明"来源:仪器信息网"。违者本网将追究相关法律责任。
② 本网凡注明"来源:xxx(非本网)"的作品,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,且不承担此类作品侵权行为的直接责任及连带责任。如其他媒体、网站或个人从本网下载使用,必须保留本网注明的"稿件来源",并自负版权等法律责任。
③ 如涉及作品内容、版权等问题,请在作品发表之日起两周内与本网联系,否则视为默认仪器信息网有权转载。
![]() 谢谢您的赞赏,您的鼓励是我前进的动力~
谢谢您的赞赏,您的鼓励是我前进的动力~
打赏失败了~
评论成功+4积分
评论成功,积分获取达到限制
![]() 投票成功~
投票成功~
投票失败了~