应用分享 | MDP在4H-SiC少子寿命中的应用
2023/06/28 18:27
阅读:64
分享:方案摘要:
产品配置单:
MDPmap 晶圆片寿命检测仪
型号: MDPmap
产地: 德国
品牌: Freiberg Instruments
面议
参考报价
联系电话
方案详情:
少数载流子寿命是影响半导体器件性能的基本参数之一,特别是对于应用在高压器件中的SiC来说。对于外延层来说,载流子寿命的主要影响因素是相当复杂的,因为外延层表面、外延层-衬底界面、外延层和衬底这都有助于载流子复合行为。因此如何在样品中获取较准确的载流子寿命成为问题的关键。通过比较不同厚度生长的4H-SiC外延层在相同激发条件下获得的光致发光和光电导衰减测量的时间常数,有助于更好地理解这个问题。
实验条件和设备
12 ~ 62 µm的4H-SiC外延层通过化学气相沉积在350 µm厚的4H-SiC n+型衬底上(电阻率约为0.05 Ω∙cm)。所有外延层为n型掺杂,载流子浓度为1014~ 1015cm-3。
微波检测光电导测量(MDP)以及时间分辨光致发光测量(TR-PL)是在高注入条件下进行测试的,由同一氮激光器发出3 ns的脉冲激发,穿透深度为14 µm。(337 nm,10-50 µJ/脉冲对应于约1 ~ 5∙´ 1017cm-3的注入水平)。其中MDP设备如下图所示。

MDPmap: Mono- and Multi-crystalline wafer lifetime measurement device
图文解析
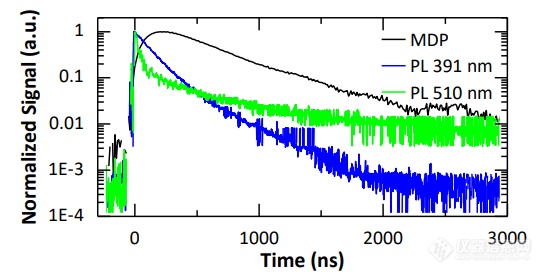
图1:在55 µm厚的4H-SiC外延层上测量MDP(黑色实线)和PL(蓝色-近带边激发,391 nm;绿色-缺陷光致发光,510 nm)的归一化信号。
根据测得信号进行数据拟合,MDP信号显示出单指数衰减,主要受电子和空穴贡献的影响。近带边激发(NBE)衰减(391 nm)信号显示出双指数衰减趋势,其中较慢的分量是归因于少数载流子寿命。与缺陷相关的PL(510 nm)信号显示出更复杂的多指数衰减行为,通常被报道与残留硼或结构缺陷有关。这说明MDP信号较为单纯,直接与载流子寿命相关。
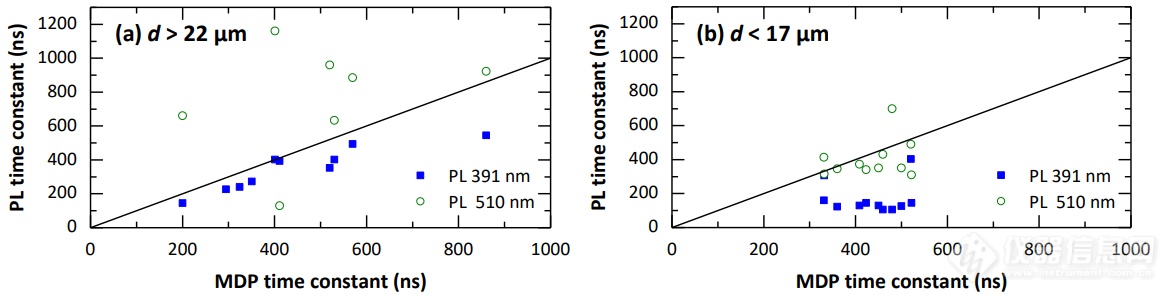
图2:4H-SiC外延层室温PL衰减时间常数与MDP衰减信号的相关性。
如在图2(a)中所示,厚度d> 22 µm的外延层近带边激发的PL信号的第二分量与MDP寿命之间存在直接相关性的趋势。这表明在所研究的样品中MDP信号衰减受少数载流子寿命的支配。MDP信号计算出的时间常数将被视为与外延层载流子寿命成比例的量度。
相比之下,d< 17 µm的薄外延层显示出NBE衰变瞬变的不同特征。在不同的初始急剧下降之后,衰减的时间常数主要约150 ns存在,衰减时间非常短。MDP寿命仍处于与较厚外延层相同的范围内(见图2(b))。NBE衰变信号非常短的原因是这些样品中几乎一半的载流子在衬底中被激发,这导致快速的电子-空穴复合速率。因此,检测到的NBE信号显示了外延层和衬底贡献的复杂叠加。另一方面,由于衬底的迁移率相当低,其电导率约为0.05 Ω∙cm,而MDP信号与光激发的过量载流子浓度和迁移率的乘积成正比,因此MDP信号受外延层特性的强烈支配。这意味着:MDP信号无论是在薄层还是厚层,收集到的基本都是外延层的信号,基板对其的干扰较小。
小结
对于d> 22 µm的厚外延层,其近带边激发(NBE)衰减信号变现出双指数衰减趋势,其中较慢的分量和载流子寿命相关。而对于较薄的外延层(12 ~ <17 µm),NBE信号主要来自于衬底的贡献,导致非常短的NBE衰减时间。此处,室温下的缺陷PL衰减显示与MDP衰减一致的时间常数。这些结果表明,与NBE相比,MDP对衬底载流子复合的扭曲影响不太敏感,因此通常更适合研究薄4H-SiC外延层中的载流子寿命。
参考文献
Beyer, Jan, et al. "Minority carrier lifetime measurements on 4H-SiC epiwafers by time-resolved photoluminescence and microwave detected photoconductivity." Materials Science Forum. Vol. 963. Trans Tech Publications Ltd, 2019.
https://doi.org/10.4028/www.scientific.net/msf.963.313
下载本篇解决方案:
更多![]()
应用分享 | TOF-SIMS在光电器件研究中的应用
光伏发电新能源技术对于实现碳中和目标具有重要意义。近年来,基于有机-无机杂化钙钛矿的光电太阳能电池器件取得了飞速的发展,目前报道的光电转化效率已接近26%。
半导体
2024/07/17
应用分享 | HAXPES∣多层结构器件界面的无损深度分析案例
XPS的探测深度在10nm以内,然而对于实际的器件,研究对象往往会超过10 nm的信息深度,特别是在一些电气设备中,有源层总是被掩埋在较厚的电极之下。因此,利用XPS分析此类样品,需要结合离子刻蚀技术。
半导体
2024/07/17
应用分享 | Bruker D6 PHASER对钨薄膜进行反射率应用分析
XRR是一种方便、快速的分析单层或多层薄膜和表面的方法,是一种纳米尺度上的分析方法,同时可实现无损分析。
材料
2024/07/17
应用分享 | 原位冷冻TOF-SIMS对斑马鱼RPE组织的生物成像
飞行时间二次离子质谱(TOF-SIMS),也叫静态二次离子质谱,是飞行时间和二次离子质谱结合的一种新的表面分析技术。因其免标记、高灵敏、多组分检测和高空间分辨成像等优势,为诸多生命科学问题的研究提供了重要的技术支持。
生物产业
2024/07/10










