产地类别: 进口
光谱范围: 190 nm - 1700 nm
单次测量时间: 2秒
样品尺寸: 50 µm
看了椭偏仪的用户又看了
Bruker椭偏仪 FilmTek 6000 PAR-SE
——用于IC器件开发和制造的多模薄膜计量学
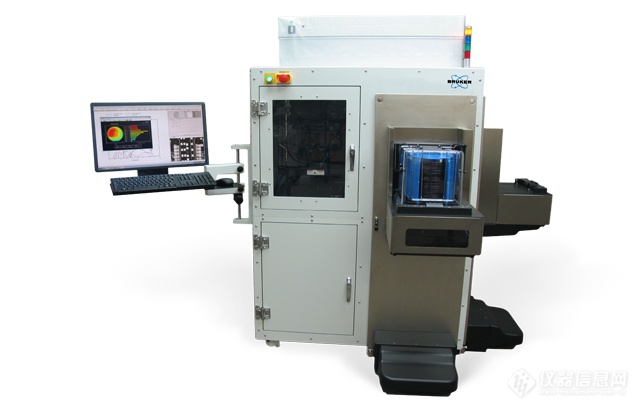
想了解相关产品,可联系上海尔迪仪器科技有限公司,拨打电话021-61552797
FilmTek™ 6000标准杆数-SE先进的多模薄膜计量系统在1x nm设计节点和更高的位置为广泛的薄膜层提供生产验证的薄膜厚度、折射率和应力测量监测。该系统能够在新一代集成电路的生产过程中实现更严格的过程控制,提高器件产量,并支持下一代节点技术的开发。
制造1x nm的先进IC器件需要使用高度均匀的复合膜。能够监测非常薄的薄膜的计量工具,通常在多层膜堆叠中(例如,高k和氧化物-氮化物-氧化物膜),使制造商能够保持对膜构建过程的严格控制。此外,一些工艺,如多重图案化,会导致薄膜厚度的梯度,必须对其进行监控,以获得佳器件性能(例如,注入损伤和低k薄膜)。不幸的是,现有的计量工具依赖于传统的椭偏测量或反射测量技术,其检测这些应用的薄膜梯度变化的能力有限。
为了克服这些挑战,FilmTek 6000标准杆数-SE将光谱椭圆偏振仪和DUV多角度极化反射仪与宽光谱范围相结合,以满足与多图案和其他前沿器件制造技术相关的需求。该系统采用我们多角度差分偏振(MADP)和差分功率谱密度(DPSD)技术,可独立测量薄膜厚度和折射率,显著提高其对薄膜变化的灵敏度,尤其是多层堆叠中的变化。这种组合方法对于用于复杂器件结构的超薄和厚膜叠层都是理想的。
| 膜厚范围 | 0 Å to 150 µm |
|---|---|
| 膜厚精度 | ±1.0 Å for NIST traceable standard oxide 100 Å to 1 µm |
| 光谱范围 | 190 nm - 1700 nm (220 nm - 1000 nm is standard) |
| 光斑尺寸的测量 | 50 µm |
| 样本量 | 2 mm - 300 mm (150 mm standard) |
| 光谱分辨率 | 0.3 nm - 2nm |
| 光源 | Regulated deuterium-halogen lamp (2,000 hrs lifetime) |
| 探测器类型 | 2048 pixel Sony linear CCD array / 512 pixel cooled Hamamatsu InGaAs CCD array (NIR) |
| Computer | Multi-core processor with Windows™ 10 Operating System |
| 测量时间 | ~2 sec per site (e.g., oxide film) |
| Film(s) | 厚 | 测量参数 | 精确 (1σ) |
|---|---|---|---|
| 氧化物/硅 | 0 - 1000 Å | t | 0.03 Å |
| 1000 - 500,000 Å | t | 0.005% | |
| 1000 Å | t , n | 0.2 Å / 0.0001 | |
| 15,000 Å | t , n | 0.5 Å / 0.0001 | |
| 150.000 Å | t , n | 1.5 Å / 0.00001 | |
| 氮化物/硅 | 200 - 10,000 Å | t | 0.02% |
| 500 - 10,000 Å | t , n | 0.05% / 0.0005 | |
| 光致抗蚀剂/硅 | 200 - 10,000 Å | t | 0.02% |
| 500 - 10,000 Å | t , n | 0.05% / 0.0002 | |
| 多晶硅 / 氧化物/硅 | 200 - 10,000 Å | t Poly , t Oxide | 0.2 Å / 0.1 Å |
| 500 - 10,000 Å | t Poly , t Oxide | 0.2 Å / 0.0005 |
保修期: 1年
是否可延长保修期: 否
现场技术咨询: 无
免费培训: 现场操作培训
免费仪器保养: 1年1次
保内维修承诺: 免费更换部件,玻璃制品和耗材除外
报修承诺: 24~48小时到达现场进行维修

Bruker VERTEX 70v 傅立叶变换红外光谱仪
型号:VERTEX 70v 面议
Bruker VERTEX 80/80v 傅立叶变换红外光谱仪
型号: VERTEX 80 面议
bruker布鲁克 JV-DX X射线衍射仪 XRD
型号:JV-DX 100万 - 150万
bruker布鲁克 JV-QCVelox X射线衍射仪 XRD
型号: JV-QCVelox 50万 - 100万——多模态临界尺寸测量和薄膜计量学 FilmTekTM CD光学临界尺寸系统是我们解决方案,可用于1x nm设计节点及更高级别的全自动化、高通量CD测量和高级薄膜分析。该系统同时提供已知和完全未知结构的实时多层堆叠特性和CD测量。
椭偏仪是一种用于探测薄膜厚度、光学常数以及材料微结构的光学测量仪器。
布鲁克椭偏仪 FilmTek 6000 PAR-SE的工作原理介绍
椭偏仪 FilmTek 6000 PAR-SE的使用方法?
布鲁克 FilmTek 6000 PAR-SE多少钱一台?
椭偏仪 FilmTek 6000 PAR-SE可以检测什么?
椭偏仪 FilmTek 6000 PAR-SE使用的注意事项?
布鲁克 FilmTek 6000 PAR-SE的说明书有吗?
布鲁克椭偏仪 FilmTek 6000 PAR-SE的操作规程有吗?
布鲁克椭偏仪 FilmTek 6000 PAR-SE报价含票含运吗?
布鲁克 FilmTek 6000 PAR-SE有现货吗?
最多添加5台
