推荐厂家
暂无
暂无
 留言咨询
留言咨询
 铜牌9年
铜牌9年
 400-860-5168转3569
400-860-5168转3569
 留言咨询
留言咨询
 留言咨询
留言咨询
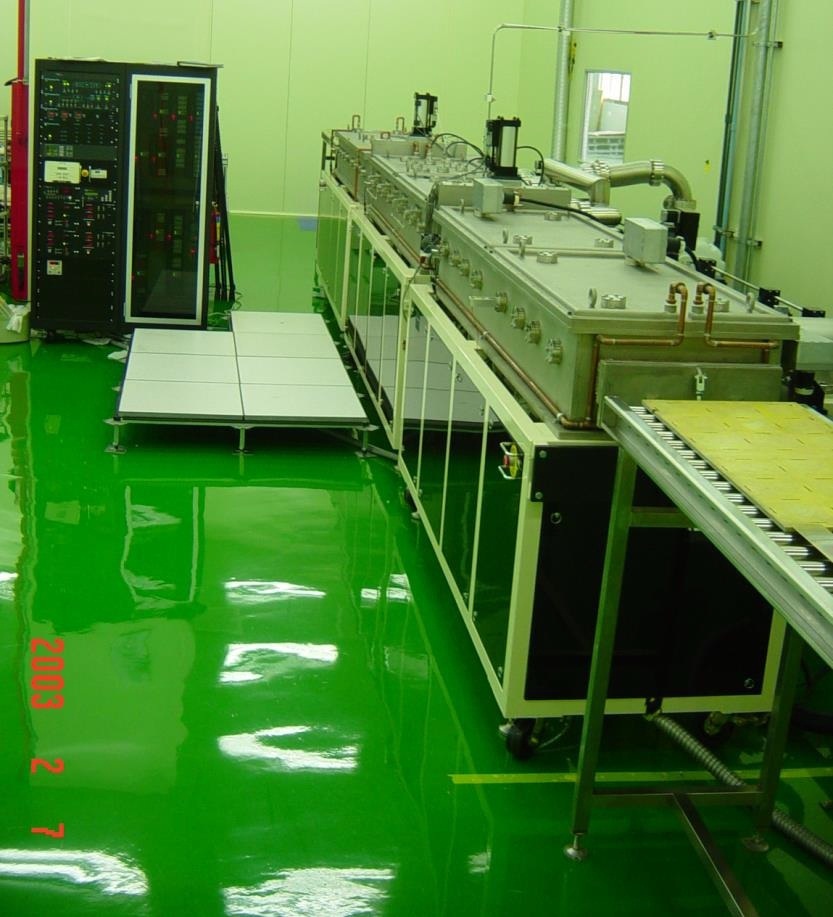
 400-860-5168转3181
400-860-5168转3181
 留言咨询
留言咨询
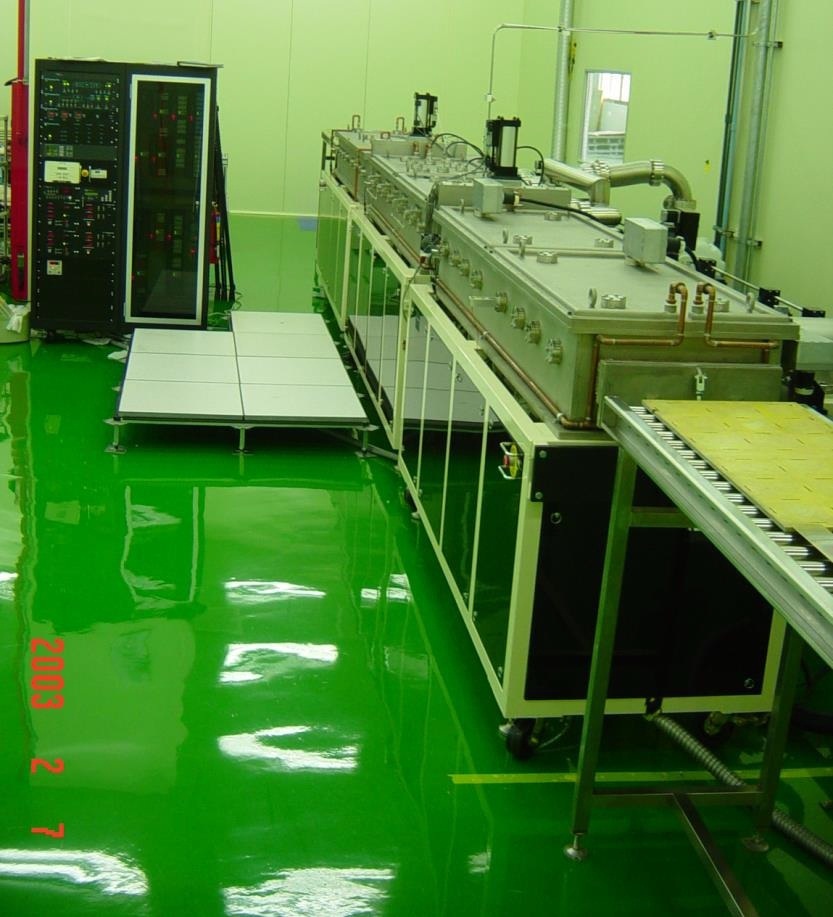
 400-860-5168转1545
400-860-5168转1545
 留言咨询
留言咨询

 400-860-5168转1679
400-860-5168转1679
 留言咨询
留言咨询


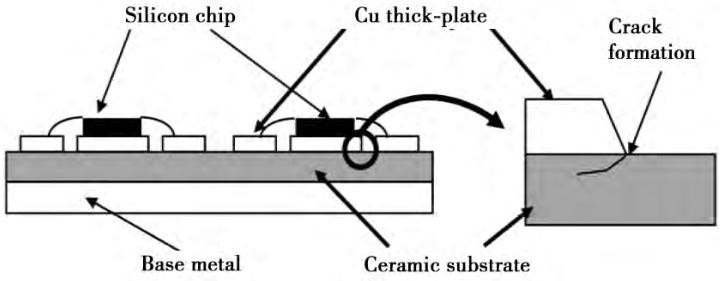



表征氮化硅微粉体个人有些地方有些迷惑,不知道选用什么方法和设备1、粒度方法:光散射法、沉降法、电导法?还有其他不清楚个人想选用 激光粒度仪,理由是检测快速,效率高,精度?2、比表面积这个不太了解,用什么方法和设备比较合适,xdjm帮忙推荐下3、元素分析主要分析金属元素Fe、Al、Ca等,氧、氮、游离硅含量、二氧化硅、氮化硅含量这个好像很复杂,选用什么方法测这些呢,我个人想法是ICP-AES(OES)测量金属元素,氧氮含量怎么测呢?红外氧氮分析仪?游离硅这么测呢,氮化硅含量怎么测量啊?4、堆积密度、堆积角?大家讨论讨论,陶瓷粉体表征有经验的xdjm给指导下
化学式Si3N4,,是一种重要的结构陶瓷材料。它是一种超硬物质,本身具有润滑性,并且耐磨损,为原子晶体;高温时抗氧化。化学式Si3N4。白色粉状晶体;熔点1900℃,密度3.44克/厘米3(20℃);有两种变体:α型为六方密堆积结构;β型为似晶石结构。氮化硅有杂质或过量硅时呈灰色。 氮化硅与水几乎不发生作用;在浓强酸溶液中缓慢水解生成铵盐和二氧化硅;易溶于氢氟酸,与稀酸不起作用。浓强碱溶液能缓慢腐蚀氮化硅,熔融的强碱能很快使氮化硅转变为硅酸盐和氨。氮化硅在 600℃以上能使过渡金属氧化物、氧化铅、氧化锌和二氧化锡等还原,并放出氧化氮和二氧化氮。
各位大虾,你们用的TEM氮化硅窗口的规格是怎么样的呢?我这边拿到10片9窗口的氮化硅窗口,规格如下:框架3mm*3mm,窗口是0.5mm*0.5mm,3*3阵列,膜厚是50nm这么小的东西,还有个薄膜,我应该用怎样规格的镊子去夹呢?各位大虾,你们用的是什么样的镊子比较好夹,又安全呢?不会夹碎窗口的……介绍下镊子型号、哪里购买的,价格什么的……各位大虾能够出来分享下TEM衬底耗材的使用心得和经验吗?分享格式如下:1、衬底名称、型号2、衬底材质、规格3、使用效果4、遇到的问题5、个人看法谢谢大家的热心分享,我是新鸟,我学会加分的时候,给参与者加分。另外有机会获得惊喜奖励!