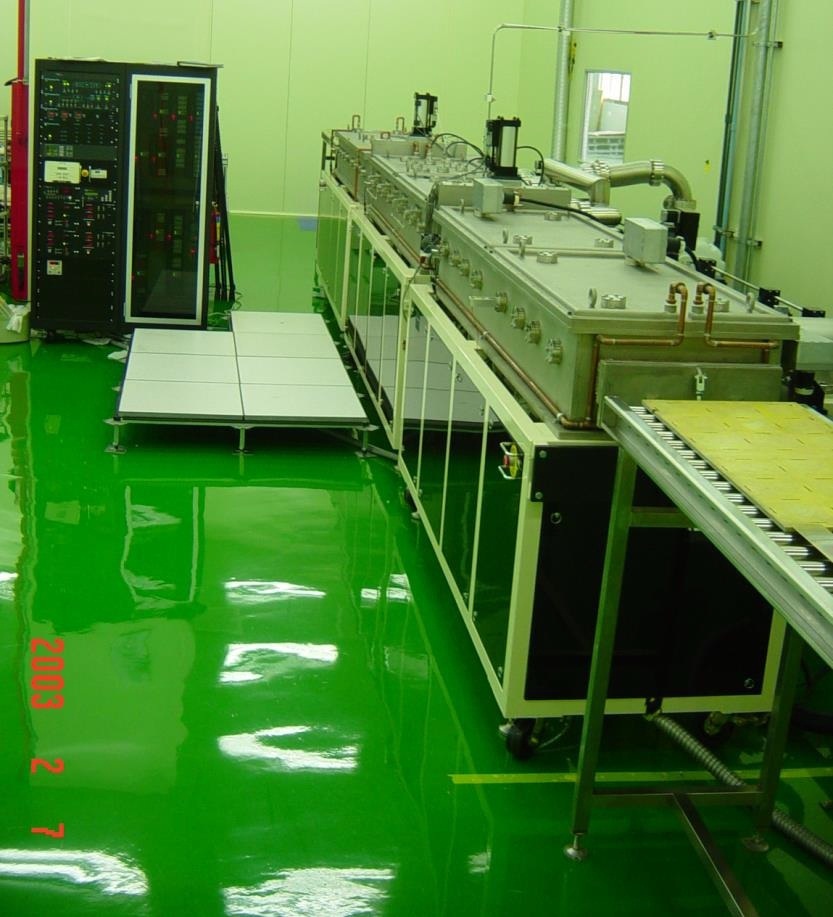
 400-860-5168转3181
400-860-5168转3181
 留言咨询
留言咨询
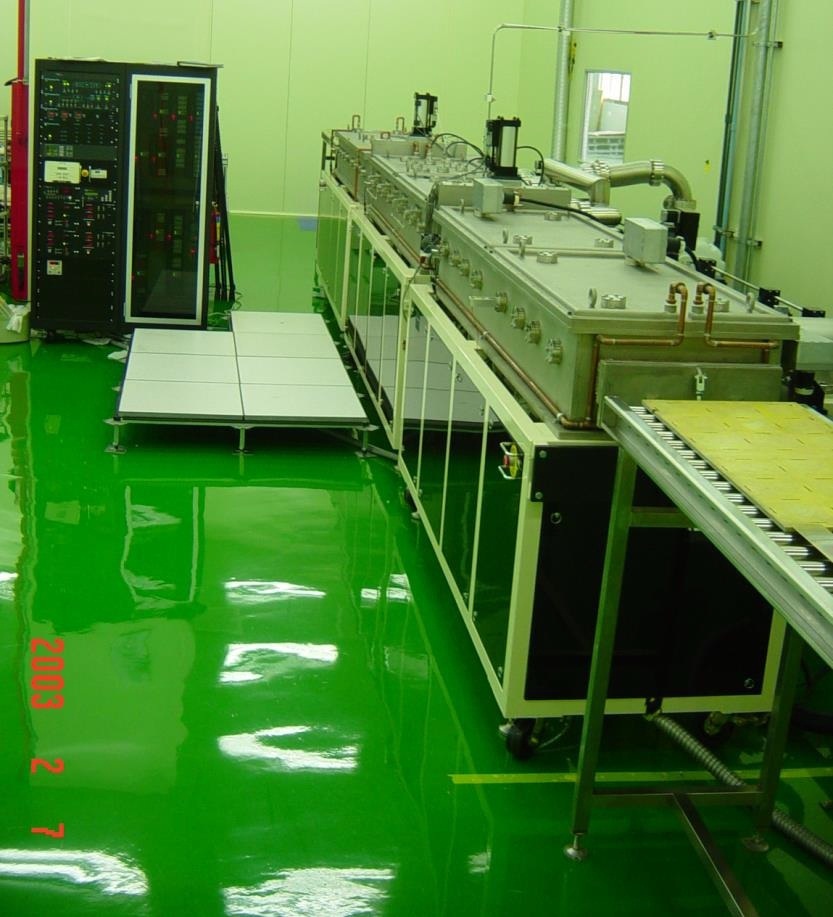
 400-860-5168转1545
400-860-5168转1545
 留言咨询
留言咨询

 400-860-5168转1679
400-860-5168转1679
 留言咨询
留言咨询
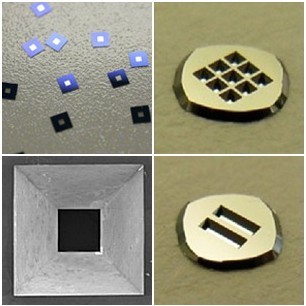
 400-860-5168转1679
400-860-5168转1679
 留言咨询
留言咨询

 留言咨询
留言咨询
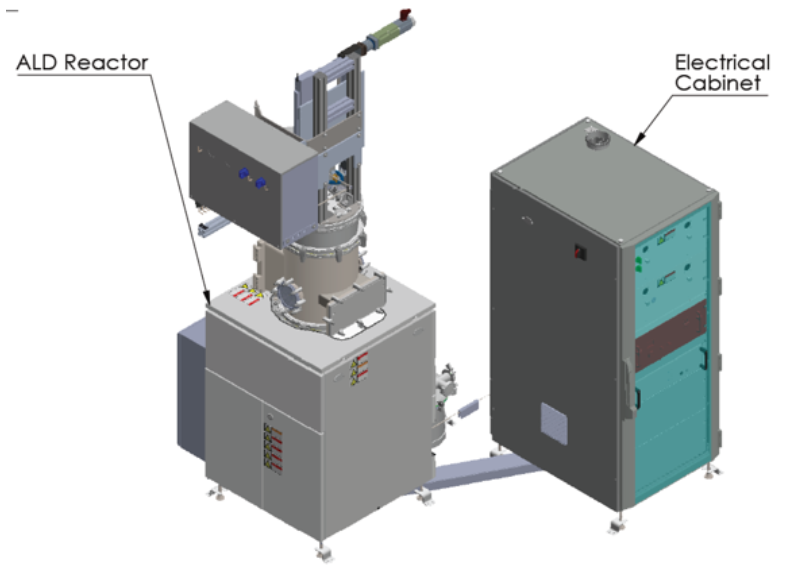
 留言咨询
留言咨询

 400-827-1665
400-827-1665
 留言咨询
留言咨询

 留言咨询
留言咨询

 留言咨询
留言咨询
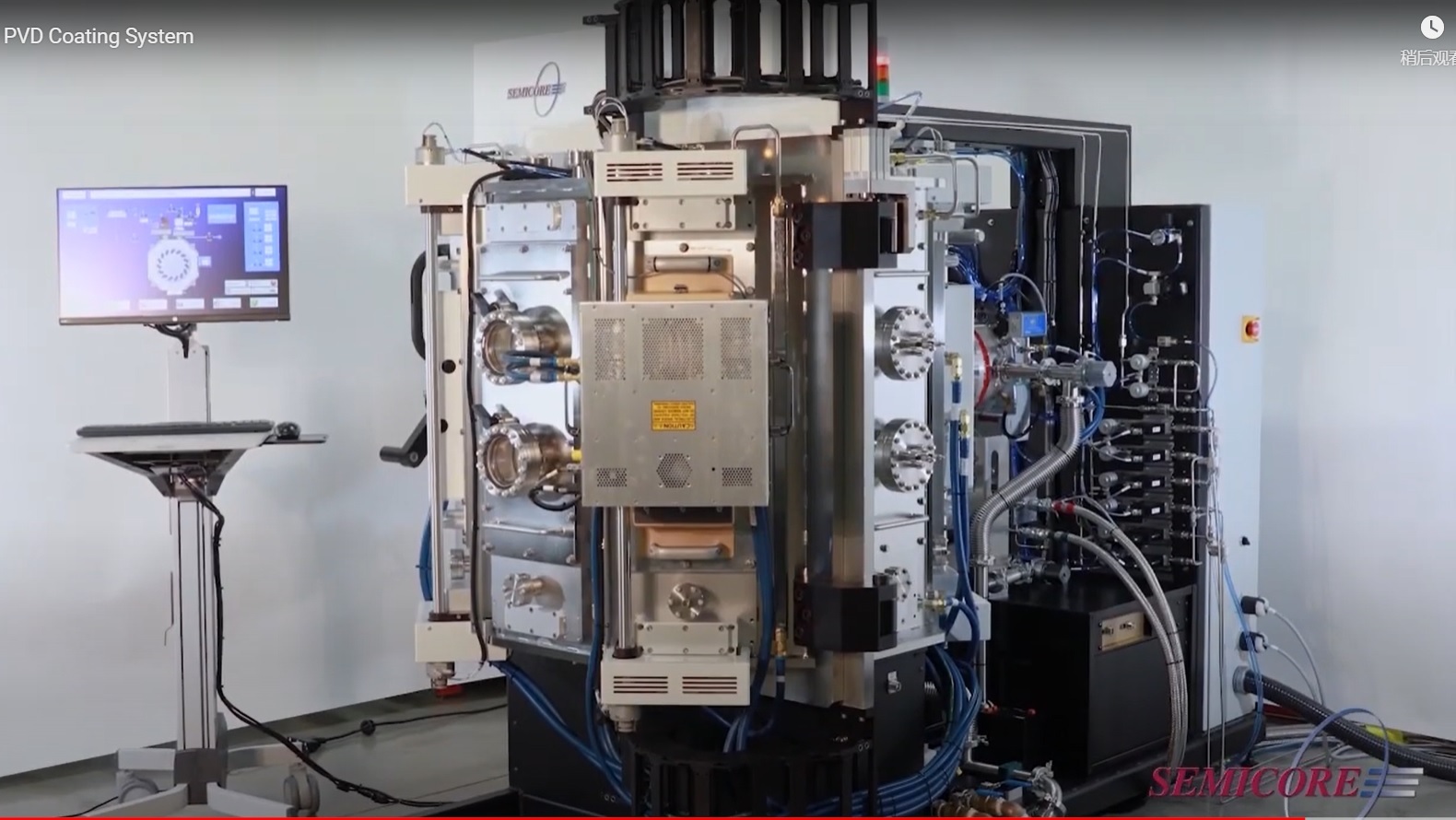
 400-860-5168转3281
400-860-5168转3281
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询
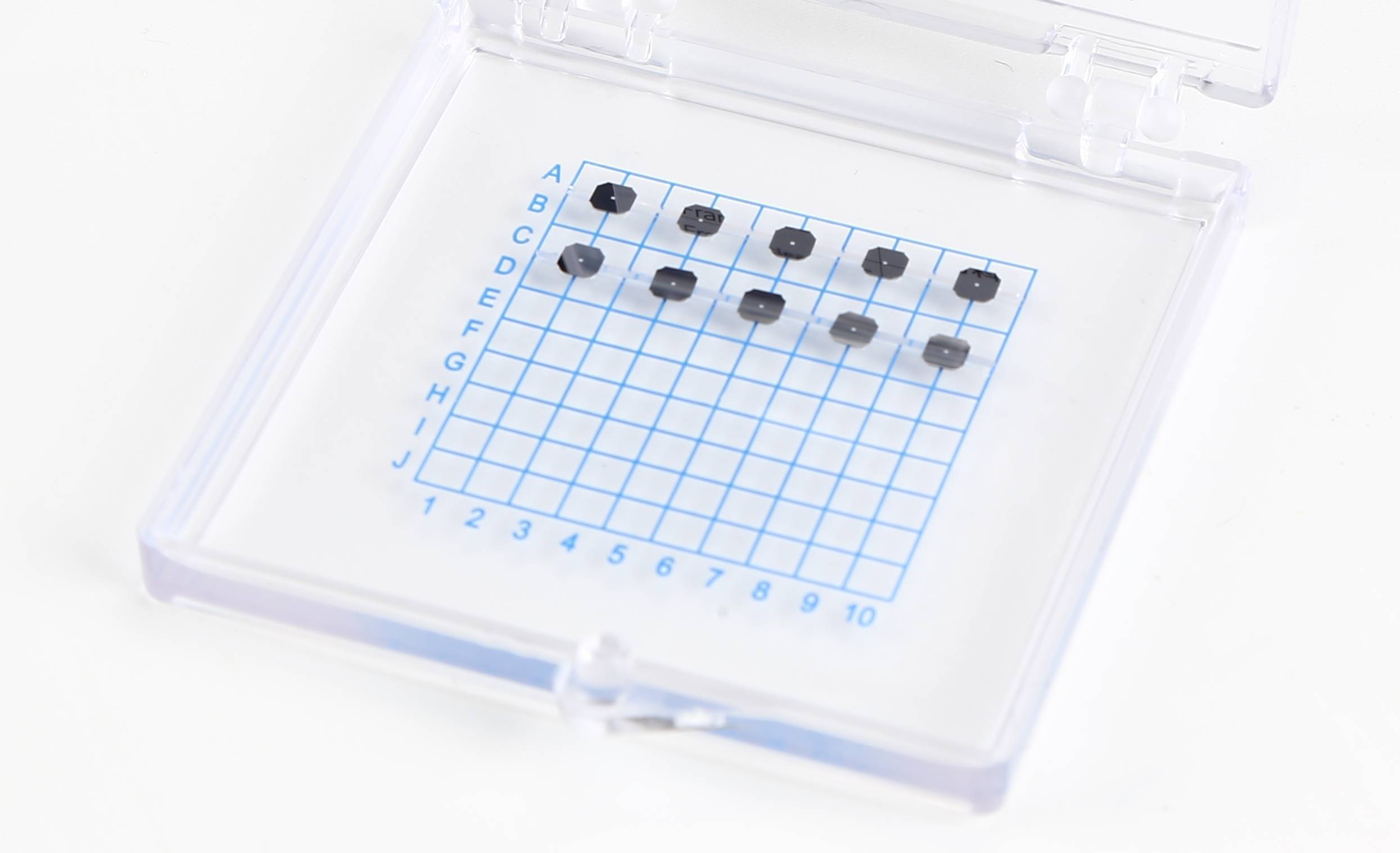
 留言咨询
留言咨询

 400-858-9311
400-858-9311
 留言咨询
留言咨询

 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询
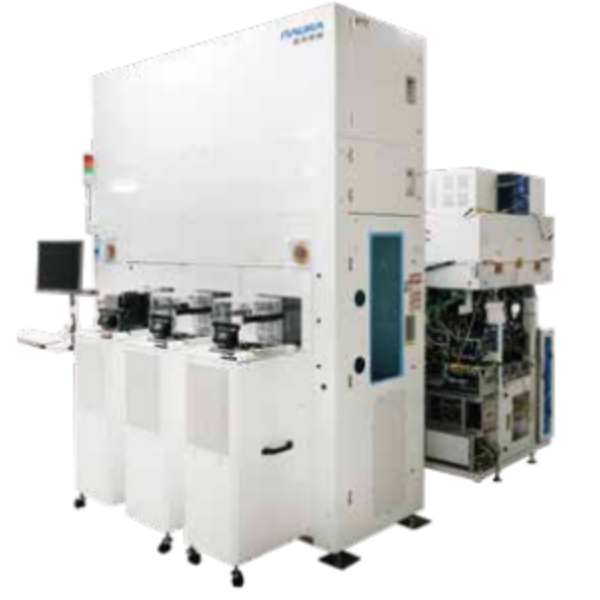
 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转4794
400-860-5168转4794
 留言咨询
留言咨询

 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 留言咨询
留言咨询
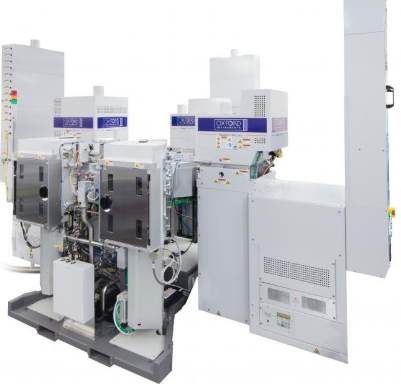
 400-860-2711
400-860-2711
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转3241
400-860-5168转3241
 留言咨询
留言咨询

 400-860-5168转4527
400-860-5168转4527
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转4527
400-860-5168转4527
 留言咨询
留言咨询
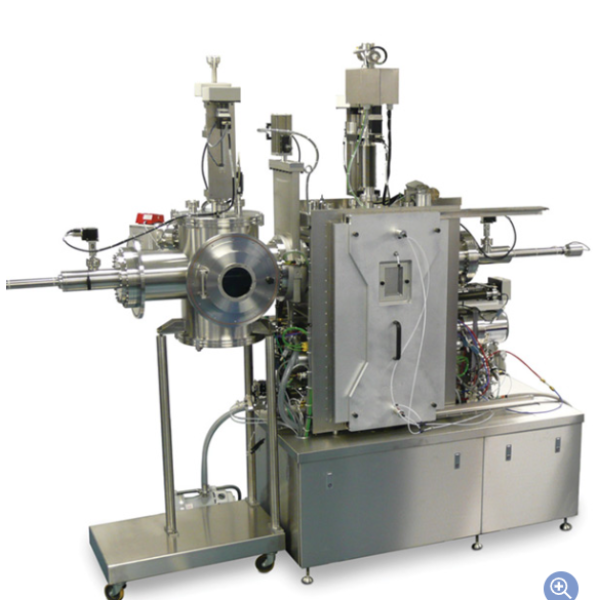
 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询