









近期,环球晶董事长徐秀兰对外透露,AI所需的HBM内存芯片,比如HBM3以及未来的HBM4,都需要在裸片(die)上做堆叠,层数从12层到16层增加,同时结构下面还需要有一层基底的晶圆,这增加了硅晶圆的使用量。
此前,媒体报道,AI浪潮之下全球HBM严重供不应求,原厂今明两年HBM产能售罄,正持续增加资本投资,扩产HBM。据业界透露,相较于同容量、同制程的DDR5等内存技术,HBM高带宽存储芯片晶圆的尺寸增大了35%~45%;同时,HBM制造工艺的复杂性导致晶圆的良率比DDR5低20%~30%。良率的降低意味着在相同的晶圆面积上,能够生产出合格芯片的数量减少,以上两个因素也意味着市场需要耗费更多硅晶圆以满足HBM的生产。
除了存储器之外,先进封装技术创新也对硅晶圆带来有利影响。徐秀兰表示,先进封装所需的抛光片也比之前要多,原因是封装变立体,结构制程也发生改变,部分封装需要的晶圆量可能会比过去多一倍。随着明年先进封装的产能开出,需要用到的晶圆数量将更加可观。
CoWoS是当前主流的先进封装技术,目前供不应求。全球市场研究机构TrendForce集邦咨询数据显示,英伟达B系列包含GB200、B100、B200等将耗费更多CoWoS产能,台积电(TSMC)亦提升2024全年CoWoS产能需求,预估至年底每月产能将逼近40k,相较2023年总产能提升逾150%;2025年规划总产能有机会几近倍增,其中英伟达需求占比将逾半数。
业界指出,过去半导体先进制程发展,die size缩小,减少了晶圆使用量。如今,在AI推动之下,封装立体化,助力晶圆使用量的提升,进而助力硅晶圆产业发展。但要注意的是,硅晶圆迎来利好的同时,HBM、先进封装技术的发展对硅晶圆质量、平整度、纯度等方面提出了更高的要求,这也将促使硅晶圆厂商做出相应的调整,以应对AI大势。
[来源:电子产品世界]

GPU、大尺寸硅单晶在列!2024重大科学问题、工程技术难题和产业技术问题发布
2024.07.03
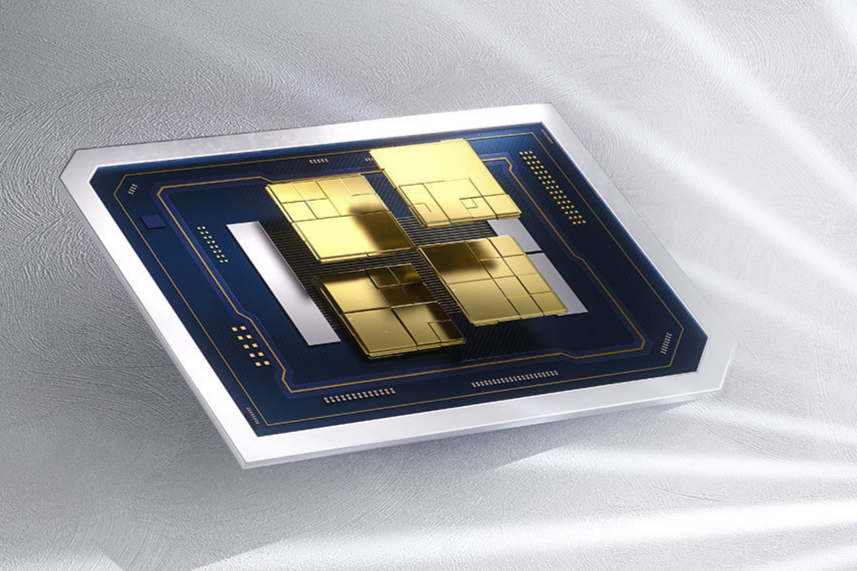
2024.07.02

2024.07.02

2024.06.27

2024.06.20

2024.06.17
版权与免责声明:
① 凡本网注明"来源:仪器信息网"的所有作品,版权均属于仪器信息网,未经本网授权不得转载、摘编或利用其它方式使用。已获本网授权的作品,应在授权范围内使用,并注明"来源:仪器信息网"。违者本网将追究相关法律责任。
② 本网凡注明"来源:xxx(非本网)"的作品,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,且不承担此类作品侵权行为的直接责任及连带责任。如其他媒体、网站或个人从本网下载使用,必须保留本网注明的"稿件来源",并自负版权等法律责任。
③ 如涉及作品内容、版权等问题,请在作品发表之日起两周内与本网联系,否则视为默认仪器信息网有权转载。
![]() 谢谢您的赞赏,您的鼓励是我前进的动力~
谢谢您的赞赏,您的鼓励是我前进的动力~
打赏失败了~
评论成功+4积分
评论成功,积分获取达到限制
![]() 投票成功~
投票成功~
投票失败了~