







半导体&电子测试测量,投稿:kangpc@instrument.com.cn


仪器信息网讯 2023年7月7-10日,由中国材料研究学会主办的中国材料大会2022-2023在深圳国际会展中心举行。据悉,本届中国材料大会系首次在深圳举办,大会聚焦前沿新材料科学与技术,设置77个关键战略材料及相关领域分会场。
7月9日,由深圳市科技创新委员会、深圳市宝安区人民政府、中国科学院深圳先进技术研究院指导,中国材料研究学会主办,深圳先进电子材料国际创新研究院、上海集成电路材料研究院承办的“中国材料大会2022-2023大湾区特色新材料论坛——集成电路材料产业创新发展论坛”在深圳国际会展中心南宴会厅A(二层)顺利召开。

广东省委常委、副省长、中国科学院院士 王曦 致辞

深圳市市委常委、市政府党组成员 郑红波 致辞

中国科学院深圳先进技术研究院院长 樊建平 致辞
广东省委常委、副省长王曦,深圳市委常委、市政府党组成员郑红波,中国科学院深圳先进技术研究院院长樊建平出席活动并致辞。来自北京、上海、江苏、广州、深圳等地的企业和科研机构、高校代表参加论坛交流。




签约仪式
随后,活动现场,深圳先进电子材料国际创新研究院与宝安区“专精特新”联合创新中心、优质“链上企业”联合创新中心等共计22家企业在现场完成签约仪式,将进一步发挥各自优势,整合研发与产业资源,推动务实合作。
签约仪式结束后,会议进入报告环节。

报告人:彭孝军 院士(中国科学院)
报告题目:先进光刻材料及其思考
据介绍,激发波长从可见光波长逐步向高能的短波长发展,成为光刻胶发展的主流趋势。未来发展5 nm以下的分节点,急需发展13.5nm的极紫外光(EUV)光刻技术。极紫外彻底改变了传统光刻系统,具有空前的挑战性。如:极紫外光对C、H、N、S等传统有机化合物元素的吸收截面极小,接近透明,没有吸收就难于获得能量而被激发,不能发生高效率的光刻反应;传统光刻胶由光致产酸剂+有机聚合物组成,由于质子扩散,分辨率难于提升,后者分子量太大,难于实现2-3 nm的分辨;EUV光子能量增大到92 eV,进入辐射化学领域,基础研究不足;而相同功率的极紫外光(13.5 nm)的光子数仅为深紫外(ArF,193 nm)光子数的7%,这对光刻胶的灵敏度提出了更高要求

报告人:俞跃辉 董事长(上海硅产业集团股份有限公司)
报告题目:大硅片的国产化路径探讨和展望
硅片,尤其是国际主流的300 mm大硅片,长期制约着国内半导体产业的发展。报告中,俞跃辉介绍了上海硅产业集团一路走来的发展历程。在硅产业集团子公司上海新昇的带领下,国内硅片行业突破了300 mm硅片的技术壁垒,未来,硅产业集团作为行业领头羊,将面向国家战略,引领国内硅片技术领或前治,扩大产业规模,开拓新领或,驱动集成电路材料产业链国产化进程。

报告人:陈贻和 副总经理(礼鼎半导体科技(深圳)有限公司)
报告题目:集成电路封装载板发展趋势
报告介绍了2010-2022年中国半导体的发展,中国封装载板产值只有全球的7%,自制缺口巨大。据介绍,2020-2022年封装载板需求旺盛,主要原因来自产品结构的变化。未来封装载板发展趋势分为两方面,FCBGA载板朝向细线路、高层数、大尺寸发展,FCCSP载板朝向细线路、微型孔、薄型化发展。

报告人:汤昌丹 总经理(深圳瑞华泰薄膜科技股份有限公司)
报告题目:高性能PI薄膜的应用与技术发展趋势
据介绍,聚酰亚胺是综合性能最好的聚合物材料之一,即是高等级绝缘、高速轨道交通、柔性电子、航天航空、集成电路与半导体等领域的战略性基础材料,迫切需求国产化替代,打破卡脖子问题;同时也是5g/6g高频高速、新能源(风、光、储、复合集流体)、新能源汽车、新型显示等新兴领域迫切需求的创新材料。报告中,汤昌丹结合产业发展与市场需求,带来高性能聚酰亚胺在集成电路等高技术领域中应用与展望。

报告人:林耀剑 副总裁(江苏长电科技股份有限公司)
报告题目:智能运算系统中的一站式封装解决方案及材料关注
半导体封装是电子产品制造中的一个重要环节。本质上是芯片成品技术,其主要对芯片起到中介互连、物化保护和散热管理的作用。随着技术的进步,封装在向微系统化方向发展以集成创新、提升性能和扩展应用。而材料在各先进封装的研发制造和应用中起到极其关键的作用。报告中,林耀剑介绍和探讨了长电科技先进封装中的散热增强功率封装、SiP、晶圆级封装、以及2.5D芯粒封装技术的特征制造和结构以及关键材料关注点。

报告人:严斌 高级技术专家 (深圳市中兴微电子技术有限公司)
报告题目:先进封装材料(基板材料&散热材料)
报告中,严斌介绍了先进封装材料的发展趋势。据介绍,随着产品复杂度提升和功能多样化,芯片Die size尺寸越来越大,封装尺寸逐步增大,基板层数逐渐增多;大尺寸封装需要更低的CTE材料,保证更平整的翘曲表现;高速信号要求非常低损耗的材料,保证高性能;同时,大尺寸芯片伴随着高功耗高功率密度的产生,带来极具挑战的散热需求;因而对芯片散热材料提出了更高的要求;低热阻,高导热的散热材料(热界面材料TIM1,高导热Lid材料)。

报告人:杨云春 董事长(北京赛微电子股份有限公司)
报告题目:对传感器材料发展趋势的期望
传感器材料正在向金属氧化物的方向发展,然而其高灵敏度只能在较高的温度下实现。作为工业界,杨云春希望学术界能够就如何将其与其他材料如金属纳米颗拉、纳米薄膜,纳米管甚至石墨烯相结合进行研究,进而利用其电化学的特殊优势,提高传感器材料的表面积与体积比,提高传感器的灵敏度,并显著降低基于传感器的工作温度。

报告人:杨之诚 董事长(深南电路股份有限公司)
报告题目:面向各类应用的半导体封装基板材料发展趋势及研究
近年来,国内半导体行业已从传统消费类向数据中心、超算、汽车电子、AI人工智能、光电传输等领域转型突破,芯片设计从轻薄化、小型化向高可靠性、高密度、复杂结构等方向升级。杨之诚表示,国内基板厂也同步在存储、射频、处理器FCCSP及FCBGA等产品上逐步实现精细线路、高多层结构、高速传输等关键技术突围,并需要同步推动上下游产业链薄弱环节如基板制造设备、配套材料等相关技术能力补强和提升,有效支撑国内lC设计公司产品迭代诉求。

报告人:傅铸红 总经理(广东华特气体股份有限公司)
报告题目:电子特气工艺及产品介绍
电子气体,是指用于半导体及其他电子产品生产的气体,与传统的工业气体相比,电子气体特殊在气体的纯净度极高。电子气体在半导体材料成本中是仅次于硅片的第二大材料种类,年需求量增长超过15%,国产化率超过35%。报告中,傅铸红介绍了电子气体的种类、应用、市场规模、生产工艺、配套技术等相关情况。

报告人:郭贵琦 总经理(广州新锐光掩模科技有限公司)
报告题目:集成电路制造用光掩模研究与应用
光掩模是半导体核心工艺——光刻的最关键器件。郭贵琦表示,光掩模是芯片制造的关键,在芯片制造中承上启下,芯片设计数据是信息安全的重中之重;光掩模将向高精度、大规模纯商业方向发展,产业链整合尤为重要;需要建立规范化高端光掩模研发生产基地,完善良性循环发展模式,成为自我发展功能、可持续发展潜能和可复制性效能的集研、学、产用于一体的产业基地;市场寡头垄断严重,国产替代正当其时。

报告人:潘杰 总经理(宁波江丰电子材料股份有限公司)
报告题目:突破核心技术,打造核心竞争力,为全球产业链提供确切性——中国超高纯材料及溅射靶材产业化新进展
报告中,潘杰主要分享了江丰电子创业以来的主要成就。据介绍,江丰电子攻破了全球最领先的5纳米工艺核心技术,是台积电等国际一流半导体制造企业的主要供应商,圆满完成28-14nm技术节点超高纯溅射靶材的国产化替代,打破依赖国外进口的局面,产品大量出口,全球市场份额超过24%,位居世界第二,形成了对国际市场的影响力,获得了国家技术发明二等奖、“制造业单项冠军”等荣誉,并在深交所成功上市。

报告人:孙蓉 院长(深圳先进电子材料国际创新研究院)
报告题目:集成电路高端材料国产化路径—实践与探索(以封装电子材料为例)
孙蓉在报告中介绍了国内电子化学品及先进电子封装材料的产业发展现状,其次提出了先进电子封装材料领域的几个关键“根问题”,介绍了高分子树脂合成与纯化、无机填料表面改性、异质界面调控、聚合物流变学、原位分析检测与服役可靠性等方面的研究进展。在此基础上介绍了芯片级底部填充胶、芯片级热界面材料、积层胶膜材料、晶圆级光敏聚酰亚胺、液态塑封料、临时键合胶等几种高端电子封装材料的研发与产业化进展。

报告人:曹勇 总监(深圳市鸿富诚新材料股份有限公司)
报告题目:鸿富诚高性能碳基导热垫片介绍
5G时代的来临,电子元器件逐步向高功率、高集成、微型化方向发展,由此带来了严重的散热问题。曹勇表示,过多的热量如果不能及时传递到冷却端,就会导致设备出现故障,降低使用寿命。因此,开发更高性能热界面材料逐步成为未来发展的趋势和挑战。报告中,曹勇介绍了鸿富诚碳纤维和石墨烯高性能碳基导热垫片。

报告人:黄嘉晔 市场部部长(上海集成电路材料研究院)
报告题目:我国集成电路材料技术研发的现状与思考
黄嘉晔在报告中首先介绍了全球集成电路材料产业情况和中国集成电路材料产业情况,之后介绍了上海集成电路材料研究院。据介绍,集材院是由中国科学院上海微系统与信息技术研究所、上海硅产业集团发起成立,聚焦集成电路村底材料、工艺材料以及产业关键技术的研发与产业化,为集成电路材料发展提供坚实的创新策源。报告最后,黄嘉晔建议,在大湾区,由深圳先进电子材料国际创新研究院牵头,上海集成电路材料研究院协同,建设聚焦封装材料的创新联合体。

报告人:朱朋莉 研究员(深圳先进电子材料国际创新研究院)
报告题目:纳米填料增强环氧基复合材料在芯片封装中的应用研究
纳米填料增强环氧基复合材料因具有低应力、低膨胀、高填充率、高介电、高粘结强度等综合特性,被广泛用作底部填充胶、环氧塑封料、覆铜基板等,以充当超大规模集成电路封装结构中的关键支撑材料。目前,物联网(IoT)、人工智能和5G通讯等高端应用领域的迅猛发展对芯片的处理速率、互连密度、功耗和稳定性提出了巨大的挑战,在此推动下,大尺寸、薄型化、窄间距、三维堆叠及高度集成化的芯片封装成为后摩尔时代集成电路发展的必然趋势。由此对作为支撑结构的环氧基复合材料性能提出的更高需求,如电子级球形二氧化硅的粒度级配、分布形态、表面化学状态等,是影响芯片封装可靠性首当其冲的问题。基于此,朱朋莉从纳米复合材料中微观的相界面出发,通过改变电子级球形二氧化硅填料的表面物理化学状态,设计了不同性质和结构的界面相,并系统研究了界面相的存在对芯片级封装材料—底部填充胶性能的影响规律,解决了底部填充胶在芯片应用过程中的诸如粘度、填充性、应力调节、焊球保护、芯片失效等问题,为高端电子封装材料的开发提供指导。

报告人:吴蕴雯 副教授(上海交通大学)
报告题目:电沉积金属微纳结构调控及在三维互连中的应用
近年来由5G高速通讯引领的元宇宙、区块链、自动驾驶、远程医疗等万物互联技术正在蓬勃发展,其中先进集成电路的发展是实现当代信息技术飞跃的基石。然而在后摩尔时代,由于先进集成电路制程工艺逐渐逼近物理极限,通过芯片三维集成是延续摩尔定律的必经路径。在三维集成技术中,互连是信号传输的主要载体,以微凸点键合和硅通孔技术为主的铜互连技术主要采用电化学沉积的方法进行微纳图形制备。随着三维集成密度不断提高,集成电路互连面临强度、导电性、可靠性等多方面的挑战,通过调节电沉积工艺及添加剂体系实现铜互连微观结构的调控是构筑高密度互连的关键。吴蕴雯基于电沉积铜微纳米结构调控,实现了具有优异物理性能的微凸点、硅通孔互连技术,为推动高密度三维互连技术提供技术思路和理论基础。
[来源:仪器信息网] 未经授权不得转载
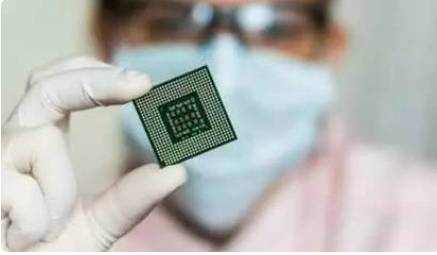
2023.07.10

2023.07.12

1.9万人齐聚鹏城!中国材料大会2022-2023在深圳开幕
2023.07.08
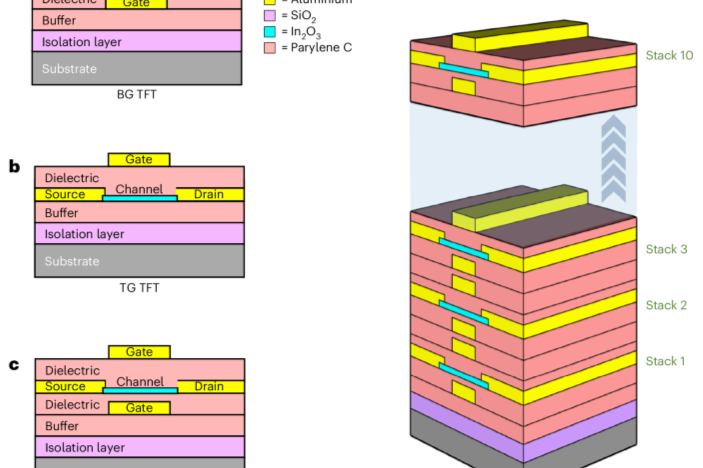
2024.08.18

2024.08.12

2024.07.03
版权与免责声明:
① 凡本网注明"来源:仪器信息网"的所有作品,版权均属于仪器信息网,未经本网授权不得转载、摘编或利用其它方式使用。已获本网授权的作品,应在授权范围内使用,并注明"来源:仪器信息网"。违者本网将追究相关法律责任。
② 本网凡注明"来源:xxx(非本网)"的作品,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,且不承担此类作品侵权行为的直接责任及连带责任。如其他媒体、网站或个人从本网下载使用,必须保留本网注明的"稿件来源",并自负版权等法律责任。
③ 如涉及作品内容、版权等问题,请在作品发表之日起两周内与本网联系,否则视为默认仪器信息网有权转载。
![]() 谢谢您的赞赏,您的鼓励是我前进的动力~
谢谢您的赞赏,您的鼓励是我前进的动力~
打赏失败了~
评论成功+4积分
评论成功,积分获取达到限制
![]() 投票成功~
投票成功~
投票失败了~