







半导体&电子测试测量,投稿:kangpc@instrument.com.cn


近年来随着5G通讯技术以及新能源汽车行业已成为当前投资热点,而5G基站和电动汽车都使用了功率半导体器件,开发出符合市场要求的功率半导体器件成了半导体行业的又一重要方向。以硅作为衬底的传统的半导体芯片因为材料本身的局限性已难满足要求,以碳化硅、氮化镓为代表的宽禁带第三代半导体材料具有击穿电场高、热导率高、电子饱和速率高、抗辐射能力强等优势,因此采用第三代半导体材料制备的半导体器件不仅能在更高的温度下稳定运行,适用于高电压、高频率场景,还能以较少的电能消耗,获得更高的运行能力。
第三代半导体材料虽然具有很多优点,但是其加工难度也是极大的。以碳化硅为例,其硬度世界排名第三,莫氏硬度为13,仅次于钻石(15)和碳化硼(14);而且其化学稳定性高,几乎不与任何强酸或强碱发生反应。晶体碳化硅还需要通过机械加工整形、切片、研磨、抛光等化学机械抛光和清洗等工艺,才能成为器件制造前的衬底材料。
化学机械抛光(CMP)
化学机械抛光(或化学机械平坦化)通常是使用专用抛光机在晶圆表面用抛光垫不断地旋转抛光并在过程中添加抛光液磨料以获得平坦光滑的衬底表面的工艺。
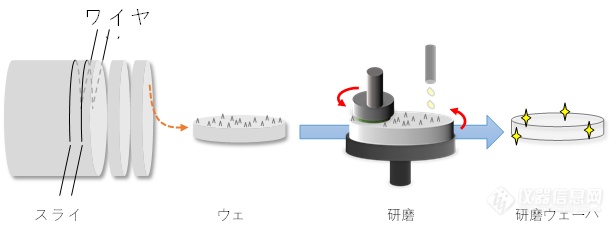
为了获得均匀平坦的晶圆衬底,厚度监测作为常用的评价手段之一。但是第三代半导体材料由于硬度高,化学机械抛光的效率比较低,部分材料抛光过程的厚度变化甚至低于数十纳米常规的位移计等监测手段已经无法达到要求,而因为材料的特殊性一般也不会使用接触式或者破坏式的测量手段。
大塚电子的SF-3系列膜厚计通过光干涉法原理,对晶圆界面之间干涉光信号进行计算从而获得晶圆的厚度信息。

SF-3膜厚计
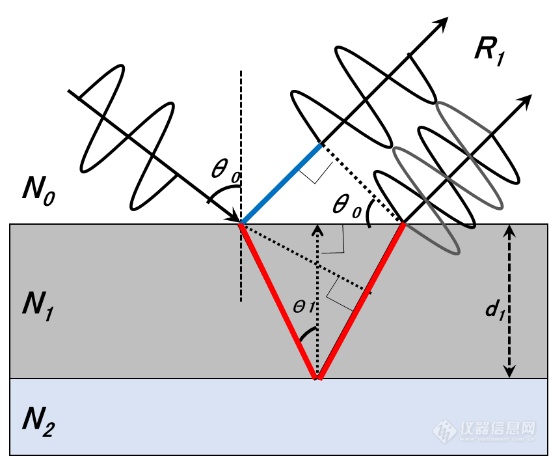
光干涉法
由于采用了光学测量原理,SF-3系列膜厚计具有极高的频率5KHZ,因而可以对晶圆厚度进行在线实时监控;同时具有高精度以及可以有效避免晶圆翘曲对结果的影响。

晶圆厚度实测
CMP抛光液
CMP抛光液作为化学机械抛光的辅助耗材,起到研磨腐蚀等作用,近年来CMP抛光液的国产化程度正在逐步提高。CMP抛光液的主要成分包括水、研磨颗粒(二氧化硅、金刚石、氧化铈、氧化锆)、氧化剂、分散剂等。不同的工艺步骤和不同的产品对CMP抛光液产品有不同的要求,通过对CMP抛光液的粒径监测、zeta电位监测可以评价CMP抛光液是否符合工艺要求以及在存储运输过程当中的稳定性。大塚电子ELSZ-neo系列纳米粒度zeta电位仪对抛光液的粒径和zeta电位检测均有大量应用。

ELSZ-neo
以下考察了CMP抛光液在不同PH值的zeta电位,并记录了不同磨料的等电点(zeta电位为零),根据抛光液的粒径和zeta电位可以选择最优的PH值从而获得稳定的产品。



晶圆清洗
在晶圆的研磨和化学机械抛光处理以后,需要对晶圆进行清洗以避免污染物的附着。一些晶圆的颗粒污染物数量要求少于10个,然而由于静电作用力,颗粒污染物与晶圆在特定的PH值环境下容易吸附,颗粒污染物通常来源于抛光液当中研磨颗粒的残留。因此,评价晶圆表面和颗粒污染物的电性对于清洗工艺有重要作用。Zeta电位(Zeta potential)作为衡量固体电性或液体的稳定性的主要指标,通常使用电泳光散射法进行测量,然而在测量固体表面zeta电位时必须要充分考虑电渗作用的影响。
(1)样品池内的粒子的电泳
以负电荷的粒子为例,理想状态下粒子无论在cell 的什么位置,都以相同的速度向正电极侧电气泳动。
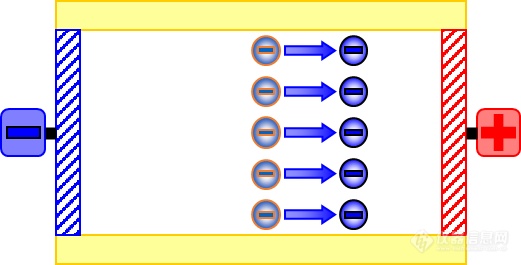
(2)样品池内的电渗流
通常cell(材质:石英)带有负电荷。所以,正电荷的离子、离子聚集在cell壁面附近,施加电场的话,壁面附近 正离子会往负极方向移动。Cell中心部为了补偿这个流动,产生相反方向的对流,这种现象叫做电渗流。

(3)样品池内可观测粒子的电泳
粒子分散在溶媒中,cell内粒子电气泳动的外观是算上这个电渗的抛物线状的流动。
为此、cell内电气浸透流的速度为零的位置,即在静止面进行测定可以得出真正粒子的电泳速度,从而得出真实的泽塔电位值。
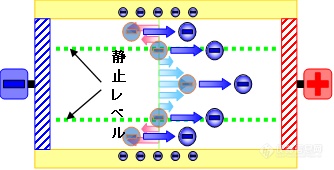
大塚电子的ELSZ系列纳米粒度zeta电位仪使用了森·岡本电渗校正专利,充分考虑了材料的电渗对电泳速度的影响。另外专用的平板样品池可选用电荷为0的涂层,并且使用中性的观测粒子,在不同PH值下测量不必考虑观测粒子电性带来的影响。
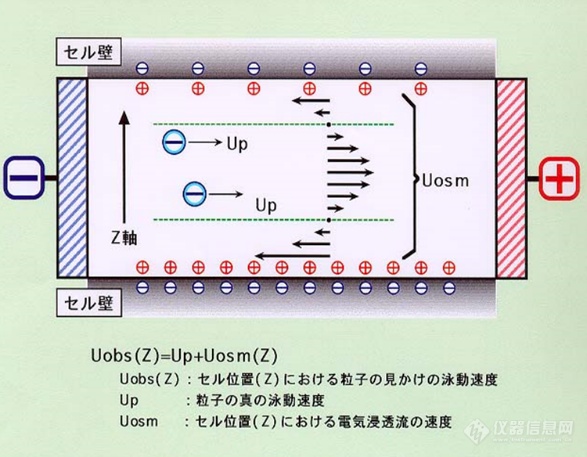
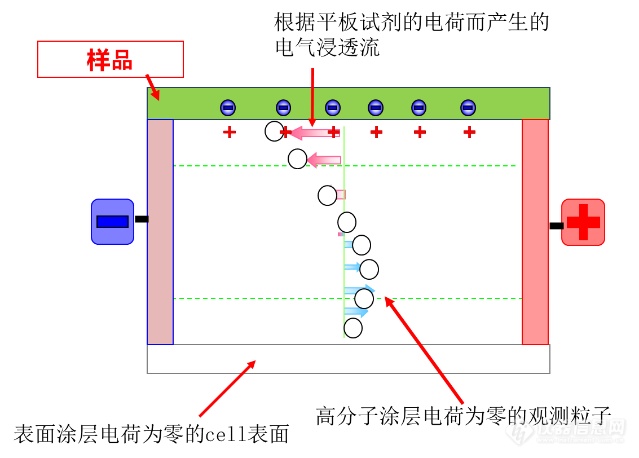


大尺寸的平板样品池,可适用不同规格的晶圆测量
实测应用时,通常会对晶圆表面和CMP抛光液的zeta电位同时进行测量。以下图为例,分别测量了硅晶圆(蓝色)和污染物粒子(红色)的zeta电位,在PH=4~8.5之间,晶圆表面与污染粒子的电性相反,因而污染粒子会依附在晶圆表面难以去除。
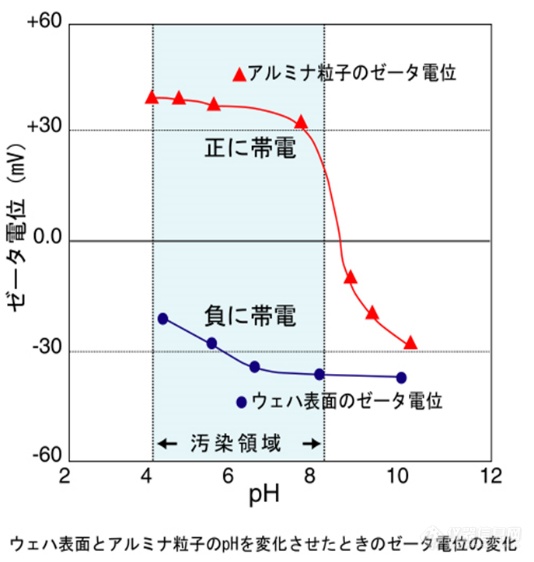
总结
大塚电子自1970年以来一直专业研究光学检测技术,秉承「多様性」「独創性」「世界化」的理念,大塚的光散射以及光干涉制品一直在包括FPD行业、半导体行业、新材料行业等专业领域占据领先地位。凭借对光学技术的深耕,大塚将继续为过国内客户提供专业的设备以及服务。
[来源:仪器信息网] 未经授权不得转载

2022.06.30

2024.07.04

2024.06.26

华海清科“集成电路化学机械抛光关键技术与装备” 项目荣获国家技术发明一等奖
2024.06.25
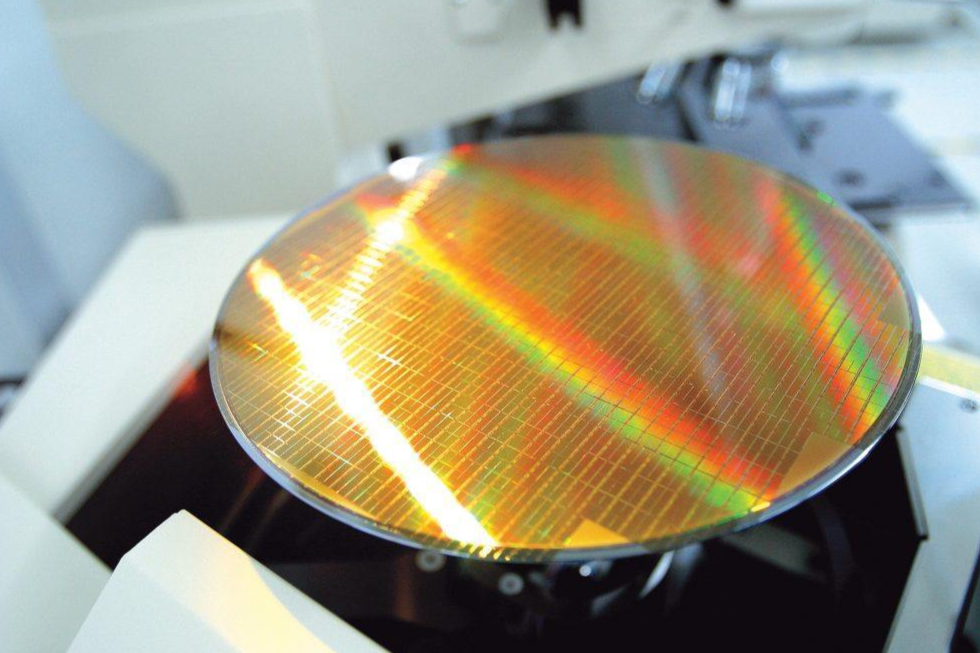
2024.06.19

专注生产抛光产品的国内新势力普瑞昇新材料完成数千万元PreA轮融资
2024.06.03
版权与免责声明:
① 凡本网注明"来源:仪器信息网"的所有作品,版权均属于仪器信息网,未经本网授权不得转载、摘编或利用其它方式使用。已获本网授权的作品,应在授权范围内使用,并注明"来源:仪器信息网"。违者本网将追究相关法律责任。
② 本网凡注明"来源:xxx(非本网)"的作品,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,且不承担此类作品侵权行为的直接责任及连带责任。如其他媒体、网站或个人从本网下载使用,必须保留本网注明的"稿件来源",并自负版权等法律责任。
③ 如涉及作品内容、版权等问题,请在作品发表之日起两周内与本网联系,否则视为默认仪器信息网有权转载。
![]() 谢谢您的赞赏,您的鼓励是我前进的动力~
谢谢您的赞赏,您的鼓励是我前进的动力~
打赏失败了~
评论成功+4积分
评论成功,积分获取达到限制
![]() 投票成功~
投票成功~
投票失败了~