推荐厂家
暂无
暂无
 金牌6年
金牌6年
 400-860-5168转3282
400-860-5168转3282
 留言咨询
留言咨询
 银牌5年
银牌5年
 400-860-5168转4306
400-860-5168转4306
 留言咨询
留言咨询
 留言咨询
留言咨询

 400-860-5168转6117
400-860-5168转6117
 留言咨询
留言咨询

 400-860-5168转1545
400-860-5168转1545
 留言咨询
留言咨询
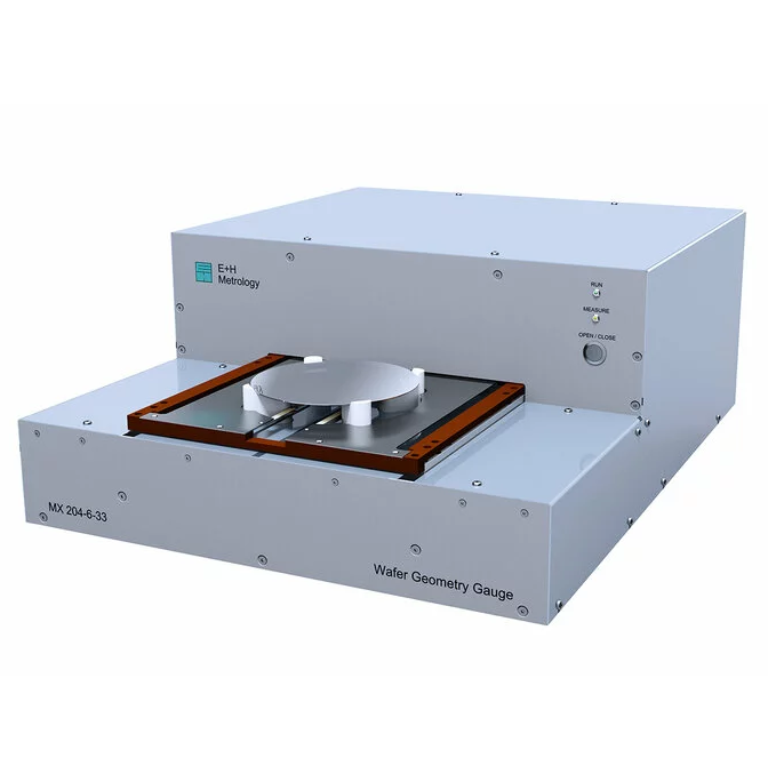
 400-860-5168转1545
400-860-5168转1545
 留言咨询
留言咨询






[font=&]请教各位老师,电线电缆的绝缘厚度为什么要求第一次测量要从最薄处进行?投影仪下确定好含最薄点的6个点位之后,跟第一次测哪个点的顺序有关吗?GB 2951.11-2008的标准中对绝缘和护套厚度的测量要求为什么特意进行了区分?8.2.4条款里面,护套的厚度测试要求就是“在任何情况下,应有一次测量在护套最薄处进行”,8.1.4条款里面,绝缘的厚度测量要求就是“在任何情况下,第一次测量应在绝缘最薄处进行”。谢谢!PS:在其它板块发了没有老师回复,所以在这里也求助一下,如果有熟悉线缆测试的老师麻烦指点指点,谢谢![/font]
请问在电镜中,或是用其他什么办法可以测量金属透射样品观察区域的厚度吗?如果不是区域的,有什么好的办法测量平均厚度(可观察区域的)的吗?万分感谢

我不是很清楚哪个版块有技术可以解决这个问题,估计电镜也许可以,所以先发在这个版块,要是有其他版块有此项技术请告知一下,我再转发。谢谢!我们需要测量的金膜是溅射在玻璃基片上的。玻璃基片约0.5mm厚,大小约1cm*1cm。基片上有一层很薄很薄的铬,完全可以忽略,金膜溅射在铬上的,厚度约50nm左右,我们想比较准确测量一下其厚度,误差 1-3nm以内吧。误差5-10nm左右呢???示意图如下[img]http://ng1.17img.cn/bbsfiles/images/2009/03/200903231024_140067_1613111_3.jpg[/img]


