









比利时微电子研究中心 imec 当地时间昨日宣布,在其与 ASML 合作的 High NA EUV 光刻实验室首次成功利用 High NA EUV 光刻机曝光了逻辑和 DRAM 的图案结构。
在逻辑图案方面,imec 成功图案化了单次曝光随机逻辑机构,实现了 9.5nm 密集金属线(注:对应 19nm Pitch),将端到端间距尺寸降低至 20nm 以下。
不仅如此,imec 实现了中心间距 30nm 的随机通孔,展现了出色的图案保真度和临界尺寸一致性。
此外,imec 通过 High NA EUV 光刻机构建了 P22nm 间距的二维特征,显示了新一代光刻技术在二维布线方面的潜力。
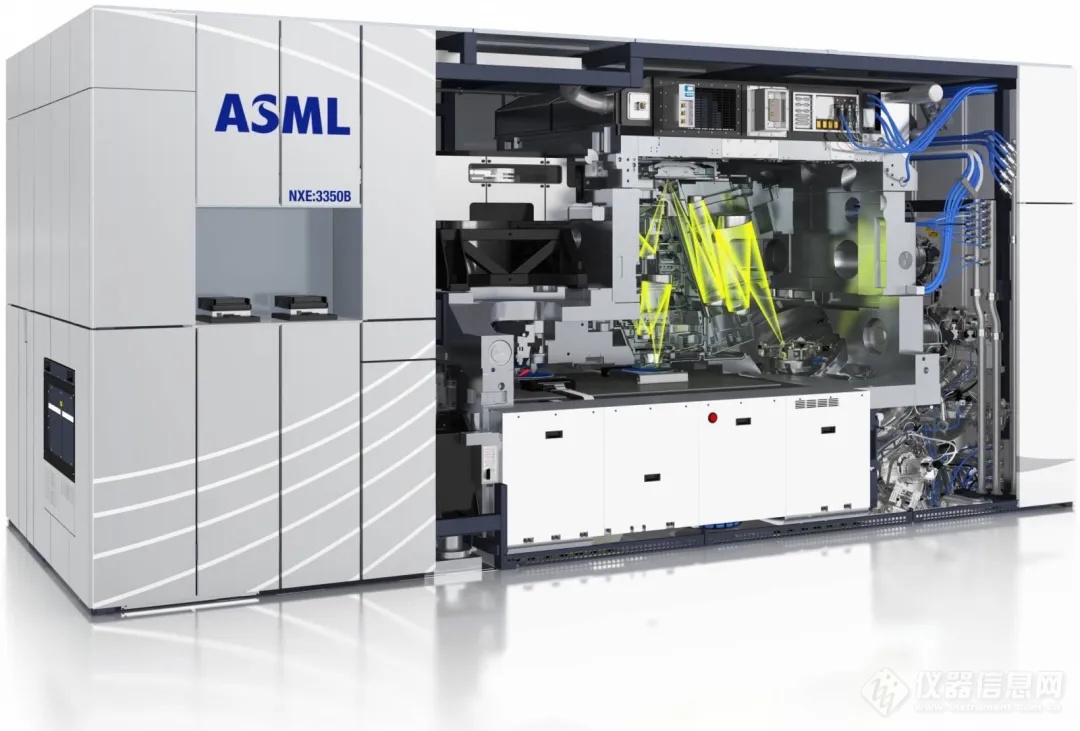
而在 DRAM 领域,imec 成功利用单次曝光图案化了集成 SNLP(Storage Node Landing Pad)和位线外围的 DRAM 设计,展现了 High NA EUV 减少曝光次数的能力。
imec 总裁兼首席执行官 Luc Van den hove 表示,这些结果证实了 High NA EUV 光刻技术长期以来所预测的分辨率能力,一次曝光即可实现 20nm 以下间距的金属层。因此 High NA EUV 将对逻辑和存储器技术的尺寸扩展起到重要作用,而这正是将路线图推向 "埃米时代" 的关键支柱之一。
[来源:微电子制造]
 台积电1.4nm工厂,曝光
台积电1.4nm工厂,曝光 东京电子中国营收占比升至50%!
东京电子中国营收占比升至50%!
新品发布!普源精电DHO5000 系列与DG5000 Pro系列重磅登场
2024.08.09

先锋精科冲击科创板IPO:深耕半导体设备零部件领域 抢占行业高难度领域市场份额
2024.08.12

2024.08.12
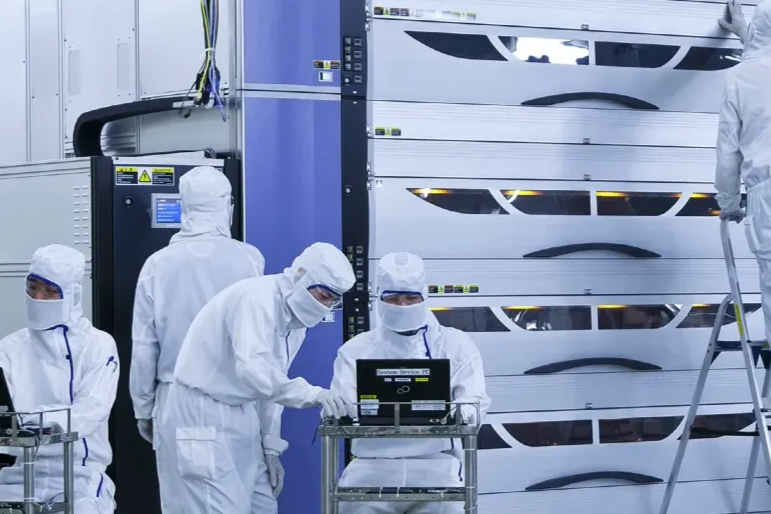
2024.08.12

半导体设备业务收入暴跌 劲拓股份上半年营收同比下降17.91%
2024.08.12

2024.08.09
版权与免责声明:
① 凡本网注明"来源:仪器信息网"的所有作品,版权均属于仪器信息网,未经本网授权不得转载、摘编或利用其它方式使用。已获本网授权的作品,应在授权范围内使用,并注明"来源:仪器信息网"。违者本网将追究相关法律责任。
② 本网凡注明"来源:xxx(非本网)"的作品,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,且不承担此类作品侵权行为的直接责任及连带责任。如其他媒体、网站或个人从本网下载使用,必须保留本网注明的"稿件来源",并自负版权等法律责任。
③ 如涉及作品内容、版权等问题,请在作品发表之日起两周内与本网联系,否则视为默认仪器信息网有权转载。
![]() 谢谢您的赞赏,您的鼓励是我前进的动力~
谢谢您的赞赏,您的鼓励是我前进的动力~
打赏失败了~
评论成功+4积分
评论成功,积分获取达到限制
![]() 投票成功~
投票成功~
投票失败了~