









天眼查显示,广东天域半导体股份有限公司“碳化硅外延片的生长工艺”专利公布,申请公布日为2024年6月28日,申请公布号为CN118256991A。
背景技术
碳化硅半导体具有优良的稳定性、高热导率、高临界击穿场强、高饱和电子漂移速度等优良特性,是制作高温、高频、大功率和强辐射电力电子器件的理想半导体材料。与传统的硅器件相比,碳化硅器件能够在10倍于硅器件的电场强度下正常工作。用于制作碳化硅器件的碳化硅材料通常是在碳化硅衬底上生长碳化硅外延片。
目前的碳化硅外延片,尤其是8英尺的碳化硅衬底,其晶体缺陷密度高,碳化硅衬底的长晶技术并不成熟,尤其是一些TSD、BPD、SF等缺陷会贯穿上来,所以需要有非常高的外延生长技术将其在外延层初期抑制住。而目前外延生长技术较为单一,主要为单一外延生长技术沉积,当前比较普遍的是采用化学气相沉积(CVD)生长外延片。现有化学气相沉积(CVD)外延生长是在碳化硅衬底上生长一层SiC外延层,以高纯H2作为输运和还原气体、TCS和C2H4为生长源(即为H2+SiH4+C2H4)、N2作为N型外延层的掺杂源、Ar作为保护气体。其工艺的主要生长环境要求1500℃以上高温,反应室内气压低于1×10-6mbar,并且水平式单片生长因其均匀性问题需要气悬浮基座旋转。于碳化硅衬底上直接采用化学气相沉积外延无法生长出高质量的、组分和杂质浓度更精确控制的单晶薄膜,并且会有残余气体对碳化硅薄膜有污染,导致衬底贯穿上来的晶体缺陷无法有效抑制,并且生长速率偏向快速,无法更精准的控制薄膜沉积。
由上可知,目前的化学气相沉积外延层仍然存在各种缺陷,其会对碳化硅器件特性造成影响,所以针对碳化硅的外延生长工艺需要进行不断的优化。
发明内容
本发明提供了一种碳化硅外延片的生长工艺。此碳化硅外延片的生长工艺包括依次的如下步骤:(I)将碳化硅衬底进行前处理;(II)采用分子束外延设备于所述碳化硅衬底上形成第一碳化硅缓冲层;(III)置于化学气相沉积设备的外延炉中,先于1000~1400℃下进行热处理,再升高温度进行气相沉积以于所述第一碳化硅缓冲层上形成第二碳化硅缓冲层;(IV)于所述第二碳化硅缓冲层上外延生长出预定厚度的外延层。本发明的碳化硅外延片的生长工艺可消除反应产物污染,在衬底与外延层间做好贯穿晶体缺陷的转化,可完美的隔离外延缺陷。
[来源:仪器信息网] 未经授权不得转载

共250个项目!2023年度国家科学技术奖获奖项目名单揭晓(附全名单)
2024.06.24

2024.07.19
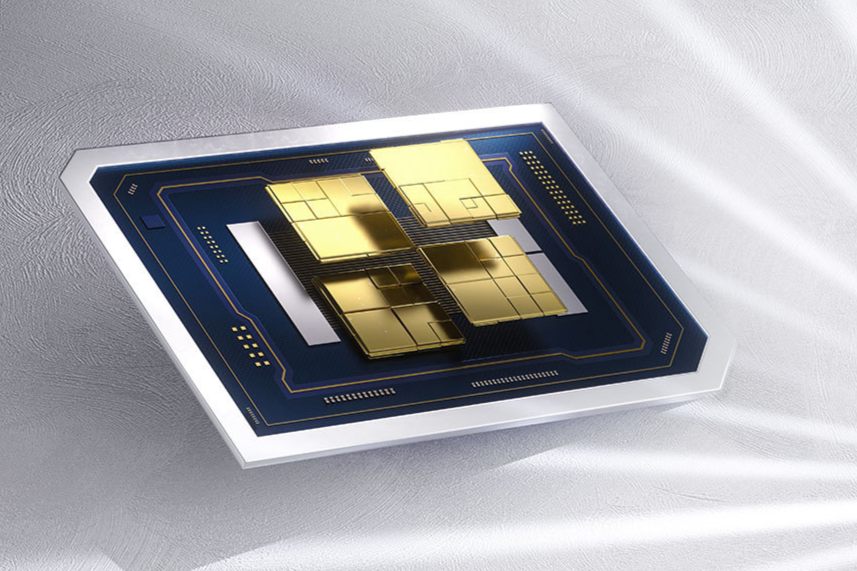
2024.07.08
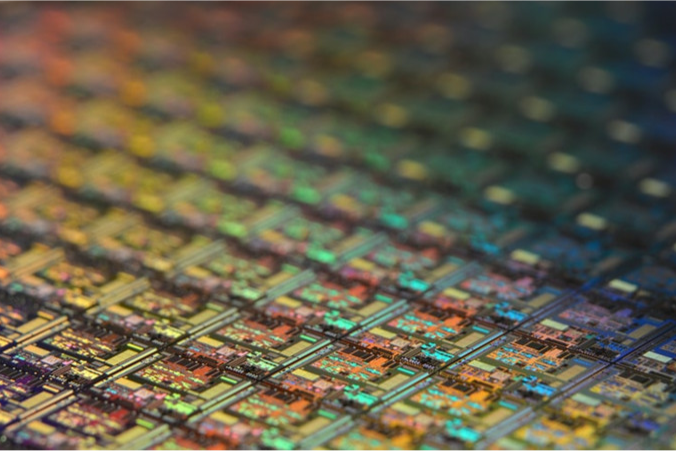
2024.07.08

2024.07.08

2024.07.04
版权与免责声明:
① 凡本网注明"来源:仪器信息网"的所有作品,版权均属于仪器信息网,未经本网授权不得转载、摘编或利用其它方式使用。已获本网授权的作品,应在授权范围内使用,并注明"来源:仪器信息网"。违者本网将追究相关法律责任。
② 本网凡注明"来源:xxx(非本网)"的作品,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,且不承担此类作品侵权行为的直接责任及连带责任。如其他媒体、网站或个人从本网下载使用,必须保留本网注明的"稿件来源",并自负版权等法律责任。
③ 如涉及作品内容、版权等问题,请在作品发表之日起两周内与本网联系,否则视为默认仪器信息网有权转载。
![]() 谢谢您的赞赏,您的鼓励是我前进的动力~
谢谢您的赞赏,您的鼓励是我前进的动力~
打赏失败了~
评论成功+4积分
评论成功,积分获取达到限制
![]() 投票成功~
投票成功~
投票失败了~