









7月3日消息,据韩国媒体ETNews的报导,韩国三星电子正在通过旗下先进封装(AVP)部门开发下一代半导体封装技术,被称之为“3.3D先进封装技术”,以替代昂贵的“硅中介层”。目标是应用在AI芯片上,计划于2026年第二季正式量产。
AI芯片通常在中央有一个负责计算的逻辑芯片,例如图形处理单元(GPU)或神经网络处理单元(NPU),并整合了高带宽內存(HBM)。而为了通过水平连接逻辑芯片和HBM,在半导体和主板之间应用了硅中介层,这就是市场所说的2.5D先进封装。而在这2.5D先进封装当中,硅中介层发挥了连接不同特性异质半导体的作用。但由于其价格昂贵且加工困难,是导致先进封装价格上涨的因素。
三星目前正在开发通过安装“铜再分配(RDL)中介层”,而非硅中介层来连接逻辑和HBM的技术。据了解,使用RDL中介层代替硅中介层,可以将材料价格降低到1/10,仅在必要的零组件中使用到硅,可以最大限度的减少芯片性能下降。另外,三星也同时进行3D堆叠技术的发展,将逻辑芯片堆叠在运算所需的高速站存內存(LLC)之上。对此,三星将其命名为3.3D封装,意思是通过3D堆叠逻辑芯片后,进一步连接HBM。
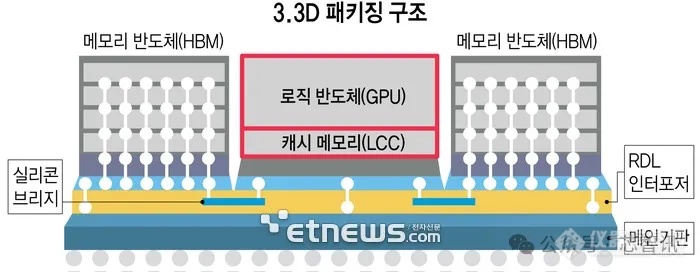
报道强调,这种尝试被解读为通过降低先进封装的价格来吸引更多客户下单。三星认为,如果将新技术商业化,与现有基于硅中介层的先进封装技术相比,将能够在不降低性能的情况下,进一步降低22%的生产成本。未来通过价格竞争力和生产力将提升,预计这将有利于获得半导体代工制造的订单。
报导进一步指出,三星还将借助通过导入面板级封装(PLP)技术进行3.3D封装。PLP是通过将芯片封装在方形面板,而不是圆形晶圆中,可以进一步提高芯片的产能。目前,三星被认为是较台积电更早进行PLP技术研发的企业。
一位韩国半导体封装产业人士表示,“只有当我们提供人工智能等先进芯片客户所需的价格和性能,并成功抢占产能是暂时,我们才能在市场上获得领先优势。”
[来源:芯智讯]

2024.07.03

2024.08.09

2024.08.09

2024.08.07

2024年全球DRAM收入将增长88%,NAND收入将增长74%
2024.08.07

2024.08.07
版权与免责声明:
① 凡本网注明"来源:仪器信息网"的所有作品,版权均属于仪器信息网,未经本网授权不得转载、摘编或利用其它方式使用。已获本网授权的作品,应在授权范围内使用,并注明"来源:仪器信息网"。违者本网将追究相关法律责任。
② 本网凡注明"来源:xxx(非本网)"的作品,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,且不承担此类作品侵权行为的直接责任及连带责任。如其他媒体、网站或个人从本网下载使用,必须保留本网注明的"稿件来源",并自负版权等法律责任。
③ 如涉及作品内容、版权等问题,请在作品发表之日起两周内与本网联系,否则视为默认仪器信息网有权转载。
![]() 谢谢您的赞赏,您的鼓励是我前进的动力~
谢谢您的赞赏,您的鼓励是我前进的动力~
打赏失败了~
评论成功+4积分
评论成功,积分获取达到限制
![]() 投票成功~
投票成功~
投票失败了~