应用分享 | 异形器件的失效分析测试方案之原位XPS+AES
2024/08/21 14:07
阅读:1
分享:方案摘要:
产品配置单:
PHI X射线光电子能谱仪
型号: PHI GENESIS 500
产地: 日本
品牌: ULVAC-PHI
面议
参考报价
联系电话
方案详情:
失效分析(Failure Analysis)是探究元器件失效根源的重要手段,旨在为元器件设计、工艺、制造等流程提供改进方向,从而提升产品良率和可靠性。在失效分析中,经常遇到异形器件,其不规则的形状与多元组件构成的特征尤为明显,直接影响着产品的性能。值得注意的是,特征尺寸在微米/亚微米级别的异形器件的表征往往存在着诸多挑战。
一方面,受限于传统分析设备的空间分辨能力,元器件微小特征的微区分析会遇到难以准确定位和准确分析的障碍,直接影响了测试结果的准确性。对此,PHI创新性推出了扫描微聚焦型XPS技术,该技术凭借小束斑X射线的扫描能力,不只实现了小束斑X-ray对微区准确分析,还通过微聚焦的X射线扫描样品表面激发二次电子成像(Scanning X-Ray induced secondary electron imaging,SXI),直观呈现类似SEM的样品表面形貌特征,实现准确导航和定位。此外, PHI XPS—GENESIS作为全新一代的产品,还可选配扫描俄歇(SAM)配件,集成了高空间分辨的SEM成像以及AES元素成像能力,实现了原位XPS+AES的一体化分析,彻底解决了微区表征中导航难、定位难、准直分析难的痛点。
另一方面,异形器件结构特殊、形状复杂,如凹槽型、L型半导体场效应晶体管,在横向和纵向上均存在明显差异。因此,全方面的、有效的分析策略,不只需要解决器件的形貌和组分在二维分布上的难题,还要解决异形件组分在深度分布的难题。原位XPS+AES技术可以有效解决二维分布难题,而微区深度分析则存在一定难度。XPS深度分析,需结合离子溅射技术,将样品层层剥离,通过“采谱-刻蚀-采谱”的方式获取组分的深度分布。然而,离子束的刻蚀面积通常较大,一般的XPS设备单次深度分析只能获取一个位点的深度曲线局限,意味着只能对单一特征区域进行表征,难以满足同时对于拥有多个、毗邻的微区特征样品的深度分析需求。对此,PHI扫描微聚焦型XPS可以在一次刻蚀过程中同时采集FOV内多个微区的XPS谱图,从而同时生成多条深度曲线。
接下来,让我们一起见证PHI GENESIS,如何通过原位XPS+AES分析策略,实现对异形半导体器件的失效分析:
样品信息
样品:SiO2/Si基底上的缺陷Au电极(完好区域:OK;缺陷区域:NG)
特征:异形件,俯视:存在多个毗邻的特征区域;剖面:各组件以嵌入式结合,且高低不平
尺寸:特征区域(①和②)的大的尺寸均在50微米以内,如图1所示
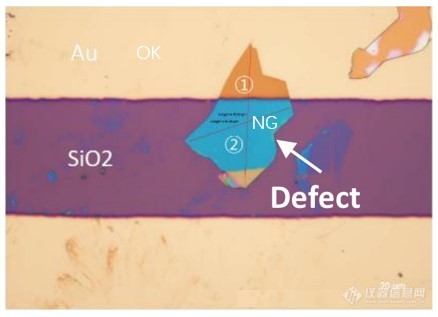
图1. SiO2/Si基板上的缺陷Au电极光学照片。
失效分析需求
目的:分析器件失效的原因
要求:1. 识别NG区域缺陷/污染物的组分;
2. OK和NG区域形貌和组分的二维分布;
3. 表征该器件的层结构。
面临的挑战
挑战一:NG区域并非只限于表面,实为嵌入式不规则块体,需进行表面+深度分析。
挑战二:在横向,NG存在两个毗邻的、尺寸均在数十微米的特征区域,表面微区分析时难以准确定位。
挑战三:在纵向,该异形件不同区域深度上组分差异明显,层结构表征中不能只靠传统的XPS深剖,还需实现深度方向上的微区分析。
分析方案
a. SXI导航和定位:采集样品表面的SXI影像,通过SXI准确定位OK和NG区域,并建立测试点;
b. 微区XPS:利用小束斑(10 um)采集OK和NG测试区的XPS全谱和精细谱,获取污染物的组分和化学态,以分析污染物的来源;
c. XPS Mapping:通过SXI定义面分析区域,采集表面的元素XPS Mapping,以获取污染物在表面的二维分布;
d. AES Mapping:借助高空间分辨的SAM配件,原位采集样品表面的SEM图像,以及元素的AES Mapping;
e. 多点同时深度分析:通过SXI定义多个测试点,再利用氩设备进行刻蚀,同时获取多个测试点各自的深度曲线。
表面分析结果
如图2所示,SXI展示了样品表面的微观形貌,准确定位到尺寸约为50 um的NG区域。进一步地,利用微区XPS采集全谱和精细谱,表明缺陷区域外源物主要为BN。值得注意的是,尽管NG区域紧邻SiO2/Si基底,但是全谱中并未检测到Si元素,表明XPS的信号完全聚焦于NG区域,做到了对微区的准确定位和分析。此外, XPS Mapping直观地展示了表面B、Au和Si元素的二维分布,成功地获取了污染物的表面具体分布情况。

图2. XPS微区分析:缺陷区域的SXI准确定位,准确组分分析和元素XPS mapping。
利用XPS仪器的SAM扫描俄歇配件,进一步对该样品进行原位AES表征,其结果如图3所示。SEM展现出比SXI更高的空间分辨能力,使得样品表面的微观形貌更加清晰明了。在AES mapping视角下,B、Au和Si的分布情况与先前XPS Mapping一致,缺陷内在BN含量较少的区域,存在富C区,二者的分布呈现互补。测试结果充分体现了二者对于微小特征组分的表征能力。
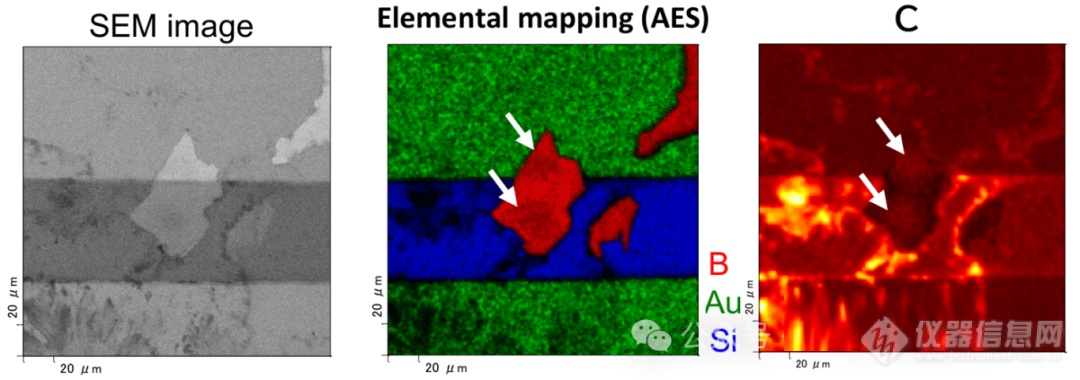
图3. SAM(扫描俄歇)分析:缺陷区域的SEM图像和元素AES mapping
深度分析结果
通过SXI分别在缺陷(NG)、Au电极(OK)以及Si基底上定义了3个测试点,结合Ar+进行XPS深度分析。结果如图4所示,PHI扫描型XPS可在微区内快速往复扫描,同时采集这3个测试点的XPS谱图,从而同时生成3个深剖曲线,直接展示了该异形件在深度方向上的组分分布情况。由此,成功绘制出该异形样品的层结构模型。
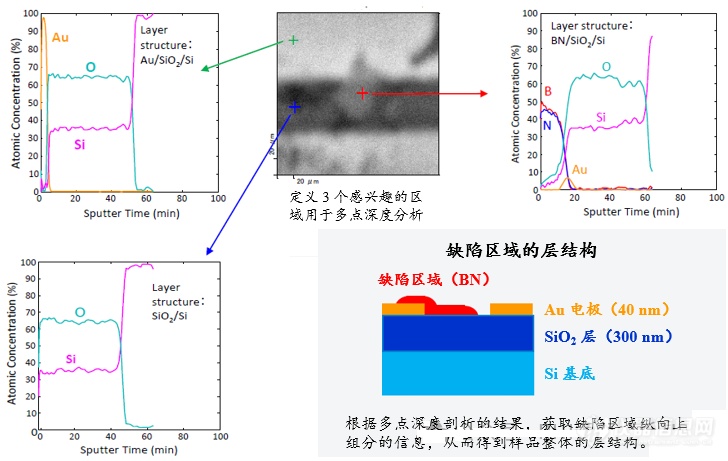
图4. XPS多点同时深度分析:多方位获取异形器件的多层结构模型。
PHI XPS以其微区XPS分析能力为基础,再结合SAM功能配件,铸就了一款功能强大与完备于一体的表面分析工具。这一组合尤其是在应对微小特征和结构复杂异形器件的失效分析上,可实现对微区特征的准确定位和可靠的分析,展现出无可比拟的优势和不可替代性。
-转载于《PHI表面分析 UPN》公众号
下载本篇解决方案:
更多![]()
应用分享 | 固态电池中电解质/金属锂界面的XPS-HAXPES表征
以立方石榴石型Li7La3Zr2O12 (LLZO)作为固态电解质的固态电池(SSB),具有高锂离子电导率、低电子导电率(EC)、高机械和热稳定性以及宽电化学窗口等特点,有望成为推动下一代储能技术腾飞的“种子选手”。
半导体
2024/08/21
应用分享 | Bruker SkyScan XRM 在电池与清洁能源领域的应用
随着全球对清洁能源需求的日益增长,电池技术的进步成为推动这一转变的关键因素之一。Bruker SkyScan X射线显微镜(XRM)因其在非破坏性高分辨率成像方面的优异表现,正在电池材料研发与质量控制中扮演着日益重要的角色。
半导体
2024/08/21
晶体日记(十六):APEX4 -从“数据库”里寻找答案
晶体学有时会让人觉得很神奇,透过一个晶体,我们可以看到微观的结构细节。但是晶体在肉眼下就只是晶体,没有X射线我们就只能看着它,可能对它无从下手。而且晶体结构解析需要有一些已知的信息,不然我们就没有办法知道这里面会有什么。
材料
2024/08/21
晶体日记 (十四)- 真实的数据质量(1)
晶体数据很清晰的显示的原子的位置,在Checkcif里却认为是有问题的Alert。如果是修,自然是可以修掉的,但是作为一个晶体学工作者的尊严,为了修而修,这不是科学,就成了画画了。
材料
2024/08/14












