四极杆气体分析仪的选型方法?
现代气相工艺的污染控制要求不断推动四极气体分析仪的性能极限。四极子技术正在迅速发展,并适应较低污染水平的规格。在选择特定应用的传感器时,充分了解影响目前不同气体分析系统的检测能力的各种因素是一个必要的工具。与通常的情况一样,大多数选择都涉及到妥协,而充分了解与不同检测器配置相关的基本权衡将使错误最小化并最大化生产力。
所有的气相处理装置都可以受益于添加一个四极气体分析仪。由匹配良好的探测器提供的信息迅速成为该过程中不可分割的组成部分,大大减少了传统上属于大多数真空故障排除程序的估算测量。随着四极杆气体分析仪变得越来越便宜,它们正迅速在所有需要严格控制工艺气体污染水平的行业中变得普遍。智能软件界面、较低的检测限制和较低的拥有成本是现代仪器中需要寻找的一些功能。
本文的以下部分描述了开放和封闭离子源四极杆质谱仪的性能规范。这些信息的主要目的是介绍为任何气相应用选择正确的分析仪所需的基本概念,并提出一些必须牢记的基本工作原理,以确保所选仪器的最佳性能。
残余气体分析仪析
典型的残余气体分析仪(RGA)有一个开放的离子源(OIS),并直接安装在一个真空室上,使整个传感器与真空系统的其余部分处于相同的压力下。较小的物理尺寸使得将 RGA 连接到几乎任何真空系统都成为可能,包括研究和工艺设置。最大工作压力为 10 -4 Torr。对于配备电子倍增器的装置,最小可检测分压(通常为 N 2 在 28amu 处测量)低至 10 -14 Torr。
在高真空应用中,如研究室、表面科学装置、加速器、航空航天室、扫描显微镜、放气室等,RGAs 被有效地用于监测真空质量,它们甚至可以很容易地检测到低压气体环境中最微小的杂质。痕量杂质可以测量到 10 -14 Torr 水平,在没有背景干扰的情况下,可以进行亚 ppm 的检测。在系统故障排除过程中,RGAs 也被用作非常灵敏的原位氦泄漏探测器。
在半导体行业中,RGA 最好用于蒸发器、溅射器、蚀刻器或任何其他高真空系统,这些系统通常被泵送到低于 10 -5 Torr。他们的主要应用是在任何晶圆投入生产之前检查真空密封的完整性和真空的质量。空气泄漏、虚拟泄漏和许多其他污染物在非常低的水平上很容易破坏晶圆,并且必须在工艺启动之前被检测到。随着半导体工艺变得更加复杂,它们对污染物的容忍度也变得越低。工艺室中的残余气体分析增加了正常运行时间和生产产量,并降低了拥有成本。
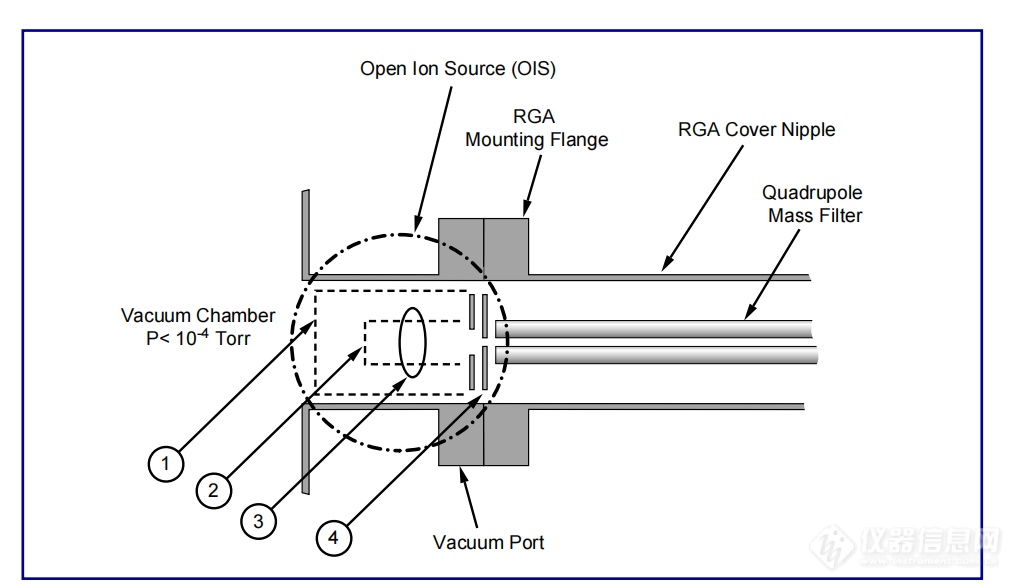
图 1:OIS 示意图
开放的离子源(OIS)
在大多数商用 RGAs 中使用的标准离子源是开放离子源(OIS)。这种电离器被认为是 RGA 的“全做”源。自 20 世纪 50 年代初以来,它就一直呈圆柱形,轴向对称的形式存在。通用的 OIS 设计原理图如图 1 所示。
OIS 渗透到工艺腔室中。灯丝和阳极电离网对周围的真空室“开放”。真空室中存在的所有分子都可以很容易地穿过离子源。电离器中的压力与周围真空的压力相同,也与四极杆质谱分析仪和离子探测器中的压力相同。OIS 对真空室中的所有气体分子都是“开放的”。只要总压力保持在 10 −4 Torr以下,它就可以用来监测和检测气体水平的变化。由于离子之间的空间电荷排斥力,较高的压力会导致灵敏度的降低。
OIS 的性能限制
OIS RGAs 在不影响真空环境气体成分的情况下测量残留气体水平。然而,必须记住一些潜在的问题,特别是当传感器被常规用于监测微量杂质(ppm 和亚 ppm 水平)或超高真空(UHV,<10 -9 Torr)环境时。
下面列出了 OIS RGA 对其背景信号的不同贡献方式,从而影响了传感器的检测能力。在适用的情况下描述最小化这些问题的方法。
除气
OIS 是一种热阴极离子源。灯丝(阴极)必须加热到高温(>1300°C),以建立电子发射电流。在高真空中,加热灯丝所需的大部分能量通过辐射过程耗散到周围环境中。因此,整个电离器和相邻的真空壁面“发热”。升高的温度导致 OIS 本身和来自相邻的腔壁的排气增加。排气释放的气体可以降低许多重要物种的 OIS RGA 的最小可检测分压(MDPP),包括 H 2 、H2 O、N 2 、CO 和二氧化碳。
从热阴极计上排气对高真空用户来说并不是一个新问题。它也存在于贝亚德-阿尔伯特电离仪中,这种电离计在过去 50 年里真空室中一直很常见。在大多数情况下,排气只会影响被测量的气体混合物的组成。然而,在某些情况下,放气可能是一个严重的问题,甚至会影响实验或过程的结果。排气电离器可以帮助最小化一些背景信号;然而,这通常只是一个临时的解决方案。
一些 RGA 供应商提供其 OIS 的 UHV 版本,其阳极(有时是整个电离器组件)由铂包层钼线制成。这种高度惰性的材料对许多气体的吸附量降低,并减少了出气和 ESD。
水气是一种常见的干扰,尤其重要,因为它是许多高真空工艺的严重污染源。在超过 200°C 的长期烘烤是减少 OIS RGA 中水气的最佳选择。
在 OIS 电极排出的 H 2 气体可能会让 UHV 状态下的用户担心,在 UHV 状态下,残留的氢通常占总气体混合物成分的 95 %。H 2 溶解在大多数 300 系列不锈钢中,很容易从热 OIS 电极排出。OIS 对 H 2 背景的贡献取决于其组成,使用铂包覆盖件可以显著减少。在所有情况下,随着气体从电极中耗尽,影响会随着时间的推移而减弱。
电子激发解吸(ESD)
即使在 RGA 被彻底烘烤后,也经常在 12、16、19 和 35 amu 处观察到峰,这是由 OIS 内部表面的 ESD 形成的,而不是由气体物质的电子冲击电离形成的。ESD 对 RGA 性能的影响类似于排气。
我们可以采取以下几个步骤来最小化其影响:
*高电子能量脱气——通常是商业仪器的一种选择
*镀金离子器——可以减少许多气体的吸附,从而降低了 ESD 效应。使用铂包层覆盖的钼离子器也是一种替代选择。
*减少了电子束的范围。
*减少 OIS 的表面积——使用金属丝网代替固体穿孔金属
*避免将离子发生器暴露在氯和氟化合物中。
背景干扰
与电离器相比,四极质量过滤器组件具有较大的表面积,即使在运行过程中不像电离器那么热,它仍然可以排气。OIS 和传感器都暴露在相同的真空环境中,这使得电离器对四极杆组件的其余部分排出的杂质非常敏感。对于许多 RGA 用户(特别是在 UHV 范围内)来说,一个严重的问题是水从未烘焙的 RGA 中排气。然而,许多其他物质也会影响背景读数。例如,如果传感器最近暴露在大量的气体中(因为它往往被吸附在 SS 表面和解吸只是非常缓慢),可以预期高 Ar 背景。
电离发生器对在热灯丝中产生的杂质也很敏感。气体分子在灯丝表面会发生热裂解和化学反应,反应的产物很容易进入电离区。以这种方式产生的杂质通常是离子发生器表面污染的一个重要来源,并对 RGA 的长期稳定性有严重影响。例如,CO 和 CO 2 是由大多数热灯丝发出的,很容易进入电离器和真空系统。
定期烘烤是尽量减少这个问题的最有效的方法。在 200°C 烘烤通常可以解决大多数污染问题。如果问题仍然存在,则可能需要清洁和/或翻新四极杆传感器。
分压系统(PPR)
RGAs 并不局限于对压力低于 10 -4 Torr 时的气体的分析。借助分压泵、减压气体进口系统(PPR)可以对更高的气体压力进行采样,该系统包括分压泵和真空泵。常规的分压是针孔和毛细管,它们可以提供超过 6 个数量级的压力降低。真空泵通常由一个前级泵和涡轮分子泵组成。RGA、进气系统和泵站构成了通常称为分压系统(PPR)。这些气体取样系统在气相过程中很常见,可以从几个 RGA供应商那里获得。如果设计得当,PPRs 可以从头到尾监控流程,为每一步都提供必要的信息。
图 2 中描述的 PPR 系统是一个典型的减压装置的示例,用于将过程压力降低到 OIS RGA 可接受的水平。PPR 包含到 RGA 的两个入口路径:用于监测基础真空的高电导率路径(Hi-C),以及用于监测工作压力下的气体的低电导率路径(Lo-C)。
当真空系统的压力低于 10 −4 Torr 时,使用高电导率路径。在高真空条件下,典型的应用是进行泄漏测试和监测腔室的极限真空。例如,在溅射室中,该过程的第一阶段是泵至小于 10 −6 Torr。此时,RGA 可用于检查背景质量的泄漏和污染物。一旦真空质量令人满意,溅射腔室以几毫托回填氩气,并开始溅射。
当工艺室的压力超过 10 −4 Torr 时,使用低电导率路径。该路径包含一个微孔节流孔,可将压力降低数个量级到适合 RGA 的水平(通常在 10 −5 Torr 左右)。孔径可用于高达 10Torr 的工作压力。有时会使用一组节流孔(或一个可调节的计量阀)来调节减压系数,以适应整个过程中的不同压力。例如,在溅射过程中,Lo-C 路径可用于监测水蒸气和碳氢化合物的水平,以确保它们不会超过降低溅射膜质量的某些临界水平。
分子泵将气体通过节流孔输送到 RGA,形成压降。在这些系统中使用的泵通常是非常紧凑,无油和低维护。
对于高于 10 Torr 的压力,进入单级 PPR(如图 2 样品样侧所示)的气体流速变得非常小,响应时间变慢,无法做出任何实际的测量。在这种情况下,双级旁通抽气取样采样系统,具有更大的气体流速和更快的响应速度,是比单级 PPR 更好的选择。旁通抽气取样采样系统,具有取中压分析的方式,能够分析几个大气压的气体混合物,可从几个 RGA 供应商获得该系统。
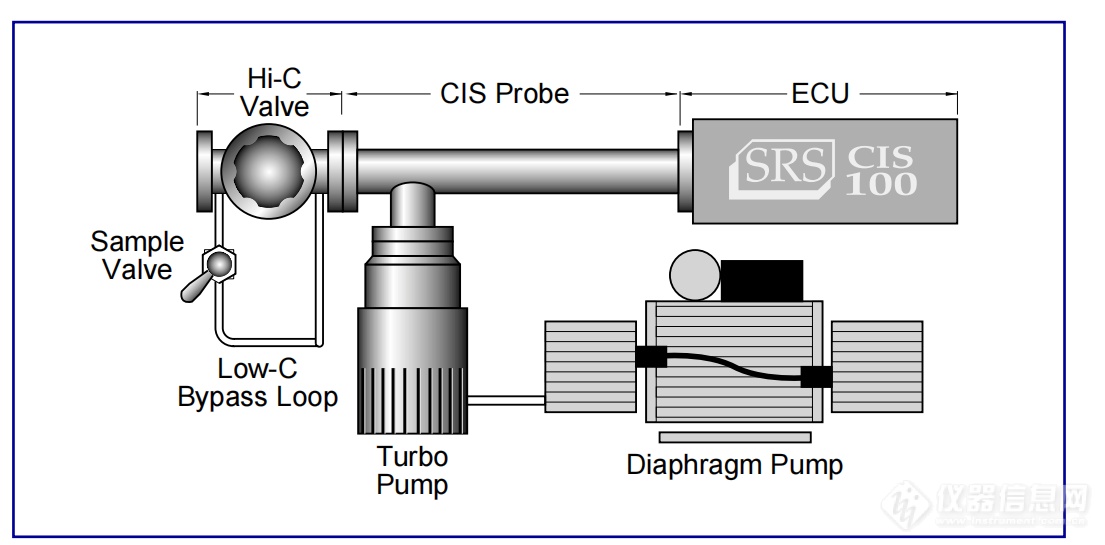
图 2:PPR 进口系统
PPR 系统的性能限制
PPR 在低于 10 Torr 压力下的可以很好的进行气体取样,它们提供的信息通常用于诊断和控制各种行业中的气相过程。随着价格的下跌和技术的发展,这些仪器正在不断地寻找新的应用领域。
大量的 PPR 系统专门用于检测气体混合物中的微量杂质。OIS RGAs 有足够的灵敏度和动态范围来检测百万分之一(ppm)级别的污染物。然而,来自过程气体的干扰和来自传感器本身的背景干扰使 PPR 在实践中很难检测到 ppm 级别的杂质。
背景干扰
分析仪腔室中存在的背景气体可以掩盖一些重要气体(H 2 、H 2 O、N 2 、CO 和 CO 2 )的 MDPPs。背景气体是由于排气、电子激发解吸和泵浦系统的有限压缩比。
为了最好地说明这一点,以 10 −2 TorrAr 溅射过程中的水的分析为例。在过程监测期间,质谱仪通常运行在约 10 −5 Torr 下,对应于 PPR 的 Lo-C 路径的降低了 3 个数量级。压降使工艺室中 1 ppm 的水达到质谱仪中的分压约 10 −11 Torr(完全在典型 RGA 的检测限范围内)。然而,由于质谱仪与工艺气体分离,PPR 室中的残余压力最多为 10 −9 Torr(其中大部分是水)。该水位比工艺室中 1 ppm 的水对应的 10 −11 Torr 大 100 倍,这意味着在这些“常见”的操作条件下,水蒸气浓度不能被可靠地检测或测量到 100 ppm 以上。
在分析过程中,将 RGA 室的工作压力提高到 5×10 −5 Torr ,MDPP 极限可以提高到 20 ppm。然而,在某些情况下,即使是 20 ppm 的 MDPP 限制也可能不够低。添加一个具有大泵送速度的低温泵,已被证明可以极大地减少 PPR 的四极室的水背景。然而,由于泵的高成本,这在实践中很少这样做。对于其他潜在的干扰气体,也必须记住同样的限制。为了在 ppm 水平检测到任何物种(10mTorr过程中 10 −8 Torr),PPR 的残余质谱必须在该物种的峰对应的质量值处显示小于 10 −11 Torr 的压力读数。在大多数真空系统中,除非采取必要的预防措施以尽量减少所有污染源,否则不容易达到这种水平。对于 50 amu 以下的质量,这个问题通常更为严重,因为在残余质谱中总是有背景峰。
尽管 RGA 本质上能够执行亚 ppm 的测量,但在 RGA 的残余质谱中找到背景处于 ppm 水平的位置并不总是容易。
PPR 中背景干扰的一个常见来源是传统油泵回流到 PPR 室的污染。切换到一个完全无油的泵站,就消除了这个问题。
空气的 MDPP 限值通常受到泵站的压缩比的限制。在大多数 PPR 系统中,N2 水平通常低于10 −9 Torr,氧水平大约低5倍。这相当于在10 mTorr过程中,N 2 @28amm的MDPP水平高于20ppm,O 2 @32amu 的 MDPP 水平高于 4 ppm。
氢气通常不可能在 ppm 的水平上检测到,因为它很容易从分析仪上排出,而且它不能被大多数涡轮泵有效地泵送。一些用于最小化 H 2 背景信号的技巧包括:使用 Pt 覆盖钼 OIS,以及增加一个特殊的泵站,增加氢的泵送速度。
工艺气体干扰
在一个典型的基于 OIS RGA 的 PPR 系统中,ppm 检测水平的另一个限制是由来自被分析的相同工艺气体的干扰造成的。
说明这一点的最好方法是回到 10 mTorr Ar 溅射过程中的水分析的例子。我们发现,检测超过20 ppm 水平的水是非常困难的,除非 PPR 室被非常小心地烘烤并免受水污染。然而,正如我们将看到的,这只是问题的一部分:在溅射系统中使用的 m/e 18 也有严重的干扰。同位素 36 Ar 的含量为 0.34 %。在电子电离过程中,形成双电荷氩,在 m/e 20( 40 Ar++)和 m/e 18( 36 Ar++)处产生峰。对于 70 eV 的电子冲击能量, 36 Ar ++ 的典型水平为 350 ppm。因此,如果你想在基于 Ar 的溅射系统中检测 ppm 的水,你必须解决两个问题:传感器排气的背景干扰和 36 Ar ++ 在 m/e 18 的干扰。
一个彻底的烘烤可以减少背景水对低几十 ppm 水平的贡献,但消除 36 Ar ++ 干扰需要使用几种技巧。一些制造商只是选择监测 m/e 17 峰值。对于 70 eV 的电离电子,这个峰在 18 amu 时比主峰小4 倍。这导致了对水的检测的灵敏度的显著降低。它还增加了丰度灵敏度的问题,同时试图测量质量 17 的强度旁边的一个大的 36 Ar ++ 峰在 18 amu。
一个更好的选择(也是推荐给具有可编程电离发生器电压的 RGAs 的选择)是在电子冲击能量降低到小于 40 eV 时操作电离发生器。这个电离能低于 Ar ++ 的外观势(43.5 eV)。例如,在操作35 eV 电子的 RGA 时,由于 Ar ++ ,质量为 18、19 和 20 的峰值消失,这是在 36、38 和 40 amu 的Ar + 检测灵敏度降低最小的情况下实现的。
不同的电子电离能通常用于选择性地电离气体混合物中的物质。从一般的质谱文献中可以很容易地得到许多不同气体的电离势表。电子能量的减少通常会给灯丝带来额外的工作负荷,并可能减少其寿命。然而,减少的干扰效应抵消了灯丝更换的额外成本。
封闭离子源(CIS)
在需要测量 10 −4 和 10 −2 Torr 之间的压力的应用中,通过用封闭离子源(CIS)采样系统取代传统的 OIS PPR 配置,可以显著减少背景和工艺气体干扰的问题。一个通用的 CIS 设置的横截面如图 3 所示。
CIS 电离器位于四极质量滤波器的顶部,取代了传统 RGA 中更传统的 OIS。它由一个短的气密管组成,两个非常小的电子和离子的出口。电子通过一个小尺寸的入口狭缝进入电离区。离子在靠近一个提取板处形成并被吸引,并通过一个小直径的圆孔离开电离器。氧化铝环密封管从四极质量组件的其余部分,并为偏置电极提供电绝缘。离子是由电子在过程压力下的直接撞击产生的。与 PPR 系统中使用的泵送系统类似,使灯丝和四极组件的其余部分保持在压力在 10 −5 Torr 以下(20 个数量级的减压)。该设计非常简单,在被四极杆气相分析仪采用之前,已成功地应用于气相色谱质谱仪器多年。大多数商业上可用的 CIS 系统被设计为在 10 −2 和 10 −11 Torr 之间运行,并在10 −4 和 10 −2 Torr 之间的工艺压力的整个质量范围内提供 ppm 级的可检测性。
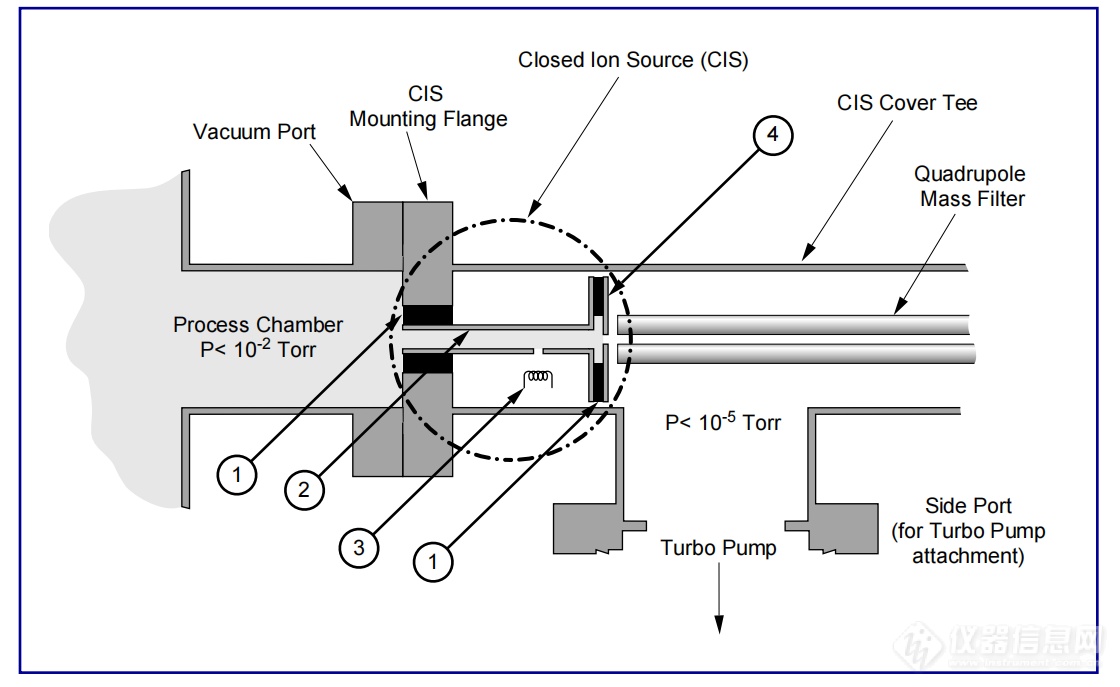
图 3:CIS 的原理图
PPR 和 CIS 系统之间的差异
在选择最适合特定工艺应用程序的传感器设置时,了解 CIS 设置和更传统的基于 OIS RGA 的PPR 之间的性能差异是必不可少的。工艺工程师在为其应用程序选择分析仪配置之前,应仔细权衡所有差异。
直接抽样
CIS 阳极可以看作是一个直接连接到工艺室的高电导管。电离区中的压力与工艺室中的压力基本相同。CIS 电离器在过程压力下直接通过电子冲击产生离子,而质谱分析仪的其余部分和灯丝保持在高真空条件下。直接采样提供了良好的灵敏度(由于可用的大离子密度)和快速的响应时间。“记忆效应”,通常与压力降低和电导孔有关,是显著减少的。此外,由于不同气体分子通过 PPR 孔径的分子量依赖性扩散系数而引起的分馏效应也不存在。
信号与背景比
由于 CIS 中的采样压力通常比传感器真空系统的其他部分高 20 倍,因此相对于 OIS PPR 系统,信号-背景比显著增加。在测量诸如水等常见的残留气体时,这一点尤为重要。为了说明这一点,我们回到 10 −2 TorrAr 溅射过程中的水测量例子。Ar 气体在 10 −2 Torr 处直接电离(比 OIS PPR 高出三个数量级!)但在相同的背景下(10 −9 Torr)的剩余水。这个剩余的水信号现在对应于 CIS 系统中水的100 ppb MDPP 水平。这是一个相当改进的 OIS PPR 性能!
直接取样和差分泵送的结合为即使是最普遍的残留气体提供了 ppm 和亚 ppm 检测极限的潜力。对于其他常见的干扰,如有机污染物或灯丝的反应副产品,源的气密设计降低了电离区域的可见性,这些气体提供一个非常干净的残留气体质谱,避免了 OIS PPR 设置中许多质谱重叠。
由 ESD 产生的污染物的干扰在 CIS 中也减少了,因为一个要小得多的电子束穿透电离网。此外,大多数市售的 CIS 的内壁都涂有高度惰性的材料,如金、铂包层和纯钼,它们比不锈钢吸附更少的杂质。
CIS 能够直接在 mTorr 范围内取样气体,并在其整个质量范围内提供 ppm 级检测,这使得 CIS系统成为半导体处理应用的首选仪器,如 PVD、CVD 和蚀刻。
离子发生器污染
在 OIS PPR 体系中,在灯丝上发生热裂化或化学反应的样品分子可以自由地漂移到电离区。这是电子冲击电离器的表面污染物的一个非常重要的来源。相比之下,CIS 的气密性设计降低了气体源对这些污染物气体的可见性,减少了污染和更好的长期稳定性。大多数 CIS 制造商在他们的系统中专门使用钨丝。W 可以抵抗许多腐蚀性气体(如 WF 6 )和活性气体(如硅烷),最大限度地减少在灯丝上的反应,也可以延长灯丝的寿命。
多用途
当与一个工艺适当匹配时,OIS PPR 和 CIS 系统都是非常通用的仪器,在整个气相过程中提供关键的信息。装有双路径气体入口的 PPR 系统,可以毫不费力地切换高\低电导率,从高灵敏度的RGA 操作模式切换到过程监测模式。
通过简单地改变一些传感器的电离参数。CIS 气体分析仪,即使不像 RGA 那样敏感,也可以处理工艺室中需要的大多数残余气体分析和泄漏检查测试。由于电子入口和离子出口的空穴非常小,CIS 的灵敏度降低。然而,在大多数情况下,在比 RGA 更高的增益水平上运行电子倍增器弥补了灵敏度的降低。典型 MDPP 值的 CIS 系统,配备了一个可选的电子倍增器,并在 RGA 模式下运行,是在 10 −11 Torr 左右。这比在 RGA 模式下打开 Hi-C 采样路径下操作的 PPRs 可以实现的 MDPP 值高出大约 20 倍。
CIS 电离器也可以重新配置,用于在线工艺监测和控制,并在使用点验证工艺气体的纯度。在残余气体分析过程中提高电子发射电流以提高灵敏度,在过程监测过程中降低电子发射电流,以避免在较高压力下电离体积中的空间电荷饱和效应。
CIS 的紧密设计使得在较低的电子电离能下操作电离器成为可能。大多数商用的 CIS 系统提供至少两个 70 和 35 eV 的电子能量设置。70 eV 设置主要用于泄漏测试和常规气体分析。收集到的质谱与用标准 RGA 获得的质谱几乎相同。在过程监测中使用 35 eV 设置,以消除过程气体干扰峰值。低能量模式的一个常见应用是消除双电离的 36 Ar ++ 峰,该峰干扰了溅射过程中 18 amu 处的水检测。具有用户可编程电离器电压的 CIS 系统提供了最高的通用性,因为它们可以被配置为通过仔细调整电子冲击能量来选择性地在气体混合物中的电离物质。
使用 CIS 气体分析仪进行高压采样
CIS 分析仪可以直接取样气体高达约 10 −2 Torr 压力水平。压力上限是由离子中性碰撞的平均自由程的减少来设定的,这种碰撞发生在较高的压力下,并导致离子的显著散射和灵敏度的降低。然而,操作并不局限于对压力低于 10 −2 Torr 时的气体进行分析。更高的气体压力可以通过分压进气系统(PPR)来取样,就像它用传统的 RGAs 所做的一样。一个与 CIS 分析仪的电导率相匹配的减压气体入口系统,将允许传感器采样高达 10 Torr 的气体压力。在 PPR 系统的情况下,所付出的代价是降低采样速度,在样品入口的气体混合物的分流,以及在电离器上可能产生的记忆效应。
对于压力大于 10 Torr 的情况,进入封闭电离器的气体流量变得非常小,而且时间响应对于任何实际测量来说都太慢。在这些情况下,一个旁路泵浦气体采样系统,具有更大的毛细管流速和更快的响应,是一个比单一的限制进入 CIS 电离器更好的选择。
结论
任何真空处理装置都可以受益于一个四极杆气体分析仪。要很好地了解影响目前不同的四极气体分析系统性能的不同因素,是为任何应用选择最佳传感器配置的重要工具。四极杆气体取样系统可以从几个不同的制造商获得,通常很难决定哪一个构成了一个工艺的最佳匹配。在大多数情况下,有不止一种方法来设置测量,而且每个选择都涉及到妥协。更好地理解可用选项之间的基本差异,可以使问题最小化,并使生产力最大化。
随着四极杆气体分析仪变得越来越便宜,它们将在所有需要严格控制过程气体污染水平的行业中成为普遍现象。
更多![]()
用户速递 | 浙大叶志镇院士团队: 减少钙钛矿中的氯缺陷实现高效蓝光LED
厂商
2024.08.05
拉曼光谱:精准量化微晶硅薄膜晶化率
厂商
2024.08.05
逐梦光电 | 来自北大、北化工、北交大、华科大、港理工、西交大、中科大、半导体所、纳米能源所、长春应
厂商
2024.07.31
飞秒时间分辨瞬态吸收光谱的突破性进展:西交大自研样机测试服务震撼来袭
厂商
2024.07.29








