推荐厂家
暂无
暂无
 留言咨询
留言咨询
 留言咨询
留言咨询
 400-860-5168转4180
400-860-5168转4180
 留言咨询
留言咨询

 400-860-5168转2205
400-860-5168转2205
 留言咨询
留言咨询

 400-860-5168转1374
400-860-5168转1374
 留言咨询
留言咨询

 400-860-5168转1374
400-860-5168转1374
 留言咨询
留言咨询
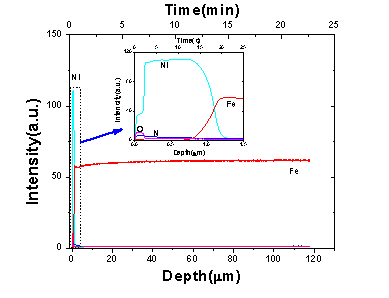
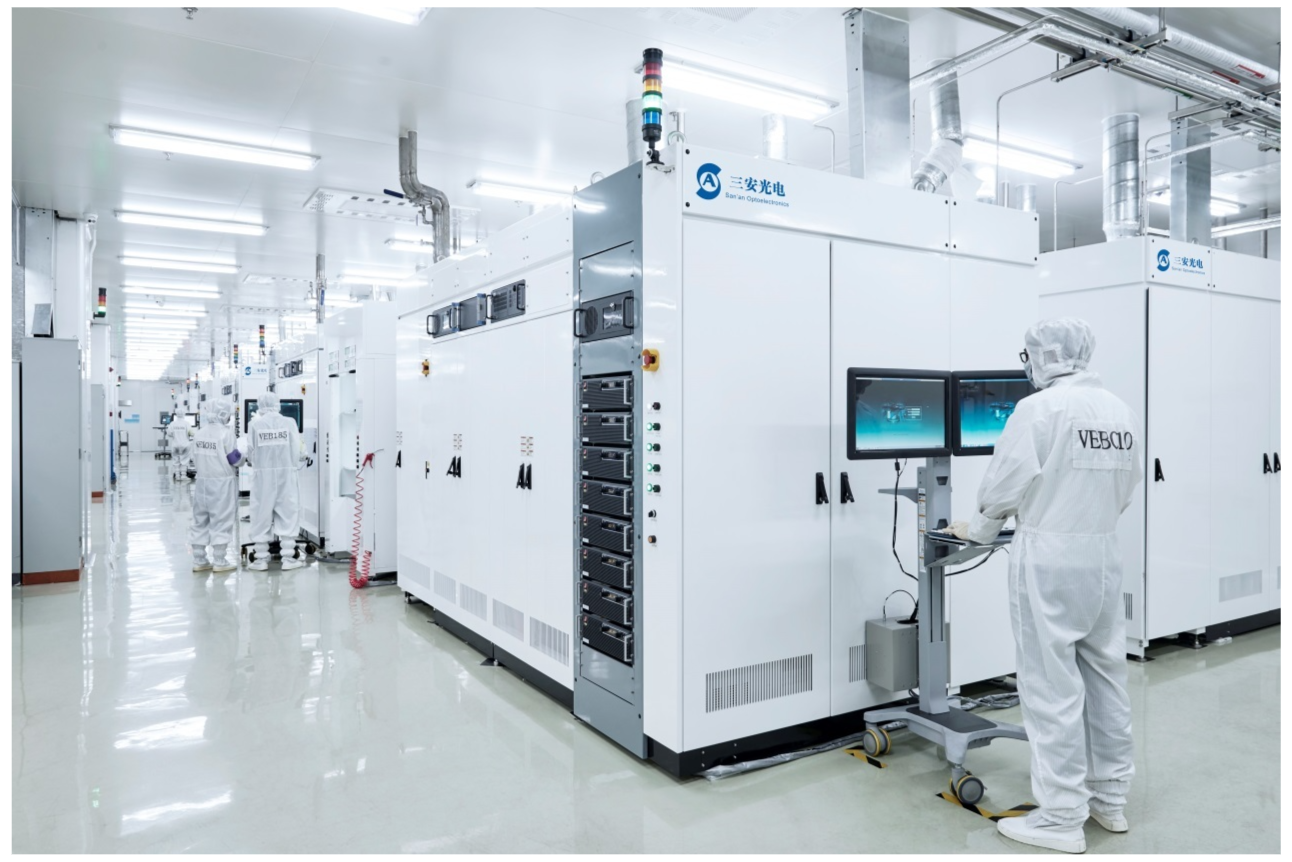




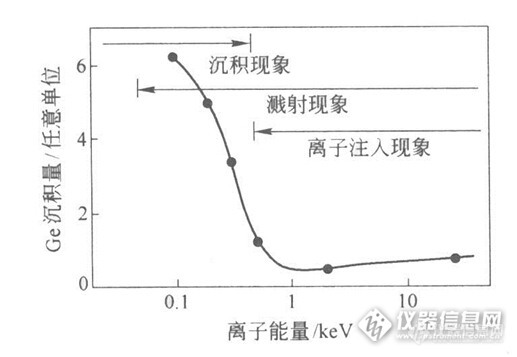
溅射制膜的过程:气体辉光放电、等离子体、靶、溅射、沉积到衬底(一)与蒸发法相比,溅射沉积的主要特点:①沉积原子能量高,因此薄膜的组织更致密,附着力也可以得到明显改善;②制备合金膜时,其成分的控制性能好;③靶材可以是极难熔的材料;④可利用反应溅射技术,从金属无素靶材制备化合物薄膜;⑤由于被沉积的原子均携带有一定的能量,因而有助于改善薄膜对于复杂形状表面的覆盖能力,降低薄膜表面的粗糙度。http://ng1.17img.cn/bbsfiles/images/2015/07/201507151100_555534_2989334_3.jpghttp://bbs.instrument.com.cn/xheditor/xheditor_skin/blank.gif(二)溅射沉积分类主要的溅射方式可以根据其特征分为四种:(1)直流溅射;(2)射频溅射;(3)磁控溅射;(4)反应溅射。http://ng1.17img.cn/bbsfiles/images/2015/07/201507151102_555536_2989334_3.jpg图1 不同溅射方法的靶电流密度和靶电压的比较http://bbs.instrument.com.cn/xheditor/xheditor_skin/blank.gif(1)直流溅射直流溅射又称为阴极溅射或二极溅射图2直流溅射沉积装置示意图,其典型的溅射条件为:工作气压10Pa,溅射电压3000V,靶电流密度0.5mA/cm2,薄膜的沉积速率低于0.1μm/min直流溅射过程中常用Ar作为工作气体。工作气压是一个重要参数,它对溅射速率以及薄膜的质量都有很大影响直流溅射设备的优点和缺点:优点:简单缺点:使用的气体压力高,溅射速率较低,这不利于减小气氛中的杂质对薄膜的污染以及溅射效率的提高。http://ng1.17img.cn/bbsfiles/images/2015/07/201507151105_555538_2989334_3.jpg图2直流溅射沉积装置示意图http://bbs.instrument.com.cn/xheditor/xheditor_skin/blank.gif(2 )射频溅射直流溅射要求靶材有较好的导电性,可以很大方便地沉积各类合金膜。对于导电性很差的非金属材料的溅射,我们需要一种新的溅射方法—射频溅射。射频溅射是适于各种金属和非金属材料的一种溅射沉积方法射频场对于靶材的自偏压效应。在衬底或薄膜本身是绝缘体的情况下,采取对其施加一个射频电压的方法,也可以起到对其施加负偏压的作用。(3)磁控溅射相对于蒸发沉积来说,一般的溅射沉积方法具有两个缺点。第一,溅射方法沉积薄膜的沉积速度较低;第二,溅射所需的工作气压较高 这两个缺点的综合效果是气体分子对薄膜产生污染的可能性较高。而磁控溅射技术:沉积速度较高,工作气体压力较低。工作原理:磁场对电弧运动有一定的约束作用(绕磁场螺旋前进);(1)电子的电离效率高,有效提高了靶电流密度和溅射效率,(2)较低气压下溅射原子被气体分子散射的几率较小(三)气体放电是离子溅射过程的基础(1)首先介绍直流电场作用下的物质的溅射现象预抽真空,充入适当压力的惰性气体,如Ar气,10-1~10Pa;在正负电极间外加电压的作用下,电极间的气体原子将被大量电离;Ar—→Ar++e,Ar+被电场加速后射向靶材,撞击出靶材原子(分子),靶材原子脱离靶时仍具有一定能量,飞向衬底,电子被电场加速飞向阳极;http://ng1.17img.cn/bbsfiles/images/2015/07/201507151107_555542_2989334_3.jpg图3直流气体放电体系模型及伏安特性曲线http://bbs.instrument.com.cn/xheditor/xheditor_skin/blank.gif电压进一步增大,发生极板两端电压突然降低,电流突然增大,并同时出现带有颜色的辉光,此过程称为气体的击穿;击穿后气体的发光放电称为辉光放电;这时电子和正离子是来源于电子的碰撞和正离子的轰击,即使自然游离源不存大,放电也将继续下去。而且维持辉光放电的电压较低,且不变,此时电流的增大显然与电压无关,而只与阴极板上产生辉光的表面积有关;正常辉光放电的电流密度与阴极材料和形状、气体种类和压强有关;由于正常辉光放电时的电流密度仍比较小,所以在溅射方面均是选择在非正常辉光放电区工作。http://ng1.17img.cn/bbsfiles/images/2015/07/201507151110_555543_2989334_3.jpg图4示意性地画出了在离子轰击条件下,固体表面可能发生的物理过程http://ng1.17img.cn/bbsfiles/images/2015/07/201507151111_555544_2989334_3.jpg图5所示,不同能量离子与固体表面相互作用的过程不同当离子入射到靶材上时,对于溅射过程来说,比较重要的过程有两个:其一是物质的溅射;其二是二次电子发射:二次发射电子在电场作用下获得能量,进而参与气体分子的碰撞,并维持气体的辉光放电过程。http://bbs.instrument.com.cn/xheditor/xheditor_skin/blank.gifhttp://bbs.instrument.com.cn/xheditor/xheditor_skin/blank.gif (四)合金的溅射和沉积用溅射法沉积合金膜,比蒸发法易于保证薄膜的化学配比;溅射过程中入射离子与靶材之间有很大的能量传递。因此,溅射出的原子将从溅射过程中获得很大的动能,其数值一般可以达到5~20eV;一方面,溅射原子具有很宽的能量分布范围,其平均能量约为10eV左右;另一方面,随着入射离子能量的增加,溅射离子的平均能量也有上升的趋势;溅射过程还会产生很少的溅射离子,它们具有比溅射出来的原子更高的能量。能量较低的溅射离子不易逃脱靶表面的鞘层电位的束缚,将被靶表面所俘获而不能脱离靶材;由蒸发法获得的原子动能一般只有0.1eV,两者相差两个数量级;在溅射沉积中,高能量的原子对于衬底的撞击一方面提高了原子自身在薄膜表面的扩散能力,另一方面也会引起衬底温度的升高。
富阳精密仪器厂电话:0571-63253615 传真:0571-63259015地址:浙江富阳新登南四葛溪南路26号 邮编:311404联系人:温先生电话:13968165189Email:manbbb@sina.com网址:www.jingmiyiqi.net 石英管式微波等离子体装置是我厂专门为大学和研究机构设计的小型化产品,可用于薄膜材料的制备和等离子体物理等方面的研究工作,并且特别适宜于大中专学校的材料、化学工程与工艺、物理等专业的学生实验。该装置利用微波能激励稀薄气体放电在石英管中产生稳态等离子体,通过通入不同的工作气体,可进行功能薄膜材料的制备、化学合成、表面刻蚀、等离子体诊断等多方面的实验。1 主要配置 1. 2.45GHz,0~500W微波功率连续可调,可满足不同实验的要求; 2. ф50mm的石英管真空室,带有一个观察窗和一个诊断窗口,保证各种实验方便进行; 3. 石英管采用水冷却,可保证装置在高功率条件下安全运行; 4. 配置了3路气体管路,气体流量控制方便; 真空测量系统及控制阀门可保证真空室所需的真空环境。2 典型实验 1. 等离子体化学[url=https://insevent.instrument.com.cn/t/Mp]气相[/url]沉积 A(气)+B(气)→ C(固)+D(气) 反应气体A、B被激发为等离子体状态, 其活性基团发生反应生成所需要的固态物沉积在基片上,可广泛用于薄膜或纳米材料的合成。如金刚石薄膜氮化碳薄膜、碳纳米材料等。 2. 等离子体表面刻蚀 A(气)+B(固)→ C(气) 反应气体A 被激发为等离子体状态与固体B表面原子发生反应生成气态物C,可用于集成电路的刻蚀实验。 3. 等离子体催化反应 利用等离子体中丰富的活性成分,如紫外和可见光子、电子、离子、自由基;高反应性的中性成分,如活性原子,受激原子态,从而引发在常规化学反应中不能或很难实现的化学反应。 4. 等离子体表面改性 A(气)+B(固)→ C(固) 反应气体A 被激发为等离子体状态与固体B表面发生反应生成新的化合物从而达到改变B物质表面性质的目的。可广泛用于高分子材料、金属材料及生物医用材料的表面改性实验。[em28] [em28] [em28] [em28]

关键词: 化学[url=https://insevent.instrument.com.cn/t/Mp]气相[/url]沉积 微波等离子体CVD法 微波等离子体热处理仪 金刚石薄膜 微波烧结 新材料 纳米催化剂 一、微波等离子体简介等离子体的研究是探索并揭示物质“第四态” ——等离子体状态下的性质特点和运行规律的一门学科。它是包含足够多的正负电荷数目近于相等的带电粒子的非凝聚系统。等离子体的研究主要分为高温等离子体和低温等离子体。高温等离子体中的粒子温度高达上千万以至上亿度,是为了使粒子有足够的能量相碰撞,达到核聚变反应。低温等离子体中的粒子温度也达上千乃至数万度,可使分子 (原子)离解、电离、化合等。可见低温等离子体温度并不低,所谓低温,仅是相对高温等离子体的高温而言。高温等离子体主要应用于能源领域的可控核聚变,低温等离子体则是应用于科学技术和工业的许多领域。高温等离子体的研究已有半个世纪的历程,现正接近聚变点火的目标;而低温等离子体的研究与应用,只是在近年来才显示出强大的生命力,并正处于蓬勃的发展时期。微波等离子体化学[url=https://insevent.instrument.com.cn/t/Mp]气相[/url]沉积技术原理是利用低温等离子体(非平衡等离子体)作能量源,工件置于低气压下辉光放电的阴极上,利用辉光放电(或另加发热体)使工件升温到预定的温度,然后通入适量的反应气体,气体经一系列化学反应和等离子体反应,在工件表面形成固态薄膜。它包括了化学[url=https://insevent.instrument.com.cn/t/Mp]气相[/url]沉积的一般技术,又有辉光放电的强化作用。 金刚石膜具有极其优异的物理和化学性质,如高硬度、低磨擦系数、高弹性模量、高热导、高绝缘、宽能隙和载流子的高迁移率以及这些优异性质的组合和良好的化学稳定性等,因此金刚石薄膜在各个工业领域有极其广泛的应用前景。 1. 在药瓶内镀上金刚石薄膜,可以避免药品在瓶内起反应,延长药品的保 全寿命; 2. 可作为计算机硬盘的保护层。目前的计算机硬盘,磁头在不用时要移到硬盘旁边的位置上,如果硬盘包有金刚石薄膜,则磁头可以始终放在硬盘上,这样就提高了效率; 3. 在切割工具上镀上金刚石薄膜,可以使工具在很长时间内保持锋利; 4. 用于制造带有极薄金刚石谐振器的扬声器; 5. 涂于计算机集成电路块,能抗辐射损坏,而一般硅集成块却易受辐射损坏。它能将工作时产生的热迅速散发掉,使集成块能排列得更紧凑些; 6. 用于分析X射线光谱的仪器,透过X射线的性能较别的材料好。 金刚石膜沉积必须要有两个条件: 1. 含碳气源的活化; 2. 在沉积气氛中存在足够数量的原子氢。 由于粒子间的碰撞,产生剧烈的气体电离,使反应气体受到活化。同时发生阴极溅射效应,为沉积薄膜提供了清洁的活性高的表面。因而整个沉积过程与仅有热激活的过程有显著不同。这两方面的作用,在提高涂层结合力,降低沉积温度,加快反应速度诸方面都创造了有利条件。 微波等离子体金刚石膜系统应由微波功率源,大功率波导元件、微波应用器及传感与控制四部分组成。应用器是针对应用试验的类型而设计,其微波功率密度按需要而设定,并按试验需要兼容各种功能,具有较强的专用性质。微波功率源、大功率波导元件及传感和控制三种类型的部件,是通用的部件,可按需要而选定。反应器必须可以抽成真空;且可置于高压。因此微波传输必须和反应器隔离开来。反应器中可以通入其他气体。下面是一个反应器图。[img]http://ng1.17img.cn/bbsfiles/images/2006/05/200605221201_18795_1613333_3.jpg[/img]半导体生产工艺中已经采用微波等离子体技术,进行刻蚀、溅射、[url=https://insevent.instrument.com.cn/t/Mp]气相[/url]沉积、氧化硅片;还可用于金属、合金、非金属的表面处理;用于等离子体光谱分析,可检测十几种元素。 二、微波等离子体源 目前国内微波离子体源的研究工作,大部分在2450MHZ这个频段上进行,部分还可能采用915MHZ频段。这两个频段均采用连续波磁控管,并做成连续波功率微波源。但实际情况均具有较大的波纹因素,说得确切一些是三相全波整流或单相全波整流的波形被磁控管锐化了波纹状态。家用微波炉的电路结构实际上是可控的单相半波倍压整流电路,其波纹因素更大。 这种工作状态受电网波动的影响,平均功率不断变化,具有很大的不稳定性,造成功率密度的不确定。在微波等离子体金刚石膜制作系统要求很严格的情况下,会造成实验结果重复性不满意。因此需要稳定且纹波系数小的微波源是系统成功关键。 另外,近来微波等离子体的研究首先发现这些问题,电源的不稳定性会造成等离子体参数的变化。但用毫秒级的脉冲调制连续波磁控管,在许多实验中取得了良好的实验效果。理论分析调制通断时间的选定可以获得改善效果。 1. 物料介电损耗的正温度系数锐化了不均匀的加热效果,造成局部点的热失控现象。必要的周期停顿,利用热平衡的过程,可以缓解这些不均匀因素,抑制热失控现象的建立。 2. 避免了微波辅助催化反应过程中若干不需要副反应的累积。周期性的停顿可以避免这些副反应累积增强,停顿就是副反应的衰落,再从新开始,这样就避免了副反应的过度增长。 三、微波等离子体的应用 微波等离子体的应用技术主要用来制造特种性能优良的新材料、研制新的化学物质,加工、改造和精制材料及其表面,具有极其广泛的工业应用——从薄膜沉积、等离子体聚合、微电路制造到焊接、工具硬化、超微粉的合成、等离子体喷涂、等离子体冶金、等离子体化工、微波源等。等离子体技术已开辟的和潜在的应用领域包括:半导体集成电路及其他微电子设备的制造;工具、模具及工程金属的硬化;药品的生物相溶性,包装材料的制备;表面上防蚀及其他薄层的沉积;特殊陶瓷(包括超导材料);新的化学物质及材料的制造;金属的提炼;聚合物薄膜的印刷和制备;有害废物的处理;焊接;磁记录材料和光学波导材料;精细加工;照明及显示;电子电路及等离子体二极管开关;等离子体化工(氢等离子体裂解煤制乙炔、等离子体煤气化、等离子体裂解重烃、等离子体制炭黑、等离子体制电石等)。 微波等离子体化学[url=https://insevent.instrument.com.cn/t/Mp]气相[/url]沉积制备纳米催化剂的研究等。 微波等离子体的应用前景广阔。来源于汇研微波


