推荐厂家
暂无
暂无
 留言咨询
留言咨询
 银牌23年
银牌23年
 400-860-5168转0264
400-860-5168转0264
 留言咨询
留言咨询
 400-860-5168转4077
400-860-5168转4077
 留言咨询
留言咨询

 400-628-5299
400-628-5299
 留言咨询
留言咨询

 400-860-5168转1887
400-860-5168转1887
 留言咨询
留言咨询

 留言咨询
留言咨询
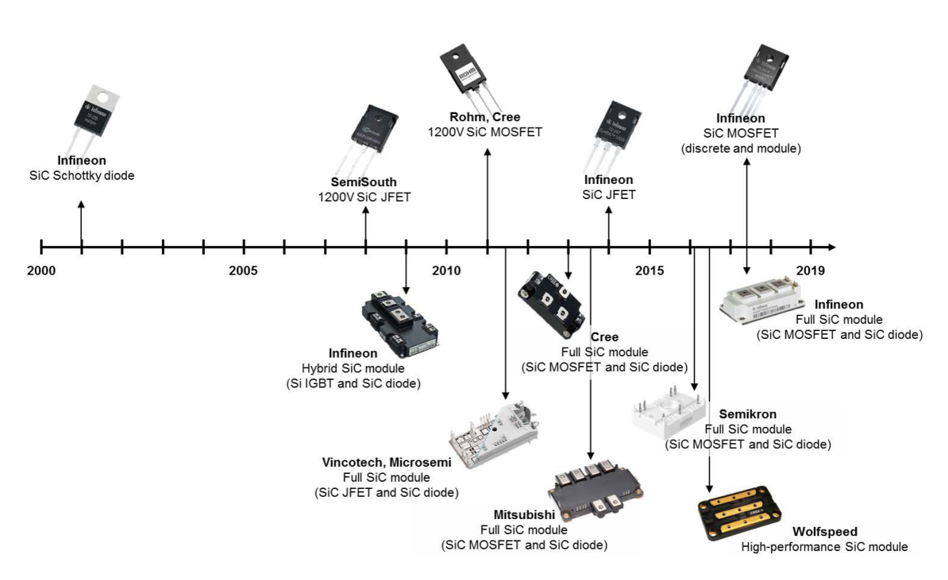






芯片推拉力测试仪 IC焊接强度测试仪 IC推拉力测试仪 功能推拉力测试机: 采用了AUTO-RANGE技术和VPM垂直定位技术,测试传感器采用自动量程设计,分辨率高达0.0001克 推拉力测试机(多功能剪切力测试仪)是用于微电子封装和PCBA电子组装制造及其失效分析领域的专用动态测试仪器,是填补国内空白的微电子和电子制造领域的重要仪器设备。该设备测试迅速、准确、适用面广、测试精度高,适用于半导体IC封装测试、LED封装测试、光电子器件封装测试、PCBA电子组装测试、汽车电子、航空航天、军工等等。亦可用于各种电子分析及研究单位失效分析领域以及各类院校教学和研究。该设备无论测试精度、重复可靠性、操控性和外观设计,均达到世界一流的水平。应用包括:wire pull, ball shear, tweezer pul,cold bump pull 和更专业的stud pull 等等。推拉力测试系统适用于半导体各种封装形式测试金铝线黏合力;及COB封装、光电,LED,SMT组装 , 原件与基板黏合测试;推拉力测试机特点: 1、重量:65公斤 2、外观:宽620毫米×长520毫米×高700毫米 3、工作台X方向和Y方向最大行程60毫米;解析度0.25微米;运动时速度2.5毫米/秒;;可承受最大力200公斤;Z方向最大行程70毫米; 解析度1微米;运动时速度10毫米/秒;可承受最大力100公斤 4、测量范围:100克/5000克/10公斤/100公斤 5、测量精度:0.1% 6、测量标准:国家鉴定 标准推拉力测试机功能: 1、可实现多功能推拉力测试;2、任意组合可实现多种功能测试; 3、满足单一测试模组; 4、创新的机械设计模式; 5、强大的数据处理功能; 6、简易的操作模式,方便、有效。推拉力试验机应用: 1、可进行各种推拉力测试: 金球、锡球、芯片、导线、焊接点等 2、最大测试负载力达500kg 3、独立模组可自由添加任意测试模组: 4、强大分析软件进行统计、破断分析、QC报表等功能 5、 X 和 Z 轴可同时移动使拉力角度保持一致 6、程式化自动测试功能拉力测试 ·金/铝线拉力测试 ·非破坏性拉力测试(无损拉克) ·铝带拉力测试 ·非垂直(任何角度)拉力测试 ·夹金/铝线拉力测试 ·夹元件拉力测试 ·薄膜/镀膜/芯片/[color=black
[color=#ff6600]问[/color]:贵阳董副总,从事粗铝线的客户想采购焊接强度测试仪,寻找焊接强度测试仪,希望推荐比较好的焊接强度测试仪厂家?[color=#ff6600]答:[/color]小编为了方便大家想采购焊接强度测试仪,给大家推荐一下科准测控的焊接强度测试仪,方便大家做想采购焊接强度测试仪时候的参考:科准测控制造厂是一家以研发制造焊接强度测试仪为核心的高新技术型企业,主要经营疲劳拉伸力焊接强度测试仪、电脑式焊接强度测试仪、芯片焊接牢固度焊接强度测试仪。拥有完整、科学的质量管理体系。焊接强度测试仪广泛应用于微电子封装、SMT焊接器件、0402元件、晶片、光电子元器件、ic焊点、金丝键合研究所材料力学研究、材料可靠性测试等应用领域,是Bond工艺、SMT工艺、键合工艺等不可缺少的动态力学检测仪器,能满足包含有:金属、铜线、合金线、铝线、铝带等拉力测试、金球、铜球、锡球、晶圆、芯片、贴片元件等推力测试、锡球、BumpPin等拉拔测试等等具体应用需求,功能可扩张性强、操控便捷、测试高效准确。可根据要求定制底座、夹具、校验治具、砝码和测试工具满足各种不同尺寸的样品。科准测控有限责任公司以诚信、实力和产品质量获得业界的认可。欢迎朋友莅临参观、指导和业务洽谈。[b]焊接强度测试仪设备特征:[/b]1、采用测试工位自动模式,在软件选择测试工位后,系统自动到达对应工作位。2、每项传感器采用独立防碰撞及过力保护系统。3、三个工作传感器,采用独立采集系统,保证测试精度。4、软件自动生成报告及存储功能,支持MES系统。5、荷重单位显示N、Ib、gf、kgf可自由切换。6、人性化的操作界面,人员操作方便。7、每项测试工作采用独立安全限位及限速功能。8、智能数据分析软件,自动记录并计算多点测试数据的Cpk值,可记录单点测试的力值、时间曲线。9、根据客户测试需求,非标定制各种精密测试夹具,有效确保用户测试数据的真实性。[b]焊接强度测试仪产品优势:[/b]1、电脑自动选取合适的推拉刀,无需人手更换2、采用进口传动部件结合独特力学算法,确保机台运行稳定性及测试精度。3、多功能精密四轴自动控制运动平台,采用进口传动部件,确保机台的高速、长久稳定运行。4、旋转盘内置三个不同量程测试传感器,满足不同测试需求,避免因人员误操作带来的设备损坏。5、优异的可操控性,左右双摇杆控制器,可自由摆放手感舒适,操作简单便捷。6、 强大分析软件进行统计、破断分析、QC报表,测试数据实时保存与导出,方便快捷。7、机载统计数据按照等级,平均值,标准差和CPK分布曲线显示测试结果。8、弧线形设计便于调整显微镜支架。9、显微镜光源为双光纤LED,冷光源,不发热,可随意弯曲。10、XY平台,可以根据要求定制,满足更广泛的测试范围。11、图像采集系统,快速简单的设置,安装在靠近测试头位置,以便帮助更快地测试。提高测试自动化速度。[b]设备成功案例:[/b]在上海、河南、安徽、北京、嘉善、苏州、昆山、四川、江苏、厦门、徐州、浙江、陕西、深圳等地区均有科准测控焊接强度测试仪的相关成功案例,欢迎大家前往实地考察。[b]设备常见系列:[/b]1、常用类型:自动焊接强度测试仪、功率强大焊接强度测试仪、全自动焊接强度测试仪、单柱焊接强度测试仪、数显焊接强度测试仪.....2、常见型号:mfm1000焊接强度测试仪、dage焊接强度测试仪、fm1200焊接强度测试仪.....3、试验功能:剪切力、钝化层剪切力、推力、拉力、粘合力.....[b]测试机的采购渠道:[/b]1、线下:可以找直接生产厂家定制、经销商可以批发代理。2、线上:京东、淘宝、知乎商家、抖音等合法线上渠道3、电话:直接拨打厂家销售人员的电话或者400电话,免费服务热线等方式[b]品牌有哪些?[/b]目前焊接强度测试仪市场的常用及认可品牌有(非官宣):科准测控、克拉克、德瑞茵、达格、力新宝、博森源.....等厂家及品牌[b]采购前需要注意的事项:[/b]一般在采购一个产品之前,先找到正规靠谱的生产厂家,然后需要咨询价格以及详细了解焊接强度测试仪的维修手册、维护、板卡驱动、夹具定制、拉力测试耗材、操作原理、相对湿度、力值显示售后服务等条件,可以找供应商提供焊接强度测试仪的产品图片、效果图、彩页、案例图、视频综合进行参考,对各方面都满意后,就可以直接下单采购了。上述内容就是关于焊接强度测试仪的全面解析介绍,从原理到怎么使用、校准方法以及注意事项,仅供您参考了解,如有不足之处欢迎各位用户及同行探讨交流互相补充,如需要详细了解其他相关封装测试设备,可以拨打我们的电话,了解更多!
【产品介绍】 泰仕达 TSD炉温测试仪优越的隔热性能使测试系统在恶劣热环境中进行温度测绘。和产品一起通过热处理炉,可全程测试监测热处理炉和产品的温度,无需拖偶试验即可取得有价值数据,形成的曲线分析报告能即时提供给工程师们产品和炉子的真实温度状态,将告诉您如何和来优化操作。通过均衡温度,时间和加热速率,您便可提高线速度和产品质量,实现高效率生产。 泰仕达 TSD炉温测试仪是一款高精度、高稳定性的炉膛温度测试记录产品,填补了国内温度采集领域的空白,该系统还配有功能强大的软件分析系统,将采集到的温度值进行数据保存,上位机软件分析系统进行功能温度与长度、时间、产品功能等参数的同步分析处理。【适用范围】: 涂装烤漆炉温测试仪,不粘涂料炉温测试仪,钢铁热处理炉温测试仪,轮毂热处理炉温测试仪,SMT炉温测试仪,钎焊炉温测试仪,汽车涂装炉温测试仪,食品烘烤炉温测试仪,陶瓷烧制炉温测试仪,搪瓷炉温测试仪。


