









随着集成电路技术的发展,半导体封装技术也在不断创新和改进,以满足高性能、小型化、高频化、低功耗、以及低成本的要求。等离子处理技术作为一种高效、环保的解决方案,能够满足先进半导体封装的要求,被广泛应用于半导体芯片DB/WB工艺、Flip Chip (FC)倒装工艺中。

DB工艺前等离子处理
芯片键合(Die Bonding)是指将晶圆上切割下来的单个芯片固定到封装基板上的过程。其目的在于为芯片提供一个稳定的支撑,并确保芯片与外部电路之间的电气和机械连接。常用的方法有树脂粘结、共晶焊接、铅锡合金焊接等。
在点胶装片前,基板上如果存在污染物,银胶容易形成圆球状,降低芯片粘结度。因此,在DB工艺前,需要进行等离子处理,提高基板表面的亲水性和粗糙度,有利于银胶的平铺及芯片粘贴,提高封装的可靠性和耐久性。在提升点胶质量的同时可以节省银胶使用量,降低成本。
WB工艺前等离子处理
芯片在引线框架基板上粘贴后,要经过高温使之固化。如果芯片表面存在污染物,就会影响引线与芯片及基板间的焊接效果,使键合不完全或粘附性差、强度低。在WB工艺前使用等离子处理,可以显著提高其表面附着力,从而提高键合强度及键合引线的拉力均匀性,提升WB工艺质量。
*WB工艺前处理应用案例
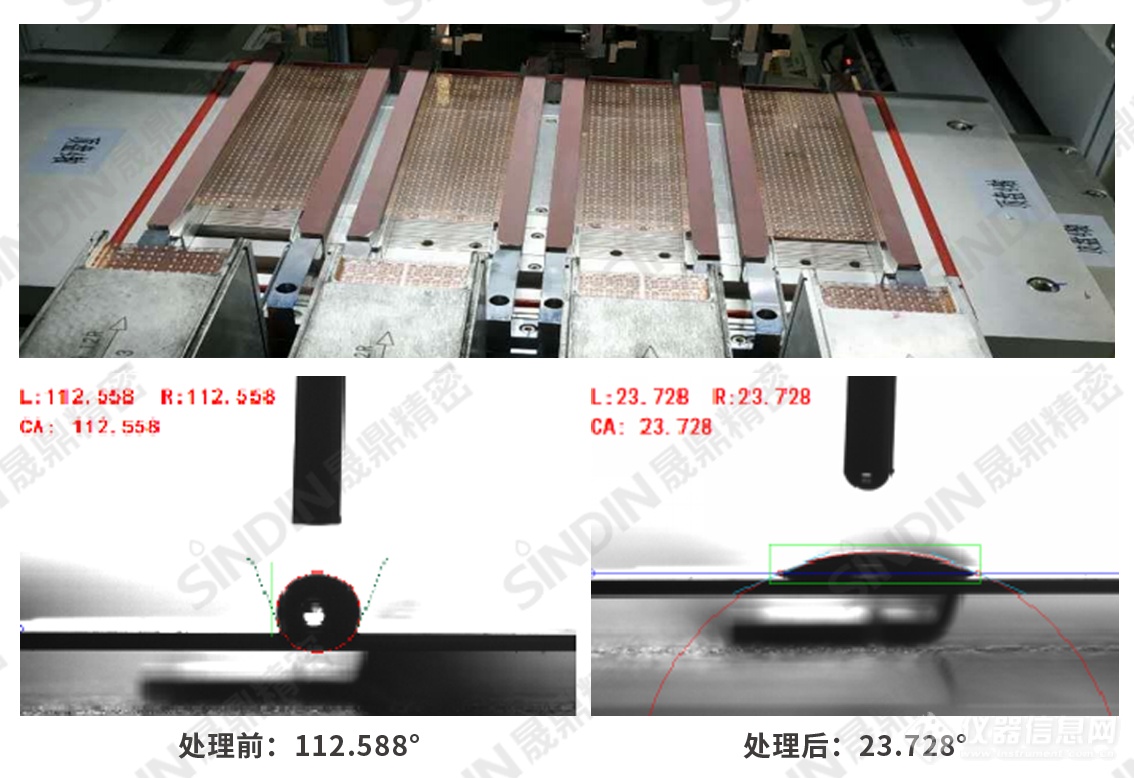
Flip Chip (FC)倒装工艺等离子应用
在Flip Chip(FC)倒装工艺中,将称为“焊球(Solder Ball)”的小凸块附着在芯片焊盘上。其次,将芯片顶面朝下放置在基板上,完成芯片与基板的连接后,通常需要在在芯片与基板之间使用填充胶进行加固,以提高倒装工艺的稳定性。
通过等离子清洗可以改善芯片和基板表面润湿性,提高其表面附着力,进而影响底部填充胶的流动性,使填充胶可以更好地与基板和芯片粘结,从而达到加固的目的,提高倒装工艺可靠性。
片式真空等离子清洗机
针对半导体行业,DB/WB工艺、RDL工艺、Molding工艺、Flip Chip (FC)倒装工艺等,能够大幅提高其表面润湿性,保证后续工艺质量,从而提高封装工艺的可靠性。

设备优势:
1. 一体式电极板结构设计,等离子体密度高,均匀性好,处理效果佳
2. 双工位处理平台,四轨道同时上料,有效提升产能
3. 可兼容多种弹匣尺寸,可自动调节宽度,提升效率并具备弹匣有无或装满报警提示功能
4. 工控系统控制,一键式操作,自动化程度高
行业应用:
1. 金属键合前处理:去除金属焊盘上的有机污染物,提高焊接工艺的强度和可靠性
2. LED行业:点银胶、固晶、引线键合前、LED封装等工序中可提高粘和强度,减少气泡,提高发光率
3. PCB/FPC行业:金属键合前、塑封前、底部填充前处理、光刻胶去除、基板表面活化、镀膜,去除静电及有机污染物
[来源:东莞市晟鼎精密仪器有限公司]
版权与免责声明:
① 凡本网注明"来源:仪器信息网"的所有作品,版权均属于仪器信息网,未经本网授权不得转载、摘编或利用其它方式使用。已获本网授权的作品,应在授权范围内使用,并注明"来源:仪器信息网"。违者本网将追究相关法律责任。
② 本网凡注明"来源:xxx(非本网)"的作品,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,且不承担此类作品侵权行为的直接责任及连带责任。如其他媒体、网站或个人从本网下载使用,必须保留本网注明的"稿件来源",并自负版权等法律责任。
③ 如涉及作品内容、版权等问题,请在作品发表之日起两周内与本网联系,否则视为默认仪器信息网有权转载。
![]() 谢谢您的赞赏,您的鼓励是我前进的动力~
谢谢您的赞赏,您的鼓励是我前进的动力~
打赏失败了~
评论成功+4积分
评论成功,积分获取达到限制
![]() 投票成功~
投票成功~
投票失败了~