









溅射深度剖析作为表面分析的常规技术,被广泛应用于膜层结构元素成分随深度变化的表征,但由于溅射、样品粗糙度以及测量信号来源于距样品表面不同的深度等因素的影响,使得测量的深度谱与原始的膜层结构比较可能会有较大的畸变。对测量深度谱数据进行定量分析,不仅可以确定样品的膜层结构,还可以获得其界面粗糙度、元素间的互扩散系数、元素的溅射速率、以及溅射深度分辨率等定量信息。报告讨论了多晶样品深度剖析中溅射诱导粗糙度产生的原因及消除的方法。并以4Si(15nm)/Al(15nm) AES、XPS和ToF-SIMS,以及60Si(3.7nm)/B4C(0.3nm)/Mo(3.0nm) 脉冲-射频-GDOES等深度谱为例,讨论了溅射诱导粗糙度对测量深度谱的影响及其相应的定量分析。同时还提出了将TV正则化与MRI深度分辨率函数结合,对深度谱数据进行反卷积定量分析的新方法,并应用于8Ni(25nm)/Cr(25nm) AES、60Si(3.5nm)/Mo(3.5nm) 脉冲-射频-GDOE和ToF-SIMS深度谱的定量分析,获得的膜层结构与HR-TEM的测量结果相吻合。
王江涌,博士,教授,1984年武汉大学理论物理专业学士;1989年四川大学原子与分子物理专业硕士;1997年南非自由州大学表面物理专业博士;1998-2001年美国堪萨斯州立大学物理系研究助理;2001-2009年德国马普金属研究所高级研究员;2009年起任汕头大学物理系教授。从事表面分析工作近三十年,在薄膜相变及深度剖析定量分析领域做出了诸多创新性工作。发表英文专著2部,论文150余篇(SCI 110余篇)。现任广东省分析测试协会表面分析专业委员会副主任委员、中国机械工程学会表面工程分会常务委员;《功能材料》、《材料科学研究与应用》与《表面技术》等期刊编委、评委。
[来源:仪器信息网] 未经授权不得转载
 杜江峰院士任浙江大学校长
杜江峰院士任浙江大学校长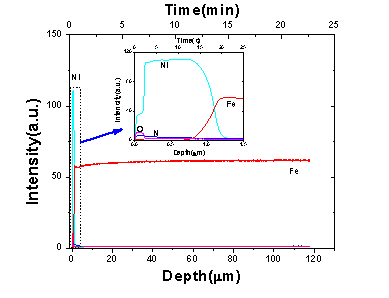
专家约稿|辉光放电发射光谱仪的应用—涂层与超薄膜层的深度剖析
2022.08.24

版权与免责声明:
① 凡本网注明"来源:仪器信息网"的所有作品,版权均属于仪器信息网,未经本网授权不得转载、摘编或利用其它方式使用。已获本网授权的作品,应在授权范围内使用,并注明"来源:仪器信息网"。违者本网将追究相关法律责任。
② 本网凡注明"来源:xxx(非本网)"的作品,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,且不承担此类作品侵权行为的直接责任及连带责任。如其他媒体、网站或个人从本网下载使用,必须保留本网注明的"稿件来源",并自负版权等法律责任。
③ 如涉及作品内容、版权等问题,请在作品发表之日起两周内与本网联系,否则视为默认仪器信息网有权转载。
![]() 谢谢您的赞赏,您的鼓励是我前进的动力~
谢谢您的赞赏,您的鼓励是我前进的动力~
打赏失败了~
评论成功+4积分
评论成功,积分获取达到限制
![]() 投票成功~
投票成功~
投票失败了~