







半导体&电子测试测量,投稿:kangpc@instrument.com.cn


光电子显微镜 (photo-emission electron microscope, PEEM),当其装备有电子枪照射系统后,可作为低能电子显微镜(low-energy electron microscope, LEEM)使用。
LEEM和PEEM的成像系统相同,所以经常被组合成一套PEEM/LEEM系统,如下图所示
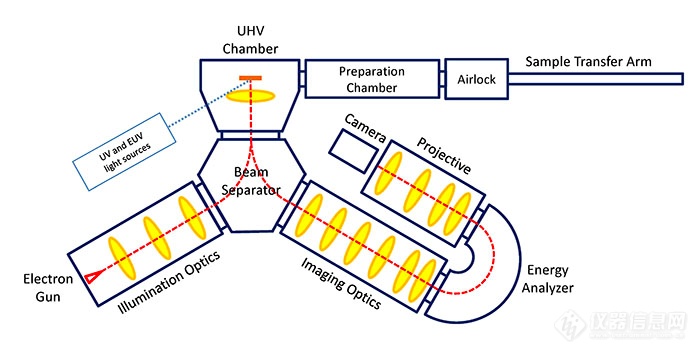
作为LEEM使用时,从电子束照射系统发射出的入射电子束,经过电子束分离器被偏转60度,经过物镜后在到达样品前被迅速从高能量减速到几个eV,被减速后的低能量电子和样品相互作用经过弹性散射后,从样品表面被反射出来,然后重新被加速为高能量电子,再通过电子束分离器偏转到反方向的成像透镜系统进行成像。
作为PEEM使用时,紫外光或X射线照射样品后产生光电子或二次电子,物镜收集这些光电子或二次电子而成像。
PEEM/LEEM作为一种实时、动态、原位的表面研究新技术,在催化、能源、纳米科学、生物、微电子、材料等领域有着重要的应用。
例如:在当下极具应用价值的石墨烯材料特性和制备研究方面、高功率半导体核心材料GaN生长研究方面等。
其中,LEEM能够在极低的电压下工作,极低电压能够最大程度保护被观察样品活性或表面状态,获得更多有价值的科学数据。
MCP是微通道板(Microchannel Plate)的英文简称,MCP被设计成一种置于光电探测器前端的器件,主要用于检测电子、离子、高能粒子等。
MCP的结构是由大量中空的微通道经过二维排列构成,微通道的内壁经过处理,使得在被粒子轰击时能够产生更多的二次电子从而起到信号增强,MCP后端放置探测器读出装置后,进而实现信号的检测和记录。
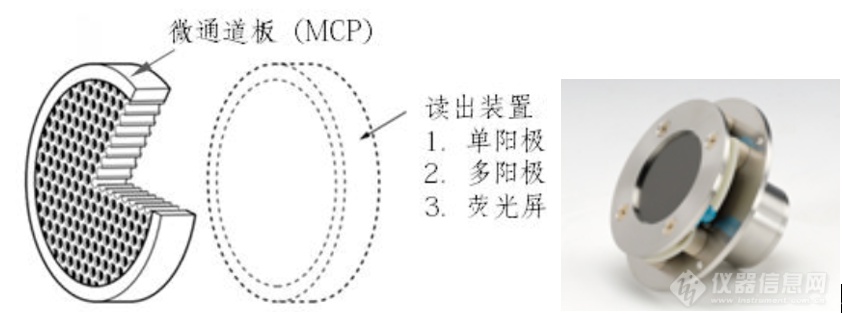
直接电子探测(Direct Electron)成像通过采用新型的电子探测相机,在不借助MCP的情况下,直接接收经过待检测样品的电子信号,具备更优的检测分辨率和成像效果。
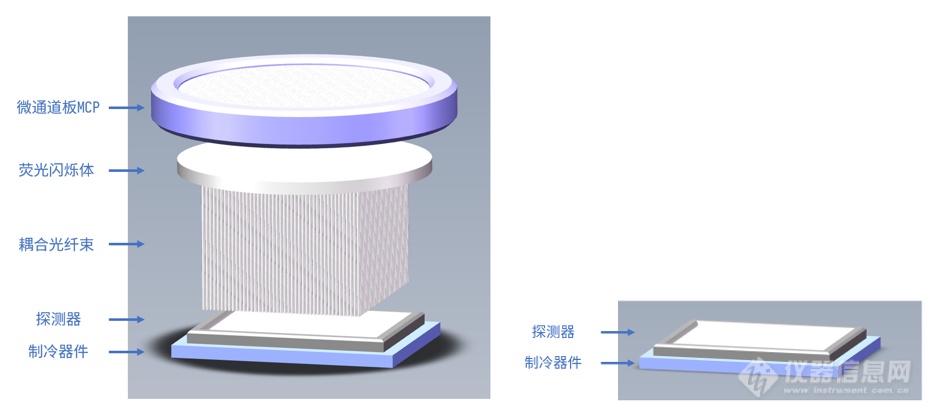
(LEEM/PEEM的MCP和直接电子探测器成像方式对比图)

纯国产直接电子探测相机,完全自主知识产权的科研级成像设备;
适配于LEEM/PEEM 低压电子显微镜,提供UHV 接口;
可在10-30kV 下清晰成像, 替代传统微通道板MCP探测器;
相机软件提供独立 GUI,也可灵活支持Labview, Micro-Manager等通用采集软件。

(BJI-L4M相机在客户设备上安装图)

(在15kv~30kv加速电压范围内,相机探测器信号接收均值随加速电压的变化曲线图)
分辨率 | 2048×2048 |
靶面大小 | 13.3mm×13.3mm |
最大帧率 | 40FPS |
曝光时间范围 | 1ms~120s |
制冷模式 | 水冷 |
参考文献
[1]郭方准.解说低能量/光电子显微镜(LEEM/PEEM)[J].物理,2010,39(03):211-218.
[2]https://groups.oist.jp/fsu/leem-peem
[3] 宁艳晓, 傅强, 包信和. PEEM/LEEM技术在两维原子晶体表面物理化学研究中的应用. 物理化学学报[J], 2016, 32(1): 171-182 doi:10.3866/PKU.WHXB201512152
[4]N. Barrett, J. E. Rault, J. L. Wang, C. Mathieu, A. Locatelli, T. O. Mentes, M. A. Niño, S. Fusil, M. Bibes, A. Barthélémy, D. Sando, W. Ren, S. Prosandeev, L. Bellaiche, B. Vilquin, A. Petraru, I. P. Krug, and C. M. Schneider , "Full fild electron spectromicroscopy applied to ferroelectric materials", Journal of Applied Physics 113, 187217 (2013)
[来源:SP中国|SingleParticle]

电镜核心部件专题|徐建勋:造中国人自己的电子枪,赋能国产电镜研制
2022.12.12

2022.11.04

2024.07.10

2.5万材料人齐聚广州:中国材料大会2024暨第二届世界材料大会开幕!
2024.07.10

突破性成果!从“盖房子”到“顶竹笋”:我国科学家首创晶体制备新方法
2024.07.09

2024.07.05
版权与免责声明:
① 凡本网注明"来源:仪器信息网"的所有作品,版权均属于仪器信息网,未经本网授权不得转载、摘编或利用其它方式使用。已获本网授权的作品,应在授权范围内使用,并注明"来源:仪器信息网"。违者本网将追究相关法律责任。
② 本网凡注明"来源:xxx(非本网)"的作品,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,且不承担此类作品侵权行为的直接责任及连带责任。如其他媒体、网站或个人从本网下载使用,必须保留本网注明的"稿件来源",并自负版权等法律责任。
③ 如涉及作品内容、版权等问题,请在作品发表之日起两周内与本网联系,否则视为默认仪器信息网有权转载。
![]() 谢谢您的赞赏,您的鼓励是我前进的动力~
谢谢您的赞赏,您的鼓励是我前进的动力~
打赏失败了~
评论成功+4积分
评论成功,积分获取达到限制
![]() 投票成功~
投票成功~
投票失败了~