







热分析&电镜&表面分析,分享最新国内外仪器技术成果进展


作者: Sang-Joon Cho, Park Systems Corp.副总裁兼研发中心总监、Ilka M. Hermes, Park Systems Europe 首席科学家
利用原子力显微镜进行的自动缺陷复检,通过纳米级的分辨率在三维空间中可视化缺陷。因此,纳米级成像设备是制造过程的一个重要组成部分,它被视为当今半导体行业中最理想的技术。
结合原子力显微镜的三维无创成像,使用自动缺陷复查对缺陷进行精确检测和准确分类。

与时俱进的光刻工艺使得生产的半导体器件越来越微小化。器件尺寸一旦减小,晶圆衬底上的纳米级缺陷就限制了器件的性能使用。因此对于这些缺陷的检测和分类需要具有纳米级分辨率的表征技术。由于可见光的衍射极限,传统的自动光学检测(AOI)无法在该范围内达到足够的分辨率,进而损害定量成像和随后的缺陷分类。
而原子力显微镜 (AFM) 自动缺陷复检 (ADR)技术则有效地解决了该问题。该技术利用 AFM 常用的纳米分辨率,能够在三维空间中可视化缺陷,大大减少了缺陷分类的不确定性。因此,ADR-AFM 成为了当今半导体行业缺陷复检最理想的技术。
缺陷检查和复检
由于摩尔定律,半导体器件变得越来越小,需要检查的缺陷(DOI)大小也在减小。DOI可能会降低半导体器件性能的缺陷,因此对工艺良率的管理非常重要。DOI尺寸的减小对缺陷分析来说是一个挑战。合适的表征技术必须能够在两位数或一位数纳米范围内以高横向分辨率和垂直分辨率对缺陷进行无创成像。
一般来说,半导体行业的缺陷分析包含两个步骤。
第一步:缺陷检测。利用吞吐量虽高但低分辨率的快速成像方法,如扫描表面检测系统(SSIS)或AOI。这些方法可以提供晶圆表面缺陷位置的坐标图。然而,由于分辨率较低,AOI和SSIS在表征纳米尺寸的DOI时提供的信息不足,接下来需要依赖高分辨率技术进行缺陷复检。
第二步:缺陷复检。利用高分辨率显微镜方法,如透射电子显微镜(TEM)或扫描电子显微镜(SEM)或原子力显微镜(AFM)。通过使用缺陷检测的缺陷坐标图,对晶圆表面的较小区域进行成像,以解析DOI。利用AOI或SSIS的坐标图可以最大限度地减少检查的扫描区域,从而缩短缺陷复检的测量时间。
众所周知,SEM和TEM的电子束可能会对晶圆造成损伤,而非接触测量模式的AFM则有效地避免了该影响。它不仅可以无创地扫描表面,还有高横向和垂直分辨率对缺陷进行成像。因此,原子力显微镜能提供可靠的缺陷定量所需的三维信息。
原子力显微镜
通过在悬臂末端使用纳米尺寸的针尖对表面进行机械扫描,AFM在传统成像方法中可达到最高的垂直分辨率。除接触模式外,AFM还可以启用动态测量模式,即悬臂在样品表面上方振荡。由此,振幅或频率的变化提供了有关样品形貌的信息。这种非接触AFM模式确保了以高横向和垂直分辨率对晶圆表面进行无创成像。随着自动化原子力显微镜的更新发展,原子力显微镜的应用越来越广泛,从学术研究扩展到了如硬盘制造和半导体技术等工业领域。
该行业开始关注AFM的多功能性及其在三维无创表征纳米结构的能力。因此,AFM正发展成为用于缺陷分析的新一代在线测量解决方案。
使用原子力显微镜自动缺陷复检
AFM 缺陷复检技术的最大挑战之一是将缺陷坐标从 AOI 转移到 AFM。基于此,用户最初会在 AOI 和 AFM 之间的附加步骤中,手动在光学显微镜上手动标记缺陷位置,然后在 AFM 中搜索这些位置。然而,这个额外的步骤不仅非常耗时还大大降低了吞吐量。
另外,使用 AFM 的自动缺陷复检需要从 AOI 数据中导入缺陷坐标。而缺陷坐标的导入需要准确对准晶圆及精减AOI 和 AFM 之间的载物台误差。位置精度比AOI 更高的光学分析工具(例如Candela),可以有效减少中间校准步骤中的载物台误差。以下 ADR-AFM 测量包括在给定缺陷坐标处的大范围调查扫描、缺陷的高分辨率成像和缺陷分类。自动化的测量过程无需用户在场,吞吐量还增加了一个数量级。为了保持纳米级的针尖半径和连续扫描依旧保持高分辨率,ADR-AFM 采用非接触式动态成像模式。因此,ADR-AFM 可有效防止探针针尖磨损并确保对缺陷进行精确地定量复检。
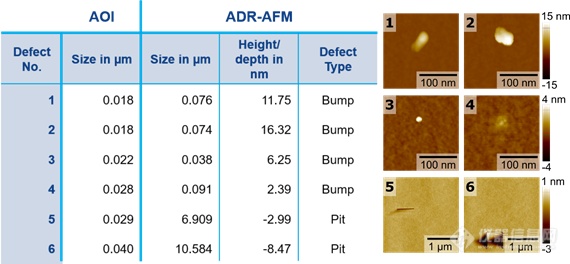
△图1:用AOI和ADR-AFM测定的缺陷尺寸的直接比较,见左侧表格。右侧显示了所有六种缺陷的相应AFM形貌扫描。突出的缺陷称为Bump,凹陷的缺陷称为Pit。
AOI和ADR-AFM的比较
图1比较了 AOI 和 ADR-AFM 在相同纳米级缺陷下所产生的不同缺陷复检结果。AOI 根据散射光的强度估计缺陷的大小,而 ADR-AFM 则通过机械直接扫描缺陷表面进行成像。除了横宽,ADR-AFM 还测量缺陷的高度或深度,从而可以区分凸出的“bump”和凹陷的“pit”缺陷。可视化的缺陷三维形状确保了缺陷分类的可靠性和精确性,而这些是AOI无法实现的。
当对比分别利用 AOI 和 ADR-AFM 确定缺陷的大小时,我们发现通过 AOI 估计的值与通过 ADR-AFM 测量的缺陷大小存在很大差异。对于凸出的缺陷,AOI 始终将缺陷大小低估了一半以上。这种低估对于缺陷 4 尤其明显。在这里,AOI 给出的尺寸为 28 nm ,大约是 ADR-AFM 确定的 91 nm 尺寸的三分之一。在测量“pit”缺陷 5 和 6 时,我们观察到了 AOI 和 ADR-AFM 之间的最大偏差。AOI将尺寸在微米范围内的缺陷低估了两个数量级以上。上述比较清楚地表明,仅用AOI不足以进行缺陷的成像和分类。
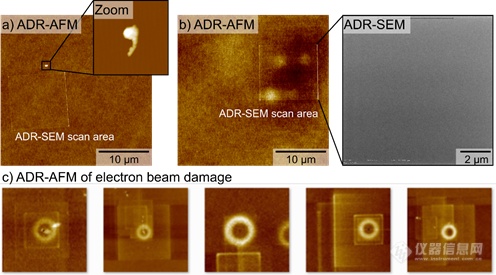
△图2:ADR-AFM 和 ADR-SEM 之间的比较,a) ADR-SEM 之前遗漏的凸出缺陷的 AFM 图像。ADR-SEM 扫描区域在 AFM 形貌扫描中显示为矩形。b) 低高度 (0.5 nm) 缺陷的成像,ADR-SEM 无法解析该缺陷。c) ADR-SEM 测量后晶圆表面上的电子束损伤示例,可见为缺陷周围的矩形区域。
ADR-SEM和ADR-AFM的比较
除了ADR-AFM, ADR-SEM 也可以进行高分辨率的缺陷复查。ADR-SEM根据AOI数据中的DOI坐标,通过SEM测量进行自动缺陷复检。在此期间,高能电子束扫描晶圆表面。虽然SEM提供了很高的横向分辨率,但它通常无法提供有关缺陷的定量高度信息。
为了比较ADR-SEM和ADR-AFM的性能,首先需要通过ADR-SEM对晶圆的相同区域进行成像,然后通过ADR-AFM进行测量(图2)。AFM图像显示,ADR-SEM扫描的晶圆表面发生了变化,在图2a中,AFM形貌显示为矩形。由于ADR-AFM中ADR-SEM扫描区域的可视性,图2a表明ADR-SEM遗漏了一个突出的缺陷,该缺陷位于SEM扫描区域正上方。此外,ADR-AFM具有较高的垂直分辨率,其灵敏度足以检测高度低至0.5nm的表面缺陷。由于缺乏垂直分辨率,这些缺陷无法通过ADR-SEM成像(图2b)。此外,图2c通过总结高能电子束对样品表面造成的变化示例,突出了电子束对晶片造成损坏的风险。ADR-SEM扫描区域可以在ADR-AFM图像中识别为缺陷周围的矩形。相比之下,无创成像和高垂直分辨率使ADR-AFM非常适合作为缺陷复检的表征技术。
结论
随着现代技术不断创新,半导体器件尺寸不断减小,原子力显微镜作为一种高分辨率、无创的缺陷分析方法在半导体工业中的作用越来越明显。AFM自动化的测量简化并加快了之前AFM在缺陷表征方面低效的工作流程。AFM自动化方面的进展是引入ADR-AFM的基础。在ADR-AFM中,缺陷坐标可以从之前的AOI测量中导入,随后基于AFM的表征不需要用户在场。
因此,ADR-AFM可作为缺陷复检的在线方法。特别是对于一位或两位级纳米范围内的缺陷尺寸,ADR-AFM补充了传统的AOI性能,AFM的高垂直分辨率有助于进行可靠的三维缺陷分类。非接触式测量模式确保了无创伤的表面表征,并有效防止AFM针尖磨损,从而确保在许多连续测量中能够依旧保持精准的高分辨率。
[来源:帕克原子力显微镜]

2024.07.25

以匠心映绘科技,以至诚点亮售后——Park Systems的“新”型售后
2024.04.23

版权与免责声明:
① 凡本网注明"来源:仪器信息网"的所有作品,版权均属于仪器信息网,未经本网授权不得转载、摘编或利用其它方式使用。已获本网授权的作品,应在授权范围内使用,并注明"来源:仪器信息网"。违者本网将追究相关法律责任。
② 本网凡注明"来源:xxx(非本网)"的作品,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,且不承担此类作品侵权行为的直接责任及连带责任。如其他媒体、网站或个人从本网下载使用,必须保留本网注明的"稿件来源",并自负版权等法律责任。
③ 如涉及作品内容、版权等问题,请在作品发表之日起两周内与本网联系,否则视为默认仪器信息网有权转载。
![]() 谢谢您的赞赏,您的鼓励是我前进的动力~
谢谢您的赞赏,您的鼓励是我前进的动力~
打赏失败了~
评论成功+4积分
评论成功,积分获取达到限制
![]() 投票成功~
投票成功~
投票失败了~