多层结构器件界面的无损深度分析案例
2024/02/19 10:08
阅读:22
分享:
![]() 免费下载
免费下载
方案摘要:
产品配置单:
PHI X射线光电子能谱仪
型号: PHI GENESIS 500
产地: 日本
品牌: ULVAC-PHI
面议
参考报价
联系电话
方案详情:
HAXPES∣多层结构器件界面的无损深度分析案例
HAXPES∣Analysis Cases of Non Destructive Depth at the Interface of Multilayer Devices
关键词:HAXPES、表/界面、埋层、无损深度分析
XPS的探测深度在10nm以内,然而对于实际的器件,研究对象往往会超过10 nm的信息深度,特别是在一些电气设备中,有源层总是被掩埋在较厚的电极之下。因此,利用XPS分析此类样品,需要结合离子刻蚀技术。显然,离子刻蚀存在择优溅射效应,特别是对于金属氧化物,会破坏样品原始的化学态,导致仅凭常规XPS无法直接对埋层区域进行无损深度分析。
好在研究表明增加X射线的光子能量可以增加探测深度。对此,ULVAC-PHI推出了实验室HAXPES设备,且可同时配备微聚焦单色化Al Kα (1486.6 eV)源和单色化Cr Kα (5414.9 eV)源。集成的SOXPS-HAXPES(软/硬X射线光电子能谱相结合)仪器拥有直接分析采样深度从1 nm到30 nm范围内的膜层结构的能力。
例如,本文中利用HAXPES(PHI Quantes)对以下器件的界面进行了无损深度分析:
器件1:HEMT(高电子迁移率晶体管),结构为Al (20 nm)/Ta (5 nm)/AlGaN (23 nm)/GaN,其中Al/Ta双层的作用是在退火时促进与AlGaN源极/漏极的欧姆接触。目标分析区域:Al/Ta /AlGaN界面。
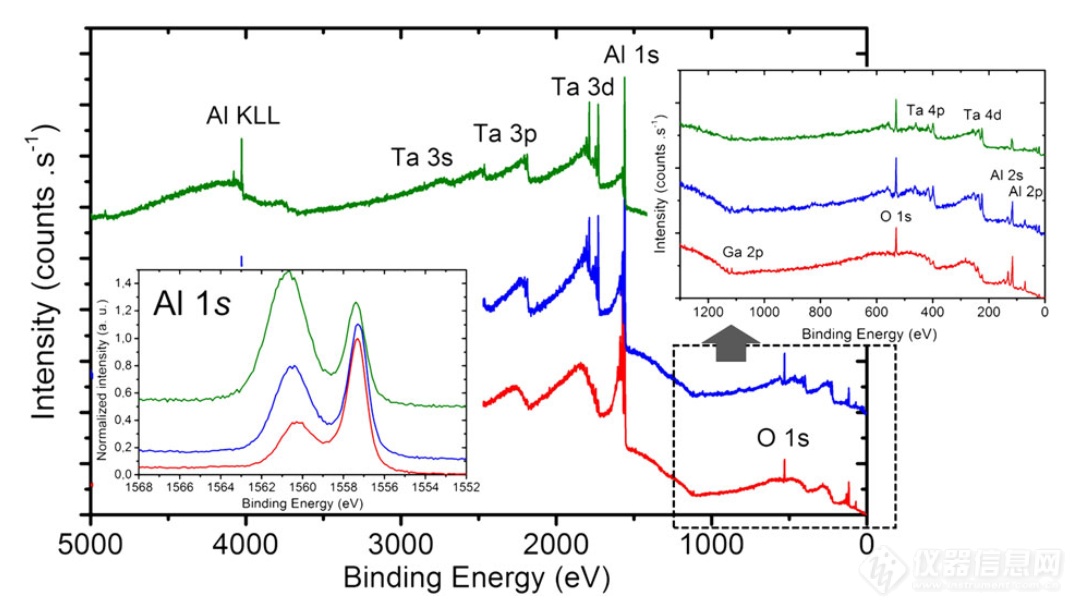
图1 Al/Ta/AlGaN堆叠器件在不同退火处理后的HAXPES分析。[1]
原始和历经2种不同退火工艺处理后的Al (20 nm)/Ta (5 nm)/AlGaN (23 nm)/GaN HEMT器件的HAXPES结果表明:①全谱中Ta和Ca的光电子特征峰证明了利用HAXPES可以直接探测埋层(~25 nm)信息;②原子百分比的变化表明退火后,Ta和Ga会向上扩散;③Al 1s的峰位移表明了Al-Ta合金的形成,进一步证明了退火后Ta的向上扩散。
器件2:OxRAM(氧化物基电阻式随机存取存储器),由Pt (5 nm)/Ti (5 nm)/HfO2 (10 nm)/TiN (35 nm)/Si堆叠组成,在此类器件中,夹在2个金属TiN和Pt/Ti电极之间的HfO2膜层的电阻率变化决定了存储器的开/关状态。目标分析区域:Pt /Ti/HfO2 /TiN界面。

图2典型Pt/Ti/HfO2堆叠结构的HAXPES全谱。插图:分别在TOA为45°和90°时采集的Ti 2p、Ti 1s和Hf 4f的高分辨芯能级谱图。[1]
图2中Hf 3d特征峰的出现表明HAXPES已经探测到Ti/HfO2界面。此外,通过改变TOA,将采样深度从14 nm(TOA=45°)增至20 nm(TOA=90°),以实现对不同深度膜层的选择性分析。Ti 2p3/2中结合能为453 eV的峰对应于金属Ti,而在TOA=90°时测量的谱图中,在更高的结合能处有出峰,表明可能在掩埋的Ti/HfO2 界面上存在Ti氧化物。
表1 本案例中考虑的Cr Kα激发光电子的非弹性平均自由程值(IMFP)

值得注意的是,Cr Kα可以激发更深层能级,同一元素不同原子轨道的光电子的非弹性平均自由程值(IMFP)不同(见表1),因此还可以直接通过检测同一元素不同的芯能级,选择性地对不同深度的结构进行无损深度分析。比如,利用HAXPES对80纳米厚的TiN层的表面和体相化学成分进行表征,结果如图3所示。由表1可知,由于Ti 1s的IMFP远小于Ti 2p,二者的采样深度差异较大,可以展示出TiN样品3种化学组分(TiO2、TiOxNy和TiN)的不同含量。Ti 1s芯能级突出了表面高价态氧化物(TiO2,占46%)的贡献,反之,Ti 2p峰的突出了来自于体相的TiN层的贡献。

图3 高分辨的Cr Kα硬X射线光电子能谱:Ti 1s和Ti 2p。二者3种化学组分含量的差异来源于分析深度的不同,Ti 2p峰的贡献更多地来自于深处的TiN层。
总之,HAXPES在表面化学分析上具有突出的优势:①检测更深芯能级的光电子谱峰,扩展光电子能谱的信息;②移动俄歇峰,避免其与特征峰的重叠;③优于常规XPS的分析深度,实现对埋层结构的无损深度分析。
ULVAC-PHI新推出的XPS设备---PHI GENESIS,可同时搭载常规XPS(Al Kα)和HAXPES(Cr Kα),以及UPS、LEIPS、SAM(AES)等功能配件,打造了全面高性能的电子结构综合分析平台。欢迎联系我们,了解更多详情!
参考文献
[1] Renault O, et al. Analysis of buried interfaces in multilayer device structures with hard XPS (HAXPES) using a CrKα source. Surf Interface Anal. 2018;50:1158–1162. DOI: 10.1002/sia.6451.
下载本篇解决方案:
更多![]()
反光电子能谱IPES专辑之原理篇
固体的电学、光学和化学性质深受其占据态(occupied state)和非占据态(unoccupied state)电子结构的共同影响。在半导体材料中,费米能级两侧的电子结构对杂质掺杂、能带调控以及器件的研发与应用至关重要,尤其是非占据态能级结构,它直接决定了电荷的转移和输运性能。虽然占据态的电子信息可通过光电子能谱,如XPS和UPS来解析,但由于非占据态没有电子填充,传统的光电效应方法无法有效获取其能带信息。
半导体
2024/04/07









