NX2000(FIB-SEM-Ar)三束在单晶铁与单晶硅透射电镜样品制备中的应用
2019/05/30 15:35
阅读:525
分享:方案摘要:
方案详情:
NX2000(FIB-SEM-Ar)三束在单晶铁与单晶硅透射电镜样品制备中的应用
聚焦离子束(focused ion beam,FIB)凭借其独特的微/纳尺寸加工制造的能力和优势,在高性能纳米材料的评价和分析领域已成为不可或缺的工具。近来,目标观察物更趋微细化,更薄,更低损伤样品的制备需求更进一步凸显。本文旨在通过几个案例来向大家展示NX2000 (FIB-SEM-Ar三束装置) 在制备高质量的TEM薄膜样品领域的探索与应用。
NX2000简介
日立高新公司,整合了高性能FIB技术和高分辨SEM技术,再加上加工方向控制技术以及Triple Beam(选配)技术,推出了新一代产品NX2000。运用高对比度,实时SEM观察和加工终点检测功能,可制备厚度小于20 nm的超薄样品。加工方向控制技术(Micro-sampling系统(选配)+高精度/高速样品台*)对于抑制窗帘效应的产生,以及制作厚度均一的薄膜类样品给予厚望。Triple Beam(选配)可提高加工效率,并能高效的消除FIB损伤。 
NX2000
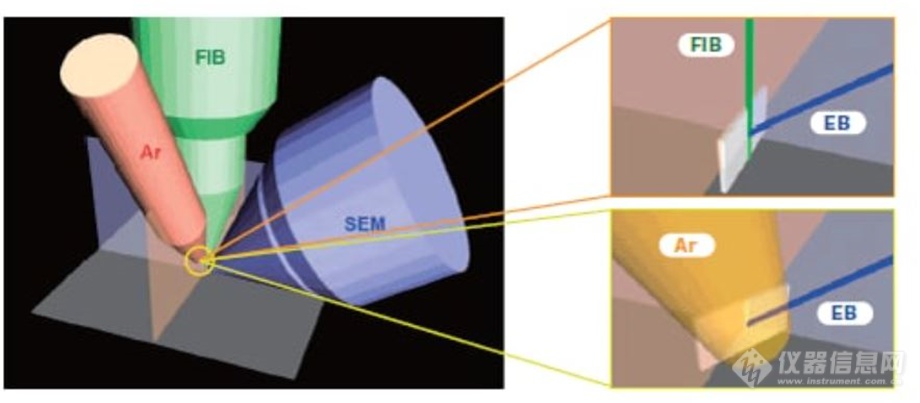
Triple Beam(FIB-SEM-Ar)可提高加工效率,并能高效的消除FIB损伤
NX2000的应用实验
(1)铁单晶损伤层的观察
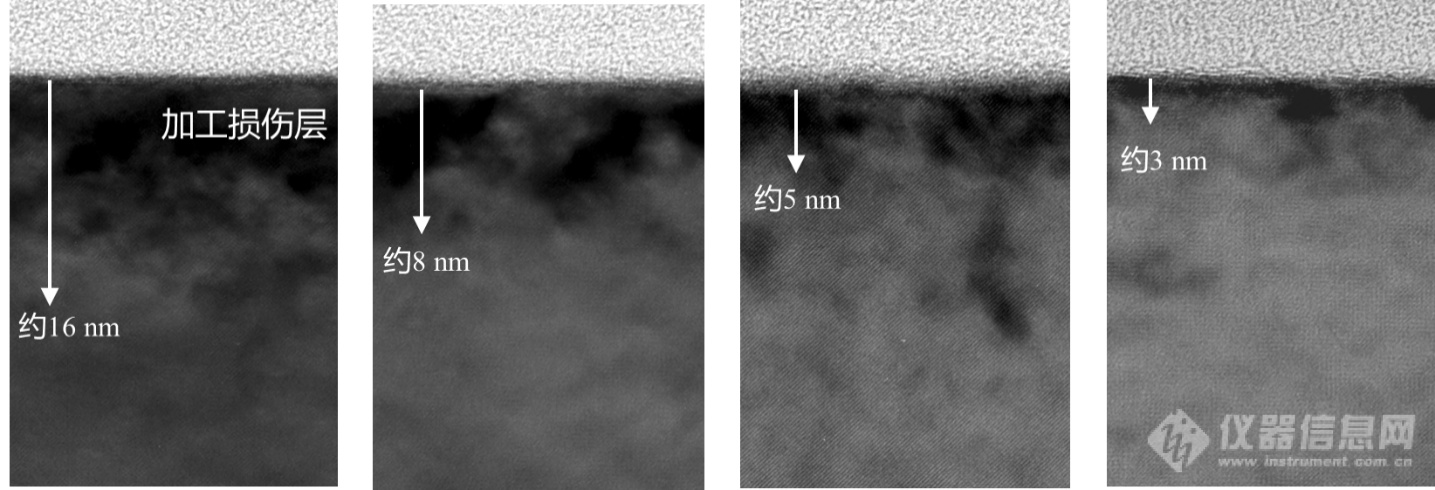
(a)FIB 30 kV (b)FIB 10 kV (c)FIB 5 kV (d)Ar 1 kV,10°
图1单晶铁加工损伤层的观察结果;
加工:NX2000,TEM观察:HF-3300(加速电压300kV),电子束入射方向:[100]
一般情况下,电解液抛光法作为一种无损处理法来制备金属类材料TEM薄膜样品,然而它也存在一些问题,例如磁性会影响电子显微镜,废液处理成本很高。此次,使用NX2000特有的FIB-SEM-Ar三束装置来制备金属TEM薄膜样品,并评估了金属材料TEM薄膜样品在不同制备条件下所产生的加工损伤。如图1所示,该实验使用NX2000 来制备单晶铁TEM样品,使用HF-3300 TEM(300 kV) 对实验结果进行观察。 其中FIB的加工条件分别是:a.FIB 30kV;b.FIB 10kV;c.FIB 5kV;d.Ar+ 1kV, 10°入射。实验发现:a.FIB在30 kV加工条件下产生的损伤层约为16nm;b.FIB在10 kV加工条件下产生的损伤层约为8 nm;c.FIB在5 kV加工条件下产生的损伤层约为5 nm;d.在FIB 5 kV加工后,使用低加速电压(1kV)、低角度(10°)入射的Ar离子束减薄样品,最终使产生的损伤层降低至3nm左右。从NX2000制备铁单晶透射样品得到的实验结果可以发现,损伤层厚度会随着FIB的加速电压的降低以及氩离子束的减薄来得到改善。
作者:日立ハイテクノロジーズ 佐藤高広、伊井由花、株式会社日立ハイテクサイエンス 清原正寛
(2)使用三束装置系统制备高质量金属材料TEM薄膜样品
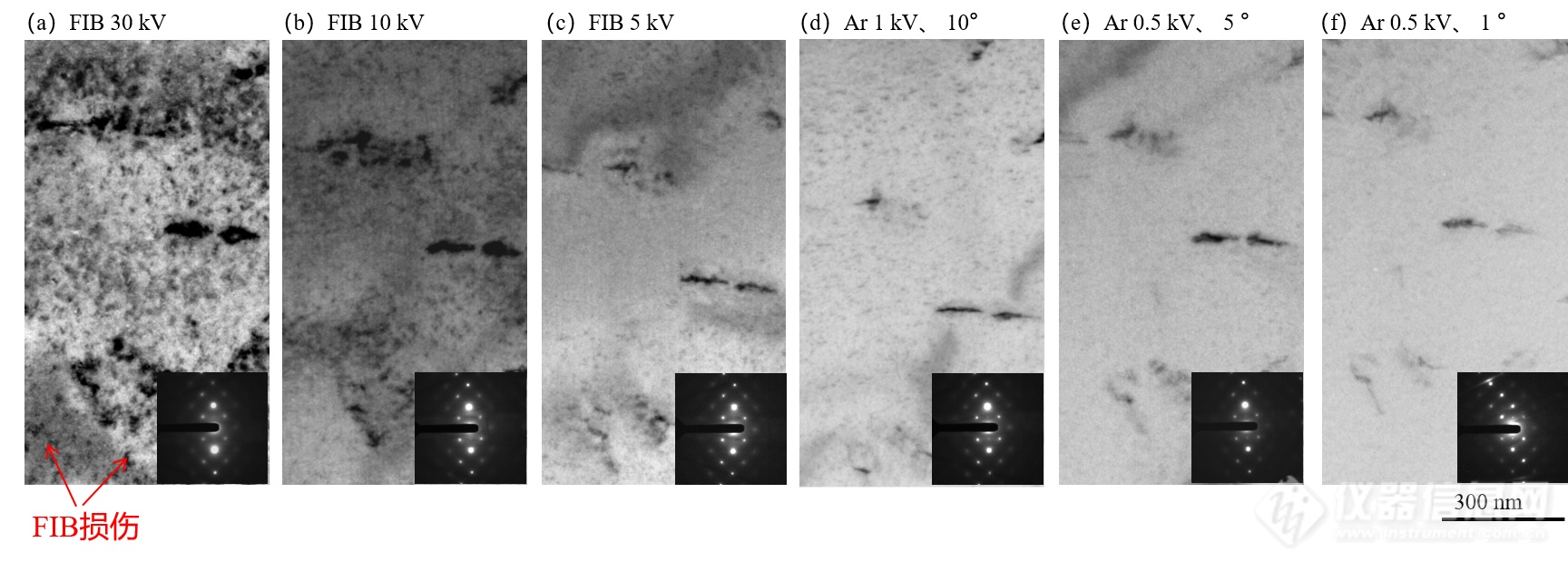
图2 不同加工条件下得到的单晶铁TEM像
加工:NX2000,TEM观察:HF-3300(加速电压300kV),电子束入射方向:[100]
在尖 端设备及高性能纳米材料的评价和分析领域,FIB-SEM已成为不可或缺的工具。近来,目标观察物更趋微细化;更薄,更低损伤样品的制备需求更进一步凸显。由上一个实验得知损伤层厚度会随着FIB的加速电压的降低以及氩离子束的减薄来得到改善。为了进一步论证该结论,进行了第二组实验:采用NX2000(FIB-SEM-Ar三束装置) 来制备高质量的金属材料TEM薄膜样品。不同加工条件下得到的单晶铁TEM实验结果如图2所示,该实验使用NX2000 (FIB-SEM-Ar三束装置)来制备单晶铁TEM样品,使用HF-3300 TEM(300 kV) 对实验结果进行观察。 其中FIB的加工条件分别是:a.FIB 30kV;b. FIB 10kV;c.FIB 5kV;d.Ar+ 1kV, 10°入射; e.Ar+ 0.5 kV, 5°入射; f.Ar+ 0.5 kV,1°入射。在图2中观察到的黑/白色斑点属于加工过程中离子束对样品产生的损伤。从(a),(b),(c)的实验结果可以发现加工损伤会随着FIB加工电压的降低而改善。另外一方面,从(d),(e),(f)条件下得到实验结果发现,使用低加速电压、低角度入射的Ar离子束减薄样品可以减少FIB加工中产生的损伤层。

图3 采用三束装置(FIB-SEM-Ar)制备的铁单晶TEM图像
加工:NX2000,观察:HF-3300,电子束入射方向:[100]
如图3所示,是使用NX2000 (FIB-SEM-Ar三束装置) 制备的铁单晶TEM像。在FIB加工后使用了Ar+来消除FIB损伤,Ar+的加工条件是:0.5 kV,5°入射。在约为4.5μm×2.5μm的视野范围内,可以清楚地观察到此样品的内部结构。通过此实验结果发现采用NX2000(三束装置)制备TEM样品的过程中,因为使用了低加速电压、低角度入射的Ar离子束减薄样品,可以有效的降低金属材料的FIB损伤层,从而制备出对高质量的TEM薄膜样品。
作者:日立ハイテクノロジーズ 佐藤高広、伊井由花、株式会社日立ハイテクサイエンス 清原正寛
(3)低电压FIB与ArIB在加工样品中所产生的损伤层厚度的比较
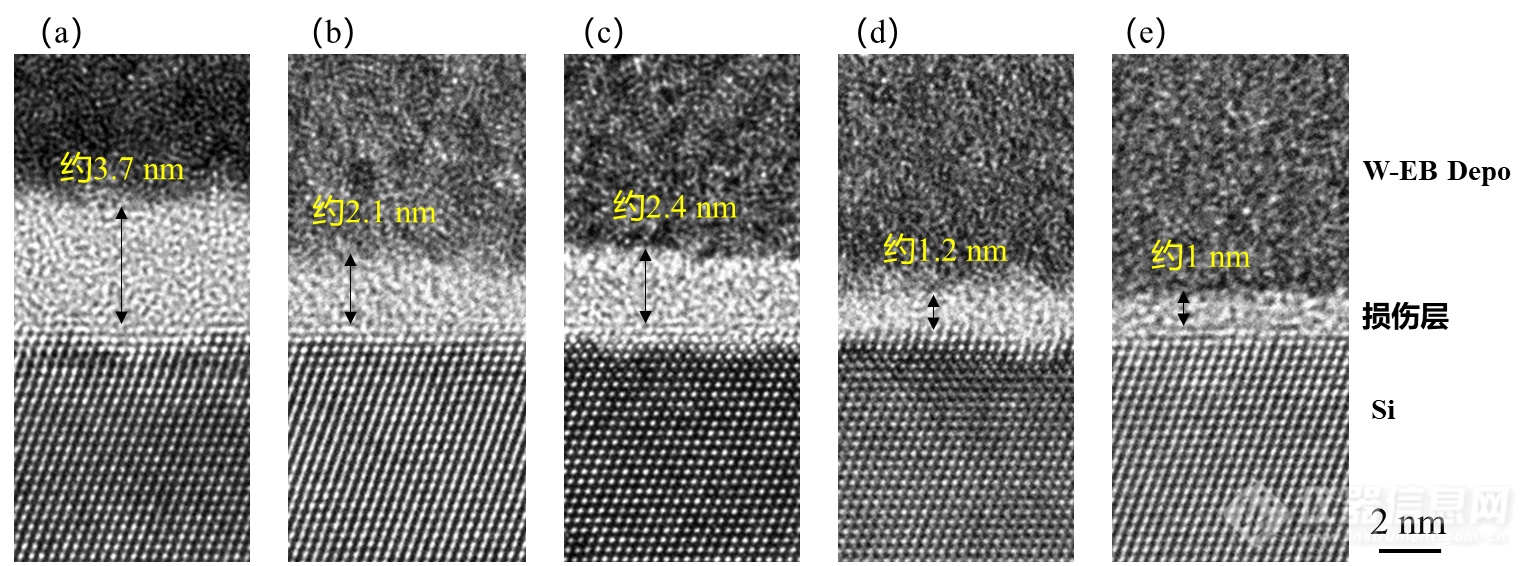
图4 FIB和ArIB损伤层厚度的比较
(a)FIB 5 kV、(b) FIB 2 kV、(c)ArIB 1 kV 20°入射、(d)ArIB 1 kV 5°入射、(e)ArIB 0.5 kV 5°入射
加工: NX2000 (FIB-SEM-Ar三束装置)、TEM观察:HF-3300(加速电压300 kV)、样品: 单晶Si
采用低加速氩离子束以及高电流密度FIB,可实现快速加工、广域加工,制备出高质量的TEM样品。比较了FIB和氩离子束(ArIB)进行单晶铁的TEM样品制备过程所产生损伤层的厚度变化,在此基础上,我们想做一系列实验来比较单晶硅TEM样品制备过程所产生损伤层的厚度随FIB和氩离子束(ArIB)加工条件改变的变化趋势。该实验使用NX2000 (FIB-SEM-Ar三束装置)进行单晶Si透射样品的制备,使用HF-3300 TEM(300 kV) 对实验结果进行观察。结果如图4所示,TEM样品的制备条件分别是(a)FIB 5 kV、(b)FIB 2 kV、(c)ArIB 1 kV ,20°入射、(d)ArIB 1 kV ,5°入射、(e)ArIB 0.5 kV, 5°入射。Ar+使用了低加速电压、低角度入射的加工条件,使得FIB损伤层的厚度降低到1nm左右。由此我们可以得出结论FIB-SEM-Ar三束装置使用Ar离子加工样品对降低材料的损伤层,得到高质量的TEM样品是可行的。
作者:日立ハイテクノロジーズ 佐藤高広、黒田靖 株式会社日立ハイテクサイエンス 清原正寛
通过以上的实验结果发现采用NX2000(三束装置)制备TEM样品的过程中,使用低加速电压、低角度入射的氩离子束减薄样品可以有效的减少金属材料/单晶硅的FIB损伤层,从而制备出对高质量的TEM薄膜样品。
下载本篇解决方案:
更多![]()
智能设备中光学材料的测定实例
智能设备的功能日益多元化,如人脸识别、测距、AR功能等。其中,相机在追求高分辨的 同时,还要求外形小巧、高倍率变焦。 本资料中的数据为测试示例,不代表真实数据,仅供参考。 注意:产品升级后,上述仪器的外观或技术参数可能会有变化。 图2 潜望镜式镜头的示例 通过搭载潜望镜式镜头,可以实现相机的小巧与高倍率变焦。传统相机镜头与智能设备垂直 放置。潜望镜式镜头平行于智能设备安装,从而实现设备的超薄化。此外,变焦倍率越高, 焦距越长,因此,需要一定的纵深空间安放镜头。传统镜头由于是垂直放置,增加焦距则需增加设备厚度,而潜望镜式镜头通过棱镜改变光路方向,将焦距所需要的厚度转化为与智能设备平行的长度,同时实现了超薄化与高倍率变焦。 此次实验,在日立紫外可见近红外分光光度计UH4150上加装微小棱镜测定附件,并使用专用支架※1,测定潜望镜式镜头中的棱镜。
电子/电气
2022/06/14
使用标准积分球与全积分球测定透镜
使用紫外分光光度计测定固体样品时,会用到积分球。积分球的种类繁多,有不同的尺寸、形状、涂层材质。这里以透镜测定为例,介绍标准积分球和全积分球。
电子/电气
2022/06/14
通过UH4150测定微小尺寸的红外截止滤光片
智能手机镜头和车载摄像头上的CCD和CMOS图像传感器采用红外截止滤光片,可以过滤降低画质的红外线,让可见光透过。 这种滤光片极其微小,需要在UH4150上配置微小样品透过率测定附件或微小°镜面反射附件进行测定。
电子/电气
2022/06/14
自动角度可变附件简介
自动角度可变附件可自动测量入射角在5°~70°范围内的正反射光谱及入射角在0°~70°范围内的透射光谱。在品质管理和研究开发方向,需要多角度或对多个样品进行测定时,使用自动角度可变附件,可节省积分球(检测器)设置时间,大幅缩短了作业时间。还可在固定波长下,测定样品的正反射率、漫反射、透射率等。
电子/电气
2022/06/14










