










![]()
本文对比研究了商品化银浆体系和新银浆体系的润湿性对芯片键合性能的影响。
![]()
银浆:新型银浆体系(记为 B),其与银浆A体系的区别在于粘合促进剂的不同。
基底:环氧玻纤基材。
采用德国 KRÜSS 公司的 DSA100 测量银浆与基材的接触角。

DSA100接触角测试仪
![]()
银浆B在基材上的接触角低于银浆A,表明银浆B的浸润性良好,有利于在基板和芯片中间产生连续的银浆层。
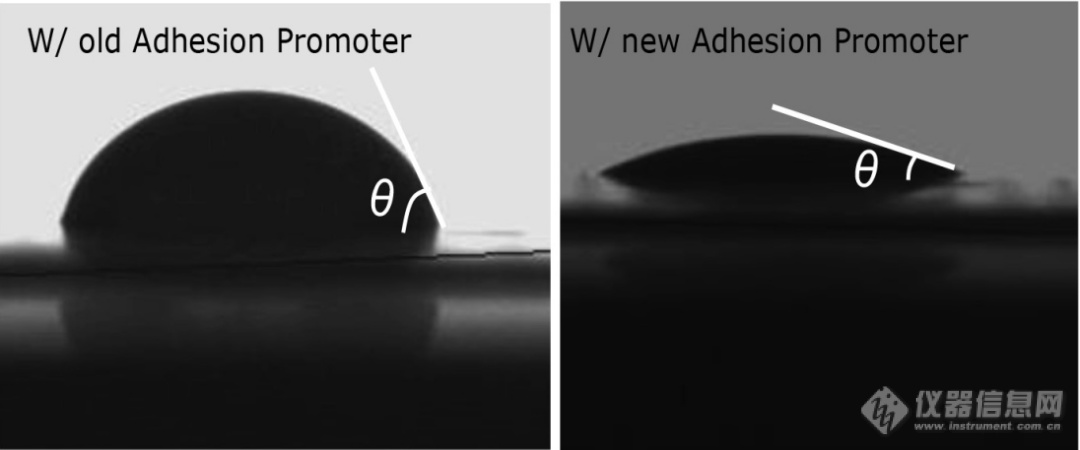
而剖面形貌分析也证实银浆 B在芯片表面形成了连续的银浆键合层。对银浆A的芯片键合层剖面进行观察,发现银浆A的键合层存在空洞,证明银浆在点胶过程中没有完全浸润基材的表面,使空气封闭在键合层中。而空气在银浆固化的过程中受热膨胀,不仅减小了界面处的银浆结合面积,减弱了键合强度,而且也导致了过高的键合层厚度。

图2,银浆 B 键合层剖面的 SEM 照片

图3,银浆 A 键合层剖面的 SEM 照片
![]()
可看出减少银浆层的空洞是提高芯片键合强度的一种有效方法。合适的粘合促进剂可以帮助增加银浆在基材表面的浸润并减少界面银浆层里的空洞。
参考文献:
本文有删减,详细信息请参考原文。
堵美军,梁国正.高芯片键合质量与高生产率的新型银浆体系的研究[J].中国集成电路,2021,1-2(260-261): 63-69.
[来源:克吕士科学仪器(上海)有限公司]

2024.07.17

2024.07.05

2024.06.26

2024.06.07

邀请函:KRÜSS诚邀您参加2024中国涂料油墨峰会暨展览会
2024.05.27

2024.05.22
版权与免责声明:
① 凡本网注明"来源:仪器信息网"的所有作品,版权均属于仪器信息网,未经本网授权不得转载、摘编或利用其它方式使用。已获本网授权的作品,应在授权范围内使用,并注明"来源:仪器信息网"。违者本网将追究相关法律责任。
② 本网凡注明"来源:xxx(非本网)"的作品,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,且不承担此类作品侵权行为的直接责任及连带责任。如其他媒体、网站或个人从本网下载使用,必须保留本网注明的"稿件来源",并自负版权等法律责任。
③ 如涉及作品内容、版权等问题,请在作品发表之日起两周内与本网联系,否则视为默认仪器信息网有权转载。
![]() 谢谢您的赞赏,您的鼓励是我前进的动力~
谢谢您的赞赏,您的鼓励是我前进的动力~
打赏失败了~
评论成功+4积分
评论成功,积分获取达到限制
![]() 投票成功~
投票成功~
投票失败了~