研磨液中分散剂的添加对铜阻挡层平坦化后划痕的影响

全文共3140字,阅读大约需要 12分钟
1
本文的应用背景
尽管铜化学机械平坦化(CMP)已成为半导体制造业实现集成电路局部和全局平坦化的关键技术,但在阻挡层CMP过程中仍有一些问题需要克服,如有机残留物、表面颗粒、蝶形缺陷、侵蚀和划痕,其中,划痕将是CMP过程中最有害的缺陷。因为在CMP后的清洗过程中,产生的其他类型的缺陷可以通过不同方法去除,但晶圆表面的微划痕不容易消除,这些微划痕可能会导致严重的电路故障,从而影响晶圆产量。
我们所熟知的CMP工艺由晶圆和抛光垫之间的化学和机械相互作用组成。一般认为,CMP浆料中团聚的大颗粒或平坦化过程中聚集的大颗粒是CMP划痕的主要来源。部分研究通过单颗粒光学传感技术(SPOS)来量化浆料中大颗粒浓度(LPC),并建立LPC与CMP过程中划痕形成的相关性。
2
本文应用思路
本文重点研究乙氧基化二烷醇(EDA)这一分散剂的添加浓度对减少CMP过程中铜表面的划痕的影响。通过考察分散剂添加浓度与浆料粒径分布(PSD)、ZETA电位、LPC的关系。另外,通过扫描电镜确定晶圆表面缺陷情况,具体研究思路如下图所示:
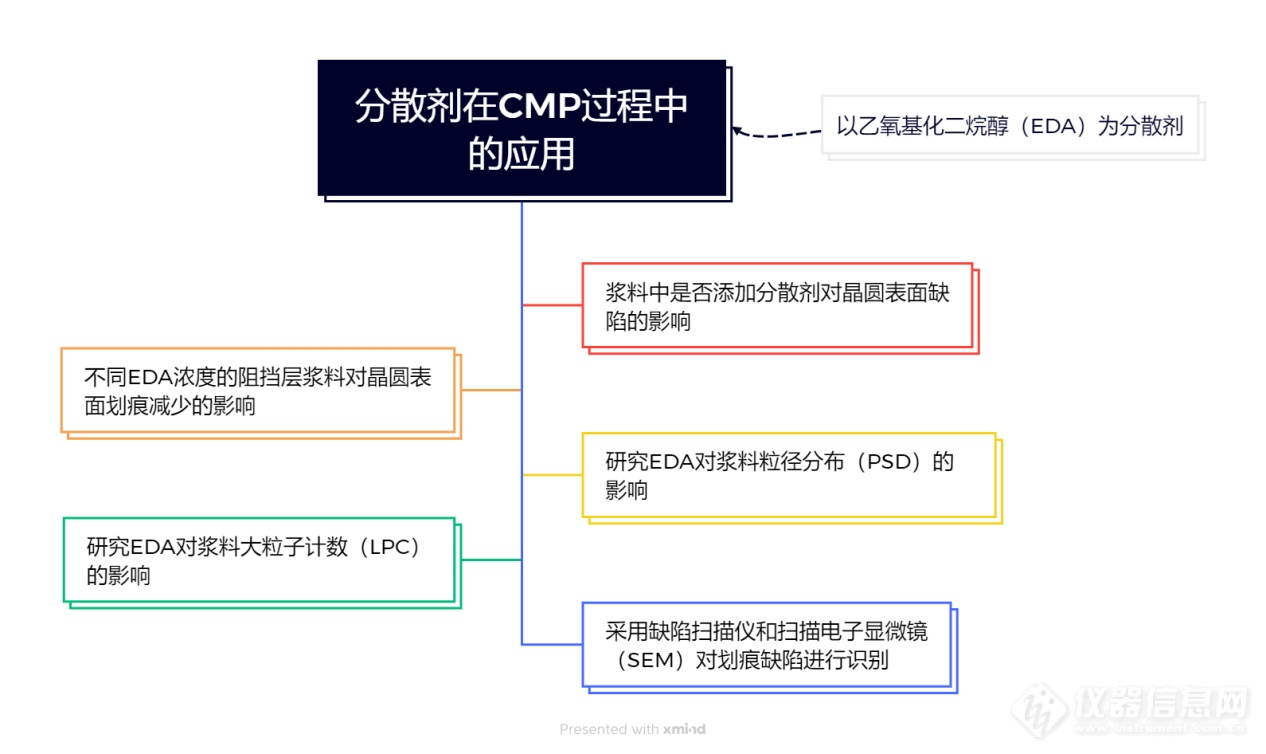
3
试验准备
在颗粒稳定乳液中,乳液类型的选择是由其润湿性决定的,并且用接触角进行量化。根据班克罗夫特规则,亲水颗粒(接触角小于90°的颗粒)能更好地稳定O/W乳液。相反,疏水颗粒(接触角大于90°的颗粒)更适合于稳定W/O乳液(图2)。

阻挡层CMP的抛光垫使用FUJIBO H7000HN,用于阻挡层CMP的研磨液中成分包含20%的胶体硅磨料(平均粒径接近90nm),乙氧基化二烷醇(EDA)[(C2H4O)n. C10H22O,n = 7] 用作为分散剂以减少划痕,阻挡层研磨液配有20wt%硅磨料、0.15wt% FA/O II络合剂、0.2wt% BRIJ30作为非离子表面活性剂和不同浓度的EDA
KLATencor 2915光学显微镜扫描抛光铜膜上残留的缺陷;KLA-Tencor SEMVision俯视扫描电子显微镜能确定模式晶片上不同缺陷类型
Figure 1. Cross section view of pattern wafers used in the experiments.
4
表征方法
Nicomp Z3000(老型号:Nicomp 380ZLS)用于测定了研磨液的平均粒径和ZETA电位
AccuSizer A7000 APS (老型号:AccuSizer 780APS)用于测定尾端大颗粒浓度(≥0.5 μm)
接触角测量仪JD200D测量研磨液表面张力、晶片与浆料之间的接触角
5
方案流程
流程一
研磨液中是否添加分散剂对晶圆表面划痕数量的影响:分别使用不含0.02wt% EDA和含0.02wt% EDA的研磨液对铜晶圆表面进行抛光,利用扫描电镜图像观察晶圆表面的划痕缺陷数量。观察EDA的添加与晶圆表面缺陷数量的关系。
结果一
采用不含EDA的研磨液抛光后得到的晶圆表面具有相对较高的缺陷数(~861ea),但当采用加入0.02wt% EDA的研磨液抛光时,缺陷数减少了近一半。扫描电镜得到的晶圆表面图像如图2所示,晶圆片表面的缺陷主要由划痕组成。
结果表明:
在研磨液中加入EDA可以有效地减少抛光后晶圆表面缺陷数量,划痕数量也明显减少。
Figure 2. Defect map and typical SEM review results without(a) and with the addition of 0.02wt% EDA(b).
流程二
不同EDA浓度的研磨液对晶圆表面划痕数量的影响:选取5种不同EDA添加浓度:0.05wt%、0.1wt%、0.25wt%、0.35wt%和0.5wt%的研磨液进行晶圆平坦化实验,并测试抛光后晶圆表面的划痕缺陷数量。
结果二
图3为晶圆缺陷图随EDA浓度的变化情况。在0.05wt%~0.35wt%的范围内,缺陷数随着EDA浓度的增加而显著降低,当EDA浓度进一步增加至0.5wt%时,其缺陷数保持不变。
Figure 3. Defect map and count of wafer surface polished by barrier slurry with different concentration of EDA: (a)0.05wt%, (b)O.1wt%, (c) 0.25wt%, (d) 0.35wt%, 0.5wt%.
图4为不同EDA浓度研磨液对晶圆表面划痕数量的影响,划痕数通过G4 SEM统计系统计算,与晶圆表面划痕数的结果相对应。可以看出,当EDA浓度从0.05wt%增加到0.35wt%时,划痕数首先从214ea逐渐减少到14ea,当EDA浓度进一步增加到0.5wt%时,划痕数趋于平稳。结果表明,EDA表面活性剂对晶片表面缺陷数量有很大的影响,在研磨液中添加EDA能有效降低晶圆表面的划痕数。
Figure 4. Seratch counts as a function of EDA a concentrations.
图5为用不同EDA浓度研磨液在铜晶圆上抛光后形成的划痕的扫描电镜图像,随着研磨液中EDA浓度的增加,划痕的长度和强度明显减小。
结果进一步表明:在研磨液中添加EDA可以有效地避免划痕的产生。
Figure 5. SEM image of seratch on copper pattern wafers polished with different concentration of EDA: (a)0.05wt%, (b)O.1wt%, (c) 0.25wt%, (d) 0.35wt%, 0.5wt%.
流程三
研究EDA添加量对硅磨料在研磨液中分散性的影响及研磨液中尾端大粒子的关系,采用动态光散射(DLS)技术检测研磨液颗粒粒径分布(PSD),利用ZETA电位检测侧面反映研磨液的稳定性
结果三
粒径分布及ZETA稳定性测试结果:
图6为不同EDA浓度研磨液的粒径分布图(6.a),研磨液平均粒径与EDA添加浓度的关系图(6.b),研磨液粒径分布的PDI值与EDA添加浓度的关系图(6.c)。
结果表明
在研磨液中添加EDA(EDA浓度从0.05wt%增加到0.50wt%)对其平均粒径影响不大,主体粒径在90nm左右。(参考6.a 和 6.b)
随着研磨液中EDA添加浓度的增加(EDA浓度从0.05wt%增加到0.35wt%),研磨液的粒径分布均一性变好,其粒径分布图变窄(参考6.a),PDI值(即多分散系数,其值越小表明体系均一性越好)变小(参考6.c)。进一步增加EDA的浓度(EDA浓度从0.35wt%增加到0.50wt%),则对研磨液粒径分布的均一性影响较小对其平均粒径影响不大(参考6.a 和 6.c)。
综合来说,在研磨液中添加EDA可有效提高研磨液粒径分布均一性,但对主体粒径影响不大
Figure 6. Relationship between EDA nonionic surfactant and (a) particle size distribution, (b) intensity average particle diameters. and (c) polydispersity indexes.
常规而言,研磨液的Zeta电位反映了其稳定性。也就是说,Zeta电位的绝对值越大,研磨颗粒能更好地分散在研磨液中。图8显示了研磨液的Zeta电位随EDA浓度的变化关系。随着EDA浓度的增加,研磨液的Zeta电位的绝对值增加,粒子间的排斥力增强,越不容易团聚。推测是由于EDA表面活性剂分子的环氧乙烷段与磨料颗粒表面的硅醇基团相互作用所致。
结果表明:在研磨液中加入EDA后,其Zeta电位绝对值越大,可有效降低纳米二氧化硅磨料间的团聚。
Figure 7, Zeta potential of the slurry as a function of EDA concentration.
流程4
通过SPOS单颗粒光学传感技术检测0.5μm以上的尾端大颗粒与不同EDA浓度之间的关系。
结果4
在图9显示了研磨液中0.5μm以上的颗粒数与EDA浓度的关系。当研磨液中EDA浓度从0.05wt%增加到0.25wt%时,≥0.5μm的颗粒数量从2.68*10^5颗/ml显著减少至1.32 × 10^5 颗/ml,当EDA浓度进一步增加到0.5wt%时,则进一步下降到1.05×10^5颗/ml。
结果表明:
在研磨液中加入EDA可以有效减少大颗粒(≥0.5μm)的数量。
Figure 8. Relationship between LPC for particles with diameter ≥0.5pm and different EDA concentrations.
6
总结
本研究采用乙氧基化二烷醇(EDA)作为分散剂,研究其添加量对于Cu CMP后晶圆划痕数量的影响。通过考察不同分散剂添加量下研磨液粒径分布(PSD)、ZETA电位、LPC的关系。另外,通过扫描电镜确定晶圆表面缺陷情况,实验结果表明:
研磨液中随着EDA的加入,其主体粒径变化不大,但粒径分布均一性变好;Zeta电位绝对值变大,说明体系更稳定;通过SPOS技术测得的研磨液尾端大颗粒(≥0.5 μm)数量减少, 。
扫描电镜结果表明,研磨液中EDA的添加可有效减少抛光后晶圆表面缺陷和划痕数;研磨液中尾端大颗粒浓度与抛光后晶圆表面缺陷数呈正相关。
推测研磨液中添加EDA可增强粒子间的斥力,减少二氧化硅颗粒间的团聚,从而使得研磨液体系更均一稳定,尾端大颗粒数量降低。
可以简要理解为: EDA 的添加,使得 Slurry 的稳定性变好,均一性变好,所以 LPC 变少,因为 LPC 变少,所以划痕变少
文献来源: Li Y , Liu Y , Wang C ,et al.Role of Dispersant Agent on Scratch Reduction during Copper Barrier Chemical Mechanical Planarization[J].ECS Journal of Solid State Science and Technology, 2018(6):7.
推荐型号及优势特点
本文中,用于研磨液粒径分布(PSD)以及Zeta电位检测对应的仪器型号是Nicomp Z3000纳米激光粒度仪;用于测量研磨液中LPC对应的仪器型号是Accusizer A7000系列颗粒计数器
Nicomp Z3000纳米粒度及Zeta电位分析仪:采用动态光散射(DLS)原理检测分析样品的粒度分布;基于多普勒电泳光散射原理(ELS)检测Zeta电位。
粒径检测范围:0.3nm~10.0μm
Zeta电位检测范围:-500mV~+500mV,超高灵敏度的Zeta电位模块
搭载Nicomp多峰算法,可以实时切换成多峰分布观察各部分的粒径
高分辨率的纳米检测,Nicomp纳米激光粒度仪对于小于10nm的粒子仍然现实较好的分辨率和准确度。

高斯粒径分布图

Nicomp多峰粒径分布图

Nicomp Z3000纳米激光粒度仪
AccuSizer颗粒计数器系列:采用单颗粒光学传感技术(SPOS)检测液体中的颗粒数量的同时精确测量颗粒的数量及粒度分布
检测范围为0.5~400μm(可将下限拓展至0.15μm)
0.01μm的超高分辨率,该系列具有1024个数据通道,能反映复杂样品的细微差异,为研发及品控保驾护航。
10PPT级别的超高灵敏度,即使只有微量的颗粒通过传感器,也可以精准检测出来。
模块化设计,具有多模式进样系统
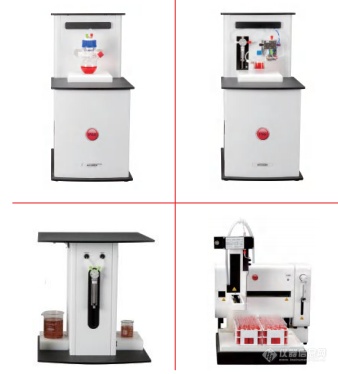


更多![]()
Particle Genius——奥法美嘉新售后服务号:科技护航,服务升级
厂商
2024.07.02
AccuSizer粒度仪数据说明
厂商
2023.11.08
诚邀您参与首届未来颗粒前沿论坛
厂商
2023.03.28
奥法美嘉宣传材料声明
厂商
2022.07.19









