产品应用进口硅片直径:2~8英寸 掺杂:N/P 晶向:100/110/111 电阻率:0.001~20000Q.cm国产硅片直径:2~8英寸 掺杂:N/P 晶向:100/110/111 电阻率:0.001~20000Q.cm高阻硅片(进口)FZ硅片直径:2~8英寸 掺杂:N/P 电阻率:10Q.cm~20kΩ.cm及以上MCZ硅片直径:2~8英寸 掺杂:N/P 电阻率:10Q.cm~20kQ.cm及以上测试片直径:2~8英寸,该类片可作为工艺陪片使用,或者作为对电学性能没有要求的正片使用外延片直径:2~8英寸,根据用户提供的衬底和外延层详细指标进行定制氧化硅片(国产/进口)直径:2~8英寸 氧化层厚度:200A~20um 氧化层厚度3um,需根据用户需求定制Dummy直径:2~12英寸 一般作为没有洁净度要求的单项工艺测试SOI硅片直径:4~8英寸 根据用户提供顶层硅、氧化硅、载片这三层的指标参数,检索库存或特殊定做其他特殊硅片1.超厚硅片2.招薄硅片3.金属化硅片(硅片表面镀有各类金属,Cr,Ti,Ni,Cu,Au ,Pt等)4.氮化硅硅片(普通LPCVD生长,或低应力SiN)5.超平硅片6.特殊晶向硅片7740玻璃片(Corning)BF33玻璃片(Sochott)直径:4~8英寸 厚度:300um~5mm,参数及包装标准:表面光洁度:0.5nm(两面光学研磨) 可定制切边:32.5±1mm(4寸) 导角:0.05~0.2mm石英片直径:2~6英寸 厚度:200um~5mm 分为单晶石英片和熔融石英玻璃片铌酸锂,钽酸锂GaNd等特殊材质衬底直径:2~4英寸砷化镓片直径 2~6英寸 晶向 100蓝宝石直径 2~6英寸 晶向 CA.R.M等.厚度:200um~1mm产品型号类型型号光源胶厚适用范围微流控胶SU-8 2000系列Near UV(350-400nm),推荐i-Line,也可用于E-beam,X-ray0.5-650um高深宽比,垂直性好,耐高温,光学透明,适用于MEMS工艺,钝化层,微流控以及光电子器件SU-8 3000系列5-100um高深宽比,垂直性好,耐高温,光学透明,较2000系列具有更好的基底粘附性,更不易在工艺过程中产生内应力积累,适用于MEMS工艺,微流控,光电器件制作以及作为芯片绝缘、保护层使用HTG910-Line95-168um厚胶,适用于电镀KMPRNear UV(350-400nm),推荐i-Line,也可用于E-beam,X-ray5-115um高分辨率,垂直性好,显影适用TMAH&KOH,易去胶,耐干法刻蚀SU-8干膜-Line5-1000um多种厚度选择,深宽比5,粗糙度小,耐腐蚀电子束胶SML系列(耐刻蚀)E-beam50-5000nmEM RESIST,5nm线宽,高分辨率,高深宽比,垂直性好,耐刻蚀,与基底粘附性好PMMA国产E-beam40-7um高分辨率,涵盖40k-1000k多种分子量,适用于掩模版制作,金属剥离lift-off和电镀掩模等工艺PMMA/MMA(进口)E-beam,X-ray&deepUV imaging50-5000nmMicroChem,950K,495K两种分子量,线宽0.1um,与基底粘附性好,适用于电子束光刻,多层T-Gate剥离,晶圆减薄等PMMA(进口)E-beam30-2000nm高分辨率电子束胶,具有35K,120K,350K,495K,950K等多种分子量,适用于各种电子束光刻SU-8GM1010E-beam,X-ray500-700nm可用于做高宽比较大的纳米结构HSQE-beam,X-ray30-950nm高分辨率,耐刻蚀,垂直性好,最常用的电子束负胶Lift-off胶ROL-7133g/h/i-Line2.2-4um负性光刻胶,倒角75~80°,粘附性好,使用普通正胶显影液,适用于制作金属电极或导线LOR/PMGI-SF与g/h/i-Line,DUV,193nm,E-beam光刻胶兼容50nm-6um高分辨率,可用于0.25um Lift-off工艺,粘附性好,良好的耐热稳定性,易去胶,作为双层胶的底层胶使用HTIN160-Line1.2-2um高分辨率负胶,400nm线宽,高对比度、高宽容度、易去胶,应用于负胶光刻、ift-off工艺,制作电极,导线等.NLOFi-Line1.8-12um感光性好,高分辨率,耐高温,适用于lift-off工艺NR系列i-Line或g/h-Line0.5-20umFuturrex,粘附性好,耐高温,适用于MEMS、封装、生物芯片等工艺DUV光刻胶HTKN601系列248nm0.4-1.2um高分辨率负胶,300nm线宽,适用于半导体的光刻工艺和金属剥离工艺RD1000248nm150-300nm分辨率高,130nm线宽,国产深紫外光刻胶,已经在量产单位规模使用正胶HTI751-Line0.8-1.2um国产高分辨率正胶,0.35um线宽,高分辨率、低驻波效应、垂直度好,应用于MEMS、IC工艺RDP-8003(55cp)i-Line,Broadband2.3-3.5um国产正胶,高分辨率,工艺宽容性高,应用于MEMS、IC、LEDSPR955系列-Line0.7-3.5um分辨率高,0.35um线宽,广泛使用的高分辨率正胶S18xx系列g-Line0.4-2.7um高分辨率正胶,0.5um线宽,粘附性好,最常用的薄光刻胶,稳定可靠SPR220系列-Line1-10um粘附性好,耐干法/湿法刻蚀,适用于选择性电镀,深硅刻蚀等工艺负胶SU-8 GM10xx系列g/h/i-Line0.1-200um高深宽比,透明度高,垂直性好,适用干微细加工的机械结构(MEMS)和其他的微型系统SU-8Microchem系列Near UV(350-400nm)推荐i-Line,也可用于E-beam,X-ray0.5-650um高深宽比,垂直性好,耐高温,光学透明,适用于MEMS工艺,钝化层,微流控以及光电子器件HTG910-Line60-140um适用于选择性电镀NR26-25000P-Line20-120um分辨率高,粘附性好,显影时间短,相对容易去胶临时键合胶激光响应LB210+临时键合TB4130激光响应波长308nm,355nm0.2-0.6um/10-40um激光拆键合,适用于器件晶圆减薄、背面工艺及室温无应力分离等工艺TB1202/12361-50um热滑移拆键合,适用于器件晶圆减薄拿持及其背面工艺等键合胶PermiNex 1000i-Line1-32 um光敏负性,工作温度:200℃,与硅和玻璃粘附性很好PermiNex 2000i-Line1-32 um光敏负性工作温度:200℃、与硅和玻璃粘附性很好兼容水性显影液
 留言咨询
留言咨询

 400-860-5168转0250
400-860-5168转0250
 留言咨询
留言咨询

 400-860-5168转2623
400-860-5168转2623
 留言咨询
留言咨询

 400-860-5168转3281
400-860-5168转3281
 留言咨询
留言咨询
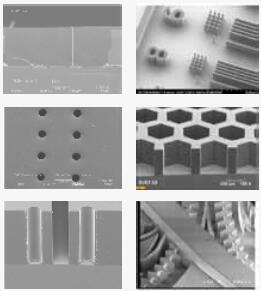
 400-860-5168转2459
400-860-5168转2459
 留言咨询
留言咨询

 400-860-5168转4585
400-860-5168转4585
 留言咨询
留言咨询

 留言咨询
留言咨询

 400-860-5168转4967
400-860-5168转4967
 留言咨询
留言咨询

 400-860-5168转6134
400-860-5168转6134
 留言咨询
留言咨询

 400-860-5168转6134
400-860-5168转6134
 留言咨询
留言咨询

 400-860-5168转4967
400-860-5168转4967
 留言咨询
留言咨询

 400-860-5168转2459
400-860-5168转2459
 留言咨询
留言咨询

 留言咨询
留言咨询
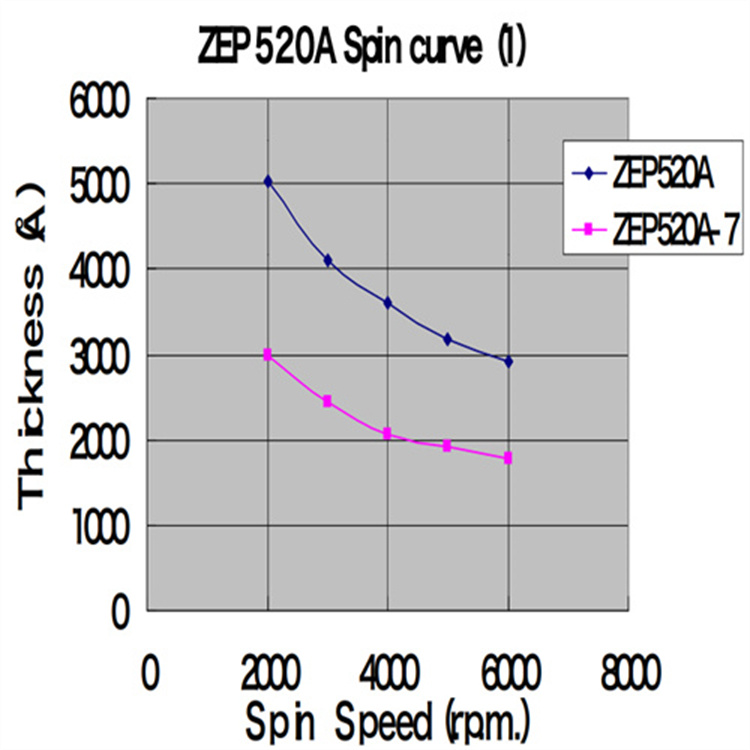
 400-860-5168转4967
400-860-5168转4967
 留言咨询
留言咨询

 留言咨询
留言咨询

 400-860-5168转2459
400-860-5168转2459
 留言咨询
留言咨询

 400-860-5168转2459
400-860-5168转2459
 留言咨询
留言咨询

 400-860-5168转4527
400-860-5168转4527
 留言咨询
留言咨询
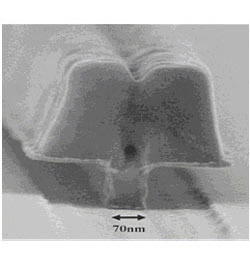
 400-860-5168转2459
400-860-5168转2459
 留言咨询
留言咨询

 留言咨询
留言咨询
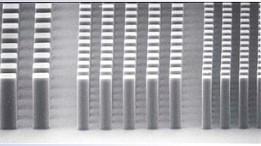
 400-860-5168转2459
400-860-5168转2459
 留言咨询
留言咨询

 400-860-5168转0803
400-860-5168转0803
 留言咨询
留言咨询

 400-860-5168转4338
400-860-5168转4338
 留言咨询
留言咨询

 400-860-5168转1451
400-860-5168转1451
 留言咨询
留言咨询

 400-860-5168转1451
400-860-5168转1451
 留言咨询
留言咨询

 400-860-5168转3569
400-860-5168转3569
 留言咨询
留言咨询

 400-860-5168转0803
400-860-5168转0803
 留言咨询
留言咨询

 400-860-5168转5943
400-860-5168转5943
 留言咨询
留言咨询

 400-860-5168转5943
400-860-5168转5943
 留言咨询
留言咨询

 400-860-5168转1936
400-860-5168转1936
 留言咨询
留言咨询

 400-860-5168转1936
400-860-5168转1936
 留言咨询
留言咨询