SD-160型离子溅射仪是采用二级(DC)直流溅射原理设计而成的离子溅射镀膜设备。二极(DC)直流溅射是一种最简单、可靠、经济的镀膜技术,是许多厂商提供的离子溅射仪的基础。除了具有通常的基本结构外,它的特点是:配置有样品溅室,真空显示表、溅射电流指示表、溅射电流调整控制器、微型真空阀、定时器。工作时结合内部自动控制电路很容易控制真空室压强、电离电流及选择所需的电离气体,获得最佳镀膜效果。特殊设计的钟罩边缘橡胶密封圈,可保证长期使用不会出现影响样品溅射室真空度的玻璃钟罩“崩边”现象;陶瓷密封高压头比通常采用的橡胶密封更经久耐用。根据电场中气体电离特性,采用大容量样品溅射真空室和相应面积溅射靶,使溅射镀层更均匀洁净。此外SD-160应用高稳定性、高灵敏 度电磁阀,采用双气路自动控制系统,更 易实现对样品的保护以及对样品成膜品质 的保证。特别适用于电镜实验室的SEM样品制备和新材料研究的电极制作。 配有高位定性的飞跃真空泵"The SD-160 type ion sputtering apparatus is designed by means of the two stage (DC) DC sputtering principle. DC (DC) sputtering is the simplest, reliable and economical coating technology, and is the foundation of many manufacturers.In addition to its usual basic structure, SD-160 is characterized by the configuration of a sample splash, a vacuum display table, a sputtering current indicator, a sputtering current adjustment controller, a miniature vacuum valve, and a timer. It is easy to control the vacuum chamber pressure, ionization current and choose the required ionization gas when working in conjunction with the internal automatic control circuit, so as to achieve the best coating effect. Specially designed bell ring rubber seal ring,It is guaranteed that the long term use of glass clocks, which will not affect the vacuum of the sample sputter room, is "disintegrating" the ceramic sealing high pressure head is more durable than the usual rubber seal. According to the ionization characteristics of the gas in the electric field, the large volume sample sputtering chamber and the corresponding area sputtering target are used to make the sputtering coating more uniform and clean.In addition, SD-160 uses high stability, high sensitivity solenoid valve and dual gas automatic control system. It is easier to protect the sample and guarantee the quality of film forming. It is especially suitable for SEM sample preparation in electron microscope laboratory and electrode preparation for new material research.High qualitative jump vacuum pump"溅射气体溅射靶材溅射电流溅射速率样品仓尺寸样品台尺寸工作电压根据实验目的可添加氩气,氮气等多种气体。标配靶材为金靶,厚度为50mm*0.1mm。也可根据实际情况配备银靶、铂靶等。最大电流50mA,最大工作电流30mA优于4nm/min直径160mm,高120mm样品台尺寸可安装直径50mm和直径70mm的样品台,也可根据自身要求定制样品台220V(可做110V),50HZ 需要镀膜的样品 电子束敏感的样品非导电的样品新材料主要包括生物样品,塑料样品等。S EM中的电子束具有较高能量,在与样品的相互作用过程中,它以热的形式将部分能量传递给样品。如果样品是对电子束敏感的材料,那这种相互作用会破坏部分甚至整个样品结构。这种情况下,用一种非电子束敏感材料制备的表面镀层就可以起到保护层的作用,防止此类损伤;由于样品不导电,其表面带有“电子陷阱”,这种表面上的电子积累被称为“充电”。为了消除荷电效应,可在样品表面镀一层金属导电层,镀层作为一个导电通道,将充电电子从材料表面转移走,消除荷电效应。在扫描电镜成像时,溅射材料增加信噪比,从而获得更好的成像质量。非导电材料实验电极制作观察导电特性
 留言咨询
留言咨询
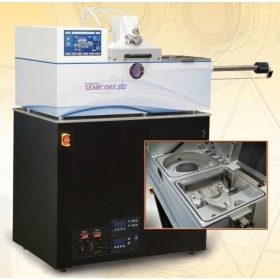
 400-860-5168转3281
400-860-5168转3281
 留言咨询
留言咨询
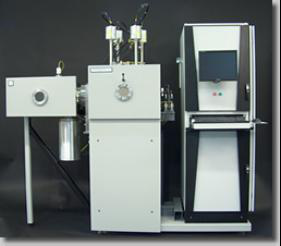
 400-860-5168转4552
400-860-5168转4552
 留言咨询
留言咨询

 留言咨询
留言咨询

 400-860-5168转1013
400-860-5168转1013
 留言咨询
留言咨询

 400-860-5168转6180
400-860-5168转6180
 留言咨询
留言咨询

 400-860-5168转1115
400-860-5168转1115
 留言咨询
留言咨询

 400-860-5168转6180
400-860-5168转6180
 留言咨询
留言咨询

 400-860-5168转0805
400-860-5168转0805
 留言咨询
留言咨询

 留言咨询
留言咨询
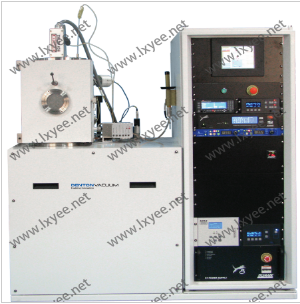
 400-860-5168转4527
400-860-5168转4527
 留言咨询
留言咨询

 400-860-5168转1115
400-860-5168转1115
 留言咨询
留言咨询

 400-860-5168转5089
400-860-5168转5089
 留言咨询
留言咨询

 400-860-5168转2205
400-860-5168转2205
 留言咨询
留言咨询

 400-860-5168转6134
400-860-5168转6134
 留言咨询
留言咨询
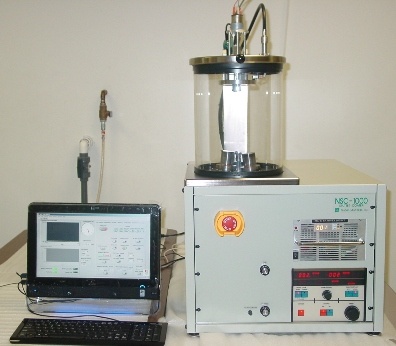
 400-860-5168转3855
400-860-5168转3855
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 留言咨询
留言咨询

 400-860-5168转6180
400-860-5168转6180
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转6180
400-860-5168转6180
 留言咨询
留言咨询

 400-860-5168转2205
400-860-5168转2205
 留言咨询
留言咨询

 留言咨询
留言咨询

 400-860-5168转0805
400-860-5168转0805
 留言咨询
留言咨询

 400-860-5168转6170
400-860-5168转6170
 留言咨询
留言咨询

 留言咨询
留言咨询

 留言咨询
留言咨询

 400-860-5168转2019
400-860-5168转2019
 留言咨询
留言咨询

 400-860-5168转2856
400-860-5168转2856
 留言咨询
留言咨询

 留言咨询
留言咨询

 400-860-5168转4552
400-860-5168转4552
 留言咨询
留言咨询