厂家正式授权代理商:岱美有限公司联系电话:,(贾先生)联系地址:北京市房山区启航国际3期5号楼801公司网址:ThetaMetrisis是一家私有公司,成立于2008年12月,位于希腊雅典,是NCSR' Demokritos' 的微电子研究所的第一家衍生公司。ThetaMetrisis的核心技术是白光反射光谱(WLRS),它可以在几埃到几毫米的超宽范围内,准确而同时地测量堆叠的薄膜和厚膜的厚度和折射率。 FR-Mic: 微米级薄膜表征-厚度,反射率,折射率及消光系数测量仪一、产品简介: FR-Mic 是一款快速、准确测量薄膜表征应用的模块化解决方案,要求的光斑尺寸小到几个微米,如微图案表面,粗糙表面及许多其他表面。它可以配备一台专用计算机控制的 XY 工作台,使其快速、方便和准确地描绘样品的厚度和光学特性图。o 实时光谱测量o 薄膜厚度,光学特性,非均匀性测量,厚度映射o 使用集成的, USB 连接高品质彩色摄像机(CCD)进行成像 二、应用领域 o 大学 & 科研院所o 半导体(氧化物、氮化物、硅、电阻等)o MEMS 元器件 (光刻胶、硅薄膜等)o LEDo 数据存储元件o 弯曲基材(衬底)上的硬/软涂层o 聚合物涂层、粘合剂等o 生物医学( parylene—— 派瑞林,气泡壁厚,等等 )o 其他更多 … (如有需求,请与我们取得联系) 三、产品特点o 单点分析(无需预设值)o 动态快速测量o 包括光学参数(n和k,颜色)o 为演示保存视频o 600 多种的预存材料o 离线分析o 免费软件更新 四、技术参数 FR-Scanner 自动化超高速精准薄膜厚度测量仪 一、产品简介: FR-Scanner 是一种紧凑的台式工具,适用于自动测绘晶圆片上的涂层厚度。FR-Scanner 可以快速和准确测量薄膜特性:厚度,折射率,均匀性,颜色等。真空吸盘可应用于任何直径或其他形状的样片。 独特的光学模块可容纳所有光学部件:分光计、复合光源(寿命10000小时)、高精度反射探头。因此,在准确性、重现性和长期稳定性方面保证了优异的性能。FR-Scanner 通过高速旋转平台和光学探头直线移动扫描晶圆片(极坐标扫描)。通过这种方法,可以在很短的时间内记录具有高重复性的精确反射率数据,这使得FR-Scanner 成为测绘晶圆涂层或其他基片涂层的理想工具。测量 8” 样片 625 点数据60 秒 二、应用领域o 弯曲基材(衬底)上的硬/软涂层o 聚合物涂层、粘合剂等o 生物医学( parylene—— 派瑞林,气泡壁厚,等等 )o 半导体生产制造:(光刻胶, 电介质,光子多层结构, poly-Si,Si, DLC )o 光伏产业o 液晶显示o 光学薄膜o 聚合物o 微机电系统和微光机电系统o 基底: 透明 (玻璃, 石英, 等等) 和半透明 三、产品特点o 单点分析(无需预设值)o 动态快速测量o 包括光学参数(n和k,颜色)o 为演示保存视频o 600 多种的预存材料o 离线分析o 免费软件更新 四、技术参数FR-Scanner: 自动化超高速薄膜厚度测量仪 FR-pOrtable:一款USB驱动的薄膜表征工具 一、产品简介: FR-pOrtable 是 一 款独 特 的 便 携 式 测 量 仪器 , 可 对 透 明 和 半 透明 的 单 层 或 多 层 堆 叠薄 膜 进 行 精 确 的 无 损(非接触式)表征。使用 FR-pOrtable,用户可以在 380-1020nm 光谱范围内进行反射率和透射率测量及薄膜厚度测量。二、应用领域o 大学 & 科研院所o 半导体(氧化物、氮化物、硅、电阻等)o MEMS 元器件 (光刻胶、硅薄膜等)o LEDo 数据存储元件o 弯曲基材(衬底)上的硬/软涂层o 聚合物涂层、粘合剂等o 生物医学( parylene—— 派瑞林,气泡壁厚,等等 )o 其他更多 … (如有需求,请与我们取得联系) 三、应用领域 FR-pOrtable的紧凑尺寸以及定制设计的反射探头以及宽带长寿命光源确保了高精度和可重复的便携式测量。 FR-Portable既可以安装在提供的载物台上,也可以轻松转换为手持式厚度测量工具。放置在待表征的样品上方即可进行测量。 FR-Portable是用于工业环境(如R2R、带式输送机等)中涂层实时表征的可靠而精确的测厚仪。四、产品特点o 一键分析 (无需初始化操作)o 动态测量o 测量光学参数(n & k, 颜色),膜厚o 自动保存演示视频o 可测量 600 多种不同材料o 用于离线分析的多个设置o 免费软件更新服务 五、技术参数FR-pRo: 按需可灵活搭建的薄膜特性表征工具一、产品简介: FR-pRo 是一个模块化和可扩展平台的光学测量设备,用于表征厚度范围为1nm-1mm 的涂层.FR-pRo 是为客户量身定制的,并广泛应用于各种不同的应用 。 FR-pRo 可由用户按需选择装配模块,核心部件包括光源,光谱仪(适用于 200nm-2500nm 内的任何光谱系统)和控制单元,电子通讯模块此外,还有各种各种配件,比如:? 用于测量吸收率/透射率和化学浓度的薄膜/试管架,? 用于表征涂层特性的薄膜厚度工具,? 用于控制温度或液体环境下测量的加热装置或液体试剂盒,? 漫反射和全反射积分球通过不同模块组合,最终的配置可以满足任何终端用户的需求 二、应用领域o 弯曲基材(衬底)上的硬/软涂层o 聚合物涂层、粘合剂等o 生物医学( parylene—— 派瑞林,气泡壁厚,等等 )O 半导体生产制造:(光刻胶, 电介质,光子多层结构, poly-Si,Si, DLC )o 光伏产业o 液晶显示o 光学薄膜o 聚合物o 微机电系统和微光机电系统o 基底: 透明 (玻璃, 石英, 等等) 和半透明 三、产品特点o 单点分析(无需预设值)o 动态快速测量o 包括光学参数(n和k,颜色)o 为演示保存视频o 600 多种的预存材料o 离线分析o 免费软件更新 四、技术参数
 留言咨询
留言咨询

 400-628-5299
400-628-5299
 留言咨询
留言咨询
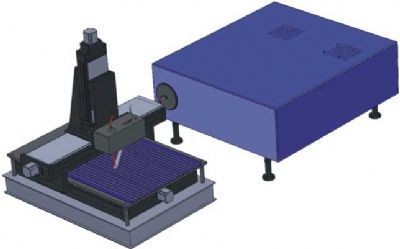
 400-628-5299
400-628-5299
 留言咨询
留言咨询

 400-860-5168转1431
400-860-5168转1431
 留言咨询
留言咨询

 400-860-5168转3855
400-860-5168转3855
 留言咨询
留言咨询

 400-860-5168转1431
400-860-5168转1431
 留言咨询
留言咨询

 400-860-5168转1431
400-860-5168转1431
 留言咨询
留言咨询

 400-860-5168转4306
400-860-5168转4306
 留言咨询
留言咨询

 400-860-5168转4135
400-860-5168转4135
 留言咨询
留言咨询

 留言咨询
留言咨询
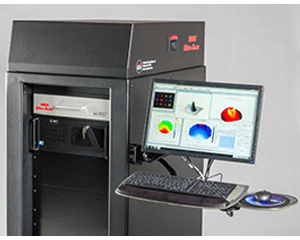
 400-860-5168转1431
400-860-5168转1431
 留言咨询
留言咨询

 留言咨询
留言咨询

 400-860-5168转1185
400-860-5168转1185
 留言咨询
留言咨询

 400-860-5168转6134
400-860-5168转6134
 留言咨询
留言咨询

 400-860-5168转4135
400-860-5168转4135
 留言咨询
留言咨询

 400-860-5168转6134
400-860-5168转6134
 留言咨询
留言咨询

 400-860-5168转4135
400-860-5168转4135
 留言咨询
留言咨询

 400-860-5168转6117
400-860-5168转6117
 留言咨询
留言咨询

 400-860-5168转2831
400-860-5168转2831
 留言咨询
留言咨询

 400-860-5168转2255
400-860-5168转2255
 留言咨询
留言咨询

 400-860-5168转6174
400-860-5168转6174
 留言咨询
留言咨询

 400-860-5168转1374
400-860-5168转1374
 留言咨询
留言咨询
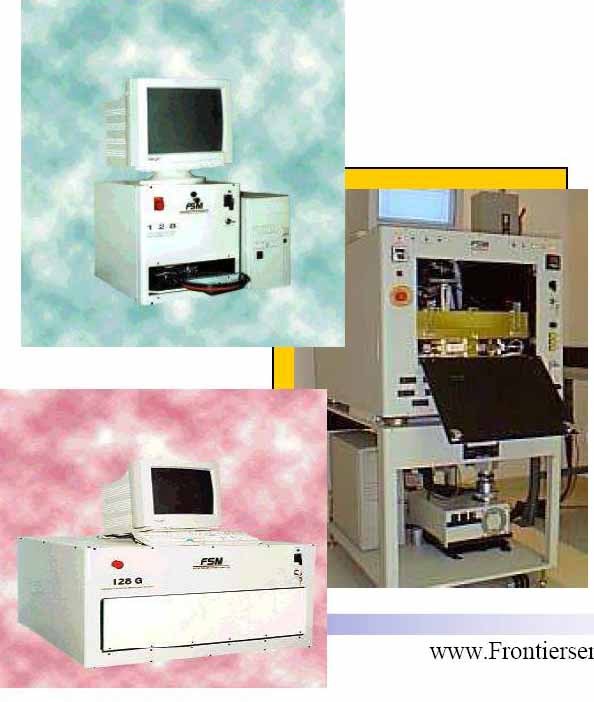
 400-860-5168转2024
400-860-5168转2024
 留言咨询
留言咨询
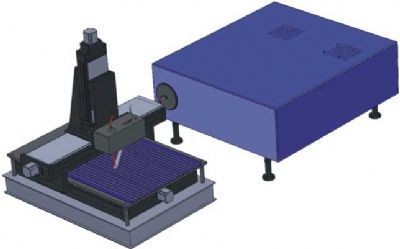
 400-628-5299
400-628-5299
 留言咨询
留言咨询

 400-860-5168转6134
400-860-5168转6134
 留言咨询
留言咨询
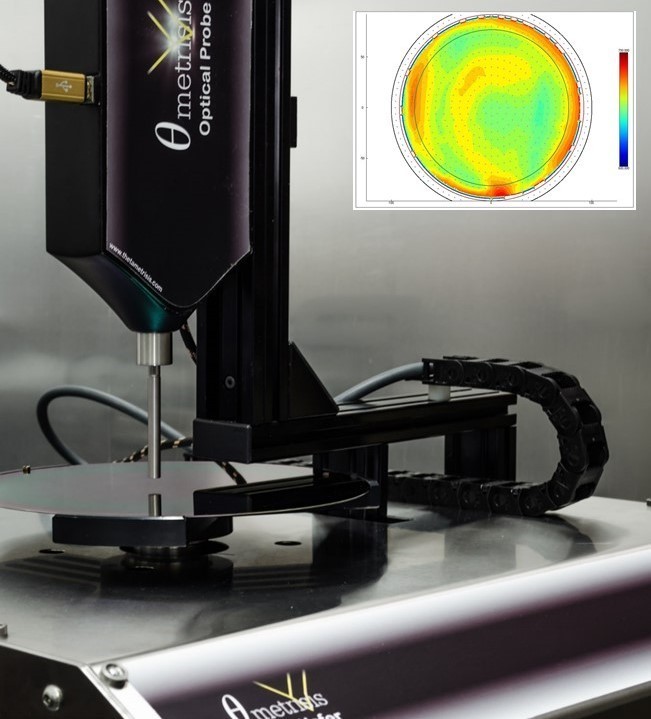
 留言咨询
留言咨询

 400-860-5168转6134
400-860-5168转6134
 留言咨询
留言咨询

 400-860-5168转3855
400-860-5168转3855
 留言咨询
留言咨询
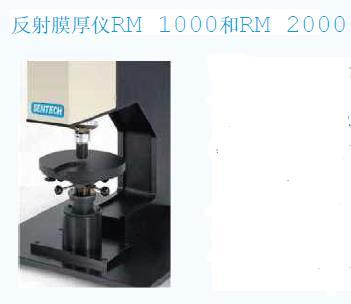
 400-860-5168转4585
400-860-5168转4585
 留言咨询
留言咨询

 400-860-5168转1655
400-860-5168转1655
 留言咨询
留言咨询

 400-860-5168转4346
400-860-5168转4346
 留言咨询
留言咨询