美国sinton少子寿命测试仪WCT-120,Suns-VocSinton instruments 少子寿命测试仪 硅片少子寿命测试系统 wct-120硅片少子寿命测试系统 美国Sinton WCT-120少子寿命测试仪器采用了独特的测量和分析技术,包括类似平稳状态photoconductance (QSSPC)测量方法。可灵敏地反映单晶体重金属污染及陷阱效应表面复合效应等缺陷情况。WCT一个高度被看待的研究和过程工具。QSSPC终身测量也产生含蓄的打开电路电压(对照明)曲线,与最后的I-V曲线是可比较的在一个太阳能电池过程的每个阶段。 美国Sinton WCT-120少子寿命测试仪器采用了独特的测量和分析技术,包括准稳定态光电导(QSSPC)测量方法。可灵敏地反映单、多晶硅片的重金属污染及陷阱效应,表面复合效应等缺陷情况。WCT在大于20%的超高效率太阳能电池(HIT,MWT,EWT,PREL,等等)的研发和生产过程中是一种被广泛选用的必备检测工具。这种QSSPC测量少子寿命的方法可以在电池生产的中间任意阶段得到一个类似光照IV曲线的开路电压曲线,可以结合最后的IV曲线对电池制作过程进行数据监控和参数优化。 主要应用:分布监控和优化制造工艺 其它应用: 检测原始硅片的性能 测试过程硅片的重金属污染状况 评价表面钝化和发射极扩散掺杂的好坏 用得到的类似IV的开压曲线来评价生产过程中由生产环节造成的漏电。 主要特点: 只要轻轻一点就能实现硅片的关键性能测试,包括表面电阻,少子寿命,陷阱密度,发射极饱和电流密度和隐含电压。少子寿命测试仪 硅片少子寿命测试系统 wct-120 常见问题:美国Sinton WCT-120与WT-2000测少子寿命的差异?WCT用的是Quasi-Steady-State Photoconductance(QSSPC)准稳态光电导衰减法,而WT2000是微波光电导衰减法。 WCT-120准稳态光电导法测少子寿命的原理? WCT用的是Quasi-Steady-State Photoconductance(QSSPC准稳态光电导)准稳态光电导衰减法(QSSPC)和微波光电导衰减法(MWPCD)的比较? QSSPC方法优越于其他测试寿命方法的一个重要之处在于它能够在大范围光强变化区间内对过剩载流子进行绝对测量,同时可以结合 SRH模型,得出各种复合寿命,如体内缺陷复合中心引起的少子复合寿命、表面复合速度等随着载流子浓度的变化关系。 MWPCD方法测试的信号是一个微分信号,而QSSPC方法能够测试少子寿命的真实值,MWPCD在加偏置光的情况下,结合理论计算可以得出少子寿命随着过剩载流子的变化曲线,而QSSPC直接就能够测得过剩载流子浓度,因此可以直接得出少子寿命与过剩载流子浓度的关系曲线,并且得到PN结的暗饱和电流密度;MWPCD由于使用的脉冲激光的光斑可以做到几个到十几个,甚至更小的尺寸,在照射过程中,只有这个尺寸范围的区域才会被激发产生光生载流子,也就是得到的结果是局域区域的差额寿命值,这对于寿命分布不均匀的样品来说,结果并不具备代表性。 少子寿命测试仪性能参数:1. 测量原理:QSSPC(准稳态光电导); 2. 少子寿命测量范围:100 ns-10 ms;3. 测试模式:QSSPC,瞬态,寿命归一化分析;4. 电阻率测量范围:3–600 (undoped) Ohms/sq.;5. 注入范围:1013-1016cm-3;6. 感测器范围:直径40-mm;7. 测量样品规格:标准直径: 40–210 mm (或更小尺寸);8. 硅片厚度范围:10–2000 μm;9. 外界环境温度:20°C–25°C;10. 功率要求:测试仪: 40 W , 电脑控制器:200W ,光源:60W;11. 通用电源电压:100–240 VAC 50/60 Hz; 晶体硅硅片、规定以及工艺过程中lifetime测试技术晶体硅太阳能电池少子寿命测试方法 少数载流子寿命(Minority carriers life time): (1)基本概念: 载流子寿命就是指非平衡载流子的寿命。而非平衡载流子一般也就是非平衡少数载流子(因为只有少数载流子才能注入到半导体内部、并积累起来,多数载流子即使注入进去后也就通过库仑作用而很快地消失了),所以非平衡载流子寿命也就是指非平衡少数载流子寿命,即少数载流子寿命。例如,对n型半导体,非平衡载流子寿命也就是指的是非平衡空穴的寿命。 对n型半导体,其中非平衡少数载流子——空穴的寿命τ,也就是空穴的平均生存时间,1/τ就是单位时间内空穴的复合几率,Δp/τ称为非平衡空穴的复合率 (即n型半导体中单位时间、单位体积内、净复合消失的电子-空穴对的数目);非平衡载流子空穴的浓度随时间的变化率为dΔp /dt =-Δp /τp, 如果τp与Δp 无关, 则Δp 有指数衰减规律:Δp = (Δp) exp( -t/τp ) 。 实验表明, 在小注入条件 (Δp。应当注意的是,只有在小注入时非平衡载流子寿命才为常数,净复合率才可表示为-Δp/τp;并且在小注入下稳定状态的寿命才等于瞬态的寿命。 (2)决定寿命的有关因素: 不同半导体中影响少数载流子寿命长短的因素,主要是载流子的复合机理(直接复合、间接复合、表面复合、Auger复合等)及其相关的问题。对于Si、Ge等间接跃迁的半导体,因为导带底与价带顶不在Brillouin区的同一点,故导带电子与价带空穴的直接复合比较困难(需要有声子等的帮助才能实现——因为要满足载流子复合的动量守恒),则决定少数载流子寿命的主要因素是通过复合中心的间接复合过程。从而,半导体中有害杂质和缺陷所造成的复合中心(种类和数量)对于这些半导体少数载流子寿命的影响极大。所以,为了增长少数载流子寿命,就应该去除有害的杂质和缺陷;相反,若要减短少数载流子寿命,就可以加入一些能够产生复合中心的杂质或缺陷(例如掺入Au、Pt,或者采用高能粒子束轰击等)。对于GaAs等直接跃迁的半导体,因为导带底与价带顶都在Brillouin区的同一点,故决定少数载流子寿命的主要因素就是导带电子与价带空穴的直接复合过程。因此,这种半导体的少数载流子寿命一般都比较短。当然,有害的杂质和缺陷将有更进一步促进复合、减短寿命的作用。 (3)少数载流子寿命对半导体器件的影响: 对于主要是依靠少数载流子输运(扩散为主)来工作的双极型半导体器件,少数载流子寿命是一个直接影响到器件性能的重要参量。这时,常常采用的一个相关参量就是少数载流子扩散长度L(等于扩散系数与寿命之乘积的平方根),L即表征少数载流子一边扩散、一边复合所能够走过的平均距离。少数载流子寿命越长,扩散长度就越大。 对于BJT,为了保证少数载流子在基区的复合尽量少(以获得很大的电流放大系数),则必须把基区宽度缩短到少数载流子的扩散长度以下。因此,要求基区的少数载流子寿命越长越好。 少子浓度主要由本征激发决定,所以受温度影响较大。 简介:少子寿命是半导体材料和器件的重要参数。它直接反映了材料的质量和器件特性。能够准确的得到这个参数,对于半导体器件制造具有重要意义。 少子,即少数载流子,是半导体物理的概念。 它相对于多子而言。 半导体材料中有电子和空穴两种载流子。如果在半导体材料中某种载流子占少数,导电中起到次要作用,则称它为少子。如,在 N型半导体中,空穴是少数载流子,电子是多数载流子;在P型半导体中,空穴是多数载流子,电子是少数载流子。 多子和少子的形成:五价元素的原子有五个价电子,当它顶替晶格中的四价硅原子时,每个五价元素原子中的四个价电子与周围四个硅原子以共价键形式相结合,而余下的一个就不受共价键束缚,它在室温时所获得的热能足以便它挣脱原子核的吸引而变成自由电子。出于该电子不是共价键中的价电子,因而不会同时产生空穴。而对于每个五价元素原子,尽管它释放出一个自由电子后变成带一个电子电荷量的正离子,但它束缚在晶格中,不能象载流子那样起导电作用。这样,与本征激发浓度相比,N型半导体中自由电子浓度大大增加了,而空穴因与自由电子相遇而复合的机会增大,其浓度反而更小了 少子寿命是半导体材料和器件的重要参数。它直接反映了材料的质量和器件特性。能够准确的得到这个参数,对于半导体器件制造具有重要意义。 少子是因电子脱离的原子,多子因电子加入而形成的原子. 少子寿命Life Time即少子形成到少子与多子结合的时间.
 留言咨询
留言咨询

 400-628-5299
400-628-5299
 留言咨询
留言咨询

 400-860-5168转1545
400-860-5168转1545
 留言咨询
留言咨询

 400-860-5168转4058
400-860-5168转4058
 留言咨询
留言咨询

 400-860-5168转1980
400-860-5168转1980
 留言咨询
留言咨询

 400-860-5168转4891
400-860-5168转4891
 留言咨询
留言咨询

 400-860-5168转4527
400-860-5168转4527
 留言咨询
留言咨询

 400-860-5168转3181
400-860-5168转3181
 留言咨询
留言咨询

 400-860-5168转1545
400-860-5168转1545
 留言咨询
留言咨询

 400-860-5168转4967
400-860-5168转4967
 留言咨询
留言咨询

 400-860-5168转4682
400-860-5168转4682
 留言咨询
留言咨询

 留言咨询
留言咨询

 400-860-5168转4527
400-860-5168转4527
 留言咨询
留言咨询

 400-860-5168转4891
400-860-5168转4891
 留言咨询
留言咨询

 400-860-5168转6134
400-860-5168转6134
 留言咨询
留言咨询

 400-860-5168转3181
400-860-5168转3181
 留言咨询
留言咨询

 400-860-5168转1545
400-860-5168转1545
 留言咨询
留言咨询

 400-860-5168转4967
400-860-5168转4967
 留言咨询
留言咨询

 400-860-5168转3181
400-860-5168转3181
 留言咨询
留言咨询

 400-860-5168转1545
400-860-5168转1545
 留言咨询
留言咨询

 400-860-5168转6134
400-860-5168转6134
 留言咨询
留言咨询

 400-860-5168转6134
400-860-5168转6134
 留言咨询
留言咨询

 400-860-5168转4682
400-860-5168转4682
 留言咨询
留言咨询

 400-860-5168转4058
400-860-5168转4058
 留言咨询
留言咨询

 400-860-5168转4058
400-860-5168转4058
 留言咨询
留言咨询

 400-860-5168转4058
400-860-5168转4058
 留言咨询
留言咨询

 400-860-5168转4682
400-860-5168转4682
 留言咨询
留言咨询

 400-860-5168转4682
400-860-5168转4682
 留言咨询
留言咨询

 400-860-5168转4682
400-860-5168转4682
 留言咨询
留言咨询
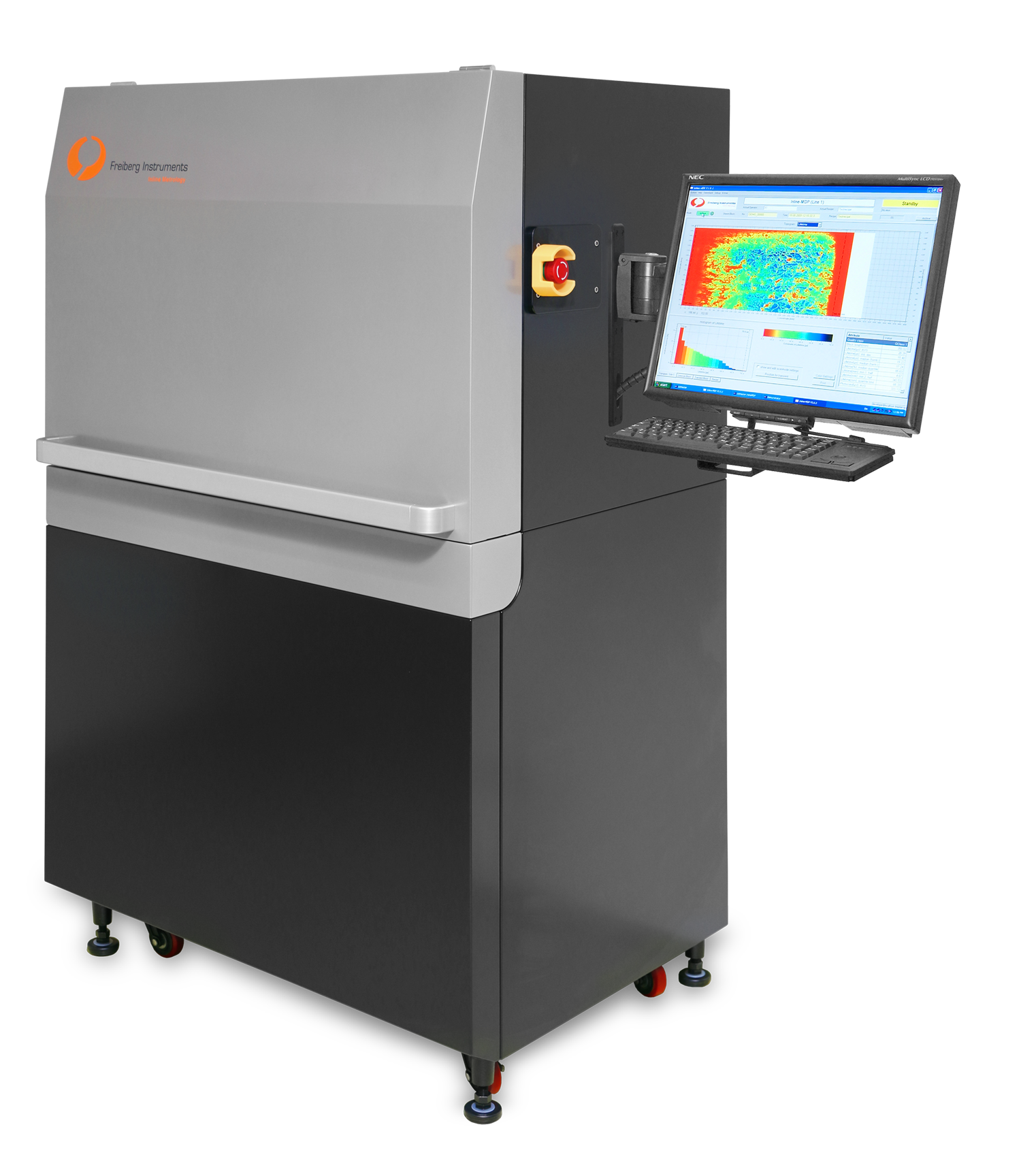
 400-860-5168转4682
400-860-5168转4682
 留言咨询
留言咨询

 400-803-3696
400-803-3696
 留言咨询
留言咨询