当前,制备非晶的方法主要有淬火法和气相沉积法。快冷法又分为铸膜法和甩带法,适合于制备大块非晶。气相沉积法分为真空蒸发法、化学气相沉积法、脉冲激光沉积法和磁控溅射法。~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~磁控溅射法制备非晶样品有其独特的有点,下面主要介绍下磁控溅射制备非晶样品的原理。电子在电场E的作用下,在飞向基板的过程中与氩气原子发生碰撞,使其电离出氩离子和一个新的电子,电子飞向基片,氩离子在电场作用下飞向阴极靶,并以高能量轰击靶的表面,使靶材发生溅射。在溅射的过程中,溅射离子,中性的靶原子或分子即可在基片上沉积形成膜。综上所述,磁控溅射的基本原理就是以磁场来改变原子的运动状态,并束缚和延长原子的运动轨迹,从而提高电子对工作气体的电离几率和有效地运用了电子的能量。这也体现了磁控溅射低温、高效的原理。常用的TEM样品以TEM载网为基片。TEM载网是直径为3nm,厚为20μm,网格间距为80μm,最底下一层铜或者钼,上面覆盖一层约为5nm厚的无定形碳作为支撑膜。利用磁控溅射法制备沉积的薄膜就沉积在这种TEM载网的无定形碳的支撑膜上,为了减少非弹性散射对衍射数据的影响,在实验过程中尽可能制备厚度比较小的薄膜厚度,约为15nm-20nm,这样制得的样品就可以直接在透射电子显微镜中进行直接的表征。
我们实验室的磁控溅射仪老是出问题,不能正常工作,有没有高手,请帮帮忙!
随着电镜技术和应用快速发展,越来越多电镜用户对样品前处理提出了更高的要求。其中磁控溅射镀膜仪就专用来给场发射扫描电镜不导电样品进行喷金镀膜。本作品主要从两大方面介绍磁控溅射镀膜仪。1.简易演示真空磁控
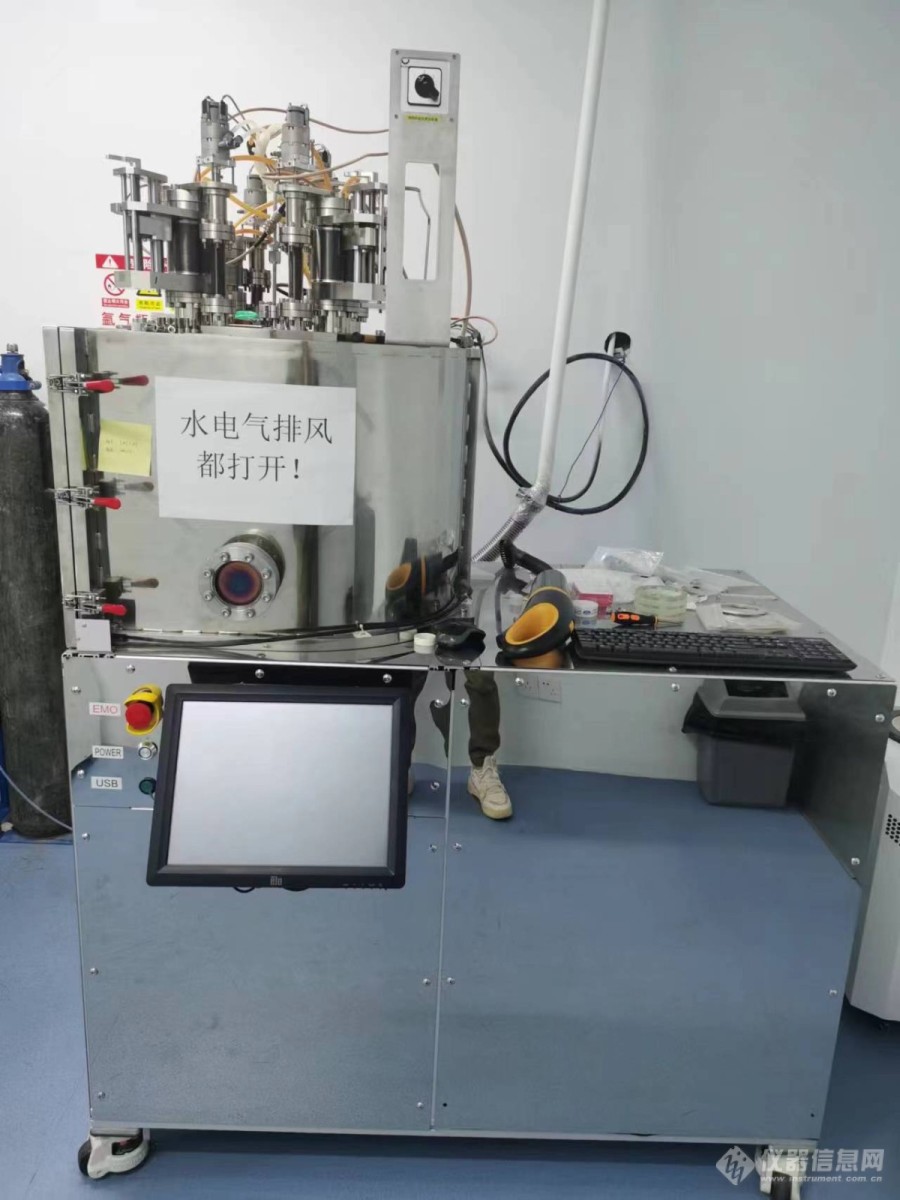
磁控溅射仪(2019下半年购入,9成9新)[img=,690,920]https://ng1.17img.cn/bbsfiles/images/2023/10/202310091529314999_3303_5829706_3.jpg!w690x920.jpg[/img][img=,690,920]https://ng1.17img.cn/bbsfiles/images/2023/10/202310091529317199_6660_5829706_3.jpg!w690x920.jpg[/img][img=,690,920]https://ng1.17img.cn/bbsfiles/images/2023/10/202310091529323410_1965_5829706_3.jpg!w690x920.jpg[/img][img=,690,920]https://ng1.17img.cn/bbsfiles/images/2023/10/202310091529325843_2573_5829706_3.jpg!w690x920.jpg[/img]设备技术要求 1.样品基台:直径 6 英寸样品2.反应腔室:304 不锈钢材质3.靶座系统:3 英寸圆形靶座 4 个,位于腔室上部;靶与样品的距离90~110mm 可调4.真空系统:分子泵,机械泵5.真空测量:薄膜规(进口),全量程规(进口)6.气路系统:标配 2 路进气,种类和流量可定制;管路配件(进口)7.电源系统:500W/13.56MHz 自动匹配射频源 1 套(进口);500W 直流电源 2 套(进口)8.样品载台:自转旋转 5-30rpm 可调;加热温度 300℃;可加射频偏压200V 预清洗基片9.真空性能:本底真空优于 6.67x10-5Pa10.控制系统:工控机;触摸屏,菜单自动/手动操作11.安全控制:异常报警12.工艺应用:金属薄膜和介质薄膜沉积13.不均匀性:≤±5%@6 英寸14.设备尺寸:一体型设备;占地面价(参考)1.0m*1.50m。[img=,554,628]https://ng1.17img.cn/bbsfiles/images/2023/10/202310091529103198_4423_5829706_3.png!w554x628.jpg[/img]运行需求:供电需求: 380V、三相五线制;设备总功率需求约为 15KW冷却水:>1.5L/min压缩空气: 0.4~0.6Mpa
我公司是真空磁控溅射氧化铟锡的生产厂家,大概原理是在真空状态下,在溅射靶材铟锡合金上施加负电压,充入溅射气体氩和反应气体氧,铟锡金属原子被溅射出后与氧发生反应成氧化铟锡,在我们实际应用中需要监控铟锡金属原子被溅射出后与氧发生反应时的光谱,以便更好的控制氧气输入的流量。请问有没有相宜的检测和监控设备?jyapu@sohu.com

http://ng1.17img.cn/bbsfiles/images/2011/08/201108112134_309901_2355867_3.jpg这是磁控溅射制备的氧化铝薄膜,厚度30-50nm, S1是制备样品,P1是经过750度处理后的样品,想对比变化,可是峰位怎么都对不上啊?? 基底材料用的是氧化硅wafer, 请这里的大师兄们给帮忙分析一下吧??? 急啊,老板要我解释呢 小师妹先在这里谢谢大家了!!
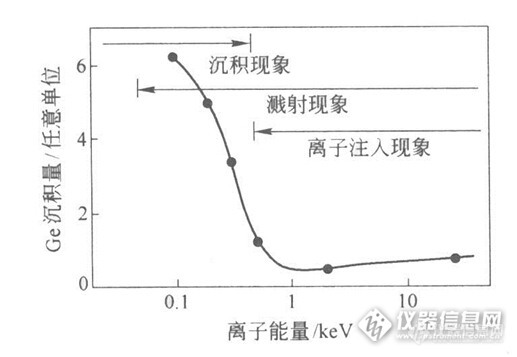
溅射制膜的过程:气体辉光放电、等离子体、靶、溅射、沉积到衬底(一)与蒸发法相比,溅射沉积的主要特点:①沉积原子能量高,因此薄膜的组织更致密,附着力也可以得到明显改善;②制备合金膜时,其成分的控制性能好;③靶材可以是极难熔的材料;④可利用反应溅射技术,从金属无素靶材制备化合物薄膜;⑤由于被沉积的原子均携带有一定的能量,因而有助于改善薄膜对于复杂形状表面的覆盖能力,降低薄膜表面的粗糙度。http://ng1.17img.cn/bbsfiles/images/2015/07/201507151100_555534_2989334_3.jpghttp://bbs.instrument.com.cn/xheditor/xheditor_skin/blank.gif(二)溅射沉积分类主要的溅射方式可以根据其特征分为四种:(1)直流溅射;(2)射频溅射;(3)磁控溅射;(4)反应溅射。http://ng1.17img.cn/bbsfiles/images/2015/07/201507151102_555536_2989334_3.jpg图1 不同溅射方法的靶电流密度和靶电压的比较http://bbs.instrument.com.cn/xheditor/xheditor_skin/blank.gif(1)直流溅射直流溅射又称为阴极溅射或二极溅射图2直流溅射沉积装置示意图,其典型的溅射条件为:工作气压10Pa,溅射电压3000V,靶电流密度0.5mA/cm2,薄膜的沉积速率低于0.1μm/min直流溅射过程中常用Ar作为工作气体。工作气压是一个重要参数,它对溅射速率以及薄膜的质量都有很大影响直流溅射设备的优点和缺点:优点:简单缺点:使用的气体压力高,溅射速率较低,这不利于减小气氛中的杂质对薄膜的污染以及溅射效率的提高。http://ng1.17img.cn/bbsfiles/images/2015/07/201507151105_555538_2989334_3.jpg图2直流溅射沉积装置示意图http://bbs.instrument.com.cn/xheditor/xheditor_skin/blank.gif(2 )射频溅射直流溅射要求靶材有较好的导电性,可以很大方便地沉积各类合金膜。对于导电性很差的非金属材料的溅射,我们需要一种新的溅射方法—射频溅射。射频溅射是适于各种金属和非金属材料的一种溅射沉积方法射频场对于靶材的自偏压效应。在衬底或薄膜本身是绝缘体的情况下,采取对其施加一个射频电压的方法,也可以起到对其施加负偏压的作用。(3)磁控溅射相对于蒸发沉积来说,一般的溅射沉积方法具有两个缺点。第一,溅射方法沉积薄膜的沉积速度较低;第二,溅射所需的工作气压较高 这两个缺点的综合效果是气体分子对薄膜产生污染的可能性较高。而磁控溅射技术:沉积速度较高,工作气体压力较低。工作原理:磁场对电弧运动有一定的约束作用(绕磁场螺旋前进);(1)电子的电离效率高,有效提高了靶电流密度和溅射效率,(2)较低气压下溅射原子被气体分子散射的几率较小(三)气体放电是离子溅射过程的基础(1)首先介绍直流电场作用下的物质的溅射现象预抽真空,充入适当压力的惰性气体,如Ar气,10-1~10Pa;在正负电极间外加电压的作用下,电极间的气体原子将被大量电离;Ar—→Ar++e,Ar+被电场加速后射向靶材,撞击出靶材原子(分子),靶材原子脱离靶时仍具有一定能量,飞向衬底,电子被电场加速飞向阳极;http://ng1.17img.cn/bbsfiles/images/2015/07/201507151107_555542_2989334_3.jpg图3直流气体放电体系模型及伏安特性曲线http://bbs.instrument.com.cn/xheditor/xheditor_skin/blank.gif电压进一步增大,发生极板两端电压突然降低,电流突然增大,并同时出现带有颜色的辉光,此过程称为气体的击穿;击穿后气体的发光放电称为辉光放电;这时电子和正离子是来源于电子的碰撞和正离子的轰击,即使自然游离源不存大,放电也将继续下去。而且维持辉光放电的电压较低,且不变,此时电流的增大显然与电压无关,而只与阴极板上产生辉光的表面积有关;正常辉光放电的电流密度与阴极材料和形状、气体种类和压强有关;由于正常辉光放电时的电流密度仍比较小,所以在溅射方面均是选择在非正常辉光放电区工作。http://ng1.17img.cn/bbsfiles/images/2015/07/201507151110_555543_2989334_3.jpg图4示意性地画出了在离子轰击条件下,固体表面可能发生的物理过程http://ng1.17img.cn/bbsfiles/images/2015/07/201507151111_555544_2989334_3.jpg图5所示,不同能量离子与固体表面相互作用的过程不同当离子入射到靶材上时,对于溅射过程来说,比较重要的过程有两个:其一是物质的溅射;其二是二次电子发射:二次发射电子在电场作用下获得能量,进而参与气体分子的碰撞,并维持气体的辉光放电过程。http://bbs.instrument.com.cn/xheditor/xheditor_skin/blank.gifhttp://bbs.instrument.com.cn/xheditor/xheditor_skin/blank.gif (四)合金的溅射和沉积用溅射法沉积合金膜,比蒸发法易于保证薄膜的化学配比;溅射过程中入射离子与靶材之间有很大的能量传递。因此,溅射出的原子将从溅射过程中获得很大的动能,其数值一般可以达到5~20eV;一方面,溅射原子具有很宽的能量分布范围,其平均能量约为10eV左右;另一方面,随着入射离子能量的增加,溅射离子的平均能量也有上升的趋势;溅射过程还会产生很少的溅射离子,它们具有比溅射出来的原子更高的能量。能量较低的溅射离子不易逃脱靶表面的鞘层电位的束缚,将被靶表面所俘获而不能脱离靶材;由蒸发法获得的原子动能一般只有0.1eV,两者相差两个数量级;在溅射沉积中,高能量的原子对于衬底的撞击一方面提高了原子自身在薄膜表面的扩散能力,另一方面也会引起衬底温度的升高。
靶以前修补过,现在缝隙变成了一个洞,怎么修复啊?
这个资料有6817次下载,却只有是601次点击,而上传日期为2006-07-16。http://www.instrument.com.cn/download/shtml/017578.shtml资料名称 下载 点击 上传日期 下载 用户论文(2005):《微纳电子技术》磁控溅射制备ZnO薄膜.. 6817 601 2006-7-16
【序号】:1【作者】:董骐 范毓殿 【题名】:非平衡磁控溅射及其应用【期刊】:真空科学与技术【年、卷、期、起止页码】:1996年 01期 【全文链接】:http://epub.cnki.net/grid2008/detail.aspx?filename=ZKKX199601010&dbname=CJFD1996【序号】:2【作者】:刘翔宇 【题名】:磁控溅射镀膜中靶的优化设计 【期刊】:电子科学与技术【年、卷、期、起止页码】:2005-04-21【全文链接】:http://epub.cnki.net/grid2008/detail.aspx?filename=2005035360.nh&dbname=CMFD2005【序号】:3【作者】:胡作启 李佐宜 刘卫忠 熊锐 【题名】:磁控溅射靶磁场的分布 【期刊】:华中理工大学学报【年、卷、期、起止页码】:1997年 11期 【全文链接】:http://epub.cnki.net/grid2008/detail.aspx?filename=HZLG711.012&dbname=CJFD1997【序号】:4【作者】:刘瑞鹏 李刘合 【题名】:磁控溅射靶优化设计及其磁场分析【期刊】:2006全国荷电粒子源、粒子束学术会议【年、卷、期、起止页码】:无【全文链接】:http://epub.cnki.net/grid2008/detail.aspx?filename=ZGDN200610001076&dbname=cpfd2006【序号】:5【作者】:张建民 王立 梁昌慧 【题名】:磁控溅射靶源设计及溅射工艺研究 【期刊】:陕西师范大学学报【年、卷、期、起止页码】:1999年 01期 【全文链接】:http://epub.cnki.net/grid2008/detail.aspx?filename=SXSZ901.010&dbname=cjfd1999
我前一阵作了一用磁控溅射的Si/Al/Si的三层膜,应该都是非晶态的,从其切面图上看不出有什么明显的区别,所以想问一下采用什么方法可以将其中Si,Al元素分辩出来。
求可以做真空磁溅射的地方。价格合理 质量可靠
【序号】: 1【作者】: 光学工程【题名】: 基于ANSYS的(非)平衡磁控溅射镀膜机磁场模拟【期刊】: 优秀研究生学位论文【年、卷、期、起止页码】: 【全文链接】:http://edu.nulog.cn/detail.htm?306178谢谢!
【序號】:1【作者】:袁渊明 弥谦 潘婷 【篇名】:磁场强度对磁约束磁控溅射源工作状态的影响【期刊】:《2010年西部光子学学术会议摘要集》【全文連接】:http://cpfd.cnki.com.cn/Article/CPFDTOTAL-SXGX201007001017.htm【序號】:2【作者】:弥谦 潘婷 袁渊明【篇名】:磁约束磁控溅射源工作特性及沉积速率的分析【期刊】:《西安工业大学学报》 2011年03期【全文連接】:http://www.cnki.com.cn/Article/CJFDTOTAL-XAGY201103005.htm【序號】:3【作者】:牟宗信 李国卿 柳翠 贾莉 张成武 【篇名】:有开放约束磁场磁控溅射系统等离子体引出【期刊】: 《真空科学与技术》 2003年04期【全文連接】:http://www.cnki.com.cn/Article/CJFDTOTAL-ZKKX200304005.htm
【序號】:1【作者】:王春【篇名】:中频磁控溅射制备氮化硅薄膜及其性能的研究【期刊】:大連理工大學 【全文連接】:http://cnki50.csis.com.tw/kns50/detail.aspx?QueryID=580&CurRec=1【序號】:2【作者】:賈曉昀【篇名】:磁控溅射制备氮化硅薄膜特性研究【期刊】:北京交通大學 【全文連接】:http://cnki50.csis.com.tw/kns50/detail.aspx?QueryID=617&CurRec=14【序號】:3【作者】:王春; 牟宗信; 劉冰冰; 臧海榮; 牟曉東;【篇名】:中频孪生靶非平衡磁控溅射制备氮化硅薄膜及其性能(英文)【期刊】:材料科學與工程學報 , 2011年 03期 【全文連接】:http://cnki50.csis.com.tw/kns50/detail.aspx?QueryID=192&CurRec=4【序號】:4【作者】:景鳳娟; 張琦; 冷永祥; 孫鴻; 楊蘋; 黃楠;【篇名】:非平衡磁控溅射制备氮化硅薄膜及其性能研究【期刊】:真空科學與技術學報 ,2009年 05期 【全文連接】:http://cnki50.csis.com.tw/kns50/detail.aspx?QueryID=192&CurRec=22【序號】:5【作者】:劉濤;【篇名】:氮化硅反应溅射源的设计及其薄膜工艺实现【期刊】:記錄媒體技術 ,2008年 06期 【全文連接】:http://cnki50.csis.com.tw/kns50/detail.aspx?QueryID=192&CurRec=33
各位大侠帮忙解答:1. 我看文献上有的说xrd掠入射看薄膜物象鉴定,常规的θ/2θ扫瞄看薄膜的择优取向。薄膜xrd掠入射能看薄膜的择优取向吗?2. 我做常规的θ/2θ扫瞄时只有衬底峰没有薄膜信息,所以只能做掠入射,我是在单晶SiC片子上磁控溅射AlN薄膜(约500nm厚),但是我要对比不同参数下薄膜的择优取向,我该怎么测呢?3. 我用的设备是日本理学D/MAX 2500PC X射线粉末衍射仪,做掠入射时加了薄膜附件,采用2θ扫瞄模式,θ角固定(2.5、3、5、8、15、30度),不管θ角多大都没出现衬底峰只有薄膜峰,但是随着θ角的增大,AlN (0002)峰强也增大,而.(10-13)峰强则减小直到消失,这是为什么?另外,掠入射时θ角越小x线在薄膜中的光程应该越大,反应的薄膜信息应该越丰富对吗?为什么我做θ角0.5度和1度时什么峰都没有呢?
真空磁溅射镀膜是否一定要在超净室中操作。放在普通房间行吗
【序號】:1【作者】:U. Krause , M. List, H. Fuchs【篇名】:Requirements of power supply parameters for high-power pulsed magnetron sputtering【期刊】:Thin Solid Films Volume 392, Issue 2, 30 July 2001, Pages 196-200 【全文連接】:http://www.sciencedirect.com/science/article/pii/S0040609001010276【序號】:2【作者】:佟洪波 柳青 巴德純 TONG Hong-bo LIU Qing BA De-chun 【篇名】:反应磁控溅射研究进展【期刊】:真空 2008, 45(3) 【全文連接】:http://d.wanfangdata.com.cn/periodical_zk200803013.aspx【序號】:3【作者】:茅昕輝 陳國平 蔡炳初【篇名】:反应磁控溅射的进展【期刊】:真空 2001, (4) 【全文連接】:http://d.wanfangdata.com.cn/Periodical_zk200104001.aspx【序號】:4【作者】:李芬; 朱穎; 李劉合; 盧求元; 朱劍豪;【篇名】:磁控溅射技术及其发展【期刊】:真空電子技術 , 2011年 03期 【全文連接】:http://cnki50.csis.com.tw/kns50/detail.aspx?QueryID=3&CurRec=17【序號】:5【作者】:宋瑞良 張毅 劉瑋 蔡永安 于濤 孫云【篇名】:磁控溅射ZAO薄膜的磁场研究【期刊】:第十一屆中國光伏大會暨展覽會論文集 【全文連接】:http://www.pv001.net/22/5/5452.html
现在我是我们实验室coating的主力了...........http://simg.instrument.com.cn/bbs/images/brow/em09509.gif
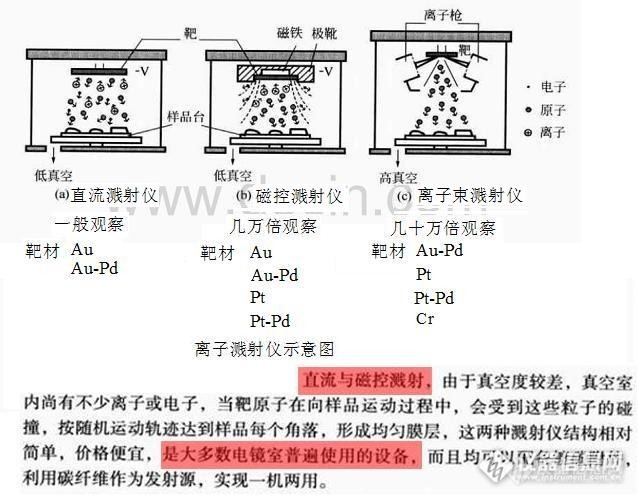
如果在镀膜时所用的设备是直流溅射仪或磁控溅射仪而非离子束溅射仪,在放大倍率为几万倍下观察,就会看到镀膜结构。绝大多数用户所使用的离子溅射仪都属于前两种。下面的照片是我对三个文献有关内容的综合。http://ng1.17img.cn/bbsfiles/images/2013/01/201301262045_422846_1609375_3.jpg
TEM要求测硅片上磁控溅射生长磁性多层膜,FIB制样过程需要真空,需要制样结束后是通过真空互联系统转移到TEM中来测试,整个过程不能爆大气!实际制样中应该怎样操作?
最近单位要买一台磁控溅射镀膜机,不知国内外哪些厂家的设备比较好,因为镀膜机的部件比较多,又要求真空,出点小问题难免,所以售后方面得好。不知哪位比较有经验的,指点指点。
【序號】:1【作者】:王军 成建波 陈文彬 杨刚 蒋亚东 蒋泉 杨健君【篇名】:磁控溅射ITO薄膜的退火处理【期刊】:《材料科学与工艺》 2008年02期【全文連接】:http://www.cnki.com.cn/Article/CJFDTOTAL-CLKG200802030.htm【序號】:2【作者】:朱长纯 商世广 【篇名】:直流磁控溅射ITO薄膜的低温等离子退火研究【期刊】:《第九届真空技术应用学术年会论文集》 2006年【全文連接】:http://cpfd.cnki.com.cn/Article/CPFDTOTAL-ZKDZ200609001064.htm【序號】:3【作者】:张怀武 仲永安 【篇名】:衬底偏压和退火对ITO膜结构和成分的影响【期刊】: 《真空》 1992年04期【全文連接】:http://www.cnki.com.cn/Article/CJFDTOTAL-ZKZK199204002.htm【序號】:4【作者】:许旻 邱家稳 贺德衍 【篇名】:退火对反应磁控溅射制备ITO薄膜性能影响【期刊】: 《真空科学与技术》 2003年03期 【全文連接】:http://www.cnki.com.cn/Article/CJFDTOTAL-ZKKX200303003.htm【序號】:5【作者】:林丽梅 赖发春 林永钟 瞿燕 盖荣权 陈超英【篇名】:热处理对直流磁控溅射ITO薄膜光电学性质的影响【期刊】: 《福建师范大学学报(自然科学版)》 2006年03期【全文連接】:http://www.cnki.com.cn/Article/CJFDTOTAL-FJSZ200603008.htm
【序号】:1【作者】:周继承 陈宇 赵保星 【题名】:磁控溅射制备TiO2薄膜及其光学特性研究【期刊】:应用科技【年、卷、期、起止页码】:2010【全文链接】:http://oldweb.cqvip.com/qk/90126X/201006/34351516.html
【序号】:1【作者】:佟洪波【题名】:反应磁控溅射制备AlN薄膜及其发光性能研究【期刊】: 《东北大学 》 【年、卷、期、起止页码】:2008【全文链接】:http://cdmd.cnki.com.cn/Article/CDMD-10145-2010259805.htm
【序号】:1【作者】:刘二强【题名】:基于等离子体光发射谱的磁控溅射薄膜成分控制及性能研究【期刊】:太原理工大学【年、卷、期、起止页码】:2009【全文链接】:http://www.cnki.net/KCMS/detail/detail.aspx?QueryID=20&CurRec=1&recid=&filename=2010074014.nh&dbname=CMFD2011&dbcode=CMFD&pr=&urlid=&yx=【序号】:2【作者】:朱岩【题名】:基于PEM反应磁控溅射制备Ti、Cr氮化物薄膜的研究【期刊】:西安理工大学【年、卷、期、起止页码】:2010【全文链接】:http://www.cnki.net/KCMS/detail/detail.aspx?QueryID=16&CurRec=1&recid=&filename=2010141288.nh&dbname=CMFD2010&dbcode=CMFD&pr=&urlid=&yx=【序号】:3【作者】:王治安; 王军生; 童洪辉;【题名】:PEM控制中频反应磁控溅射制备TiO2薄膜的研究【期刊】:真空【年、卷、期、起止页码】:2011年第48卷第4期 76-79页【全文链接】:http://www.cnki.net/KCMS/detail/detail.aspx?QueryID=16&CurRec=24&recid=&filename=ZKZK201104022&dbname=CJFD2011&dbcode=CJFQ&pr=&urlid=&yx=
【序號】:1【作者】:劉立【篇名】:电子全息与离子致变形貌及磁控溅射成膜机理的计算机模拟研究【期刊】: 復旦大學 【全文連接】:http://d.wanfangdata.com.cn/Thesis_Y1168856.aspx【序號】:2【作者】:吳志瑋【篇名】:等离子体离子注入表面改性与磁控溅射成膜的计算机模拟研究【期刊】: 復旦大學 【全文連接】:http://d.wanfangdata.com.cn/Thesis_Y951679.aspx【序號】:3【作者】:李庆成 【篇名】:磁控溅射铜薄膜生长过程的蒙特卡罗模拟【期刊】: 合肥工業大學【全文連接】:http://cdmd.cnki.com.cn/Article/CDMD-10359-2009155097.htm【序號】:4【作者】:M Horkel, K Van Aeken, C Eisenmenger-Sittner, D Depla, S Mahieu and W P Leroy【篇名】:Experimental determination and simulation of the angular distribution of the metal flux during magnetron sputter deposition【期刊】: Journal of Physics D: Applied Physics 【全文連接】:http://iopscience.iop.org/0022-3727/43/7/075302
第一章 总 则 第一条 为加强我省电磁辐射建设项目管理,规范审批行为,提高审批效率,保护环境和公众安全,根据国家有关规定,结合我省实际情况,制定本细则。 第二条 在我省范围内建设110kV及以上输变电工程,广播电台、差转台,电视塔台,卫星地球上行站,雷达,无线通讯,豁免水平以上的工业、科学、医疗等电磁辐射建设项目,应遵守本细则。第二章 环境影响评价 第三条 根据《建设项目分类管理名录》的规定,对电磁辐射建设项目实行分类管理: (一)以下新、改、扩建设项目应当编制环境影响报告书: 1、500kV及以上输变电工程;220kV至500kV跨地市的输变电工程。 2、中波50kW及以上、短波100kW及以上或者在敏感区建设的广播电台,差转台。 3、100kW及以上的电视发射塔。 4、一站多台卫星地球上行站。 5、多台雷达探测系统。 6、一址多台或者多址发射的无线通信系统。 7、两个及两个以上合并审批的项目。 (二)以下新、改、扩建设项目应当编制环境影响报告表: 1、500kV以下的输变电工程。 2、中波50kW以下、短波100kW以下,且位于非敏感区建设的广播电台,差转台。 3、100kW以下的电视发射塔。 4、一站单台卫星地球上行站。 5、单台雷达探测系统。 6、一址单台的无线通信讯系统。 7、豁免水平以上的工业、科学、医疗等电磁辐射设施。
我比较熟的产品有MBE,磁控溅射,电子束蒸发,PLD,PECVD,等离子刻蚀RIE,ICP.如果大家在这方面有什么问题,非常愿意与大家交流,如果想采购这类产品和组件,或这方面的任何需求,我都可以向你推荐,可以发mail给我,lhm115011@gmail.com
学校要搞平台建设,那位大牛能帮我构思一下 表面处理的校级平台 主要包括 表面改性(磁控溅射、离子注入、PCVD、热浸镀等)等一系列设备和试样制备、表面性能检测、性质检测(如高温高压釜350-600度,10.3-25MPa)一系列设备 最好给相关设备的特点和报价 谢谢哈邮箱 :[email]srwangjun@163.com[/email]