上海伯东日本 Atonarp Aston™ 质谱分析仪无等离子体设计,可以实现快速, 化学特定的原位定量气体分析, 与光学发射光谱 OES 对比, Aston™ 质谱仪 的 OA% 灵敏度显示为 0.25%, 适用于半导体工艺中蚀刻计量控制, ALD, 3D-NAND 和新兴的堆叠式 DRAM.半导体蚀刻工艺挑战日益增加蚀刻是半导体制造中常用的工艺之一. 介电蚀刻用于形成绝缘结构, 触点和通孔, 多晶硅蚀刻用于在晶体管中创建栅极, 金属蚀刻去除材料以显示电路连接图案并钻穿硬掩模.连续蚀刻铝 Al, 钨, 铜 Cu,钛 Ti 和氮化钛 TiN 等工艺金属具有挑战性, 因为许多金属会形成非挥发性金属卤化物副产品(例如六氯化钨 WCl6), 这些副产品会重新沉积在蚀刻侧壁上, 导致成品率降低(通过微粒污染或沉积材料导致短路).随着半导体行业不断缩小关键特征尺寸并采用垂直扩展 (如 3D-NAND 存储器和全环绕栅极先进技术节点), 各种新的蚀刻挑战已经出现. 这些包括在晶圆上蚀刻更小的特征, 高展弦比 HAR 沟槽蚀刻 (具有小的开放面积百分比- OA%), 以及在新兴的非挥发性存储器和高 k介质中蚀刻金属闸极, 稀土金属等新材料. 对于先进的纳米级工艺, 如蚀刻到硅介质和金属薄膜, 选择性处理, 如原子层蚀刻 ALE 一次去除材料的几个原子层. ALE 提供了比传统蚀刻技术更多的控制. 对于 3D-NAND 和先进 DRAM 来说, 向批量生产过渡的重大挑战包括解决导体蚀刻困难的要求, 满足积极的生产斜坡和实现所需的吞吐量, 以推动成本效益.上海伯东日本 Atonarp Aston™ 质谱分析仪提供高性能, 嵌入式和可靠的原位定量分子气体计量已经成为验证工艺室和持续监测工艺化学过程的关键工具, 确保生产环境中的高产率和更大吞吐量.Aston™ 质谱分析仪提供全腔室解决方案使用上海伯东 Atonarp Aston™ 质谱仪通过实时, 定量和精确的分子传感器来解决半导体新兴蚀刻工艺技术相关的关键挑战. 通过解决传感器耐久性, 灵敏度, 匹配, 系统集成和易用性等方面的挑战, 日本 Atonarp Aston™ 质谱仪升级了传统的气体分析计量方法. Aston 是一种全室解决方案, 用于在各种工艺步骤中实时监测前体, 反应物和副产物.这些包括基准室和过程指证, 腔室清洁, 过程监测 (包括存在腐蚀性气体), 颗粒沉积和气体污染物凝结. 小的占地面积和灵活的通信接口允许在室内安装和集成到过程设备控制系统. 为了集成到半导体工艺工具中, Aston 质谱分析仪的高性能和可靠性设计用于生产晶圆的大批量生产过程控制.Aston™ 质谱分析仪半导体蚀刻计量控制半导体行业正从二维结构的扩展转向复杂三维结构的挑战性要求. 传统的离线晶圆测量已不足以实现性能和良率目标, 原位蚀刻测量传统上缺乏生产所需的鲁棒性和可重复性. Aston™ 质谱分析仪的结构中嵌入了专利技术, 使其具有卓越的分析和操作性能. 为了满足过程控制和跨工厂生产工具匹配的严格要求, Aston 从头开始设计, 高运行时间和低维护的吞吐量, 长期信号稳定性和可重复性.为了承受腐蚀和沉积过程的恶劣环境, Aston™ 引入了两个的功能: 等离子电离和自清洁 (ReGen™模式). 等离子体电离消除了由于与腐蚀性气体(如NF3, CF4, Cl2)的反应而导致的灯丝降解. 此外, 除去(正硅酸四乙酯) TEOS 等颗粒和蒸汽污染物沉积, 同时定期进行室内清洁循环, 延长了 Aston™ 质谱仪的使用寿命. ReGenTM 模式使仪器能够使用高能等离子离子清洗自身, 通过去除在膜沉积过程中可能发生在传感器和腔室壁上的沉积. 结合这两个功能, 传感器的灵敏度可维持在数百个RF(射频)小时的操作. Aston质谱仪支持的基于测量的控制, 有可能延长清洗间隔 MTBC 的平均时间. MTBC 的增加意味着工具可用性和长期吞吐量的增加. 除了等离子电离器(用于工艺), 传感器还配备了传统的电子冲击 EI 灯丝电离器, 用于基线和校准.分子传感器的分析级是使用微米级精密双曲电极的四极杆. 由高度线性射频(RF)电路驱动, Aston 质谱的HyperQuad 传感器在 2到300 amu的质量范围内具有更高的分析性能.Aston™ 质谱分析仪技术参数参数值质量分辨率0.8u质量数稳定性0.1u灵敏度(FC / SEM)5x10-6 / 5x10-4 A/Torr最低可检测的部分压力(FC / SEM)10-9 / 10-11 Torr检测极限10 ppb最大工作压力1X10-3 Torr每 u 停留时间40 ms每u扫描更新率37 ms发射电流0.4 mA发射电流精度0.05 %启动时间5mins离子电流稳定 ±1%浓度的准确性 1%浓度稳定±0.5%电力消耗350w重量13.7kg尺寸400 x 297 x 341mm高展弦比 HAR 3D 蚀刻随着多模式技术和 3D器件结构的出现, 高度密集的蚀刻和沉积过程驱动了计量需求. 3D多层膜栈, 如 NAND 存储架构, 代表复杂的, 具有挑战性的蚀刻过程, 具有关键的蚀刻角度, 统一的通道直径和形状要求, 尽管高蚀刻纵横比通道 100:1 是常见的. 对于 3D-NAND, 关键导体蚀刻过程包括阶梯蚀刻(下图)和用于垂直通道和狭缝的 HAR 掩模打开. 通过硝酸硅和氧化硅交替层蚀刻需要高速定量终点检测. 对于 DRAM, 蚀刻过程包括 HAR 门, HAR 沟槽和金属隐窝. 对于阶梯蚀刻, 关键是在整个 3D堆栈的每个介质膜对的边缘创建等宽的“步骤”, 以形成阶梯形状的结构. 在器件加工过程中, 这些步骤的大量重复要求蚀刻高吞吐量和严格的过程控制.多功能现场气体计量需要在一个工具中执行多种监测功能:• 检测和量化污染, 交叉污染, 气体杂质和工艺室内的工艺化学• 评估已开发的蚀刻过程在生产工具 / 运行的复杂功能上的性能• 测量刻蚀后的清洁 (包括先进的无晶圆自动清洁 WAC) 作为腔条件对于消除工艺漂移和确保可重复性性能是至关重要的• 快速准确的蚀刻端点检测 EPD, 通过等离子体或气体监测, 因为这是一个关键的控制功能. 举例包括一氧化碳 CO 副产物在介电蚀刻中下降或氯 Cl 反应物在多晶硅和金属蚀刻端点上升.• 全面的实时计量数据, 允许过程等离子体和反应物的动态腐蚀控制, 以管理要求的腐蚀剖面Aston™ 质谱分析仪无等离子体终点检测虽然光学发射光谱 OES 已被广泛用于蚀刻 EPD, 但低开放面积 OA 和 HAR 设计的趋势使其在许多蚀刻任务中无效. OES 技术需要等离子体'开'和发光物种. 随着昏暗和远程等离子体越来越多地用于 3D设备和原子水平蚀刻 ALE 工艺, 需要更多敏感的数据和分析技术来实现迅速和确定的 EPD. 此外, 脉冲等离子体通常用于管理 HAR 和 低 OA% 工艺的蚀刻剖面, 这使得 OES 对于 EPD 来说是一个不切实际的解决方案. 在3D 结构中, 多层薄膜和多个接触深度阻碍了每一行触点到达底部时端点的光学发射信号的急剧步进变化其他 OES 限制包括:• 在电介质蚀刻中, 在 OA 5% 的模式上进行 EPD一直具有挑战性, 因为 OES 在低浓度下具有低信噪比.在高压Si深蚀刻(例如博世工艺)中, 要求 OA% 的 EPD低于 0.3%, OES 中较大的背景噪声水平抑制了对发射种数量的任何变化的检测.• 在金属蚀刻中, OA% 可能低于10%, 这取决于所涉及的互连尺寸. 对于接触和通过蚀刻, OA 可以在0.1-0.5%之间或更低, 这取决于所涉及的特征的大小. 在钨 W 蚀刻的情况下, 随着 OA的减小, 氯 Cl 反应物的消耗减少, 由于材料运输到 HAR 蚀刻特征, 蚀刻趋于放缓. 这两个因素都降低了反应气的消耗率. 因此, 由于等离子体中反应物的耗尽, 很难看到在终点处 OES信号的显著变化.Aston™ 质谱仪可以利用蚀刻反应物和 EPD 的副产物. 此外, Aston 能够在小的, 有限体积的传感器上运行周期性清洗, 以保持其性能(灵敏度), 在延长晶圆运行次数的情况下获得更大的正常运行时间. 然而, OES 要求在腔室上有一个需要保持清洁的访问窗口,以获得足够强度的稳定信号。通常,加热石英窗用于减缓工艺产品的堆积. 使用 Aston™质谱分析仪,在低浓度下的检测不受等离子体发射的背景光谱的影响, 也不受射频功率脉冲期间等离子体强度波动的影响.图 3a/3b 显示了 CO+和 SiF3 +的副产物 OA%下降到0.25%的电介质腐蚀EPD数据数据清楚地显示了线性行为和在低浓度下的检测不受等离子体发射的背景光谱影响. Aston 质谱的 ppb 灵敏度是针对 0.1%以下的 OA性能.原子级蚀刻 ALE在三维结构中, ALE 过程中的逐层去除需要脉冲射频电源来控制自由基密度和较低的离子能量, 以减少表面损伤和保持方向性. 在这样的光源中, 等离子体的整体光强较低, 并表现出波动幅度. 通常等离子体离晶圆区很远(距晶圆区25厘米), 而且等离子体激发的副产物很少, 使得光学测量不切实际.在 ALE中, 由于每个周期都是自我限制的, 端点检测可能不那么重要. 然而, 在缺乏气体分析的情况下, 工艺工程师对监测腔室和工艺健康状况“视而不见”, 因为无法看到化学状态, 特别是在工艺步骤 (吸附/净化/反应/净化) 之间过渡时的动态状态, ALE 的自限性并不能使它不受过程漂移的影响. 此外, 由于 ALE 不是基于等离子体的, 因此过程中的化学变化不一定可以通过等离子体监测检测到.有一种误解, 认为 ALE 技术实际上是一次一个原子层 相反, 它们每循环的去除/沉积量可能比单分子膜多一点(或少一点). 由于真空泵性能, 晶圆温度或离子轰击能量 (电压) 的变化分别导致表面饱和度和表面反应性的变化, 工艺移位(Å/周期的变化)可能发生.在 ALE (下图)中,由于等离子体的使用不一致, 化学监测方面的差距就不那么明显了. 在这种情况下, Aston™ 质谱仪具有以下优点:• 在每个工艺步骤中建立一个腔室化学状态的指证. 这可以参照其自身的正常行为, 也可以参照标准腔• 描述和监控与化学变化相关的动态过程中, 从一个步骤过渡到下一个步骤• 监测在 ALE 循环第一步之后从系统中清除吸附物质的时间. 等离子体通常用于产生吸附物质(自由基), 但它是在远离晶圆片的地方产生的• 监测 ALE 循环第二步反应产物的变化. 等离子体光强通常较低, 因为它使用了低占空比的脉冲射频• 监测反应产物和反应物在ALE循环第二步后被净化的时间结论原子级蚀刻只能使用像上海伯东日本 Atonarp Aston™ 质谱仪这样的分子传感器进行真正的测量和监测. 它的高灵敏度, 速度和对等离子体强度变化的低敏感性产生可靠的定量测量, 即使在低浓度的反应物和副产物, 具有低于1% 水平的高精度, 可以监测微妙的过程漂移和过程变化效应, 提供了可用于机器学习模型的见解.利用其高扫描速度, 通过监测反应产物减少的时间来实现步进时间优化, 因为它是表面反应活性变化的指示, 增加了总体吞吐量.ALE 是先进的蚀刻技术, 上海伯东 Aston 质谱仪为 ALE 提供了先进的化学计量技术, 可以测量和控制反应及其持续时间, 为大批量生产提供了可靠的解决方案.若您需要进一步的了解 Atonarp Aston™ 在线质谱分析仪详细信息或讨论, 请参考以下联络方式:上海伯东: 罗先生
 留言咨询
留言咨询
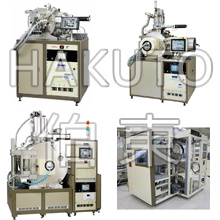
 400-860-5168转0727
400-860-5168转0727
 留言咨询
留言咨询
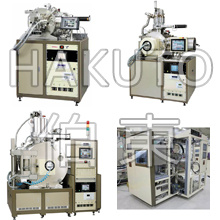
 400-860-5168转0727
400-860-5168转0727
 留言咨询
留言咨询

 400-860-5168转0727
400-860-5168转0727
 留言咨询
留言咨询

 400-860-5168转2459
400-860-5168转2459
 留言咨询
留言咨询
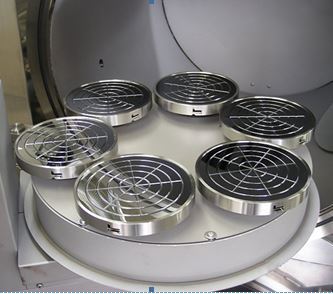
 400-860-5168转0727
400-860-5168转0727
 留言咨询
留言咨询
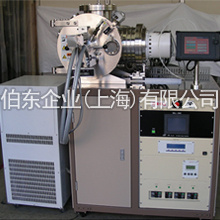
 400-860-5168转0727
400-860-5168转0727
 留言咨询
留言咨询
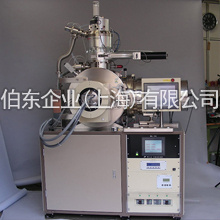
 400-860-5168转0727
400-860-5168转0727
 留言咨询
留言咨询

 400-816-7838
400-816-7838
 留言咨询
留言咨询

 400-892-5667
400-892-5667
 留言咨询
留言咨询

 400-860-5168转4552
400-860-5168转4552
 留言咨询
留言咨询

 400-860-5168转4552
400-860-5168转4552
 留言咨询
留言咨询

 400-860-5168转6134
400-860-5168转6134
 留言咨询
留言咨询

 400-860-5168转4552
400-860-5168转4552
 留言咨询
留言咨询
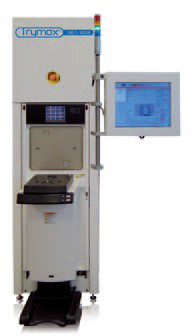
 400-860-5168转4552
400-860-5168转4552
 留言咨询
留言咨询
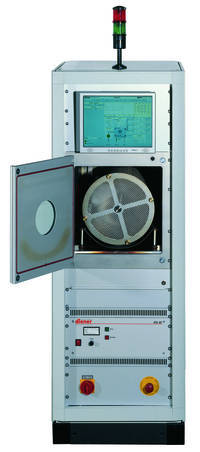
 400-816-7838
400-816-7838
 留言咨询
留言咨询

 400-860-5168转4452
400-860-5168转4452
 留言咨询
留言咨询

 400-860-5168转0727
400-860-5168转0727
 留言咨询
留言咨询

 400-860-5168转0727
400-860-5168转0727
 留言咨询
留言咨询

 留言咨询
留言咨询

 400-892-5667
400-892-5667
 留言咨询
留言咨询

 400-860-5168转4967
400-860-5168转4967
 留言咨询
留言咨询

 400-860-5168转3827
400-860-5168转3827
 留言咨询
留言咨询

 400-860-5168转2459
400-860-5168转2459
 留言咨询
留言咨询

 400-801-5960
400-801-5960
 留言咨询
留言咨询

 留言咨询
留言咨询

 400-860-5168转3688
400-860-5168转3688
 留言咨询
留言咨询

 400-860-5168转0727
400-860-5168转0727
 留言咨询
留言咨询

 400-860-5168转3241
400-860-5168转3241
 留言咨询
留言咨询
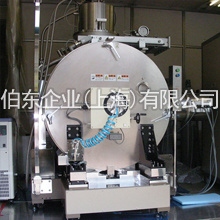
 400-860-5168转0727
400-860-5168转0727
 留言咨询
留言咨询

 400-860-5168转1185
400-860-5168转1185
 留言咨询
留言咨询