









TOF-SIMS在半导体领域有着广泛的应用,如表面痕量金属的检测和定量、工艺过程的有机污染、超浅层深度剖析、超薄介电层分析、界面/bond pad/test pad的分析等等。
TOF-SIMS技术的性能优势主要体现在高质量分辨率、高质量精度和良好的数据速率等方面。另外,低能量、小束斑、高电流的新型双束离子溅射源可以实现溅射快、精度高的深度分析,深度分辨<1nm。且TOF-SIMS技术无需复杂的样品前处理,可以对样品进行直接测试。
本文主要分享半导体器件的浅层、薄层、界面的深度分析的应用案例。(表面的痕量金属的检测和定量、表面污染检测等方面的分析测试案例请参考之前的推文。)
一、包埋500nm深度处的多膜层深度分析

Profiling Conditions: sputtering Cs 2 keV, 45°, analysis Bi 25 keV, 50 kHz interlaced
Speed: 2 µm in 1200 s, 3 datapoints per s, 1.7 nm/s (102 nm/min), 0.5 nm per datapoint
二、N, C, O, 和 Cl离子注入的深度分析

三、浅层注入的深度分析
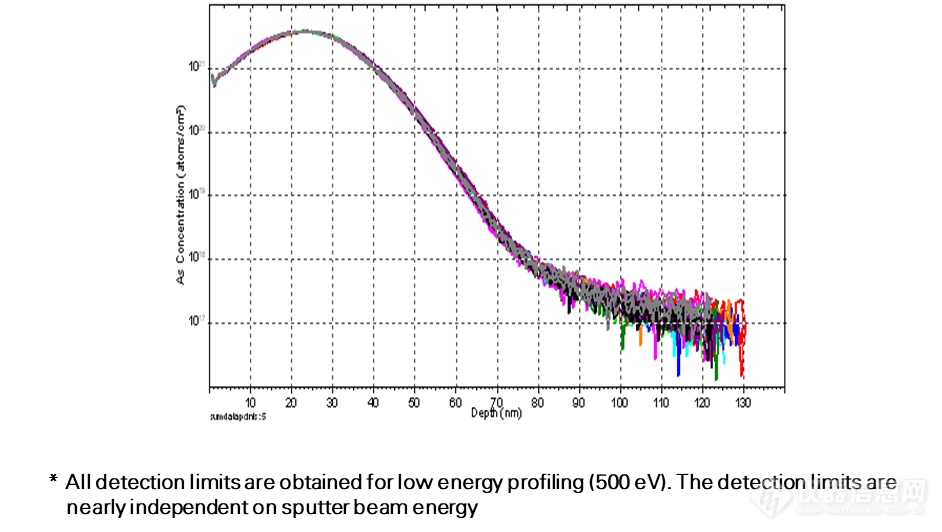
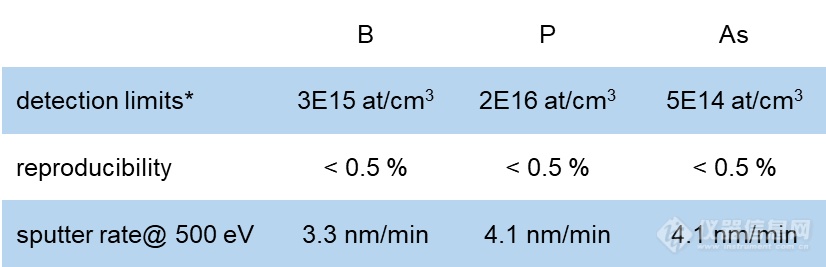
四、SiGe Testpad中B注入的深度分析

Analysis Beam:Bi1 @ 15 keV, 1 pA,35 x 35 µm2
Sputter Beam:O2 @ 500 eV, 90 nA,200 x 200 µm2
Total time for analysis including pad alignment: ≈15 min
五、SiCP Testsample的深度分析

Analysis Beam:Bi1 @ 15 keV, 8 pA,50 x 50 µm2
Sputter Beam:O2 @ 500 eV,80 nA,200 x 200 µm2
Total time for analysis: ≈10 min
六、GaAs/InGaP多膜层深度

Analysis Beam:Bi1 @ 15 keV, 7 pA,00 x 100 µm2
Sputter Beam:Cs @ 1000 eV,100 nA,300 x 300 µm2
Total time for analysis: ≈20 min
关注公众号“IONTOF-CHINA”,更多TOF-SIMS案例分享和实际应用技术解读。
[来源:北京艾飞拓科技有限公司(IONTOF中国代表处)]

AI驱动半导体向上 再议创新合作|第二届半导体第三方分析检测生态圈战略大会召开
2024.07.27

2024.07.26

2024.07.25

2024.07.25

炸裂舞台!7月31日 DSC差示扫描量热新技术发布会,梅特勒托利多带来革新体验
2024.07.24

从实验室到产业化,我国材料产业仪器装备从有向领先迈进——访贝意克董事长孔令杰
2024.07.23
版权与免责声明:
① 凡本网注明"来源:仪器信息网"的所有作品,版权均属于仪器信息网,未经本网授权不得转载、摘编或利用其它方式使用。已获本网授权的作品,应在授权范围内使用,并注明"来源:仪器信息网"。违者本网将追究相关法律责任。
② 本网凡注明"来源:xxx(非本网)"的作品,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,且不承担此类作品侵权行为的直接责任及连带责任。如其他媒体、网站或个人从本网下载使用,必须保留本网注明的"稿件来源",并自负版权等法律责任。
③ 如涉及作品内容、版权等问题,请在作品发表之日起两周内与本网联系,否则视为默认仪器信息网有权转载。
![]() 谢谢您的赞赏,您的鼓励是我前进的动力~
谢谢您的赞赏,您的鼓励是我前进的动力~
打赏失败了~
评论成功+4积分
评论成功,积分获取达到限制
![]() 投票成功~
投票成功~
投票失败了~