









XRT 在半导体材料晶体缺陷表征中的应用介绍
半导体(semiconductor)指常温下导电性能介于导体与绝缘体之间的材料。半导体在集成电路、消费电子、通信系统、光伏发电、照明、大功率电源转换等领域都有应用,如二极管就是采用半导体制作的器件。无论从科技或是经济发展的角度来看,半导体的重要性都是非常巨大的。大部分的电子产品,如计算机、移动电话或是数字录音机当中的核心单元都和半导体有着极为密切的关联。按照半导体材料发展历程和材料本征禁带宽度,习惯上按照如下方法进行分类:
第一代半导体材料主要是指硅(Si)、锗(Ge)这类半导体材料,主要兴起于二十世纪五十年代,其兴起也带动了以集成电路为核心的微电子产业的快速发展,并被广泛的应用于消费电子、通信、光伏、军事以及航空航天等多个领域。就应用和市场需求量而言,半导体Si材料仍是半导体行业中体量最大的,产品规格以8-12英寸为主。
第二代半导体材料是以砷化镓(GaAs)、磷化铟(InP)为主的化合物半导体,其主要被用于制作高频、高速以及大功率电子器件,在卫星通讯、移动通讯以及光通讯等领域有较为广泛的应用。相比于第一代半导体而言,化合物半导体长晶和加工工艺复杂,产品附加值要高一些,产品规格以3-6英寸为主,国内部分厂家可以提供8英寸晶圆。
第三代半导体材料包括了以碳化硅(SiC)、氮化镓(GaN)为代表的宽禁带化合物半导体。相比于第一代及第二代半导体材料,第三代半导体材料在耐高温、耐高压、高频工作,以及承受大电流等多个方面具备明显的优势,因而更适合于制作高温、高频、抗辐射及大功率器件,在电力电子器件、微波射频等领域的应用优势更为明显。产品规格以2-6英寸为主。

图1不同半导体材料禁带宽度及应用[1]
在半导体材料制备和应用过程中,对于晶体缺陷的要求与控制是十分重要的。因为晶体缺陷的类型、大小和多少直接决定了半导体器件性能的优劣和使用稳定性等性能指标。所以,无论是在晶体长晶环节还是晶片加工及晶圆外延等环节,都要进行晶体/晶圆缺陷检查,确保使用在器件上芯片是满足设计要求的。晶圆中常见的缺陷主要有如下几类,参见图2[2]。
点缺陷:在三维空间各方向上尺寸都很小的缺陷。空位、间隙原子、替位原子等;
线缺陷:在两个方向上尺寸很小,而另一个方向上尺寸较大的缺陷。如位错,刃型位错和螺型位错;
面缺陷:在一个方向上尺寸很小,在另外两个方向上尺寸较大的缺陷。如晶界、相界、表面等。
体缺陷:杂质沉积、孔洞及析出相等。

图2 半导体材料中常见晶体缺陷
对于上述提到的四类半导体材料缺陷中,第一类缺陷属于原子层面的缺陷,通常是从掺杂及长晶工艺优化等角度去进行改进。通常不作为生产过程控制的主要参数,一般选择用其他方法进行测量,如采用FTIR方法可以测量Si晶体中代位C原子和间隙氧原子的浓度。第二到四类缺陷,则需要在加工环节进行100%直接或间接检测,确保所生产晶圆/芯片缺陷指标满足订单要求。对于这类缺陷传统方法就是采用腐蚀性化学药液(如熔融的KOH)对晶、体/圆进行腐蚀。在腐蚀过程中由于晶体有缺陷的区域会优先腐蚀,无缺陷区域则腐蚀速度相对较慢,所以在规定腐蚀时间后在晶圆表面会有腐蚀坑(Etch Pit)出现,这是一种破坏性的检测方法。腐蚀好的晶圆在显微镜下对这些腐蚀坑识别和计数,就可以得到该晶体的缺陷信息, 图3 为SiC 晶圆通过KOH腐蚀得到缺陷照片,缺陷主要有刃型位错、螺型位错和微管等[2]。
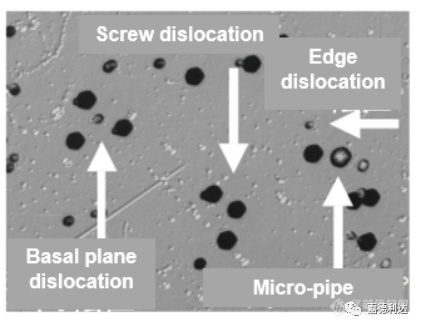
图3 SiC 晶片腐蚀后缺陷形貌[3]
对于半导体晶圆,上述传统缺陷表征方法最大的问题就是破坏性的,检测后的晶圆无法继续使用只能做报废处理。对于像第二代和第三代半导体材料而言,晶体生长技术要求水平较高,成品和晶圆数量受晶棒长度及其他加工方式限制而良率相对不高。像国内部分企业SiC 晶棒成品长度一般在20mm左右。如果按照单片晶圆成品厚度约在0.5mm,除去切割和研磨、抛光损耗,基本上0.8mm才能出一片合格晶圆。如果在晶棒头、尾各取一片晶圆去做缺陷检测,则有约8%的成本损耗。所以很多半导体厂家都希望有一种可以用于半导体晶体材料缺陷的表征的无损检测技术。
日本理学株式会社(www.rigaku.com)作为全球著名的X-Ray 仪器制造商,自1923年以来,理学公司一直专注于X射线仪器领域的研发和生产。该公司生产制造的XRT (X-ray Topography)检测系统则是利用X射线的布拉格衍射原理和晶格畸变(缺陷)造成特征峰宽化和强度变化等特性,再结合理学公司开发的X射线形貌技术,可以对晶体内缺陷进行成像。这种XRT检测技术最大的优点就是无损检测,在不破坏晶圆的情况下实现2-12英寸半导体晶体中线缺陷、面缺陷和体缺陷的检测和表征。

图4 XRT设备实物图

图5 XRT 缺陷表征原理示意图[3]
工作模式:XRT主要有反射成像和透射成像两种模式,反射模式是Cu靶,透射模式则是Mo靶,参见图6。透射模式成像后可以进行3D重构和成像,参见图7 SiC晶圆缺陷图片。
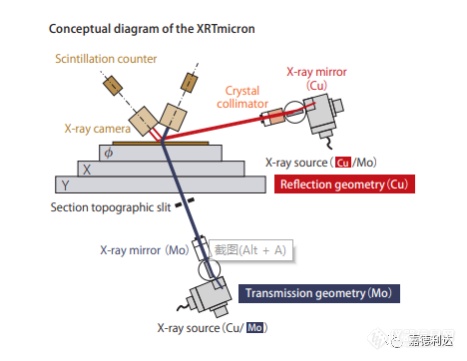
图6 XRT 反射模式和透射模式[3]

图7 SiC 晶圆缺陷表征[3]
系统软件介绍:该仪器标配的图像分析软件可以对检测样品内的缺陷进行统计,给出缺陷数量和分布信息,参见图8。

图 8 XRT 标配软件数据结果界面[3]
后续我们会针对XRT在不同半导体材料检测和应用案例刊发几期相关介绍,敬请期待。
附:
[1] 第三代半导体-氮化镓(GaN) 技术洞察报告,P3;
[2] 理学XRT 内部资料;
[3] 理学XRT公开彩页.
[来源:北京嘉德利达科技有限公司]

为电池研发和质量控制提供精准的分析技术—Mo光源Rietveld结构精修
2023.10.31

北京嘉德利达和天大分析中心及理学中国举办的 X射线分析技术系列交流研讨会 回顾
2023.10.07

2023.10.07

2023.09.11

2022.09.27

2021.07.07
版权与免责声明:
① 凡本网注明"来源:仪器信息网"的所有作品,版权均属于仪器信息网,未经本网授权不得转载、摘编或利用其它方式使用。已获本网授权的作品,应在授权范围内使用,并注明"来源:仪器信息网"。违者本网将追究相关法律责任。
② 本网凡注明"来源:xxx(非本网)"的作品,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,且不承担此类作品侵权行为的直接责任及连带责任。如其他媒体、网站或个人从本网下载使用,必须保留本网注明的"稿件来源",并自负版权等法律责任。
③ 如涉及作品内容、版权等问题,请在作品发表之日起两周内与本网联系,否则视为默认仪器信息网有权转载。
![]() 谢谢您的赞赏,您的鼓励是我前进的动力~
谢谢您的赞赏,您的鼓励是我前进的动力~
打赏失败了~
评论成功+4积分
评论成功,积分获取达到限制
![]() 投票成功~
投票成功~
投票失败了~