半导体 | 离子注入设备


一、什么是离子注入设备?
如果半导体是本征半导体(指完全不含杂质且无晶格缺陷的纯净半导体)或者只有同一类型的杂质的半导体,是无法作为晶体管使用的。为此,需要在硅基板内制作N型区域和P型区域。这些区域的制作需要向晶圆中掺杂杂质。掺入的杂质主要有两类:第一类是提供载流子的受主杂质或施主杂质(如Si中的B、P、As):第二类是产生复合中心的重金属杂质(如Si中的Au)。承担这个任务的就是离子注入装置。
什么是离子注入?
专用设备出现之前是如何引入杂质的呢?答案是扩散。例如在晶圆上形成含有P(磷)这种N型杂质的薄膜,然后通过固相扩散扩散到硅晶体中。这种方法已不再用于先进的半导体工艺了,但它仍被用于形成结晶系太阳能电池的N型区。离子注入从字面上看是将杂质原子电离,给它们足够的加速能量,使其能够被打入硅晶体中的掺杂方法。由于这种方法只是将杂质离子打入硅单晶体内,并没有形成稳定结构,因此需要进行热处理以恢复晶体结构。换句话说,离子注入和用于晶体恢复的热处理是两位一体的工艺。然而,由于两个设备本身有很大的不同,顺便说一下,离子注入的深度对于直径 300mm 的晶圆而言是非常浅的。注入的深度约为1-2um。离子注入后的晶体恢复过程也是在这个厚度中进行的。实际的离子注入只在所需的区域通过抗蚀剂掩膜进行。抗蚀剂掩膜的形成将后面介绍。
离子注入设备的构成要素
下图显示了离子注入设备的概况。离子注入设备由一个离子源、一个质量分离单元、一个加速单元、一个光束扫描单元和一个离子注入室组成。简而言之,离子源使电子与杂质气体分子碰撞,以产生所需的离子,而质量分离器利用电场和磁场的作用去除不需要的离子(例如除了所需的杂质或多电荷的离子以外的离子),只提取必要的离子。其原理与质谱仪的原理相同。多价离子,例如P(磷)是指一价的P+和二价的P++。
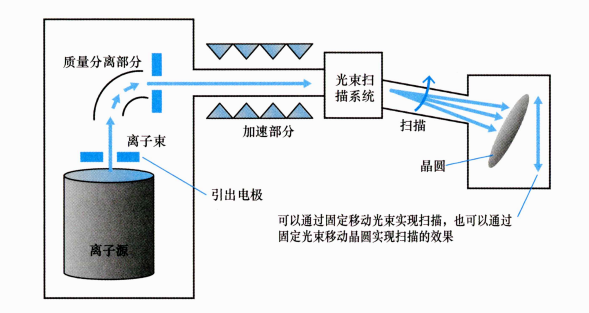
离子注入设备的概念图
通常情况下,使用的是一价离子。加速器通过施加高电压,使得离子拥有足够的打入硅晶体中的能量。光束扫描仪对离子束塑形,使用离子束对晶圆表面进行扫描。离子注入室包含一个盘状板(未显示),晶圆将在上面被注入离子。
由于晶圆是在离子状态下照射的,离子注入室需要高真空和满足这些规格的真空泵。离子源、光束扫描方法将在后面讨论。上图中没有显示离子注入设备,但它需要上述的高真空系统,以及离子质量分离器、加速器和光束扫描系统,是半导体前段制程工艺中的一个很复杂的设备。因此,设备本身又大又重。当然价格也是非常昂贵的。这里需要说明一下,杂质是指与硅不同的元素。杂质本身其实是“高纯度”的某种元素。
二、离子源
离子注入设备的根基还应该是离子源。本部分将对离子源进行介绍。
含有离子源物质的气体
在硅半导体中,磷(P)或砷(As)被用作N型杂质,而硼(B)被用作P型杂质括号内的符号是元素符号。这些元素的氢化物气体被作为离子源的气体使用。最常见的有PH3(磷化氢)、AsH3(砷化氢)、B2H6(硼烷)。根据《日本高压气体安全法》,所有这些气体都被归类为有毒气体,其管理和使用受到了严格监管。所以离子注入的气瓶(用于成膜和蚀刻的小型气瓶。以前也使用过固体蒸发源。)就出于这样的考量做了特殊形状的设计。
弗里曼型离子源
接下来简单了解一下离子源。在后面内容中,会讨论FIB(Focused lon Beam:聚焦离子束),它也是一种离子源,但它是一种产生特定类型离子的离子源,与离子注入设备不同。离子注入设备的情况是,根据杂质对象是N型还是P型,所使用的离子是不同的,所以即便是对同一杂质类型,也有可能使用不同的离子。最经典的弗里曼型离子源本质上是一个热灯丝,当热电子与原始气体碰撞时产生离子。下图显示了该离子源的概要。然而,由于更大电流和更长离子源寿命的需求,它已被伯纳斯(Bermus)型离子源取代。

弗里曼型离子源的示意图
伯纳斯(Bernus)型离子源
下图显示了伯纳斯(Bermus)型离子源的概要。热灯丝呈螺旋状,并且采用与灯丝相对的反射板。因此,灯丝的热电子和反射板中出来的二次电子相结合就可以形成较大的电弧电流。
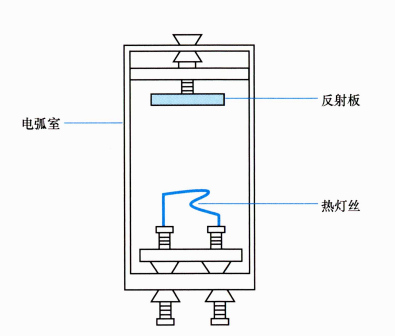
伯纳斯(Bernus)型离子源的示意图
因此它被当作大电流类型的离子源使用,参见4-4节。另外它也可以被用作中等电流和高能型的离子源。对于离子源来说,寿命是非常重要的。特别是为了减少对灯丝的损耗,会在灯丝外面罩上罩子。即便是在寿命上做了很多优化,但是灯丝终归是有使用寿命的,所以基本上离子源就是一个消耗品。
三、晶圆和离子注入设备
离子注入设备的晶圆搬运和其他设备是一样的,但是离子注入设备需要进行离子束扫描,所以存在一些其他设备没有的课题。
离子注入设备中的晶圆扫描
由于离子束的作用范围很小,因此如上所述,需要通过离子束或者晶圆本身的移动来实现扫描进而对晶圆实行离子注入。对于前者,已经使用了一种被称为光栅扫描的方法。这是一种基于电子束扫描的方法,已被应用于阴极射线管和电子显微镜扫描(即SEM)。光栅扫描是一种在固定方向上重复扫描光束的方法,在晶圆的中心和外围之间的注入角度是不同的,导致离子注入的不均匀性。随着晶圆的直径变大,晶圆内的均匀性问题更加严重。因此现在已很少使用。取而代之的是使用混合扫描,即离子束在一个固定的方向上扫描,而晶圆又同时移动进行正交扫描。这两种方法的比较见下图。
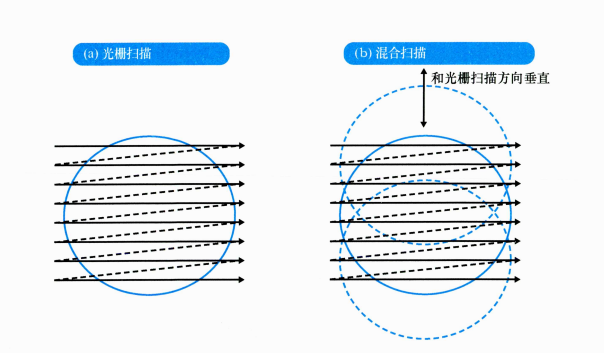
离子束的扫描方法
晶圆扫描设备的课题
晶圆的扫描会增加工序的处理时间。这与可以一次性完成或者可以进行批量处理的清洗和干燥、成膜、蚀刻、CMP 等工艺的情况是非常不同的。下图显示了两种情况的比较示意图。批量式设备的吞吐量随着晶圆尺寸的增大而略有下降,但扫描设备(如离子注入设备)的吞吐量往往与晶圆面积成反比。具有类似窘境的还有其他工艺设备,包括光刻设备、同样需要扫描的曝光设备、热处理中的激光退火设备等。
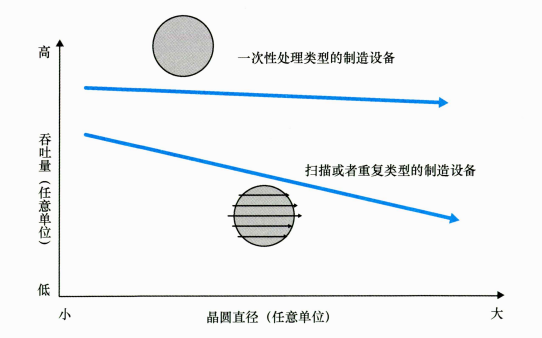
制造设备的吞吐量比较
但是这种窘境是原理上的,不可避免。只能提升单枚晶圆的扫描速度。
四、制造 CMOS 的离子注入设备
离子注入法被用于各种工艺中。本节以CMOS 工艺为例,解释不同类型的离子注入设备及其使用方法。
各种扩散层形成的 CMOS
扩散层(由杂质形成的区域)是一个由杂质形成的层。扩散层有“N型”或“P型”两种,它们在杂质的深度和浓度上不尽相同。为了下面的说明,我们在下图总结了CMOS(CMOS:Complementary Metal Semiconductor Oxide的缩写。N型和P型晶体管的形成使其各自工作,从而达到降低功率的效果)逻辑晶体管原理的例子。在CMOS晶体管中,N型和P型晶体管并排构建,见下图。源极和漏极是扩散层,而栅极是一种操作晶体管的开关,它们一起构成了晶体管为了制造N通道和P通道晶体管,要形成一个称为井的区域。可以满足N型或P型的塑造需求,所以就需要在硅基板中注入杂质区域。
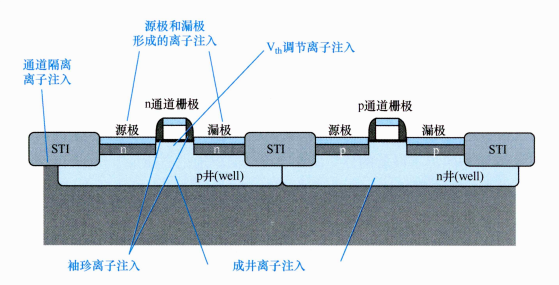
各种各样的离子注入设备
下图中双井的构造是如今的主流。井的英文是 well,指晶圆与杂质或者杂质与杂质之间形成的扩散层。用于栅极开关电压调节(也称为 Vth 调节)的离子注入在栅极下方进行。还有其他各种离子注入工艺,如栅极周围的袖珍离子注入,以及在图中标记为ST的器件分离区的通道隔离离子注入。为了避免在不需要的地方注入离子,需要使用光刻技术形成一个抗蚀剂掩膜。
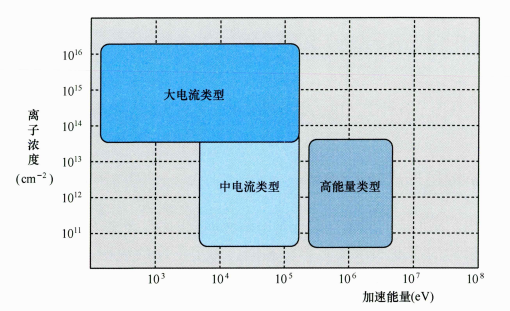
不同加速能量和束电流的离子注入设备
这些扩散层和离子注入区域在杂质浓度和扩散深度上不尽相同。这是通过用离子注入设备的加速能量控制扩散层的深度和用离子束电流控制杂质浓度来实现的。例如,由于井的扩散深度,需要足够的加速能量,而源-漏极则需要高浓度的杂质来驱动晶体管。每一种工艺都有专门的设备,它们可以分为三大类:高能量、大电流(也称为高浓度)和中电流(也称为中浓度)。上图中给出了设备的分类概要。可以简单地把高能量看作是井,把大电流看作是源和漏极,把中电流看作是其他部分。特别是,随着元器件小型化的进展,源极和漏极需要高电流但低能量的离子注入设备的需求增大。下图显示了每个离子注入工艺的加速能量和离子浓度。这只是一个粗略的指南,可以结合上图进行对比观察。可以毫不夸张地说,如果没有离子注入技术,这里介绍的双井CMOS是不可能出现的。
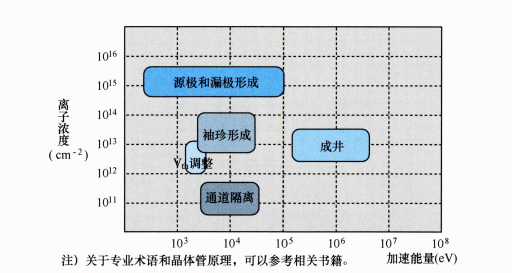
各个离子注入工艺的能量和离子浓度
其他离子注入技术
上述的离子注入技术是先进半导体工艺不可或缺的部分。不仅限于CMOS方面的应用,还有为了降低多晶硅的电阻值而向多晶硅实行的离子注入,以及为了减小扩散层和接触孔金属塞之间的接触电阻,所进行的接触离子注入等诸多例子。
五、离子注入的替代技术
离子注入是半导体工业中一个成熟的工艺,但进行该工艺所需的设备过于昂贵,因此很多掺杂技术被提出用于替代离子注入。
等离子掺杂设备
在历史上,有各种替代离子注入的技术来进行杂质掺杂。在改进离子注入技术方面有蔟离子注入法和气体蔟离子注入法等,虽然是改良,但其设备仍然非常庞大
在本节中,将讨论等离子体掺杂和激光掺杂这两种不使用离子源的设备。
等离子体掺杂系统的概念已经存在了一段时间。在使用等离子体这一点就和等离子体 CVD成膜法、蚀刻法相同。下图显示了等离子体掺杂系统的概况。基本上,与干式蚀刻设备以及等离子体 CVD设备大同小异。工艺室被抽成真空,利用高频放电电解杂质气体,从而实现晶圆的掺杂。如图所示在晶圆一侧施加一个负的偏压电源,以促进杂质离子的掺入。此外,还安装了线圈,以产生高密度的等离子体。
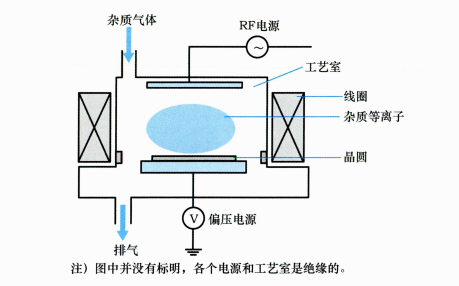
等离子掺杂设备的概念图
与离子注入设备相比,该设备不需要大型高真空设备,也不需要离子加速,从而降低了设备的成本。没有离子束意味着不仅可以在正面,也可以在侧面进行掺杂。最近也有利用等离子掺杂的方法尝试实现鳍状结构(鳍状结构:不同于源极和漏极的第二代栅极结构,使得栅极能够拥有第三代结构,从而提升栅极的支撑力实现晶体管精细化的结构。作为一种挑战晶体管精细化极限的技术被提出)。这种具有三维结构的掺杂。虽然等离子体掺杂设备已经被离子注入设备挤压得一度消失,如果能看到等离子体掺杂装置再次被重视,将是很有趣的。
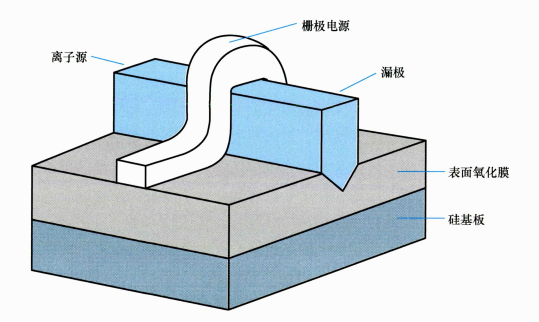
鳍状结构的模型图
然而,正如在前面的介绍中,由于离子没有被加速,掺杂的深度没有办法做得很深。所以它主要应用于超浅源极和漏极的形成。
激光掺杂设备
它基本上是与激光热处理设备的应用版本一样。下图显示了设备的概况。杂质气体在减压的情况下被引入工艺室中,并由激光照射以熔化晶圆表面并实现掺杂。当然,这个过程没有办法使用抗蚀剂掩膜。
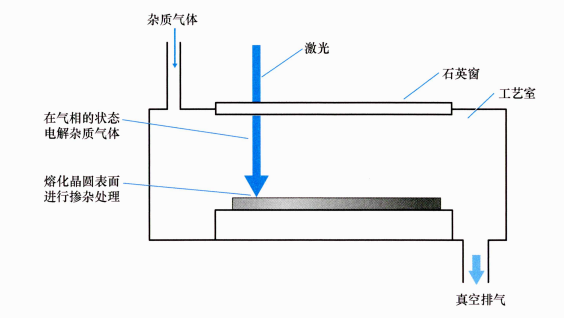
激光掺杂设备的概念图
这种技术对于掺杂深度也没有办法到达很深。与等离子体掺杂一样,它主要用于超浅结合的形成。
参考文献:
内容来源:爱蛙科技编辑整理
更多![]()
半导体 | 清洗和干燥设备
厂商
2024.09.10
半导体 | 半导体工艺的发展趋势
厂商
2024.09.06
半导体 | 前道工艺概述
厂商
2024.09.04
半导体 | 封测技术趋势
厂商
2024.08.30









