������0�γ齱����
����



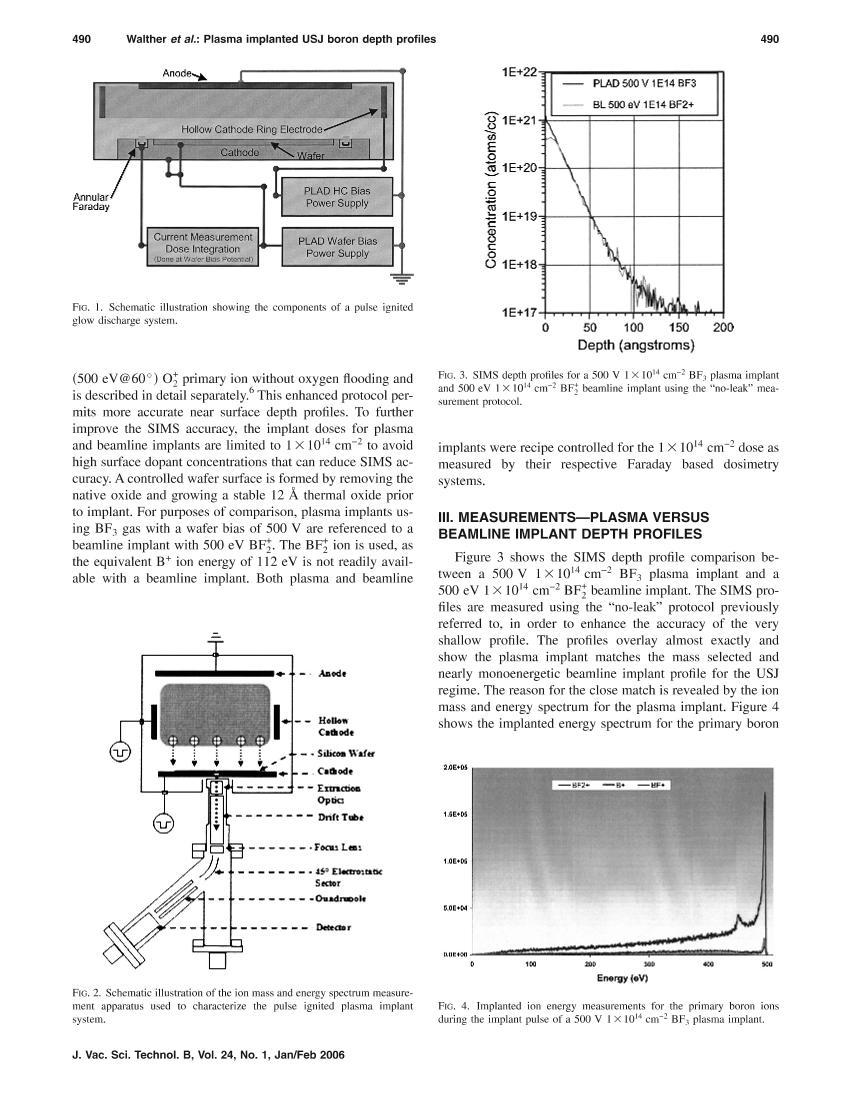


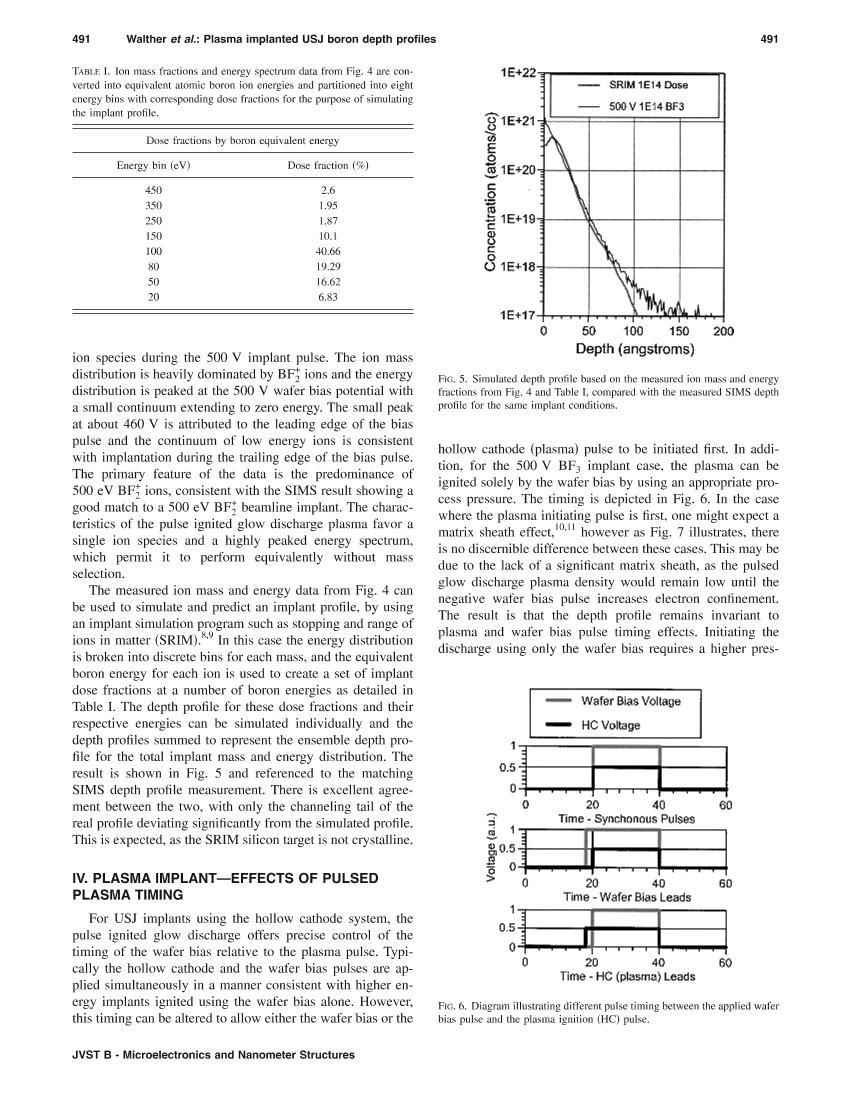


 һ��ѯ��
һ��ѯ��

��װApp���������

��������������������